我們知道,單顆芯片里集成的晶體管越變越多,
現已容納超過500億個,
這簡直就是個天文數字。
眼看平面上即將無處安放,
是不是“縱向發展”更有機會呢?
沒錯!造芯片就好比蓋房子。
傳統的結構像是單層平房;
再高級點好似聯排小區,
更先進就是摩天大樓了。
從2D到3D
以前,芯片的結構是單層的,
一個封裝里通常只有一個裸芯,
通過引腳或焊球連接到電路板上,
為芯片提供電氣和力學支持。

這種2D封裝方式真香:
成本低、易制造、可靠性相當高。
然而,隨著摩爾定律的發展和工藝的演進,
2D封裝開始難以滿足日益膨脹的性能需求。
開發者們腦洞大開,要不垂直堆疊多個裸芯試試?
這一疊,打開了新世界的大門。
三維短程垂直互連替代了二維長程互連,
不僅提高了信號傳輸速度,
還能降低功耗和成本。

至此,這種3D封裝方式堪稱封神,
可是新的麻煩又接踵而至。
由于多個裸芯堆疊在一個小空間中,
散熱問題變得十分棘手,
可靠性問題也令人頭禿。
為了解決這些難題,
將2D和3D封裝的優勢鍛造融合,
一種全新的封裝方式
“2.5D封裝”閃亮登場。


2.5D封裝通過一片中介層連結,
實現了多塊裸芯的系統級封裝。
3D封裝則將多個裸芯縱向堆疊在一起,
利用垂直互連技術提高芯片的性能。
打個比方,2.5D結構就像平面版樂高像素畫,
在一個底面上水平固定積木塊;
3D結構則類似于立體版樂高積木,
把功能模塊一層層垂直疊高高。

2.5D封裝擁有較高的性價比,
出色的熱管理,較短的開發時間,
實現了成本、性能和可靠性的平衡,
3D封裝擁有超大帶寬和更高性能,
廣泛應用于高性能計算領域,
如數據中心、網絡、服務器等。
3D結構的種種優點,

2.5D和3D都是先進的封裝與集成方式,
但從2.5D到3D并不算迭代關系,
它們不是水火不容的競爭對手,
而是一對需求互補的“好麗友”,
在不同的應用場景里滿足各種芯片的設計需求。
從3D向未來
人們對高維世界的探索從未止步。
盜夢空間里垂直的地面,
高高懸掛于地面的建筑,
都像極了未來的四維折疊城市。

由于地心引力等因素的存在,
4D折疊城市暫時還無法建造,
但4D芯片設計已不再是夢。
4D封裝的概念并不難理解:
將多塊基板彎曲和折疊,
每塊基板上安裝不同的芯片和器件,
連接方式也可以多種多樣。
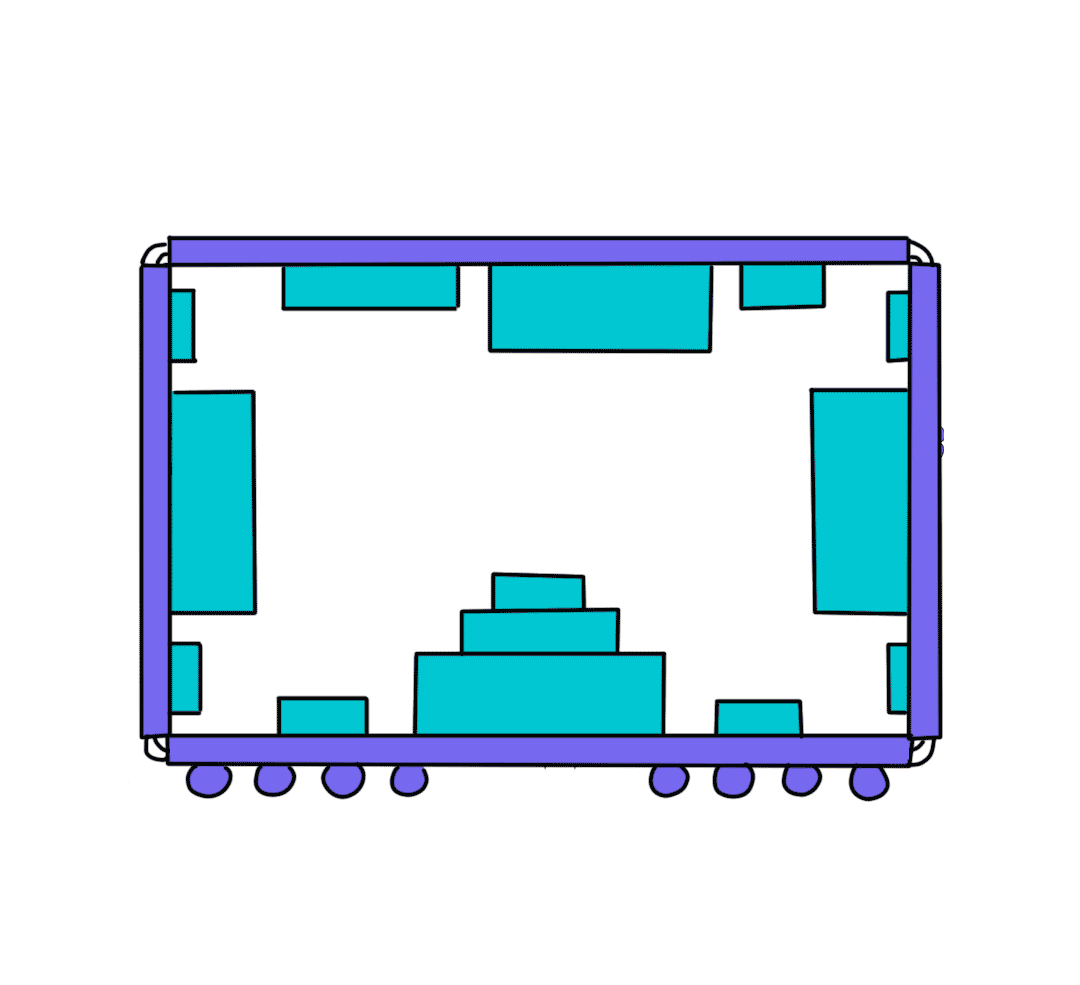
可以說,4D封裝與集成就是集2D/2.5D/3D之大成,
不僅提供了更靈活的安裝空間,
還解決了氣密、抗震的問題,
在高溫、高壓等復雜環境中也毫無壓力,
必定會在更多應用中大放異彩。

幫助開發者從多維度考慮設計策略,
不管是2D/2.5D/3D還是4D封裝與集成,
3DIC Compiler統統都能搞定。
不僅減少了迭代次數,
還能提供功耗、熱量和噪聲感知優化,
輕松實現最佳PPAC目標,讓產品閃電上市。

-
新思科技
+關注
關注
5文章
855瀏覽量
51247
原文標題:3D封裝:芯片 “蓋樓”大法好
文章出處:【微信號:Synopsys_CN,微信公眾號:新思科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
2.5D/3D封裝技術升級,拉高AI芯片性能天花板
3D打印可以打印那種柔韌性好,能隨意變形的模型嗎?
芯片3D堆疊封裝:開啟高性能封裝新時代!






 3D封裝:芯片 “蓋樓”大法好
3D封裝:芯片 “蓋樓”大法好



















評論