氧化鎵(Ga2O3 )是性能優異的超寬禁帶半導體材料,不僅臨界擊穿場強大、飽和速度高,而且具有極高的 巴利加優值和約翰遜優值,在功率和射頻器件領域具有重要的應用前景。本文聚焦于 Ga2O3射頻器件,首先介紹了 Ga2O3在射頻器件領域的優勢和面臨的挑戰,然后綜述了近年來 Ga2O3射頻器件在體摻雜溝道、AlGaO/Ga2O3調制 摻雜異質結以及與高導熱襯底異質集成方面取得的進展,并對研究結果進行了討論,最后展望了未來 Ga2O3射頻器 件的發展前景。
0 引言
超寬禁帶半導體的禁帶寬度大于4eV,其臨界擊穿場強遠高于SiC和GaN,被認為是研制下一代超高耐壓電力電子器件和超大功率射頻器件的先進電子材料。常見的超寬禁帶半導體有金剛石、氧化鎵(Ga2O3)、氮化鋁(AlN)、氮化硼(BN)等,然而,金剛石、AlN等絕大多數超寬禁帶半導體的雜質激活能較高、摻雜難度大,限制了其在功率和射頻器件領域的發展。Ga2O3是目前唯一可以容易實現高效率n型摻雜的超寬禁帶半導體材料,雖然起步較晚,但隨著大尺寸單晶襯底制備和n型外延摻雜技術的日益成熟,近年來在功率器件領域的發展十分迅速,其中功率器件的擊穿電壓已超過10kV,功率優值(P?FOM)最高達13.2GW/cm2,超越了GaN和SiC的理論極限,發展速度超過金剛石、AlN等其他超寬禁帶半導體,有望率先實現工程化應用。
在射頻器件領域,與GaN器件相比,由于Ga2O3在禁帶寬度和擊穿場強上的優勢,Ga2O3射頻器件不僅可在更高場強和更高電壓下工作,大幅度提升輸出功率密度,還可以實現在高溫、強輻照等極端環境下的應用。由于其飽和速度較高,Ga2O3射頻器件有望與GaN器件一樣獲得較高的截止頻率。Ga2O3的約翰遜優值(JFOM)約為GaN的2.6倍,表明Ga2O3在射頻器件領域也具有較大的應用潛力。美國空軍研究實驗室、美國紐約州立大學布法羅分校(以下簡稱布法羅大學)等機構已相繼布局開展氧化鎵射頻器件的研究。根據前期研究進展,整理出Ga2O3射頻器件發展技術路線如圖1所示。2017年,美國空軍研究實驗室首次報道了Ga2O3器件的射頻性能,然而,由于體摻雜Ga2O3溝道較厚,限制了柵長的進一步縮小,此外Ga2O3還存在遷移率低、熱導率低等問題,制約了其在射頻器件領域的發展。為了抑制器件的短溝道效應和提高電子遷移率,2019年和2021年美國俄亥俄州立大學和布法羅大學分別報道了δ摻雜和基于AlGaO/Ga2O3異質結調制摻雜結構的Ga2O3射頻器件,頻率性能得到顯著提升。2023年和2024年南京大學和上海微系統與信息技術研究所分別報道了SiC和金剛石與Ga2O3射頻器件的異質集成,器件的飽和電流密度、頻率及功率性能均得到顯著提升。本文圍繞以上技術發展路線,主要介紹了氧化鎵射頻器件的國內外發展現狀,并對存在的問題和發展趨勢進行了分析。
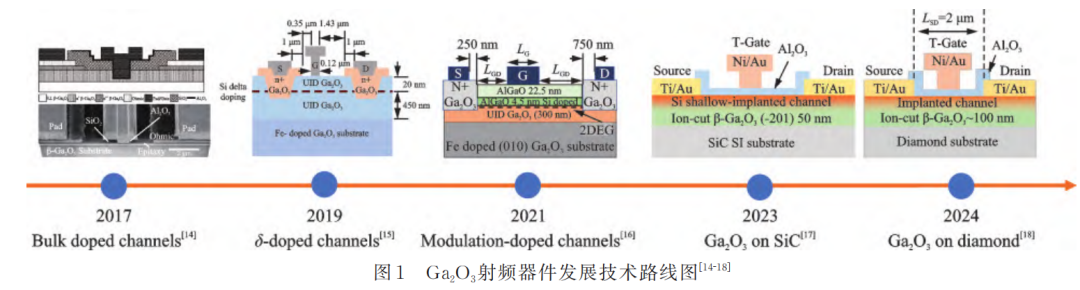
1 Ga2O3在射頻器件領域的優勢及面臨的挑戰
表 1 列出了幾種常見半導體材料的物理參數, 其中 Eg 為禁帶寬度,Ebr 為擊穿場強,μ 為電子遷移 率,vsat 為飽和速度,λ 為熱導率,ε 為相對介電常數。 可以看到 Ga2O3的 禁 帶 寬 度 為 4.8 eV,臨 界 擊穿 場 強 高 達 8 MV/cm,是 4H?SiC 材 料 的 3.2 倍 ,表 明 Ga2O3在 大 功 率 器 件 領 域 更 具 有 優 勢,不 僅 可 以 提 升電力電子器件的耐壓,還可以提升射頻器件的工 作電壓,從而有望實現更大的功率。飽和速度是用 來衡量器件理論頻率性能的重要指標,飽和速度越 大,載 流 子 在 溝 道 中 的 渡 越 時 間 越 短,器 件 的 截 止 頻 率 越 高。Ga2O3的電子飽和速度 為 2×107cm/s, 與 SiC 相 當,是 GaN 的 80%,表明 Ga2O3 理 論 上 也 具 備 高 頻 應 用 潛 力。BFOM 是衡量功率 器 件 導 通 電 阻 和 擊 穿 電 壓 綜 合 性 能 的 參 數,正 比 于 遷 移 率, 同 時 正 比 于 擊 穿 場 強 的 立 方,故 擊 穿 場 強 對 器 件 BFOM 的 貢 獻 要 遠 高 于 遷 移 率 ,因 此 雖 然 Ga2O3 的 遷 移 率 遠 低 于 SiC 和 GaN,但 卻 獲 得 了 更 高 的 BFOM 值 ,達 到 了 SiC 的 10 倍 。 JFOM 與 材 料 的 擊 穿 場 強 和 載 流 子 的 飽 和 速 度 的 乘 積 有 關,綜 合 考 慮 了 射 頻 器 件 的 頻 率 和 功 率 特 性,是 衡 量 射 頻 器 件 綜 合 性 能 最 重 要 的 指 標。 Ga2O3 的 JFOM 值 為 2844,分 別 是 SiC 和 GaN 的 10 倍 和 2.6 倍, 表 明 Ga2O3 在 射 頻 器 件 領 域 也 具 有 潛 在 的 應 用 價 值。
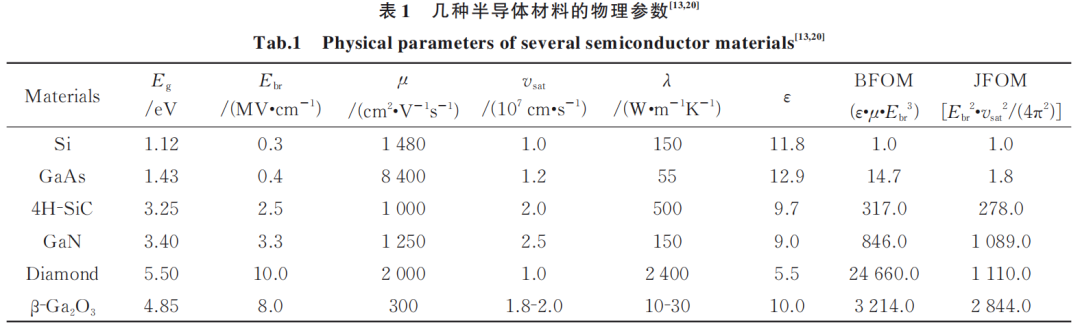
早在 2017 年,美國海軍研究實驗室(NRL)就對 Ga2O3器件的應用前景進行了研究和分析。他們 認 為 ,由 于 Ga2O3 的 飽 和 電 子 速 度 較 大 ,理 論 上 Ga2O3 射 頻 器 件 也 可 以 獲 得 較 高 的 截 止 頻 率。 然 而,由 于 其 熱 導 率 極 低,器 件 將 面 臨 嚴 重 的 自 熱 效 應,限 制 了 其 在 高 頻、高 功 率 下 的 應 用。他 們 繪 制 了 幾 種 半 導 體 材 料 應 用 領 域 的 功 率-頻 率 圖,如 圖 2 所示,Ga2O3器件的工作頻率范圍與 SiC 器件 相當,但功率有望提升一個數量級,從 1 kW 提升至 10 kW。
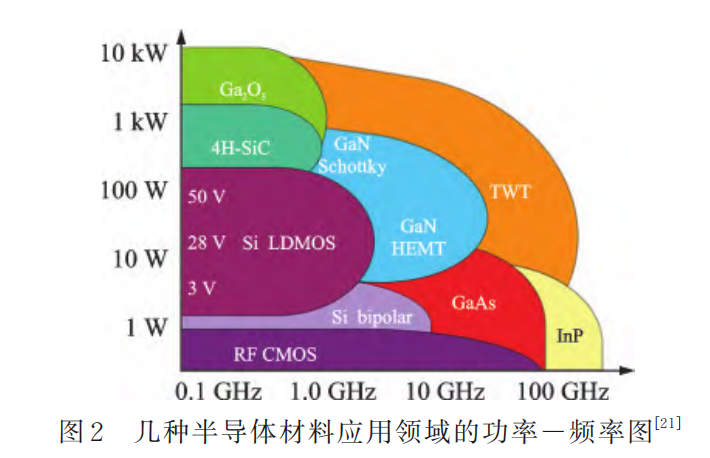
然而,由于短溝道效應、遷移率低、熱導率低等 因 素 的 制 約,目 前 Ga2O3 射 頻 器 件 的 電 流 密 度、頻 率、功 率 密 度 等 性 能 指 標 仍 然 處 于 較 低 的 水 平,發 展面臨著高難度的挑戰。
首 先,與 電 力 電 子 器 件 相 比,射 頻 器 件 的 柵 長 更 短,對 溝 道 厚 度 和 摻 雜 濃 度 的 精 準 調 控 要 求 更 高。GaAs、GaN 射頻器件的成功離不開其高遷移率 的 二 維 電 子 氣(Two ? dimensional electron gas, 2DEG)溝道,由于載流子的輸運被限制在超薄的 量 子 阱 中,器 件 的 短 溝 道 效 應 得 到 有 效 抑 制。而 Ga2O3難以獲得如此高性能的 2DEG 溝道,美國布法 羅 大 學 雖 然 通 過 AlGaO/Ga2O3 調 制 摻 雜 技 術 獲 得 了 2DEG 溝道,有效抑制了器件的短溝道效應,將器 件的截止頻率提升至 30 GHz,但由于 2DEG 的濃度 和 遷 移 率 較 低,器 件 的 電 流 密 度 僅 為 74 mA/mm, 限 制 了 其 在 射 頻 器 件 上 的 應 用。目 前 更 多 的 是 采 用 外 延 摻 雜 的 溝 道 ,溝 道 層 厚 度 普 遍 在 50~ 200 nm,縮 短 柵 長 容 易 產 生 短 溝 道 效 應,從 而 降 低 柵對溝道載流子的調控能力和器件的頻率特性。
其次,Ga2O3的電子遷移率低,不管是傳統體摻 雜還是調制摻雜,遷移率普遍低于200cm2/(V?s), 較 AlGaN/GaN 異質結的 2DEG 遷移率低了一個數 量 級。低 遷 移 率 導 致 器 件 難 以 在 低 電 場 下 獲 得 較 高的電子飽和速度,從而限制了器件的跨導和頻率 性 能 。 此 外 ,低 遷 移 率 還 會 增 大 溝 道 方 阻 ,目 前 Ga2O3 的 溝 道 方 阻 普 遍 大 于 5 kΩ/sq,是 AlGaN/ GaN 異質結的 10 倍以上,給射頻器件引入了較高的 柵源和柵漏串聯電阻,從而降低了器件的電流密度和頻率特性。
再 次,射 頻 器 件 不 僅 特 征 尺 寸 小,而 且 功 率 密 度高,如果散熱不好會導致器件在工作時結溫急劇 上 升,飽 和 電 流 和 功 率 發 生 退 化,因 此 對 器 件 散 熱 能力有著極高的要求。然而,Ga2O3的熱導率極低, 僅為 10~30 W/(m·K),遠低于 SiC 和 GaN。隨著功 率密度的提升,散熱已成為 GaN 射頻器件需要進一 步解決的問題,對于熱導率更低的 Ga2O3射頻器件, 其 面 臨 的 散 熱 問 題 將 更 為 嚴 峻,嚴 重 制 約 了 Ga2O3 在射頻器件領域的發展。
2 基于體摻雜溝道的Ga2O3射頻器件
早期對 Ga2O3射頻器件的研究主要基于傳統體 摻 雜 Ga2O3外 延 材 料,即 在 半 絕 緣 襯 底 上 同 質 外 延 體 摻 雜 的 Ga2O3溝 道 層,或 者 通 過 離 子 注 入 技 術 在 非故意摻雜 Ga2O3外延層中形成摻雜溝道。體摻雜 的 溝 道 厚 度 普 遍 在 50 nm 以 上 ,當 柵 長 縮 短 至200 nm 以 下 時,器 件 將 面 臨 嚴 重 的 短 溝 道 效 應,制 約頻率性能的提升。2017 年,美國空軍研究實驗室 (ARFL)首次報道了 Ga2O3器件的射頻性能。采 用 金 屬 有 機 氣 相 外 延(Metal ? organic vapor phase epitaxy,MOVPE)技術在(100)晶向半絕緣 Ga2O3襯 底上生長了一層 180 nm 厚的 Ga2O3溝道層,Si 摻雜 濃度為 1×1018cm-3。由于溝道較厚,采用挖槽技術 將柵下溝道減薄至 90 nm 左右,并制備了 SiO2介質 輔助的 T 型柵,柵長 0.7 μm,器件結構和性能如圖 3 所 示。柵 下 挖 槽 技 術 有 效 提 升 了 器 件 柵 長 與 有 源 層溝道厚度的比值,峰值跨導達到 21 mS/mm,在柵 壓 VGS=-8 V 時表現出良好的關斷特性,開關比達 到 106 ,表明短溝道效應得到了有效抑制。然而,柵 下 挖 槽 增 大 了 溝 道 電 阻,器 件 飽 和 電 流 密 度 僅 為 150 mA/mm。器 件 的 截 止 頻 率 fT 和 最 大 振 蕩 頻 率 fmax分別為 3.3 GHz 和 12.9 GHz,其中 fT較低可能與 介 質 輔 助 T 型 柵 引 入 了 較 高 的 寄 生 電 容 有 關。對 該 器 件 在 800 MHz 頻 率 下 進 行 了 連 續 波 功 率 輸 出 特 性 測 試,在 漏 極 偏 置 VDS=25 V 下 的 功 率 密 度 為 230 mW/mm。柵下挖槽技術有效提升了器件的柵 控 能 力,但 也 降 低 了 飽 和 電 流 密 度。此 外,刻 蝕 過 程 中 可 能 產 生 刻 蝕 損 傷,引 入 較 高 密 度 的 界 面 態, 從而影響器件的射頻性能。

2020 年 ,AFRL 直 接 在 65 nm 薄 溝 道 的 Ga2O3 外延材料上研制了 0.5 μm 柵長的射頻器件,如圖4所示 ,飽 和 電 流 密 度 和 跨 導 分 別 提 升 至 300 mA/mm 和 40 mS/mm,fT 達 到 了 4.2 GHz。在 1 GHz 頻率下對器件進行了功率輸出性能測試,脈 沖 模 式 下 輸 出 功 率 密 度 達 715 mW/mm,然 而 在 連 續波下僅為 213 mW/mm,表明 Ga2O3射頻器件即使 在低頻和低功率密度下也存在嚴重的自熱效應,嚴 重 制 約 了 器 件 的 功 率 性 能。同 時 也 研 究 了 器 件 的 脈沖 I?V 特性,當漏極靜態偏置電壓為 0 V 時,器件 的 飽 和 電 流 密 度 達 到 了 300 mA/mm 以 上,柵 極 靜 態偏置電壓對電流的影響不大,但當漏極靜態偏置 電壓增大至 20 V 時,器件出現了嚴重的電流崩塌,導 通電阻急劇上升,飽和電流密度下降至 200 mA/mm, 表明漏極應力導致了器件的電流崩塌,這也是器件 輸出功率密度低于預期的主要原因之一。
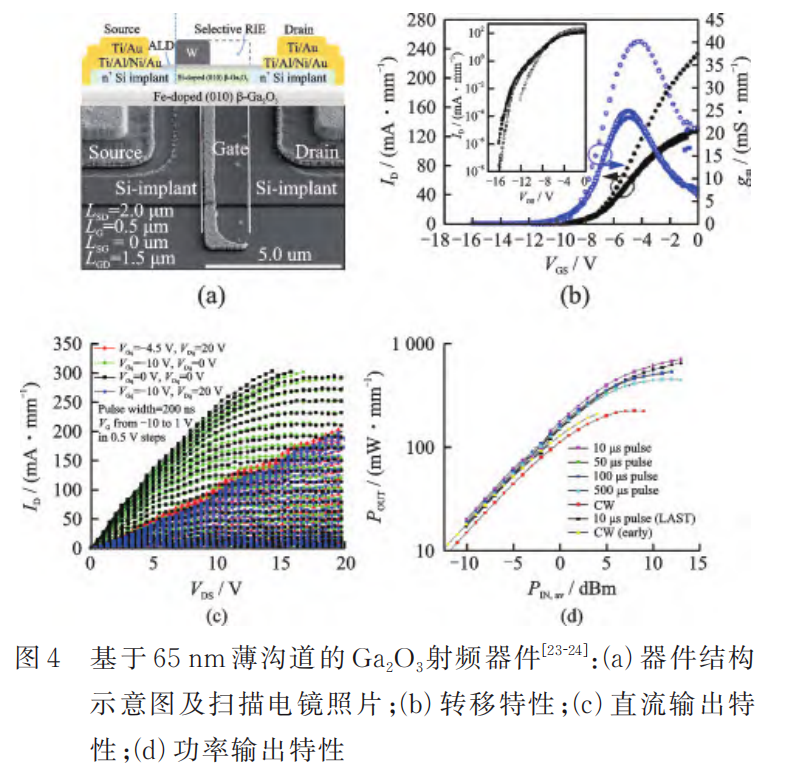
同年,日 本 國 立 信 息 通 信 技 術 研 究 所(NICT) 通過 Si 離子注入技術在非故意摻雜(Unintentional? ly doped,UID)Ga2O3外延材料上形成了 70 nm 厚的 薄 層 溝 道,Si 摻 雜 濃 度 約 為 4.8×1018cm-3,并 采 用 T 型柵技術制備了柵長 50 nm 至 1 μm 的 Ga2O3射頻 器件,器件結構和性能如圖 5 所示。200 nm 柵長 器件的飽和電流密度 250 mA/mm,由于溝道較厚,閾 值 電 壓 達 到 了 -24 V,fT 和 fmax 分 別 為 9 GHz 和 27 GHz。對 不 同 柵 長 器 件 的 頻 率 特 性 進 行 了 對 比 和分析,當柵長(L G)大于 200 nm 時,頻率性能隨著 柵長的縮短而增大并達到飽和,進一步縮短柵長至 200 nm 以 下 時 ,頻 率 性 能 反 而 出 現 了 下 降 ,表 明 200 nm 以下柵長的器件面臨著嚴重的短溝道效應, 限制了器件頻率性能的提升。因此,溝道厚度決定 了 Ga2O3射 頻 器 件 的 最 小 柵 長,要 獲 得 高 的 頻 率 特 性,溝道厚度需要隨柵長的縮短而等比例減薄。
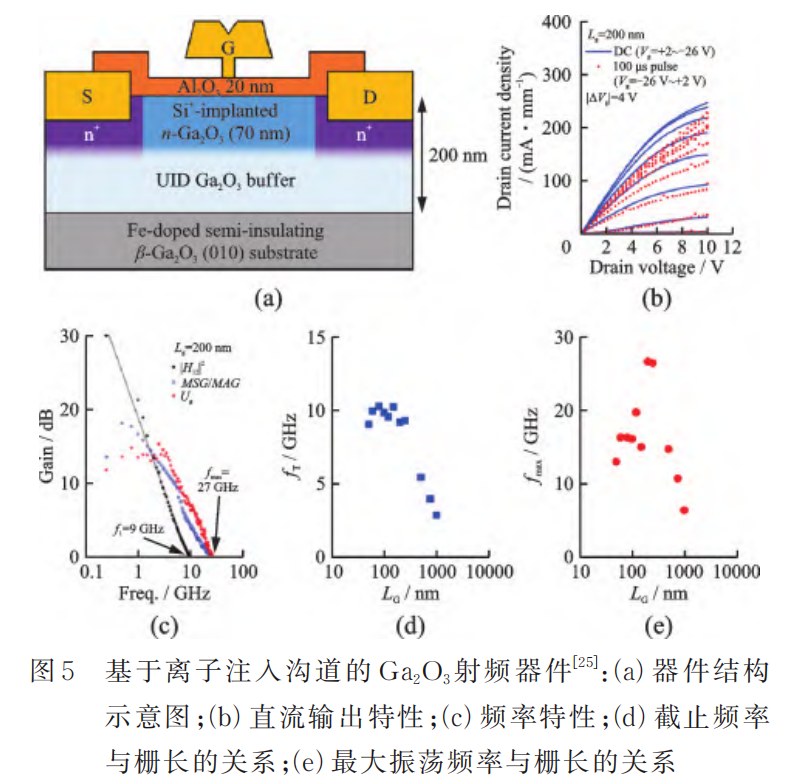
2023 年,美國布法羅大學也報道了 60 nm 薄溝 道 的 Ga2O3 射 頻 器 件 ,溝 道 摻 雜 濃 度 為 9.2× 1017cm-3,器 件 采 用 了 20 nm 厚 的 SiO2 柵 介 質 和 175 nm 柵長的 SiN 介質輔助 T 型柵,器件結構和性 能如圖 6 所示。該器件電流密度 285 mA/mm,閾 值電壓僅為-4 V,未出現明顯的短溝道效應,跨導 52 mS/mm,擊穿電壓高達 192 V,對應的擊穿場強 達到 5.4 MV/cm,fT和 fmax分別為 11 GHz 和 48 GHz, 表 現 出 優 異 的 直 流 和 頻 率 特 性。由 于 采 用 介 電 常 數相對較高的 SiN 介質對 T 型柵進行了保護,增大 了器件的柵源和柵漏寄生電容,導致器件的 fT較低。 由 于 其 單 指 柵 寬 僅 為 20 μm,大 幅 度 降 低 了 器 件 的 柵阻,從而獲得了較高的 fmax。

近年來,國內也逐步開展了氧化鎵射頻器件的研究。2020 年,河北半導體研究所也報道了基于 體 摻 雜 溝 道 的 Ga2O3 射 頻 器 件 ,其 材 料 結 構 包 含 (010)晶向半絕緣 Ga2O3襯底、500 nm UID Ga2O3緩 沖層以及 200 nm 厚的溝道層。由于外延較厚,為 了提升器件的柵控能力和降低器件的關態漏電,開 發 了 柵 下 氧 氣 退 火 技 術,有 效 抑 制 Ga2O3緩 沖 層 中 的背景載流子濃度,提升了器件的關斷特性和頻率 性 能 。 1 μm 柵 長 的 Ga2O3 器 件 的 飽 和 電 流 密 度 200 mA/mm,fT和 fmax分別達到 1.8 GHz 和 4.2 GHz。 在 1 GHz 頻率下進行了功率輸出性能測試,脈沖和 連 續 波 下 的 輸 出 功 率 密 度 分 別 為 0.43 W/mm 和 0.4 W/mm。
2022 年,針對體摻雜溝道器件柵長縮短后柵控 能 力 減 弱、短 溝 道 效 應 嚴 重 等 問 題,南 京 電 子 器 件 研 究 所 聯 合 南 京 大 學 將 三 維 柵 工 藝 用 于 射 頻 器 件 中,通過三維柵來提升柵電極對溝道載流子的調控 能 力,從 而 提 高 器 件 的 跨 導 和 頻 率 特 性,如 圖 7 所示。與平面型器件相比,三維柵射頻器件的 fT從 4.5 GHz 提 升 至 5.4 GHz,fmax 從 7.2 GHz 提 升 至 11.4 GHz,提 升 幅 度 分 別 達 到 了 20% 和 58%,表 明 三 維 柵 結 構 可 以 通 過 提 升 器 件 的 跨 導 和 抑 制 器 件 的短溝道效應來提升射頻器件的頻率特性。然而, 三維柵會引入較高的寄生電容,影響器件的頻率特 性,因此該三維柵器件的頻率特性依然低于薄溝道 器件。
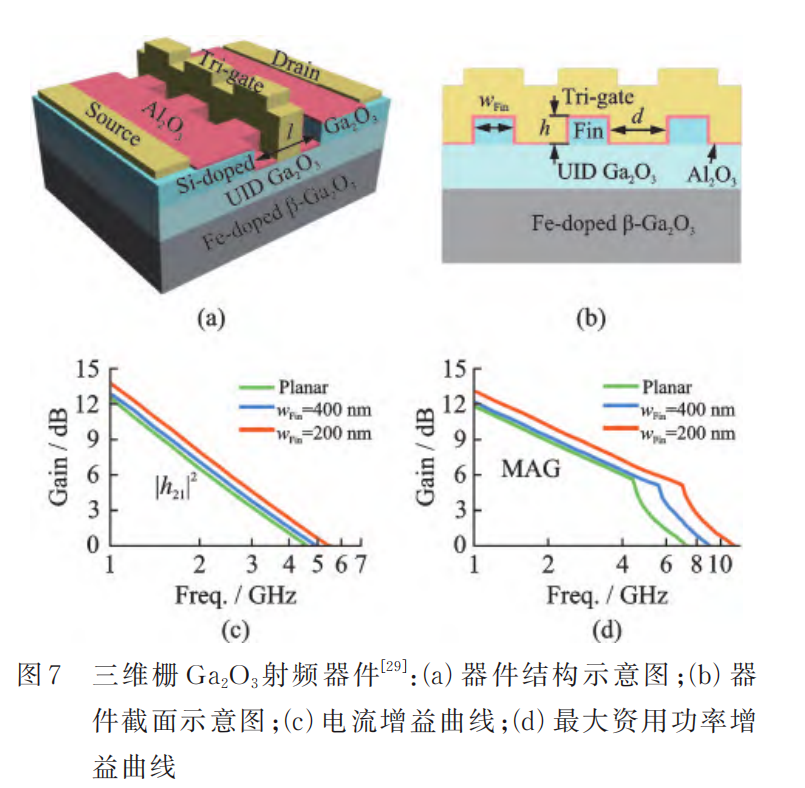
為了進一步降低溝道厚度,抑制器件的短溝道 效應,南京電子器件研究所又聯合南京大學等單位 開 展 了 Ga2O3上 超 淺 離 子 注 入 溝 道 技 術 的 研 究。 通過低能量的 Si 離子注入,在 Ga2O3上實現了超薄 的 導 電 溝 道,通 過 C?V 提 取 得 到 溝 道 電 子 分 布 與 2DEG 類似,電子面密度高達 3.2×1013cm-2,主要分 布在距 Ga2O3表面 10 nm 范圍內。基于該溝道研制 的 Ga2O3射頻器件結構和性能如圖 8 所示,得益于其 超薄的溝道,即使柵長縮短至 0.15 μm,器件也未出 現 明 顯 的 短 溝 道 效 應 。 該 器 件 電 流 密 度 165 mA/mm,fT 和 fmax 分 別 為 29 GHz 和 35 GHz,擊 穿 電 壓 高 達 193 V,考 慮 到 柵 漏 間 距 僅 為 0.93 μm, 柵漏擊穿場強達到了 2.07 MV/cm,展現出 Ga2O3射 頻器件高耐壓的優勢。

通過以上研究結果可以看出,如何隨著柵長的 縮 短 來 等 比 例 減 薄 Ga2O3 溝 道 厚 度 是 抑 制 體 摻 雜 Ga2O3射頻器件短溝道效應和提升器件頻率特性的 關 鍵 。 目 前 ,通 過 外 延 摻 雜 形 成 的 溝 道 普 遍 在 50 nm 以上,而通過低能離子注入技術可以在 Ga2O3 表面形成 10 nm 厚的溝道,為 Ga2O3射頻器件的溝道 設計提供了一個新的思路。此外,在功率性能研究 中 也 發 現,基 于 同 質 襯 底 的 Ga2O3射 頻 器 件 面 臨 著 嚴 重 的 自 熱 效 應 ,嚴 重 制 約 了 器 件 的 功 率 輸 出 性能。
3 基于二維電子氣溝道的Ga2O3射頻器件
GaAs、GaN 射頻器件的成功離不開其高遷移率 2DEG 溝 道,2DEG 不 僅 遷 移 率 高,而 且 厚 度 極 薄, 可以有效抑制器件的短溝道效應。為發展 Ga2O3射 頻 器 件,國 外 開 展 了 Ga2O3上 2DEG 溝 道 制 備 技 術 的研究。研究發現,通過在 AlGaO 勢壘層中進行 δ 調制摻雜(如圖 9 所示),可在 AlGaO/Ga2O3異質結 界面實現 2DEG 溝道。由于雜質離化后產生的電子 進 入 了 異 質 結 量 子 阱 中,降 低 了 離 化 雜 質 散 射,因 此可以獲得比傳統體摻雜更高的遷移率。2018 年, 美 國 俄 亥 俄 州 立 大 學 首 次 報 道 了 AlGaO/Ga2O3 調 制 摻 雜 結 構 材 料,室 溫 下 2DEG 面 密 度 2.25× 1012cm-2,遷 移 率 180 cm2/(V·s),在 50 K 低 溫 下 遷 移率大幅度提升至 2 790 cm2/(V·s),表明聲子散射 是制約 Ga2O3室溫遷移率的主要因素。由于電子濃 度 較 低,器 件 表 現 出 增 強 型 特 性,飽 和 電 流 密 度 也 僅為 46 mA/mm,0.7 μm 柵長器件的 fT和 fmax分別為 3.1 GHz 和 13.1 GHz。
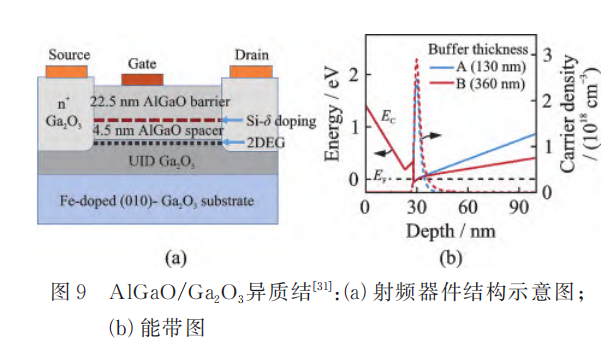
2021 年 ,美 國 布 法 羅 大 學 也 報 道 了 AlGaO/ Ga2O3調制摻雜結構的射頻器件,如圖 10 所示,該 器件同樣表現出了增強型,160 nm 柵長的射頻器件 雖 然 飽 和 電 流 密 度 僅 為 74 mA/mm,但 跨 導 高 達 64 mS/mm,fT和 fmax分別高達 30 GHz 和 37 GHz,表 明柵極對 2DEG 的調控能力要遠高于體摻雜溝道, 有效抑制了短柵長器件的短溝道效應,器件的頻率 性能得到了大幅度提升。該結果充分展現出 Ga2O3 調制摻雜結構材料在研制射頻器件方面的優勢,未 來 有 望 用于 更 高 頻 率 的 射 頻 器 件 中。另 外 需 要 指出的是,調制摻雜結構材料可以直接在 AlGaO 勢壘 層上制備肖特基柵電極,可以避免在生長柵介質時 引 入 新 的 界 面 態,這 對 射 頻 器 件 也 至 關 重 要,因 此 肖特基柵也是該器件結構的一大優勢。然而,目前 調 制 摻 雜 結 構 材 料 面 臨 的 最 大 問 題 是 電 子 濃 度 和 遷移率均低于預期,嚴重限制了器件的直流和射頻性能。
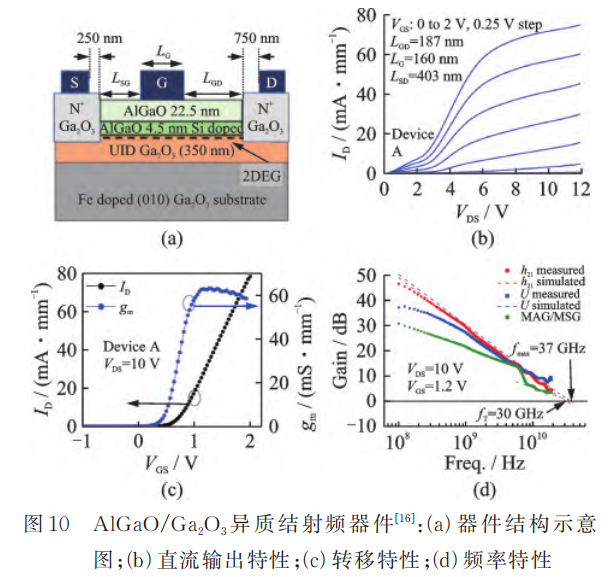
2019 年,美國俄亥俄州立大學采用分子束外延 (Molecular beam epitaxy,MBE)技術在 Fe 摻雜半絕 緣 Ga2O3 襯 底 上 生 長 了 δ 摻 雜 的 外 延 層,并 研 制 了 120 nm 柵長的射頻器件,如圖 11 所示。通過 C?V 提取了溝道電子濃度,其分布類似于異質結 2DEG, 面密度高達 9.9×1012cm-2,遠高于 AlGaO/Ga2O3異 質 結,飽 和 電 流 密 度 也 因 此 提 升 至 260 mA/mm,fT 和 fmax 分 別 達 到 27 GHz 和 16 GHz。其 中 fT 與 異 質 結射頻器件接近,但 fmax卻出現了大幅度下降,這可 能與其制備的 T 型柵截面積小、柵阻大有關。
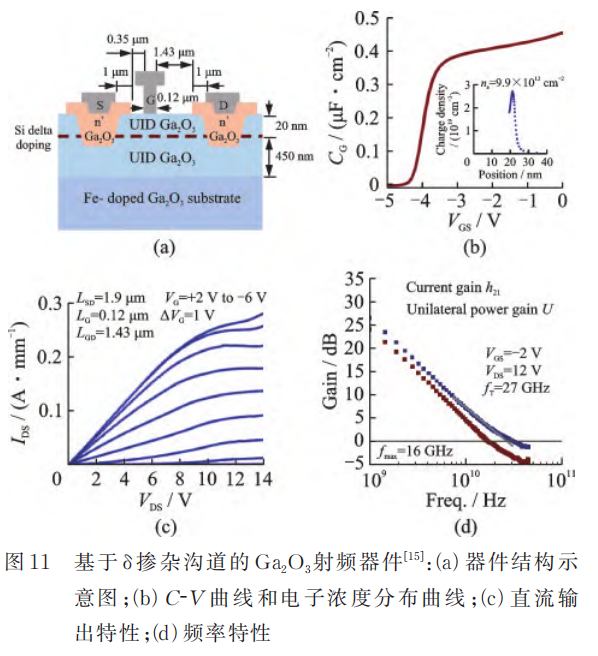
通過采用 AlGaO/Ga2O3異質結調制摻雜或者 δ 摻雜技術均可實現 2DEG 溝道,與體摻雜溝道相比 具有更高的電子遷移率和更薄的溝道厚度,是研制 Ga2O3射頻器件的理想方法。異質結調制摻雜材料 的電子面密度目前還比較低,導致器件的飽和電流 密度較小;而 δ 摻雜的溝道由于電子面密度更高,器件的飽和電流密度得到了顯著提升。然而,由于受 到聲子散射的制約,Ga2O3中形成的 2DEG 在室溫下 的遷移率依然低于 200 cm2/(V·s),較傳統體摻雜溝 道未展現出明顯優勢,制約了器件的頻率特性。
4Ga2O3射頻器件的異質集成技術
射 頻 器 件 特 征 尺 寸 小、功 率 密 度 高,熱 效 應 要 遠 超 電 力 電 子 器 件。而Ga2O3的 熱 導 率 極 低,僅 為SiC的2%~6%,Ga2O3射頻器件將面臨嚴重的自熱 效應。采用高導熱的襯底與Ga2O3異質集成是解決Ga2O3射 頻 器 件 散 熱 問 題 的 有 效 方 法,同 時 利 用 異 質 結 的 能 帶 結 構 可 以 將 電 子 束 縛 在Ga2O3薄 膜 中, 從而抑制器件的短溝道效應。2019年,上海微系統 與 信 息 技 術 研 究 所 首 次 通 過 離 子 刀 技 術 實 現50.8 mm(2英 寸)(-201)晶 向Ga2O3薄 膜 與SiC襯 底的異質集成,如圖12所示,表面粗糙度RMS小 于0.5 nm,X射線衍射(X?ray diffraction,XRD)搖擺 曲線半高寬為130 arcsec,表明異質集成后的Ga2O3薄膜的晶體質量較高,可以用于射頻器件研制。
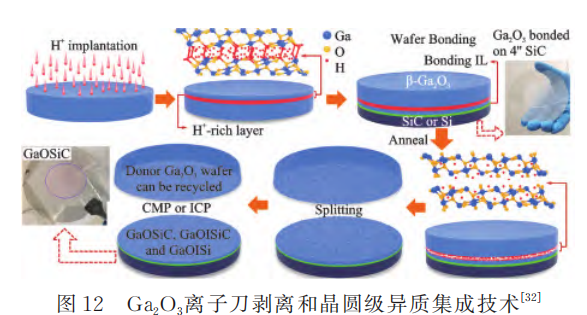
2023年,南 京 大 學 聯 合 南 京 電 子 器 件 研 究 所、 上海微系統與信息技術研究所等單位,首次報道了 高導熱SiC襯底與Ga2O3射頻器件的異質集成,并 通過低能離子注入技術實現了超薄導電溝道,有效 抑制了Ga2O3射頻器件的短溝道效應,結果如圖13所示。研制的0.1 μm柵長的Ga2O3射頻器件飽和電 流密度高達661 mA/mm,遠高于Ga2O3同質襯底器 件。得益于高導熱的SiC襯底和超薄導電溝道,器 件未出現明顯的自熱效應和短溝道效應,峰值跨導 高 達57 mS/mm。器 件 的fT和fmax分 別 高 達47 GHz和51 GHz,較Ga2O3襯底的射頻器件得到了顯著提 升。然 而,與 同 質 襯 底 器 件 相 比,該 器 件 的 擊 穿 電 壓從193 V大幅度下降至90 V,在2 GHz下的連續 波 輸 出 功 率 密 度 為296 mW/mm,未 展 現 出 明 顯 優 勢,這 可 能 與 異 質 集 成 界 面 或Ga2O3薄 膜 內 部 存 在 較多的缺陷態有關,是未來異質集成技術需要重點 解決的關鍵問題之一。 同年,西安電子科技大學也報道了SiC襯底上 的Ga2O3射頻器件,器件結構和性能如圖14所示。 通 過 氫 離 子 注 入 和 剝 離 技 術 將Sn摻 雜 濃 度 為3× 1018cm-3的Ga2O3薄膜轉移至SiC襯底上,并通過化 學 機 械 拋 光(Chemical mechanical polishing,CMP) 結 合BCl3干 法 刻 蝕 的 方 法 將Ga2O3薄 膜 的 厚 度 從500 nm左右減薄至100~110 nm。為了提升器件的 柵控能力和抑制短溝道效應,又進一步對柵下刻蝕 了45 nm。研 制 的180 nm柵 長 的 射 頻 器 件 飽 和 電 流 密 度 高 達1.1 A/mm,fT和fmax分 別 達 到27.6 GHz和57 GHz。對器件進行了功率性能測試,2 GHz下 連 續 波 輸 出 功 率 密 度 高 達2.3 W/mm,功 率 密 度 隨 著工作頻率的上升而下降,8 GHz下的輸出功率密 度 降低 至0.7 W/mm。該 結 果 表 明 采 用 高 導 熱 的SiC襯 底 與Ga2O3異 質 集 成 可 以 很 好 地 解 決Ga2O3射頻器件的散熱難題,器件的飽和電流密度和輸出 功率密度均得到了極大提升。
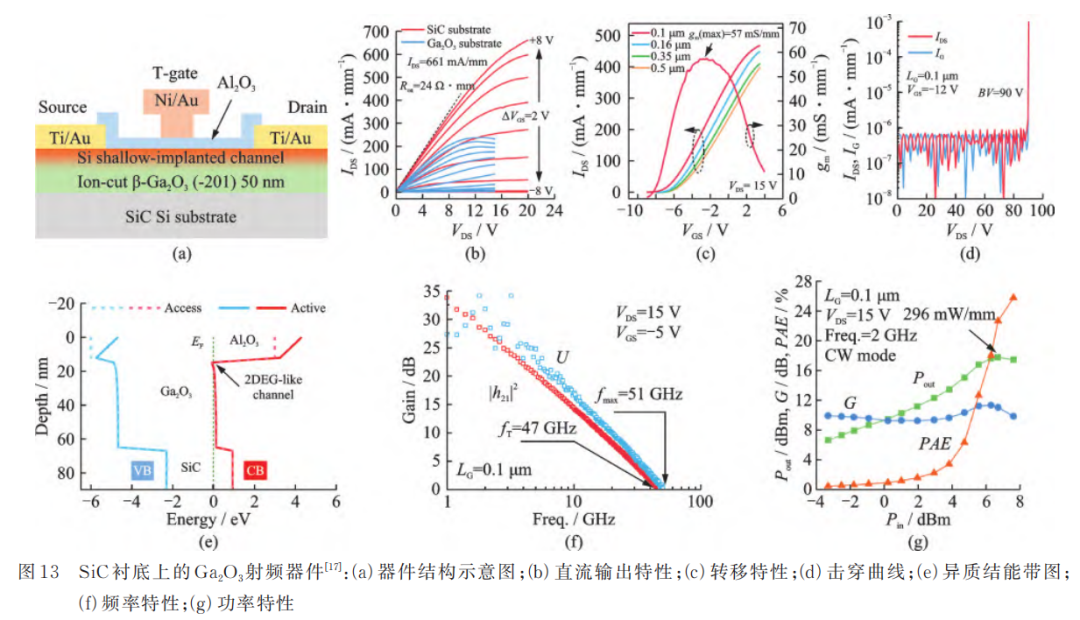
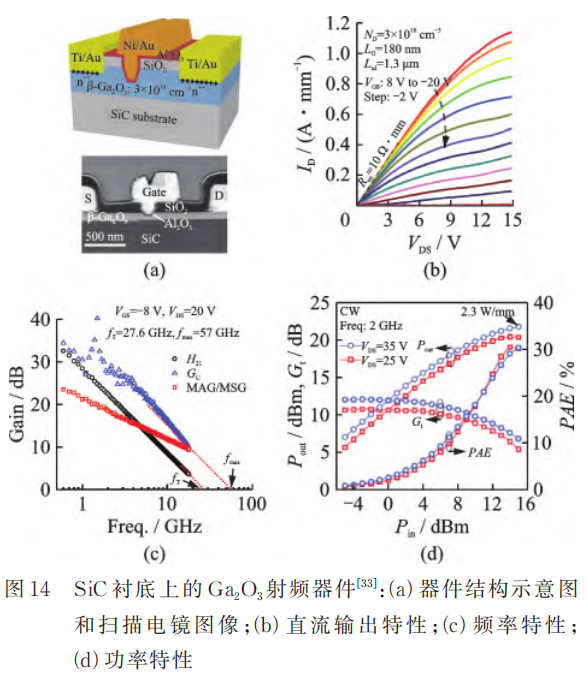
金 剛 石 不 僅 與Ga2O3同 為 超 寬 禁 帶 半 導 體,而 且 其 熱 導 率 高 達2 200 W/(m·K),是SiC的4倍 以 上,如果與Ga2O3器件集成,有助于進一步提升其耐 壓和散熱能力。2024年,上海微系統與信息技術研 究所聯合南京電子器件研究所在第70屆國際電子 器 件 會 議(IEDM)上 首 次 展 示 了Ga2O3薄 膜 與 高 導 熱金剛石襯底的晶圓級異質集成技術,極大地提升 了Ga2O3射頻器件的性能,研究結果如圖15所示。0.1 μm柵 長 的 器 件 的 電 流 密 度 達 到810 mA/mm, 在 未 剝 離 寄 生 參 數 的 情 況 下,fT和fmax分 別 達 到 了34 GHz和61 GHz。由 于 金 剛 石 襯 底 的 高 熱 導 率, 與Ga2O3同質襯底器件相比,熱阻從62.4 K·mm/W下降至5.52 K·mm/W,結溫下降了約250℃,有效解 決了Ga2O3器件散熱能力差這一瓶頸問題,為Ga2O3器 件 的 熱 管 理 提 供 了 晶 圓 級 解 決 方 案 ,對 推 動Ga2O3射頻器件的發展具有重要的意義。
以上研究表明,與SiC、金剛石等高導熱襯底異 質集成,可以有效提升Ga2O3射頻器件的散熱能力, 從而提高器件的飽和電流密度和功率性能。然而, 基于離子刀的異質集成技術在Ga2O3薄膜和鍵合界 面 處 引 入 了 陷 阱,不 僅 降 低 了Ga2O3射 頻 器 件 的 擊 穿 電 壓,還 加 劇 了 器 件 的 電 流 崩 塌,制 約 器 件 功 率 性 能 提 升。未 來,通 過 優 化 異 質 集 成 工 藝,或 者 在 高 導 熱 襯 底 上 異 質 外 延Ga2O3溝 道 有 望 解 決 以 上 問題。
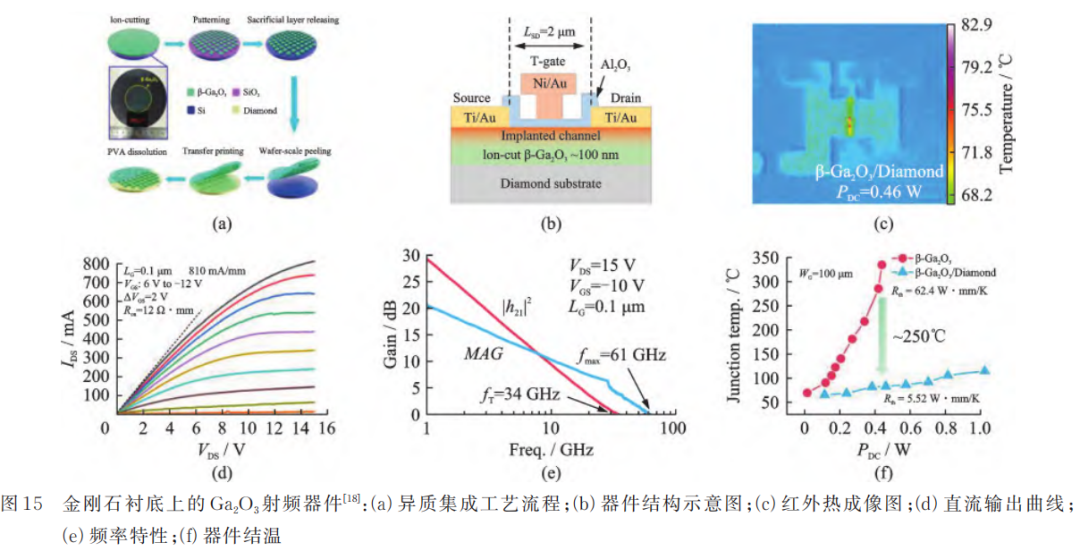
5 結束語
Ga2O3不僅禁帶寬度大、擊穿場強高,而且具有較高的飽和速度和約翰遜優值,在射頻器件領域具有 潛 在 的 應 用 價 值。得 益 于Ga2O3超 寬 禁 帶 的 優勢,Ga2O3射頻器件的平均擊穿場強達5.4 MV/cm,超越GaN、SiC的理論極限,展現出Ga2O3在高耐壓射頻器件方面的巨大優勢。然而,由于受到短溝道效應、遷移率低和熱導率低等因素的制約,Ga2O3射頻器件的發展面臨著諸多挑戰。近年來,國內外研究 機 構 已 對Ga2O3射 頻 器 件 開 展 了 廣 泛 研 究,通 過異質結、超淺離子注入等溝道技術有效抑制了器件的短溝道效應,通過與SiC、金剛石等高導熱襯底異質 集 成,初 步 解 決 了Ga2O3射 頻 器 件 面 臨 的 散 熱 難題,器件的電流密度達到了1 A/mm以上,接近GaN射 頻 器 件 的 水 平。然 而,由 于 聲 子 散 射 的 制 約,即使采用AlGaO/Ga2O3異質結調制摻雜結構,室溫遷移率仍然低于200 cm2/(V·s),導致器件的頻率特性遠低于GaN射頻器件,制約了Ga2O3射頻器件在高頻 領 域 的 發 展。因 此,鑒 于Ga2O3低 遷 移 率 和 低 熱導 率 的 物 理 特 性,未 來Ga2O3主 要 聚 焦 于 低 頻 率 下的射頻器件,并且需要通過異質集成或異質外延等技 術 來 提 高 器 件 的 散 熱 能 力。隨 著 材 料 和 器 件 工藝 的 發 展,Ga2O3有 望 在 更 高 功 率 的 射 頻 器 件 上 取得突破。
來源:固體電子學研究與進展
作者:郁鑫鑫 1,2;沈 睿 1,2,3;譙 兵 1,2;李忠輝 1,2,3;葉建東 4;孔月嬋 2,3;陳堂勝 2,3
(1中國電科碳基電子重點實驗室,南京,210016) (2南京電子器件研究所,南京,210016)
(3固態微波器件與電路全國重點實驗室,南京,210016) (4南京大學 電子科學與工程學院,南京,210023)
-
半導體
+關注
關注
335文章
28650瀏覽量
233118 -
GaN
+關注
關注
19文章
2181瀏覽量
76232 -
射頻器件
+關注
關注
7文章
130瀏覽量
25808 -
氧化鎵
+關注
關注
5文章
83瀏覽量
10573
原文標題:氧化鎵射頻器件研究進展
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 氧化鎵射頻器件研究進展
氧化鎵射頻器件研究進展
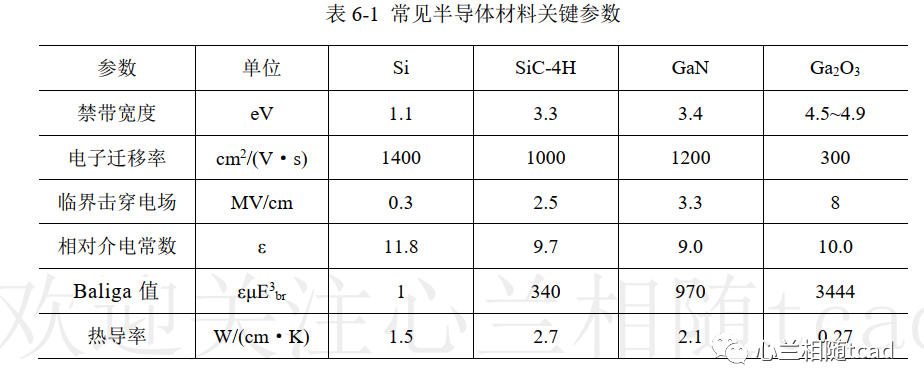











評論