在Hybrid Bonding前,2D,2.5D及3D封裝都是采用焊錫球凸點(solder bump)或微凸點(Micro bump)來實現芯片與基板,芯片與中介層(interposer), 芯片與芯片間的電連接。Solder bump/micro bump在制備工藝中都有植球的步驟,所植的球就是焊錫球(Solder bump),所以在Hybrid Bonding之前芯片間的連接都是靠焊錫球進行連接。
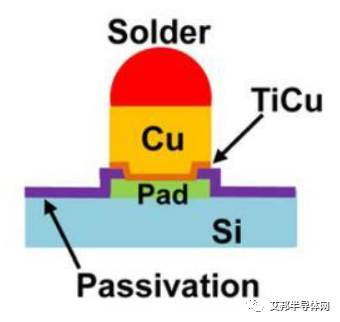
圖1,Cu+Solder 統稱為bump, 細分又可以分為Cu bump 和Solder Bump. 當然Solder bump是植在銅柱 (Copper bump)上的。如圖2所示,當copper bump pitch 小于10~20um時,焊錫球 solder bump就變成了工藝難點及缺陷的主要來源。這時候就需要一種新的工藝來解決bump 間距小于10微米芯粒間鍵合的問題。當然Hybrid Bonding在電學性能方面也有獨特的優勢,如圖3所示,Hybrid Bonding信號丟失率幾乎可以忽略不計,這在高吞吐量,高性能計算領域優勢明顯。在業界強烈需求的呼喚下,Hybrid Bonding騰空出世。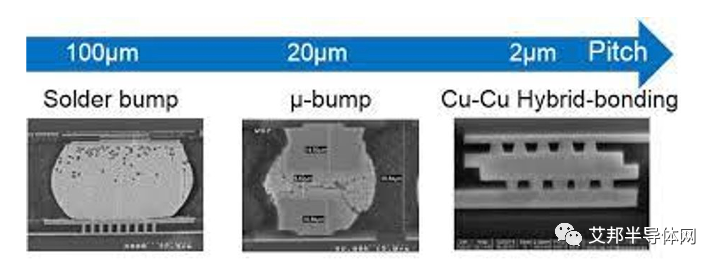
圖2,不同bump間距(pitch)所采用BUMP形式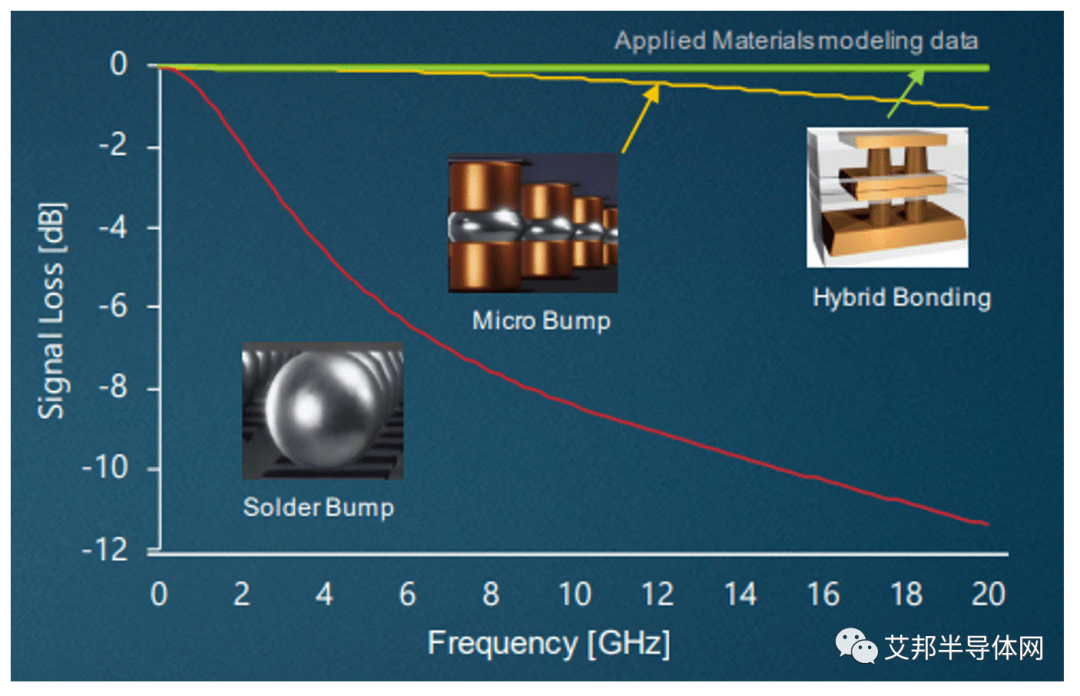
圖3,頻率與信號丟失對應曲線圖
Hybrid Bonding中的Hybrid是指除了在室溫下凹陷下去的銅bump完成鍵合,兩個Chip面對面的其它非導電部分也要貼合。因此,Hybrid Bonding在芯粒與芯粒或者wafer與wafer之間是沒有空隙的,不需要用環氧樹脂進行填充。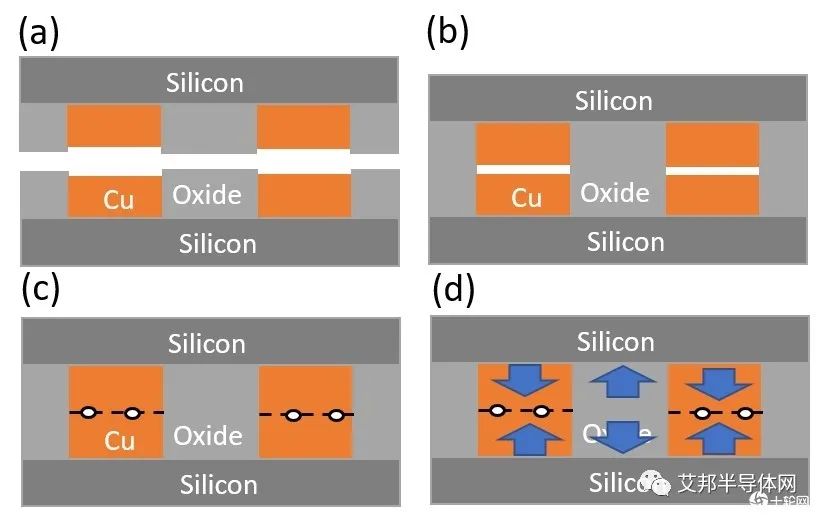
圖4,圖源十輪網
混合鍵合流程圖:(a)試片未接合面貌(b)介電材料接合步驟(c)提高溫度銅接點接合過程(d)高溫時接點內部應力分布狀態 Hybrid Bonding是近幾年被叫響的,在之前業界通常稱其為DBI(Direct Bond Interconnect,直接鍵合連接),它是在20世紀80年代中期由Paul Enquist,Q.Y. Tong和Gill Fountain在三角研究所(RTI)的實驗室首次構思,DBI因其優雅和簡潔而成為鍵合大海上的明燈。他們三個后來在2000年成立了一家叫Ziptronix的公司,并于2005年實現了10um bump間距用DBI技術連接的鋁布線層,接著又在2011年發布2um bump間距用DBI技術完成wafer to wafer 連接。2015年Ziptronix被Xperi (前Tessera)收購。在2019年,DBI/Hybrid Bonding技術由Xperi (前Tessera)完成了最終的專利布局,其本身沒有量產的產品推出。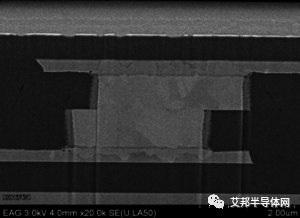
圖5,2005年Ziptronix發布10um間距 用DBI技術連接的鋁布線層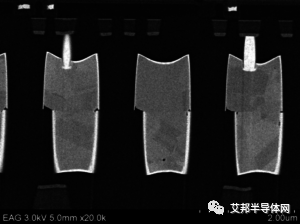
圖6,2011年Ziptronix發布2um間距用DBI技術完成的wafer to wafer連接
業界第一個DBIDBI/Hybrid Bonding量產的產品是由Sony在圖像傳感器上進行應用。這項技術在堆疊的CMOS圖像傳感器的下部電路芯片和上部像素芯片中增加了Cu連接焊盤,以同時建立物理和電氣連接。由于Cu-Cu直接鍵合是在wafer生產過程中進行的,索尼開發了原始的制造工藝來克服這些問題,并成為世界上第一個推出該技術的公司。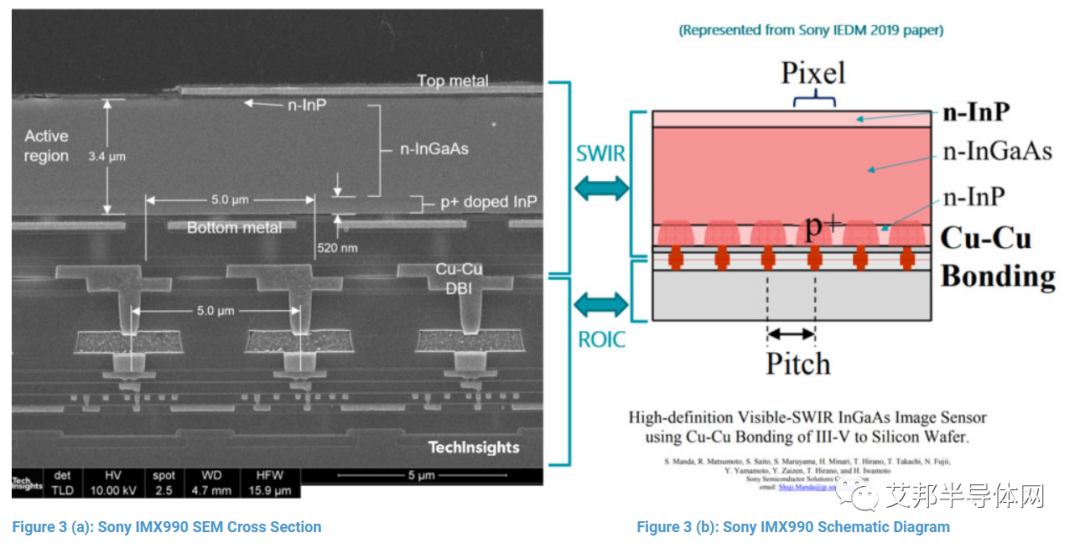
圖7,Sony首款采用HybridBonding/DBI銅銅鍵合的傳感器
接著臺積電,英特爾、三星等大廠都開始采用該工藝用于進行3D封裝,并陸續推出用于CPU、GPU及高性能計算中。到今天,Hybrid Bonding已經被叫的越來越響。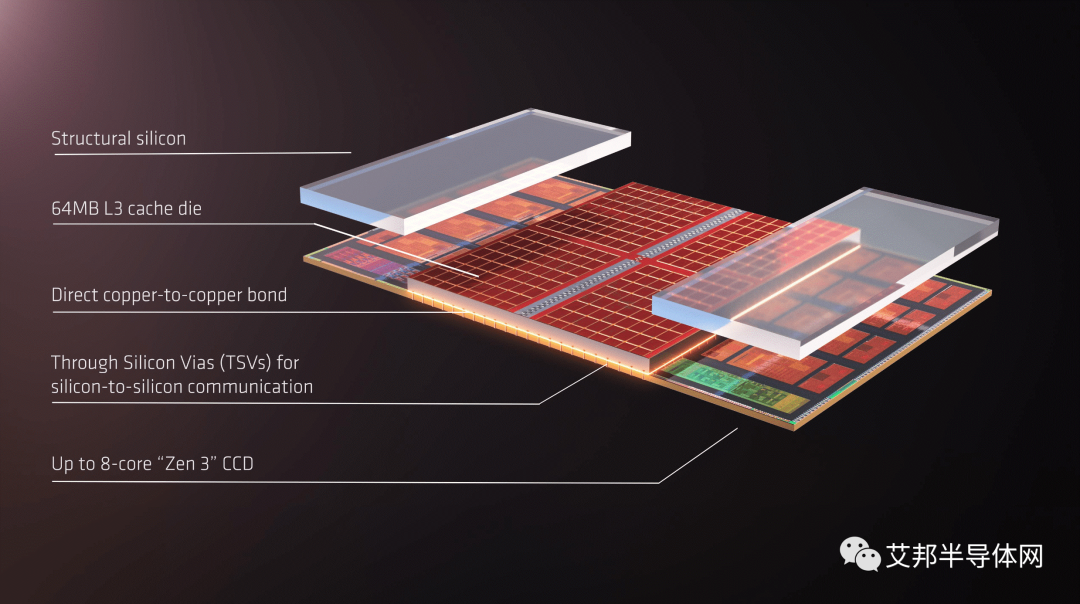
圖8,AMD Hybrid Bonding產品
最后我們再談談相應的設備廠家,Hybrid Bonding代表著未來,代表著研發實力,設備巨頭們都在積極跟進。當前主要有兩個實力強勁的聯盟:Besi與Applied Material的BA聯盟以及香港的ASMPT與EV GROUP (EVG)的AE聯盟,巨頭們強強聯合來爭奪先進封裝設備中的塔尖。另外,根據新聞報道近期異軍突起的華封也在積極研發布局。如果您是我們的老朋友應該看到過我們艾邦半導體公眾號對TCB(熱壓鍵合)設備的介紹,相信大家對TCB設備的復雜性已經有一定的了解。
TCB設備升級改造后可以具備Hybrid Bonding的功能,但是后者的難點除了貼裝精度要求更高外,對晶粒及晶圓本身共面性、表面粗糙度、潔凈度等要求都極為苛刻。這也就是為什么一套Hybrid Bonding設備的研發需要巨頭們強強聯合的原因。
審核編輯:劉清
-
CMOS
+關注
關注
58文章
5993瀏覽量
238087 -
gpu
+關注
關注
28文章
4912瀏覽量
130661 -
圖像傳感器
+關注
關注
68文章
1965瀏覽量
130421 -
3D封裝
+關注
關注
7文章
139瀏覽量
27661 -
RTI
+關注
關注
0文章
10瀏覽量
3362
原文標題:先進封裝之混合鍵合(Hybrid Bonding)的前世今生
文章出處:【微信號:半導體設備與材料,微信公眾號:半導體設備與材料】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
先進封裝爆發,但TC Bonding讓Hybrid Bonding推遲進入市場
銅線鍵合IMC生長分析

Cu-Cu Hybrid Bonding技術在先進3D集成中的應用

三維堆疊封裝新突破:混合鍵合技術揭秘!

電子封裝 | Die Bonding 芯片鍵合的主要方法和工藝

混合鍵合技術:開啟3D芯片封裝新篇章

金絲鍵合工藝溫度研究:揭秘鍵合質量的奧秘!






 什么是Hybrid Bonding?Hybrid Bonding是銅銅鍵合嗎?
什么是Hybrid Bonding?Hybrid Bonding是銅銅鍵合嗎?
















評論