裝片又稱黏片。廣義的裝片是指通過精密機械設(shè)備將芯片或其他載體,利用粘貼介質(zhì)將其固定在為達成某種功能而構(gòu)建的平臺、腔體或任意材料組成的器件內(nèi)。狹義的裝片是指IC封裝前的工序,即通過專門的裝片設(shè)備,利用裝片膠、膠膜等材料,將切割后的圓片芯片與不同封裝形式的框架或基板進行黏結(jié)。
裝片的目的:在芯片與載體之間實現(xiàn)有效的物理性連接;滿足電性能的要求,在芯片與框梁之間達到傳導性成絕緣性的連孩:作為傳導介質(zhì)特芯片上產(chǎn)生的熱能傳導到器件外部,達到一定的散熱效果。??
裝片的要求:必領(lǐng)具備永久結(jié)合性,在器件應(yīng)用過程中不應(yīng)出現(xiàn)在外部環(huán)境作用下導致電子產(chǎn)品失效的情況,這對于在應(yīng)用于很強的物理作用力環(huán)境中的產(chǎn)品龍為重要;工藝本身選用的材料應(yīng)該不含污染物,在余下的流水作業(yè)的加熱環(huán)節(jié)中不會釋放氣體;工藝本身還應(yīng)該具有較高的應(yīng)用效率和較低的制造成本。
裝片工藝大致分為如下4類。
(1) 銀漿裝片:又稱環(huán)氧樹脂貼裝,是指在液體樹脂黏合劑中摻人銀粉,用于在芯片和框架之間黏合,從而形成永久性物理連接,并實現(xiàn)導熱和導電功能的一種經(jīng)濟實用的裝配方法。
(2)共晶裝片:用高溫熔化金屬,使其原子活躍達到熔融狀態(tài),利用每個金屬組織至少有一個合成物的熔點比其內(nèi)部其他合成物的熔點低的原理來完成焊接裝片的過程。共晶裝片采用的材料一般有金一錫、金一硅、金一鍺等,
(3)焊料裝片:主要使用鉛錫絲作為芯片與框架的連接介質(zhì),通過軌道高溫和壓膜的作用,將鉛錫絲熔化成既定形狀的液態(tài),經(jīng)過軌道通人氮氫混合氣體對框架進行氧化-還原反應(yīng)后的裝片形式。
(4)熱超聲覆晶倒裝焊接:其工藝原理是在一定的壓力和溫度下,對芯片的凸點施加超聲波能量,在一定的時間內(nèi),凸點與框架、基板或焊盤產(chǎn)生結(jié)合力,從而實現(xiàn)芯片與框架的連接。
裝片設(shè)備的關(guān)鍵材料和治具及其功用見下表格。

裝片的主要步驟如下所述。
(1) 吸片:頂針從藍膜下方將芯片上頂,使真空吸嘴與芯片接觸,通過負壓將芯片向上提拉,從而做反向力,使芯片背面掙脫開藍膜的黏附力,達到剝離藍膜的目的,如下圖所示。
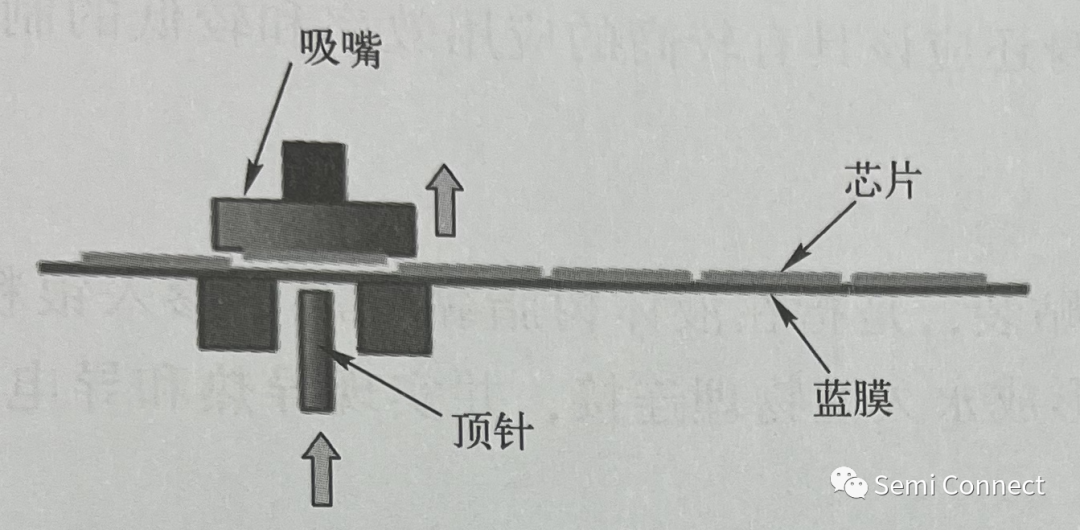
(2)涂膠:將液態(tài)環(huán)氧樹脂 (導電銀漿或絕緣膠)涂覆到引線框架的載片臺(Lcad-Frame Pad)上,如下圖所示。
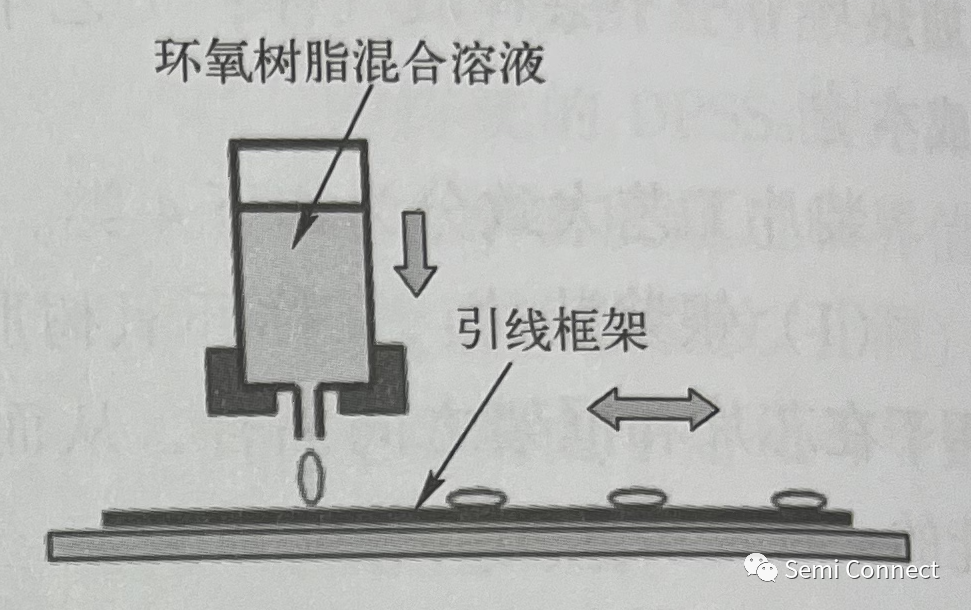
(3)鍵合:將芯片安裝到涂好環(huán)氧樹脂的引線框架上,如下圖所示。
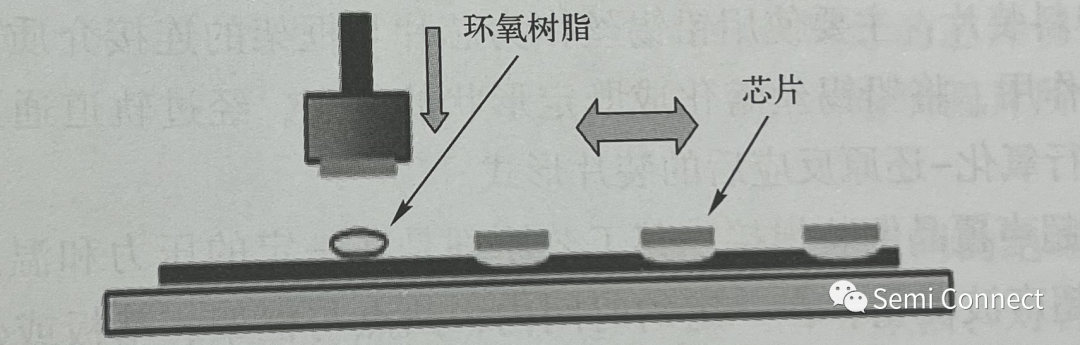
裝片工藝需要根據(jù)材料的變化及封裝產(chǎn)品的特點不斷提高工藝要求。隨著電子器件的不斷小型化,超小超薄芯片的開發(fā)將給裝片帶來前所未有的挑戰(zhàn),并將孕育出更多、更復雜的工藝流程和更高密集度工藝的開發(fā)。
審核編輯:劉清
-
電子器件
+關(guān)注
關(guān)注
2文章
602瀏覽量
32621 -
IC封裝
+關(guān)注
關(guān)注
4文章
187瀏覽量
27129
原文標題:裝片工藝,黏品粒製程,Die Attach Process
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
SMT工藝---表面貼裝及工藝流程
SMT貼裝基本工藝流程
電動汽車電機制造工藝流程圖解
貼片機生產(chǎn)工藝流程的影響
晶圓級CSP的裝配工藝流程
鋰離子電池極片制造的工藝流程介紹與輥壓工藝基本的過程

SMT貼片加工的工藝流程及作用
芯片封裝工藝流程是什么
扇出式封裝的工藝流程
裝片工藝的主要步驟
半導體封裝中的裝片工藝介紹






 裝片工藝的流程
裝片工藝的流程











評論