半導(dǎo)體加工正處于關(guān)鍵轉(zhuǎn)折點。
隨著芯片行業(yè)向前端的納米片晶體管和后端的異質(zhì)集成過渡,半導(dǎo)體晶圓廠正在采取“全員參與”的方法來解決嚴(yán)峻的計量和良率管理挑戰(zhàn),結(jié)合工具、工藝和其他技術(shù)。
光學(xué)和電子束工具正在擴(kuò)展,同時根據(jù)具體情況添加 X 射線檢測。對于納米片晶體管制造和深溝計量等新工藝,拉曼光譜、SIMS 和質(zhì)量計量等替代方法正在發(fā)揮作用。
拐點
半導(dǎo)體加工正處于幾個關(guān)鍵的拐點之中——向EUV的過渡和最終的高 NA EUV 圖案化、使用 3D 結(jié)構(gòu)進(jìn)行高密度存儲、納米片晶體管和異質(zhì)集成。
“所有這些變化都在計量層面帶來了一些相當(dāng)大的挑戰(zhàn)。首先,尺寸要小得多,因此我們需要靈敏度和精度更高的計量學(xué),”Lam Research 計算產(chǎn)品公司副總裁 David Fried 說。“其次,越來越多的具有隱藏結(jié)構(gòu)的高縱橫比設(shè)計為偏移和風(fēng)險創(chuàng)造了更多機(jī)會。”
根據(jù) Fried 的說法,對混合計量學(xué)的需求越來越大,將不同的技術(shù)結(jié)合在一起,以了解在過程和設(shè)備級別發(fā)生的事情。建模和虛擬制造也將在缺陷和尺寸計量中發(fā)揮關(guān)鍵作用。
其他人同意。“關(guān)鍵是尺寸計量,我們真正關(guān)注的是復(fù)雜的 3D 結(jié)構(gòu),”Nova的首席技術(shù)官 Shay Wolfling 說。“它始于 3D NAND。現(xiàn)在,在納米片 FET 中,客戶真正感興趣的是控制每個單獨的納米片,例如,三個納米片。如果你看一下路線圖,它會涉及到更多的納米片,最終是 CFET,所以它只會變得更具挑戰(zhàn)性。”
Gate-all-around 晶體管
GAA 晶體管,也稱為納米片 FET,被領(lǐng)先的芯片制造商用于 3nm(三星)和 2nm(臺積電和英特爾)節(jié)點,接觸柵極間距擴(kuò)展到 40nm,金屬間距降至 30nm 以下。將這些先進(jìn)的 3D 結(jié)構(gòu)從研發(fā)引入制造需要快速、非破壞性的測量方法,具有快速的學(xué)習(xí)周期并且盡可能少地依賴離線技術(shù)。
IBM 最近對納米片晶體管制造的各個步驟和可能的實施計量工具進(jìn)行的分析指出,隨著環(huán)柵晶體管的推出而發(fā)生變化。“納米片技術(shù)可能是一些離線技術(shù)從實驗室過渡到工廠的時候,因為某些關(guān)鍵測量需要實時監(jiān)控。”
光學(xué)依然強(qiáng)勁
IBM 工程師強(qiáng)調(diào)了測量方法的使用,包括 OCD(散射測量法)、CD-SEM、AFM、Raman、XRD 和 XRF(X 射線衍射和熒光)以及 VC-SEM(電壓對比 SEM)。OCD 和 CD-SEM 都廣泛應(yīng)用于整個半導(dǎo)體制造領(lǐng)域,這一趨勢有望繼續(xù)下去。也許可以結(jié)合使用散射測量法和自上而下的 CD-SEM 來測量翅片寬度,但該研究強(qiáng)調(diào),需要做更多的工作來表征納米片和翅片結(jié)構(gòu)。計量學(xué)中的不同隨機(jī)效應(yīng),包括線粗糙度、局部 CD 變化、邊緣位置和重疊誤差以及缺失或橋接特征,會顯著影響產(chǎn)量和設(shè)備性能。
基于光學(xué)的方法提供了最快的在線檢測和計量方法。光學(xué) CD 測量(OCD,又名散射測量)不是薄膜厚度的直接測量,需要建模和參考方法才能與實際值相關(guān)聯(lián)。OCD 測量通常發(fā)生在位于晶圓劃線處的光柵目標(biāo)上。KLA、Applied Materials、Onto Innovation 和 Nova 提供領(lǐng)先的 OCD 解決方案。
Onto Innovation 的光學(xué)解決方案將光譜反射儀和橢圓偏振儀與基于人工智能的引擎 AI-Diffract 相結(jié)合,以分析納米片晶體管中的不同層。這種方法旨在提供優(yōu)于傳統(tǒng) OCD 系統(tǒng)的層對比度。此外,機(jī)器學(xué)習(xí)在強(qiáng)迫癥維度分析中發(fā)揮著越來越重要的作用,建立在長期使用的強(qiáng)迫癥物理模型之上。
Nova 有自己的 OCD 風(fēng)格,即垂直移動散射測量法,它結(jié)合了散射測量法的反射率數(shù)據(jù)和光的相位。當(dāng)在多個波長上執(zhí)行此操作時,會產(chǎn)生垂直移動散射測量法。正如 Wolfling 解釋的那樣,VTS 算法允許過濾光譜信息,忽略底層對厚度的影響。例如,可以測量 metal1 CMP 中細(xì)微的金屬線高度差異,而無需測量下面的晶體管層。
質(zhì)量計量
質(zhì)量計量是一種非破壞性方法,可以在傳統(tǒng)計量不足的應(yīng)用中對高縱橫比溝槽進(jìn)行量化。“在一些先進(jìn)的存儲器、DRAM 和 NAND 中,有趣的是你在晶圓上蝕刻了數(shù)萬億個,”Fried 說。“你在這些蝕刻中去除的質(zhì)量非常重要,這就是質(zhì)量計量學(xué)如此有效的原因。”
這是正在評估的納米片工藝技術(shù)之一(見圖 1)。第二個例子著眼于測量溝槽尺寸的質(zhì)量計量。
據(jù)Infineon的工程師稱,OCD 有效地測量溝槽深度,CD-SEM 測量頂部 CD,但事實證明直接測量底部 CD 很困難。[3] 他們使用 Lam Research 的 OCD、CD-SEM 和 Metryx 質(zhì)量計量來確定蝕刻前后 42μm 深溝槽(6.75μm 間距)中的溝槽底部寬度。該研究發(fā)現(xiàn)質(zhì)量損失和散射測量的底部 CD 之間存在線性關(guān)系。質(zhì)量損失和 CD-SEM 橫截面測量之間也有很好的相關(guān)性。“質(zhì)量損失法能夠監(jiān)測蝕刻過程的穩(wěn)定性,并提供有關(guān)深溝槽幾何形狀的定量信息,”工程師總結(jié)道。
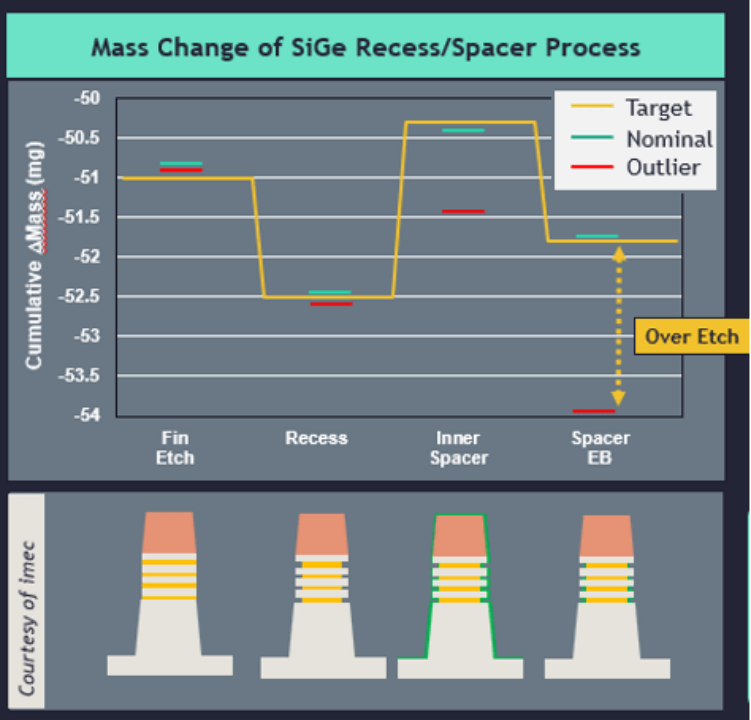
圖 1:質(zhì)量計量檢測到納米片間隔物凹蝕中的異常值。來源:Lam Research X射線檢查
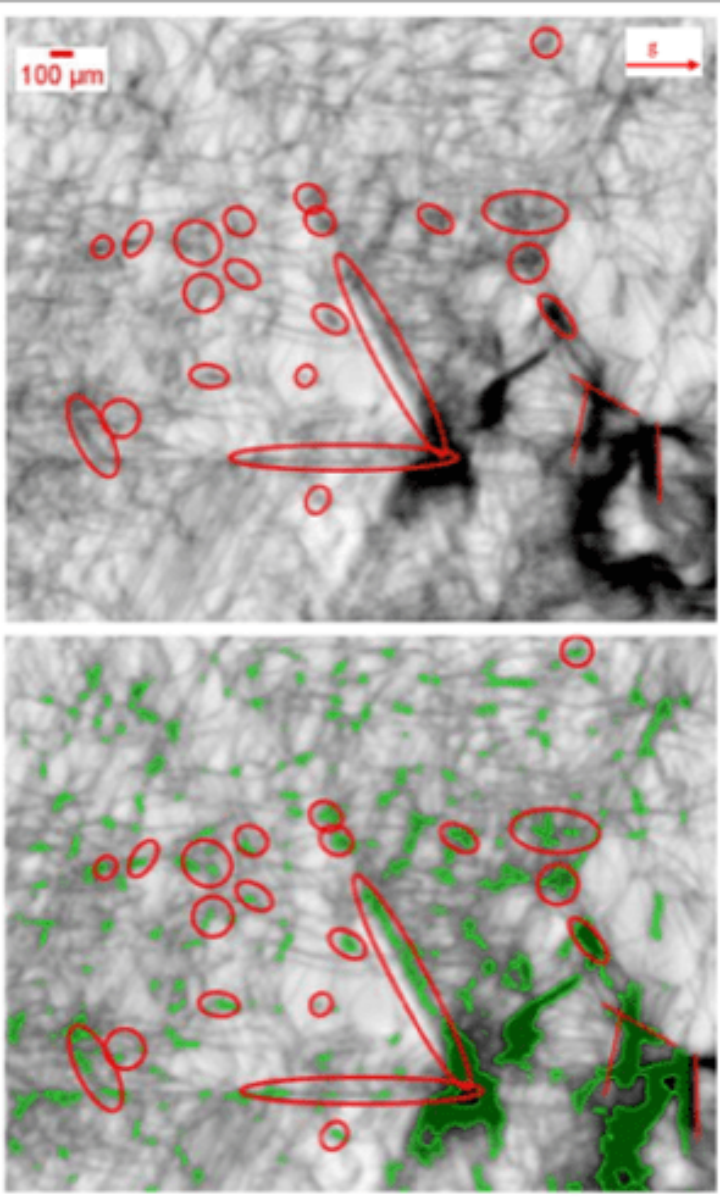
圖 2:X 射線檢查(上)和分析(下)識別由于晶格中的堆垛層錯、螺紋位錯和微管而導(dǎo)致的“死”區(qū)域。來源:布魯克
X 射線檢測提供缺陷分析的一個領(lǐng)域是功率 IC,特別是 GaN-on-SiC 晶圓(見圖 2)。必須檢查 SiC 晶圓是否存在各種類型的缺陷,包括晶格中的微管和螺紋位錯,通常沿著晶圓的基面(基底缺陷)。此類缺陷的尺寸范圍從埃級到數(shù)百納米,并可能導(dǎo)致器件故障或 SiC 晶圓本身報廢。
拉曼光譜在鍺成分測量方面是一個亮點,它可以提供在線 SiGe 應(yīng)變分析,這是晶體管性能的一個重要因素。然而,使用拉曼更難以獲得與深度相關(guān)的濃度讀數(shù),這可能是 SIMS(二次離子質(zhì)譜)發(fā)揮作用的領(lǐng)域。
SIMS 提供化學(xué)成分信息,使用濺射離子束并測量從晶圓射出的二次離子。輸出被視為晶片上不同點處鍺濃度的深度均勻性(見圖 3)均勻性(見圖 4)。

圖 3:SiGe 層中的鍺深度分布。來源:新星

圖 4:基于 9 點晶圓測量的鍺濃度在線 SIMS。來源:新星
BEOL 計量
“所有檢查和計量的一個重要部分是我們需要在某種程度上為應(yīng)用程序定制系統(tǒng),”CyberOptics 總裁兼首席執(zhí)行官 Subodh Kulkarni指出. 以高產(chǎn)量制造數(shù)百萬個微凸塊的需求催生了 100% 的檢測方法。“我們需要知道客戶在尋找什么。在一個簡單的例子中,如果它是一個凸點測量,客戶想要檢查 1000 萬個凸點并確保我們給他們所有的異常值——最高的凸點、最短的凸點和平均值、3 西格瑪?shù)取.?dāng)一個有缺陷的凸點是發(fā)現(xiàn)后,他們想知道所有細(xì)節(jié)、物理損壞的類型等,這樣他們就可以進(jìn)行快速故障分析。” CyberOptics 最近推出了更高分辨率的 5 μm MRS 傳感器(xy 分辨率)作為其 7μm 傳感器的升級。
在這些情況下,銅柱凸塊變得非常普遍,基本上是帶有圓形銀錫焊頭的高柱。X 射線衍射和 XRF 提供了另一種質(zhì)量檢查。“我們用 XRF 測量的最重要的東西是合金的厚度和成分。通過測量焊料成分,我們會查看 RDL 和 UBM 薄膜厚度之類的東西——例如凸塊中的銀含量——并尋找 3D 封裝中的空隙或橋接缺陷。一致性是關(guān)鍵——確保 RDL 具有正確的合金成分,”布魯克X 射線部門副總裁兼總經(jīng)理 Paul Ryan 說。
結(jié)論
OCD 和 CD-SEM 方法正在擴(kuò)展以滿足納米片晶體管的需求,但深層結(jié)構(gòu)和隱藏特征的挑戰(zhàn)繼續(xù)挑戰(zhàn)計量方法。隨著芯片制造商在 5 納米和 3 納米節(jié)點上大批量生產(chǎn),X 射線、拉曼、SIMS 和質(zhì)量計量等替代方案正在開拓各自的利基市場。
審核編輯 :李倩
-
傳感器
+關(guān)注
關(guān)注
2564文章
52607瀏覽量
763853 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28613瀏覽量
232802 -
光學(xué)
+關(guān)注
關(guān)注
4文章
785瀏覽量
36996
原文標(biāo)題:光學(xué)和電子束方法得到擴(kuò)展,應(yīng)對嚴(yán)峻的計量和良率挑戰(zhàn)
文章出處:【微信號:ICViews,微信公眾號:半導(dǎo)體產(chǎn)業(yè)縱橫】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
電子束半導(dǎo)體圓筒聚焦電極
電子直寫光刻機(jī)駐極體圓筒聚焦電極
一文詳解電子束光刻技術(shù)
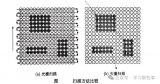
APEX經(jīng)濟(jì)型減速器——助力TETA電子束焊機(jī)高性價比焊接

VirtualLab Fusion應(yīng)用:非近軸衍射分束器的設(shè)計與優(yōu)化
三星重啟1b nm DRAM設(shè)計,應(yīng)對良率與性能挑戰(zhàn)
透射電子顯微鏡(TEM)快速入門:原理與操作指南

泊蘇 Type C 系列防震基座在半導(dǎo)體光刻加工電子束光刻設(shè)備的應(yīng)用案例-江蘇泊蘇系統(tǒng)集成有限公司

聚焦離子束一電子束(FIB-SEM)雙束系統(tǒng)原理

電子束光刻技術(shù)實現(xiàn)對納米結(jié)構(gòu)特征的精細(xì)控制
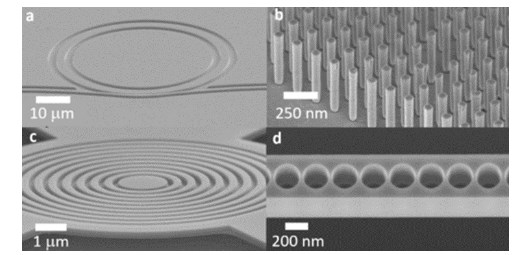
東方晶源深耕電子束量測檢測核心技術(shù) “三箭齊發(fā)”新一代EOS上“機(jī)”

三大產(chǎn)品線全力升級 東方晶源引領(lǐng)國內(nèi)電子束量測檢測發(fā)展






 光學(xué)和電子束方法得到擴(kuò)展,應(yīng)對嚴(yán)峻的計量和良率挑戰(zhàn)
光學(xué)和電子束方法得到擴(kuò)展,應(yīng)對嚴(yán)峻的計量和良率挑戰(zhàn)
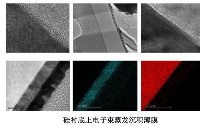











評論