為解決SOC片上系統(tǒng)的設計瓶頸,SiP(system in Package)微系統(tǒng)技術已成為最普遍的應用手段。SiP能在同一個封裝基板上布局多個裸die,實現(xiàn)了系統(tǒng)間快速互聯(lián)互通。 SiP的實現(xiàn)有兩種形式,一種是傳統(tǒng)BGA形式,它利用封裝基板互連,可以通過ubump或wirebond進行die和基板連通;另一種是2.5D、3DIC先進封裝形式,利用interposer(硅中介層)及TSV(硅通孔)實現(xiàn)水平RDL布局及垂直方向通孔連接。 本文介紹的是利用芯和半導體Hermes 3D軟件,實現(xiàn)“倒裝焊-金線(FC-BW)BGA封裝的電磁場仿真”的應用。通過Hermes 3D快速的版圖導入、bump添加、版圖切割、端口添加等功能,便利地完成仿真工程的建立以及模型抽取。
Hermes 3D的FC-BW BGA仿真建模流程
1.軟件概述
Hermes 3D是一款針對各類封裝和PCB的電磁場仿真平臺。它支持主流版圖文件導入,例如mcm、sip、brd、dxf、dwg、gds、ODB++、PADs等文件格式;支持版圖在軟件內(nèi)自動或手動隨意截取操作;采用3D FEM求解引擎,能對各類3D結(jié)構(gòu)準確仿真建模;支持多種端口激勵添加,例如lumped port、wave port、coax port、annular port等;支持HFSS工程腳本導出,方便用戶橫向?qū)Ρ确抡婢取?/p>
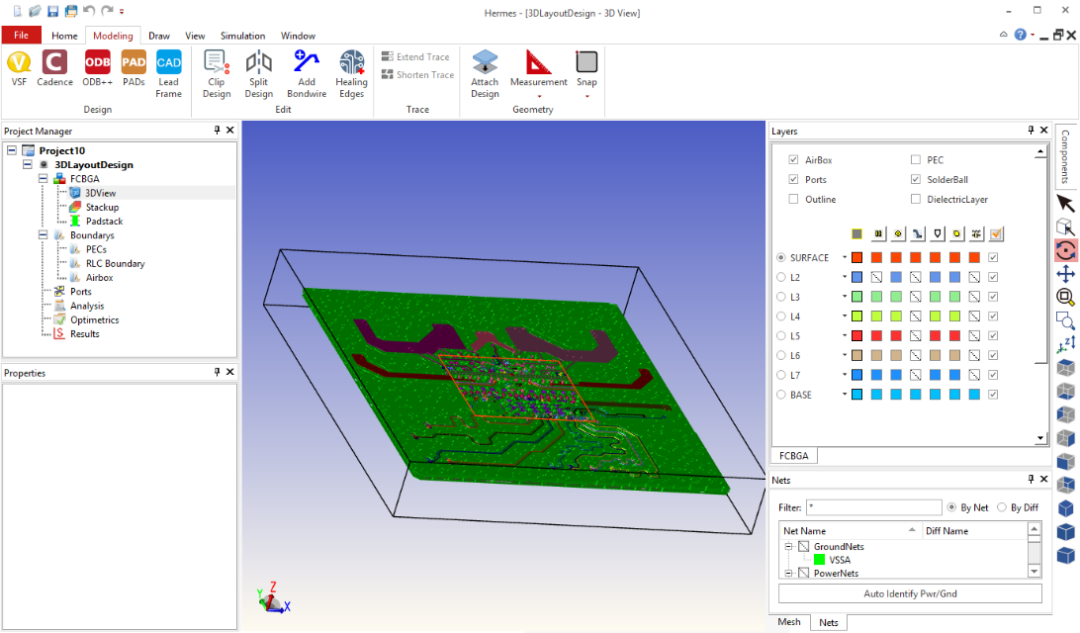
2.導入FC-BW BGA版圖文件
Hermes 3D能夠快速導入.sip版圖格式。其中,版圖中的nets可以全部導入,也可以根據(jù)需求選擇性導入。 當導入版圖文件時,所有相關金屬層、過孔、介質(zhì)的材料信息也會一并導入,生成疊層文件,用于仿真求解。

本例中,有8個die通過金線和封裝基板連接,其中兩個die是flipchip形式,通過ubump和封裝基板連接,因此結(jié)構(gòu)屬于FC-WB混合類型。

3. 仿真前設置
(1)添加FC結(jié)構(gòu)的ubumpHermes 3D提供ubump自動添加功能,選中die結(jié)構(gòu),創(chuàng)建ubump模板,軟件會在封裝的finout位置添加對應的ubump結(jié)構(gòu)。
首先找到FC連接的die名稱:

點擊Edit進入ubump創(chuàng)建窗口:

自定義ubump模板:

軟件自動在finout位置布滿ubump結(jié)構(gòu):

(2)按網(wǎng)絡nets進行版圖切割Hermes 3D支持信號網(wǎng)絡選擇,然后根據(jù)nets區(qū)域可自動進行版圖切割,操作如下。 連續(xù)選擇需要仿真的nets和參考地:

點擊Clip Design,開始切割版圖:
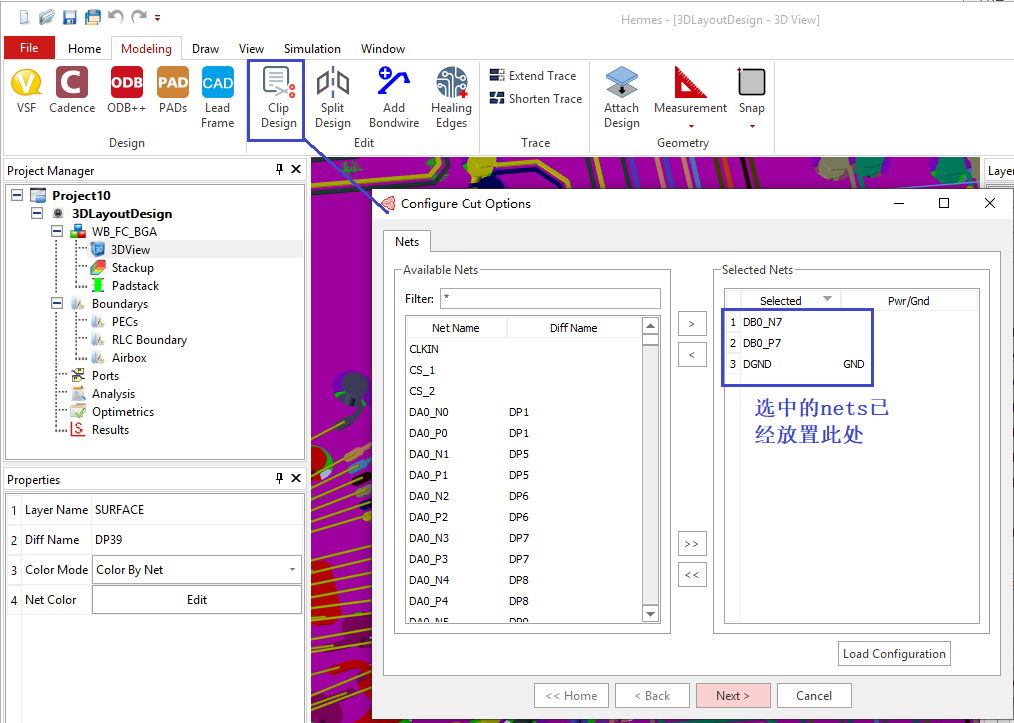
選擇切割方式,開始切割:

最終根據(jù)選擇nets,自動完成版圖切割:
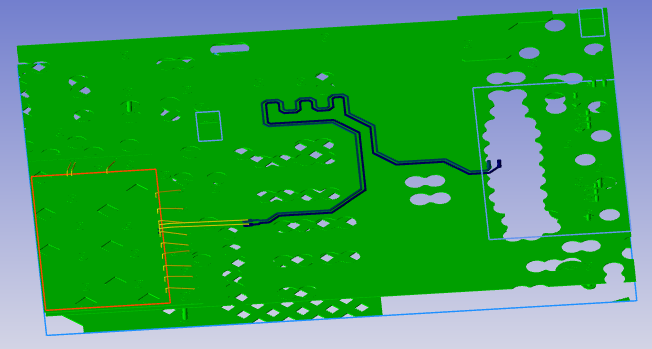
(3)激勵端口添加
版圖切割完成后,用戶必須添加端口激勵才能仿真。本文以差分nets添加激勵端口為例,進行演示。
首先點擊Generate Ports:
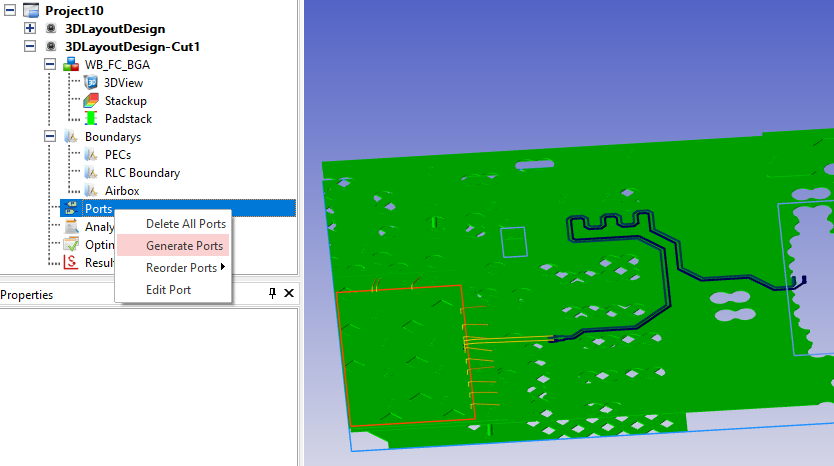
勾選nets相關的component,點擊Generate生成激勵ports:

此時在ubump和wirebond端點處自動添加了環(huán)形激勵端口,如下圖所示:

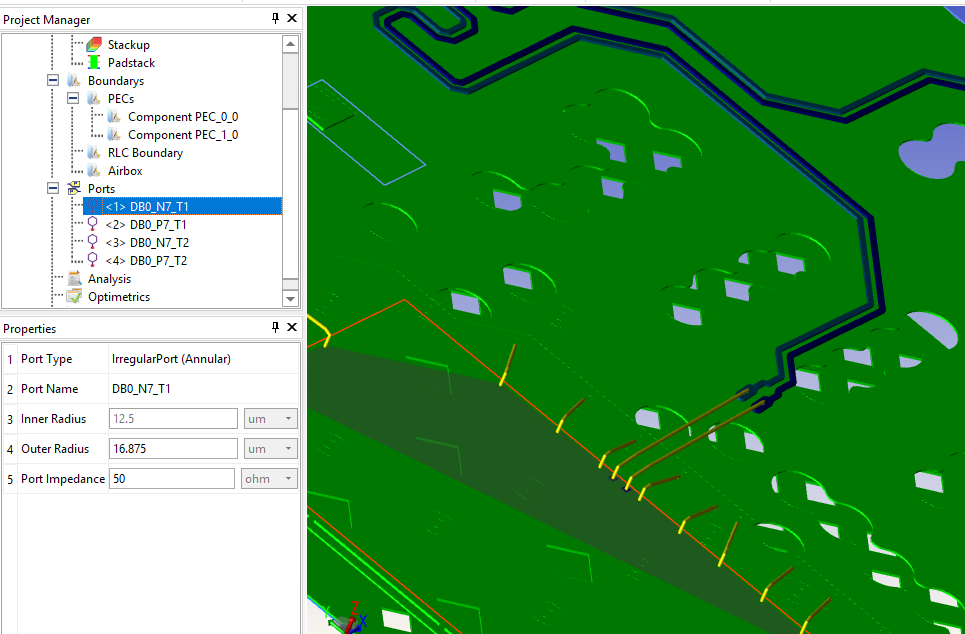
(4)提交電磁場仿真
首先添加仿真分析類型:
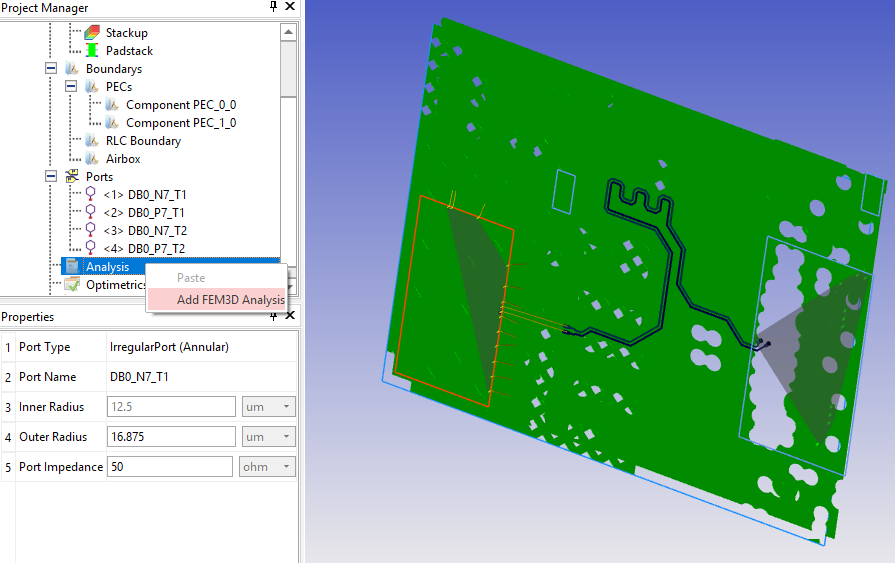
接著設置掃頻范圍:

最后提交仿真任務:

4.仿真結(jié)果分析
Hermes 3D完成BGA封裝仿真后,用戶可利用芯和半導體的s參數(shù)后處理工具SnpExpert進行結(jié)果查看和指標分析。 首先導入s參數(shù),并完成差分端口配對:

接著查看差分回波損耗:
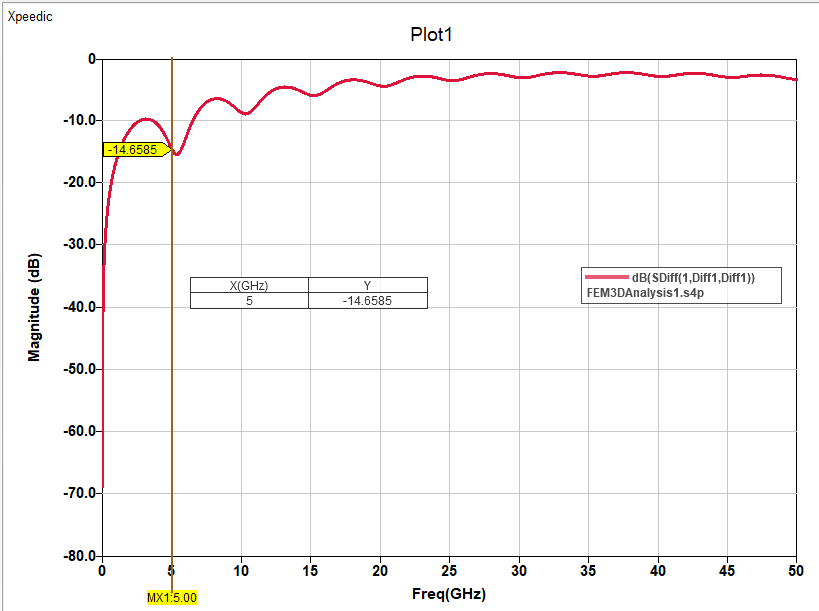
查看差分插入損耗:
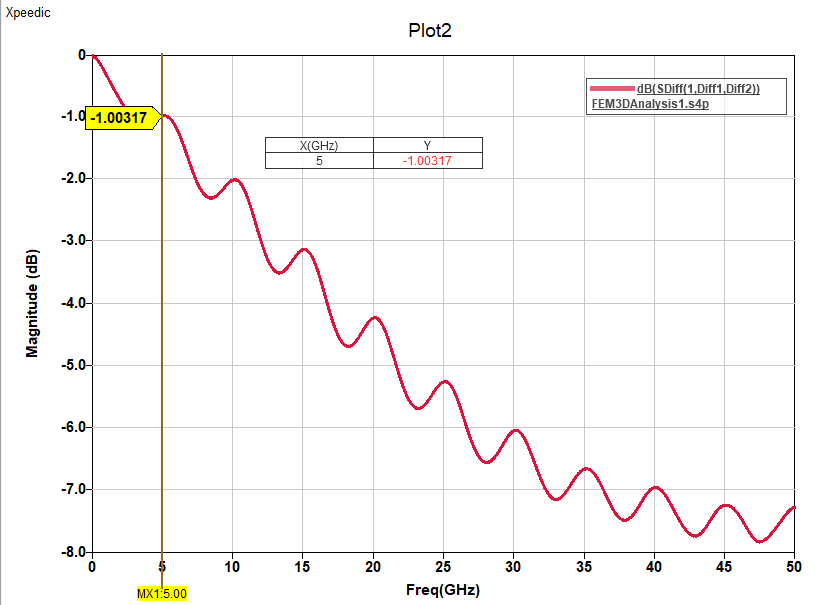
SnpExpert也支持Grid模式顯示所有指標曲線結(jié)果:
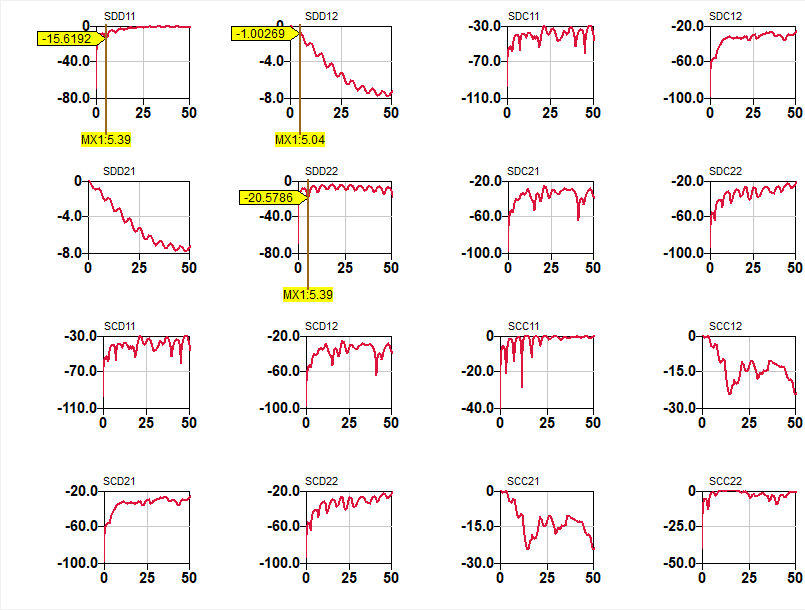
總結(jié)本文通過實際案例介紹了Hermes 3D進行倒裝焊-金線(FC-BW)BGA封裝的電磁場仿真流程,并利用SnpExpert軟件進行S參數(shù)分析。 Hermes 3D提供了向?qū)降慕A鞒蹋⒑喕睡B層建立與設置。這種方案不需要用戶太過關注復雜的軟件設置,不需要特別了解電磁場仿真原理,使得用戶能夠快速上手,并正確生成仿真模型。
原文標題:【應用案例】如何快速實現(xiàn)倒裝焊-金線混合的BGA封裝建模仿真?
文章出處:【微信公眾號:Xpeedic】歡迎添加關注!文章轉(zhuǎn)載請注明出處。
審核編輯:劉清
-
片上系統(tǒng)
+關注
關注
0文章
187瀏覽量
27199 -
SoC芯片
+關注
關注
1文章
636瀏覽量
35657 -
BGA封裝
+關注
關注
4文章
121瀏覽量
18418 -
電磁仿真
+關注
關注
2文章
76瀏覽量
20063
原文標題:【應用案例】如何快速實現(xiàn)倒裝焊-金線混合的BGA封裝建模仿真?
文章出處:【微信號:Xpeedic,微信公眾號:Xpeedic】歡迎添加關注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
BGA封裝焊球推力測試解析:評估焊點可靠性的原理與實操指南

倒裝芯片封裝:半導體行業(yè)邁向智能化的關鍵一步!

倒裝芯片的優(yōu)勢_倒裝芯片的封裝形式

BGA技術賦能倒裝芯片,開啟高密度I/O連接新時代

BGA芯片的封裝類型 BGA芯片與其他封裝形式的比較
芯片倒裝與線鍵合相比有哪些優(yōu)勢

如何進行BGA封裝的焊接工藝
不同BGA封裝類型的特性介紹
BGA封裝的測試與驗證方法
【Moldex3D丨產(chǎn)品技巧】使用金線精靈與樣板快速建立金線組件

引腳封裝HotRod和FC-SOT上倒裝芯片的降額和壽命計算






 Hermes3D進行倒裝焊-金線(FC-BW)BGA封裝的電磁場仿真流程簡析
Hermes3D進行倒裝焊-金線(FC-BW)BGA封裝的電磁場仿真流程簡析












評論