我們測量了硅化物膜(CoSi2、NiSi2、TiSi2和WSi)的濺射刻蝕速率,并研究了離子能量的依賴性,發現它們與二氧化硅薄膜的相對濺射刻蝕速率幾乎與濺射離子能量無關,從相對濺射蝕刻速率和計算的Ni和Si的截面比率來估計Ni的表面結合能,并發現由相對濺射刻蝕速率決定的表面結合能與眾所周知的值一致。
薄膜(Cosi2,Nisi2,Tisi2,WSi)通過濺射方法在n型Si (100)基板上沉積約200 納米,這些是由表面分析研究組提供的,它是多晶的,所以說一個的深度是用一個臺階總和來衡量的。
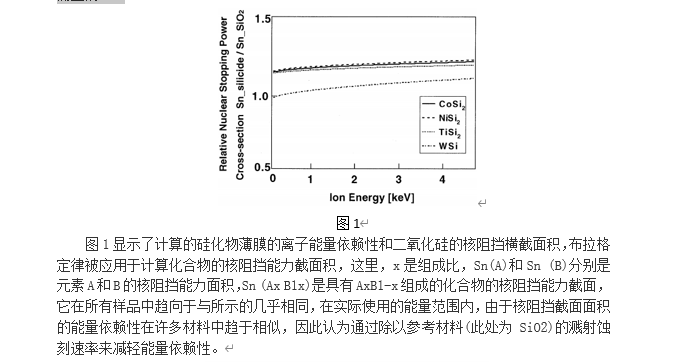
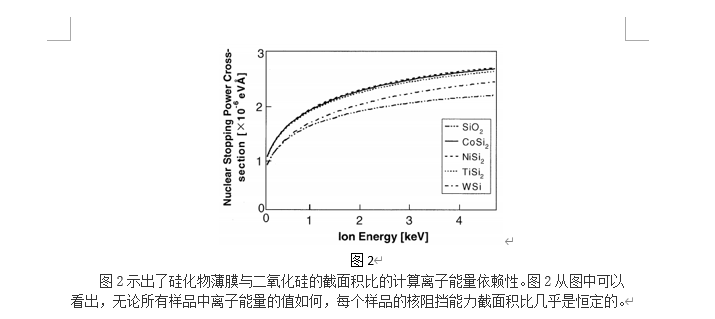

由本實驗求出的鎳對硅的相對濺射蝕刻速率的離子能量依賴性,用最小二乘法擬合核可阻止截面積比和濺射蝕刻速率,得到硅的離子能量依賴性,根據這些結果,可以認為通過實測不知道表面鍵能的物質、表面鍵能和原子密度已知的物質和相對濺射蝕刻速率,計算核阻止能截面積的比,可以推測某物質的表面鍵能。
測量濺射坑的深度,并且測量硅化物薄膜的濺射蝕刻速率,并且檢查這些樣品的相對蝕刻速率對SiO2的能量依賴性,可以發現,硅化物薄膜相對于SiO2的相對蝕刻速率具有很小的能量依賴性,如從核阻擋能力橫截面積的計算中所預期的,并且能量依賴性放松是實際的優點,因為它可以估計尚未測量的能量下的值,此外,樣品的近似表面結合能可以從相對濺射蝕刻速率和核阻擋能力截面比來估計。
審核編輯:湯梓紅
-
測量
+關注
關注
10文章
5161瀏覽量
112918 -
硅薄膜
+關注
關注
0文章
6瀏覽量
6214 -
刻蝕
+關注
關注
2文章
202瀏覽量
13319
發布評論請先 登錄
自對準硅化物工藝詳解
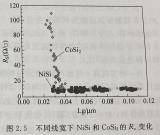
芯片刻蝕原理是什么
磁性靶材磁控濺射成膜影響因素
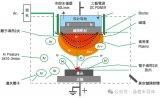
深入剖析半導體濕法刻蝕過程中殘留物形成的機理
半導體濕法刻蝕殘留物的原理
芯片濕法刻蝕方法有哪些
如何提高濕法刻蝕的選擇比
干法刻蝕工藝的不同參數
刻蝕工藝評價的工藝參數以及如何做好刻蝕工藝






 硅化物膜的濺射刻蝕速率研究
硅化物膜的濺射刻蝕速率研究














評論