不斷發(fā)展的電子設(shè)備總是需要挑戰(zhàn)極限,對節(jié)能和高頻半導(dǎo)體的需求越來越強烈。電源的穩(wěn)定對于半導(dǎo)體在高頻范圍內(nèi)的穩(wěn)定運行非常重要,旁路電容的處理是關(guān)鍵。半導(dǎo)體封裝 對于因板載技術(shù)的演進而變得越來越小、越來越薄,具有足夠電容的情況下如何確保芯片工作頻率下所需的電源阻抗以及電容器安裝的位置和面積是關(guān)鍵。因此對于電源穩(wěn)定性來說,是個很大的挑戰(zhàn)。
由于高頻區(qū)域的電源噪聲,無法完全發(fā)揮性能
隨著工作電壓的降低,想辦法減少工作時的壓降和噪聲
想搭載對應(yīng)必要的靜電容量的適當?shù)碾娙萜?/p>
需要大容量電容器,但沒有空間承載
加賀富儀艾電子代理的品牌FICT株式會社(原富士通互聯(lián)技術(shù))已成功生產(chǎn)嵌入薄膜電容器 (TFC) 的半導(dǎo)體封裝基板,該產(chǎn)品符合長期的行業(yè)要求。基板中的嵌入式 TFC 具有更大的電容,并且比以往更能減少連接電感,因為它現(xiàn)在可以放置在離 LSI 更近的位置作為去耦電容器。
今天為大家分享的是FICT采用的一種名為GigaModule-EC的基板結(jié)構(gòu)技術(shù),這是帶有TFC的新一代基板。這種結(jié)構(gòu)滿足兩個復(fù)雜的要求:半導(dǎo)體封裝的微型化以及電容器和LSI之間的穩(wěn)定電源。同時,GigaModule-EC 解決了現(xiàn)在制造封裝基板的 4 個挑戰(zhàn)。
一降低高頻范圍內(nèi)的電源噪聲
GigaModule-EC 半導(dǎo)體封裝基板包含嵌入式薄膜電容器,它支持 LSI 在高頻率和低電壓下工作。該TFC在高頻范圍內(nèi)具有低阻抗值,并且具有大電容和低電感。
由于 GigaModule-EC 基板中的 TFC 可以作為去耦電容器嵌入 LSI 下方,因此可以降低電容器和 LSI 之間的電感。如果增加這種 GigaModule-EC 半導(dǎo)體封裝基板中使用的過孔數(shù)量,則電感會進一步降低。
利用這一特性,在演示實驗中證實了該基板在低頻到高頻范圍內(nèi)的阻抗降低。這意味著可以降低半導(dǎo)體封裝基板在高頻范圍內(nèi)的噪聲,這在過去使用外部電容器很難實現(xiàn)。因此,您可以期待半導(dǎo)體的頻率特性得到極大改善,LSI 的效率最大化。

嵌入式 TFC 對 V/G之間阻抗的變化
 二將運行期間的電壓降降至最低
二將運行期間的電壓降降至最低
由于 LSI 采用低電壓驅(qū)動,因此控制運行期間的電壓降變得更具挑戰(zhàn)性。不過,這款 GigaModule-EC 基板可以解決這個問題。支持高頻范圍的 TFC 可以嵌入基板上的 LSI 下方,該電容器將通過連接電源層在操作之間進行充電和放電,這可以降低電源電壓的不穩(wěn)定性,并允許您期望 LSI 具有穩(wěn)定的高性能。
 三可通過圖案設(shè)計獲得任意大小的電容器電容
三可通過圖案設(shè)計獲得任意大小的電容器電容
這種嵌入式 TFC 是 1.0μF/cm2 的高電容類型。由于它以另一層的形狀嵌入基板中,因此可以通過圖案設(shè)計將電容設(shè)置為您需要的任何尺寸。該電容器可以通過蝕刻加工。這意味著由于設(shè)計階段的限制較少,曾經(jīng)被認為不可能的設(shè)計現(xiàn)在可以使用嵌入式 TFC 技術(shù)實現(xiàn)。
 四有效利用 LSI 上的安裝空間
四有效利用 LSI 上的安裝空間
由于FICT可以將 TFC 嵌入基板中,這可以顯著減少安裝在電路板表面的電容器數(shù)量,從而增加可用空間。此外,由于可以以窄間距將過孔連接到 TFC,因此基板上的布線限制將更少。

GigaModule-2EC結(jié)構(gòu)可應(yīng)用于服務(wù)器等中高端設(shè)備。采用規(guī)則積層結(jié)構(gòu)的基板核心層之間最多可嵌入兩片TFC。這種 GigaModule-2EC 結(jié)構(gòu)最好用于需要非常穩(wěn)定的電源的 LSI。因此,建議用于嚴重依賴穩(wěn)定電源的電路,特別是對于高速或同時開關(guān)。
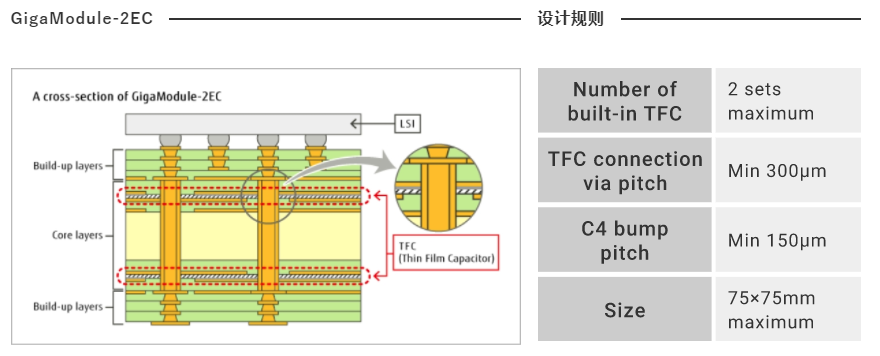
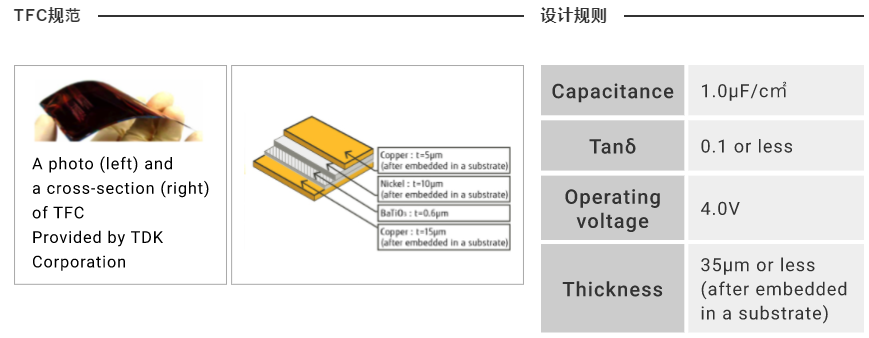
審核編輯 :李倩
-
阻抗
+關(guān)注
關(guān)注
17文章
970瀏覽量
47051 -
封裝
+關(guān)注
關(guān)注
128文章
8527瀏覽量
144830 -
薄膜電容器
+關(guān)注
關(guān)注
2文章
116瀏覽量
13671
原文標題:制造封裝基板的4大挑戰(zhàn)如何解決?
文章出處:【微信號:Fujitsu_Semi,微信公眾號:加賀富儀艾電子】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
PEEK注塑電子封裝基板的創(chuàng)新應(yīng)用方案
封裝基板設(shè)計的詳細步驟
迎接玻璃基板時代:TGV技術(shù)引領(lǐng)下一代先進封裝發(fā)展

EC-Master 支持 Xenomai 4 了!實時性與可靠性再升級
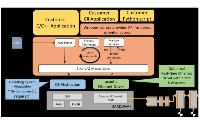
一文解讀玻璃基板與陶瓷基板、PCB基板的優(yōu)缺點及適用領(lǐng)域
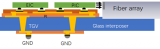
玻璃基板、柔性基板和陶瓷基板的優(yōu)劣勢

共封裝光學(xué)器件的現(xiàn)狀與挑戰(zhàn)

玻璃基板:半導(dǎo)體封裝領(lǐng)域的“黑馬”選手

玻璃基板的四大關(guān)鍵技術(shù)挑戰(zhàn)

韓國JNTC為三家芯片封裝企業(yè)供應(yīng)新型TGV玻璃基板
PCB與半導(dǎo)體的橋梁:封裝基板的奧秘與應(yīng)用

安捷利美維蘇州封裝基板項目投產(chǎn)
集成電路封裝基板工藝詳解:推動電子工業(yè)邁向新高度!
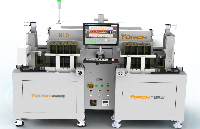
探尋玻璃基板在半導(dǎo)體封裝中的獨特魅力
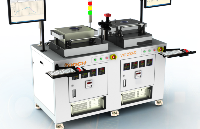





 GigaModule-EC解決了現(xiàn)在制造封裝基板的4個挑戰(zhàn)
GigaModule-EC解決了現(xiàn)在制造封裝基板的4個挑戰(zhàn)










評論