一顆芯片的誕生,可以分為芯片設計與芯片制造兩個環節。
芯片設計: 規劃“芯”天地
芯片設計階段會明確芯片的用途、規格和性能表現,芯片設計可分為規格定義、系統級設計、前端設計和后端設計4大過程。
規格定義,工程師在芯片設計之初,會做好芯片的需求分析、完成產品規格定義,以確定設計的整體方向。
系統設計, 基于前期的規格定義,明確芯片架構、業務模塊、供電等系統級設計,例如CPU、GPU、NPU、RAM、聯接、接口等。芯片設計需要綜合考量芯片的系統交互、功能、成本、功耗、性能、安全及可維可測等綜合要素。
前端設計,前端設計時,設計人員根據系統設計確定的方案,針對各模塊開展具體的電路設計,使用專門的硬件描述語言(Verilog或VHDL),對具體的電路實現進行RTL(Register Transfer Level)級別的代碼描述。代碼生成后,就需要嚴格按照已制定的規格標準,通過仿真驗證來反復檢驗代碼設計的正確性。之后,用邏輯綜合工具,把用硬件描述語言寫成的RTL級的代碼轉成門級網表(NetList),以確保電路在面積、時序等目標參數上達到標準。邏輯綜合完成后需要進行靜態時序分析,套用特定的時序模型,針對特定電路分析其是否違反設計者給定的時序限制。整個設計流程是一個迭代的流程,任何一步不能滿足要求都需要重復之前的步驟,甚至重新設計RTL代碼。
后端設計,后端設計是先基于網表,在給定大小的硅片面積內,對電路進行布局(Floor Plan)和繞線(Place and Route),再對布線的物理版圖進行功能和時序上的各種驗證(Design Rule Check、Layout Versus Schematic等),后端設計也是一個迭代的流程,驗證不滿足要求則需要重復之前的步驟,最終生成用于芯片生產的GDS(Geometry Data Standard)版圖。
芯片制造是一層層向上疊加的,最高可達上百次疊加。每一次的疊加,都必須和前一次完美重疊,重疊誤差要求是1~2納米。
芯片制作完整過程包括芯片設計、晶片制作、封裝制作、成本測試等幾個環節,其中晶片制作過程尤為的復雜。 精密的芯片其制造過程非常的復雜首先是芯片設計,根據設計的需求,生成的“圖樣”。
1、芯片的原料晶圓
晶圓的成分是硅,硅是由石英沙所精練出來的,晶圓便是硅元素加以純化(99.999%),接著是將些純硅制成硅晶棒,成為制造集成電路的石英半導體的材料,將其切片就是芯片制作具體需要的晶圓。
2、晶圓涂膜
晶圓涂膜能抵抗氧化以及耐溫能力,其材料為光阻的一種。
3、晶圓光刻顯影、蝕刻
該過程使用了對紫外光敏感的化學物質,即遇紫外光則變軟。通過控制遮光物的位置可以得到芯片的外形。在硅晶片涂上光致抗蝕劑,使得其遇紫外光就會溶解。
這時可以用上第一份遮光物,使得紫外光直射的部分被溶解,這溶解部分接著可用溶劑將其沖走。這樣剩下的部分就與遮光物的形狀一樣了,而這效果正是我們所要的。這樣就得到我們所需要的二氧化硅層。
4、攙加雜質
將晶圓中植入離子,生成相應的P、N類半導體。具體工藝是是從硅片上暴露的區域開始,放入化學離子混合液中。
這一工藝將改變攙雜區的導電方式,使每個晶體管可以通、斷、或攜帶數據。簡單的芯片可以只用一層,但復雜的芯片通常有很多層,這時候將這一流程不斷的重復,不同層可通過開啟窗口聯接起來。
這一點類似多層PCB板的制作制作原理。 更為復雜的芯片可能需要多個二氧化硅層,這時候通過重復光刻以及上面流程來實現,形成一個立體的結構。
5、晶圓測試
經過上面的幾道工藝之后,晶圓上就形成了一個個格狀的晶粒。通過針測的方式對每個晶粒進行電氣特性檢測。
6、封裝
將制造完成晶圓固定,綁定引腳,按照需求去制作成各種不同的封裝形式,這就是同種芯片內核可以有不同的封裝形式的原因。
7、測試、包裝
經過上述工藝流程以后,芯片制作就已經全部完成了,這一步驟是將芯片進行測試、剔除不良品,以及包裝。
個人圖書館,海思官網,半導體行業聯盟綜合整理
責任編輯:李倩
-
芯片
+關注
關注
459文章
52170瀏覽量
436129 -
晶圓
+關注
關注
52文章
5118瀏覽量
129161 -
芯片制造
+關注
關注
10文章
675瀏覽量
29517
發布評論請先 登錄
PanDao:簡化光學元件制造流程
【「芯片通識課:一本書讀懂芯片技術」閱讀體驗】芯片怎樣制造
深入解析硅基光子芯片制造流程,揭秘科技奇跡!

【「大話芯片制造」閱讀體驗】+ 芯片制造過程和生產工藝
大話芯片制造之讀后感超純水制造
GDS文件在芯片制造流程中的應用
淺談芯片制造的完整流程
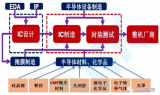
芯片制造全流程簡述






 芯片制造過程完整流程
芯片制造過程完整流程
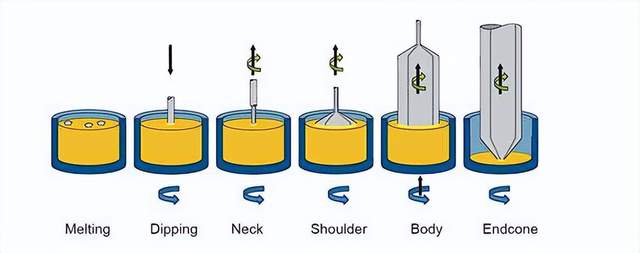




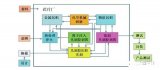










評論