電子發燒友報道(文/吳子鵬)Chiplet,小芯片,也被譯為芯粒,其核心思想是通過預先開發設計好的die直接集成到IC封裝中,以此來降低芯片開發的時間和成本。
目前主流的做法是,如果要打造一顆高性能的芯片,需要開發一個片上系統(SoC),然后借助晶圓代工廠的先進工藝將里面的功能單元微縮,在相同面積或者更小面積的裸片上實現更高的性能。很明顯,隨著特征尺寸逐漸逼近物理極限,且工藝復雜度越來越高,這條路越走下去難度會越大。
通俗地講,小芯片的方式就是像搭積木一樣制造芯片,AMD、英特爾、臺積電、Marvell、Cadence等產業巨頭對其都頗為關注,將其視為延續摩爾定律的選擇之一。在這里,我們看一下AMD在小芯片方面的布局。
可以說,業界如今對于小芯片的關注,AMD在其中起到了重要作用。小芯片概念最早可以追溯到上世紀七十年代的多芯片模組——將原來制造好的芯片再加以組裝。2014 年,芯片設計公司開始關注到這項技術。2016年,美國國防部高級研究計劃局Darpa 啟動Chips 項目,里面提到了chiplet Reuse的想法。但小芯片真正聲名鵲起還是因為AMD EYPC系列CPU的成功。
2017年,AMD 在其“Zen 2”架構中使用小芯片來開發EYPC 服務器處理器“Naples”,根據當時的AMD工程師表述,采用這樣的創新方式,比片上系統設計減少了一半的成本,并大幅降低了設計時間。隨后,AMD在消費級 CPU和企業級EPYC 處理器中都部署了“Zen 2”小芯片技術。
AMD在官網中提到,“Zen 2”核心在“Zen”架構之上進行了重大更新。主要優勢如下:
·時鐘周期指令數提升高達 15%
·3 級高速緩存容量翻倍(高達32MB)
·浮點吞吐能力翻倍(256位)
·OpCache 容量翻倍(4K)
·Infinity Fabric 帶寬翻倍(512位)
·全新的 TAGE 分支預測器
我們以Ryzen 3000為例來看一下這項技術的創新點。在之前片上系統的AMD CPU中,會使用四個Zen CPU 模塊,而在Ryzen 3000中,AMD采用了Zen 2核心,也就是8個小CPU核心,采用臺積電7nm工藝,并搭載了采用格芯14nm工藝的I/O 芯片,既保證了性能,又降低了成本。
通過采用7nm工藝的小CPU核心,AMD EPYC Rome 處理器擁有多達 8 個芯片,從而使平臺能夠支持多達 64 個內核。目前,小芯片技術已經廣泛大量應用于AMD的EPYC服務器CPU和線程撕裂者桌面CPU產品中。
在CPU取得成功之后,AMD又計劃將小芯片技術引入到了GPU領域。半導體制造設備也有光罩尺寸限制,這實質上造成了一個障礙,無法制造更大的 GPU,這讓后續單顆GPU芯片的性能提升非常困難。在專利中AMD提到,由于多數應用是以單個GPU為前提打造的,所以為了保留現有的應用編程模型,將小芯片設計實現在GPU上向來都是一大挑戰。
為了解決這一挑戰,AMD使用高帶寬互連來促進小芯片之間的通信,AMD將這種交聯稱為 HBX。該方法具體的實現方式是將CPU連接到第一個GPU小芯片,并且用一個無源互連將L3緩存和小芯片之間的其他通道連接在一起。這意味著就 CPU而言,它與一個大GPU而不是一堆小GPU進行通信。從開發人員的角度來看,GPU模型不會發生變化。
在 COMPUTEX 2021 上,AMD 總裁兼首席執行官 Lisa Su分享了AMD在3D小芯片方面的最新進展。她表示,AMD 將繼續利用 AMD 3D 小芯片技術鞏固其領先的 IP 和對領先制造和封裝技術的投資,這是一項封裝突破,使用行業領先的混合鍵合方法將 AMD 的創新小芯片架構與3D堆疊相結合,提供超過200倍的互連密度,2D小芯片的數量和密度是現有 3D封裝解決方案的15倍以上。與臺積電密切合作率先推出的行業領先技術,其能耗也低于當前的3D解決方案,是世界上最靈活的主動對主動硅堆疊技術。
目前主流的做法是,如果要打造一顆高性能的芯片,需要開發一個片上系統(SoC),然后借助晶圓代工廠的先進工藝將里面的功能單元微縮,在相同面積或者更小面積的裸片上實現更高的性能。很明顯,隨著特征尺寸逐漸逼近物理極限,且工藝復雜度越來越高,這條路越走下去難度會越大。
通俗地講,小芯片的方式就是像搭積木一樣制造芯片,AMD、英特爾、臺積電、Marvell、Cadence等產業巨頭對其都頗為關注,將其視為延續摩爾定律的選擇之一。在這里,我們看一下AMD在小芯片方面的布局。
可以說,業界如今對于小芯片的關注,AMD在其中起到了重要作用。小芯片概念最早可以追溯到上世紀七十年代的多芯片模組——將原來制造好的芯片再加以組裝。2014 年,芯片設計公司開始關注到這項技術。2016年,美國國防部高級研究計劃局Darpa 啟動Chips 項目,里面提到了chiplet Reuse的想法。但小芯片真正聲名鵲起還是因為AMD EYPC系列CPU的成功。
2017年,AMD 在其“Zen 2”架構中使用小芯片來開發EYPC 服務器處理器“Naples”,根據當時的AMD工程師表述,采用這樣的創新方式,比片上系統設計減少了一半的成本,并大幅降低了設計時間。隨后,AMD在消費級 CPU和企業級EPYC 處理器中都部署了“Zen 2”小芯片技術。
AMD在官網中提到,“Zen 2”核心在“Zen”架構之上進行了重大更新。主要優勢如下:
·時鐘周期指令數提升高達 15%
·3 級高速緩存容量翻倍(高達32MB)
·浮點吞吐能力翻倍(256位)
·OpCache 容量翻倍(4K)
·Infinity Fabric 帶寬翻倍(512位)
·全新的 TAGE 分支預測器
我們以Ryzen 3000為例來看一下這項技術的創新點。在之前片上系統的AMD CPU中,會使用四個Zen CPU 模塊,而在Ryzen 3000中,AMD采用了Zen 2核心,也就是8個小CPU核心,采用臺積電7nm工藝,并搭載了采用格芯14nm工藝的I/O 芯片,既保證了性能,又降低了成本。
通過采用7nm工藝的小CPU核心,AMD EPYC Rome 處理器擁有多達 8 個芯片,從而使平臺能夠支持多達 64 個內核。目前,小芯片技術已經廣泛大量應用于AMD的EPYC服務器CPU和線程撕裂者桌面CPU產品中。
在CPU取得成功之后,AMD又計劃將小芯片技術引入到了GPU領域。半導體制造設備也有光罩尺寸限制,這實質上造成了一個障礙,無法制造更大的 GPU,這讓后續單顆GPU芯片的性能提升非常困難。在專利中AMD提到,由于多數應用是以單個GPU為前提打造的,所以為了保留現有的應用編程模型,將小芯片設計實現在GPU上向來都是一大挑戰。
為了解決這一挑戰,AMD使用高帶寬互連來促進小芯片之間的通信,AMD將這種交聯稱為 HBX。該方法具體的實現方式是將CPU連接到第一個GPU小芯片,并且用一個無源互連將L3緩存和小芯片之間的其他通道連接在一起。這意味著就 CPU而言,它與一個大GPU而不是一堆小GPU進行通信。從開發人員的角度來看,GPU模型不會發生變化。
在 COMPUTEX 2021 上,AMD 總裁兼首席執行官 Lisa Su分享了AMD在3D小芯片方面的最新進展。她表示,AMD 將繼續利用 AMD 3D 小芯片技術鞏固其領先的 IP 和對領先制造和封裝技術的投資,這是一項封裝突破,使用行業領先的混合鍵合方法將 AMD 的創新小芯片架構與3D堆疊相結合,提供超過200倍的互連密度,2D小芯片的數量和密度是現有 3D封裝解決方案的15倍以上。與臺積電密切合作率先推出的行業領先技術,其能耗也低于當前的3D解決方案,是世界上最靈活的主動對主動硅堆疊技術。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
發布評論請先 登錄
相關推薦
熱點推薦
從 Arm 行業報告看芯片產業應如何構建面向未來十年的技術基石
半導體產業正經歷一場由人工智能 (AI) 崛起以及傳統摩爾定律放緩所驅動的關鍵轉型。在此背景下,Arm于近日發布了《芯片新思維:人工智能時代的新根基》行業報告。在報告中,來自 Arm 與業界的專家
面向AI與機器學習應用的開發平臺 AMD/Xilinx Versal? AI Edge VEK280
AMD/Xilinx Versal? AI Edge VEK280評估套件是一款面向AI與機器學習應用的開發平臺,專為邊緣計算場景優化設計。以下從核心配置、技術特性、應用場景及開發支持等方面進行詳細

面向未來 三星構建移動安全防護體系
近期,三星全新上市的Galaxy S25系列,在數據安全與隱私保護領域進行了深入的創新實踐。通過硬件級安全架構與創新加密技術的深度融合,三星構建了面向未來的移動安全防護體系,不僅重新定義了智能手機
案例之靈活且面向未來的ATE系統
得益于Intepro和Pickering公司在開放架構硬件領域的緊密協作及共同愿景,雙方成功開發出一系列及時交付、量身定制、適應性高且可擴展的ATE(自動化測試設備)系統,為終端客戶帶來了顯著效益。 自1981年成立以來,Intepro公司一直專注于為電力電子組件制造商提供ATE解決方案,在航空航天、國防、汽車、醫療、電信以及可再生能源等多個關鍵領域積累了豐富的經驗。 盡管公司規模相對較小,僅在愛爾蘭、英國和美國設有辦事處并擁有25名員工,但其業務
AMD芯片首次進入戴爾企業PC,戴爾品牌簡化新策略
近日,據彭博社報道,AMD公司在CES 2025展會上宣布了一項重要進展:其芯片將首次被戴爾科技公司采用,用于面向企業客戶的個人電腦(PC)產品。 AMD高管在展會發言中透露,戴爾已決
AMD獲得玻璃核心基板技術專利
AMD?最近獲得了一項關于玻璃核心基板技術的專利,預示著在未來幾年內,玻璃基板有望取代傳統的多芯片處理器有機基板。這項專利不僅體現了AMD在相關技術領域的深厚研究,還使公司在
使用 AMD Versal AI 引擎釋放 DSP 計算的潛力
的 DSP 應用。 AMD Versal AI 引擎使您能夠擴展數字信號處理 (DSP) 計算和面向未來的設計,以適應當前和下一代計算密集型 DSP 應用。借助 Versal AI 引擎,客戶可以期望以
AMD或涉足手機芯片市場
近日,據行業內部知情人士透露,全球知名的半導體巨頭AMD正計劃進軍移動設備芯片市場,此舉或將為移動計算領域帶來一場新的變革。 據悉,AMD擬推出的新產品將采用臺積電先進的3納米工藝制造,這一決策不僅
使用AMD Versal AI引擎加速高性能DSP應用
AMD Versal AI 引擎使您能夠擴展數字信號處理( DSP )算力與面向未來的設計,從而適應當前和下一代計算密集型 DSP 應用。借助 Versal AI 引擎,客戶能以更低的功耗1和更少的可編程邏輯資源2獲得高性能 DSP。
AMD發布新一代AI芯片MI325X
在舊金山舉辦的Advancing AI 2024大會上,AMD正式推出了其新一代AI芯片——GPU AMD Instinct MI325X。這款芯片的發布標志著
AMD AI芯片需求井噴,業績預估再獲提升
全球芯片巨頭AMD近期發布的財報與未來財測數據令人矚目,尤其是其在數據中心領域的強勁表現,再次引發了市場的熱烈反響。AMD的執行長蘇姿豐更是直接表示,AI
使用STM32F407ZGT6的設備無法連接到AMD處理器的電腦上,怎么處理?
使用貴公司的STM32芯片,型號:STM32F407ZGT6。CAN總線轉串口,可以正常連接到英特爾處理器的電腦上;但是無法連接到AMD處理器的電腦上。請問怎么處理?
連接到AMD處理器的電腦上,串口顯示如下:
發表于 07-23 07:58





 解密AMD面向未來的小芯片設計
解密AMD面向未來的小芯片設計
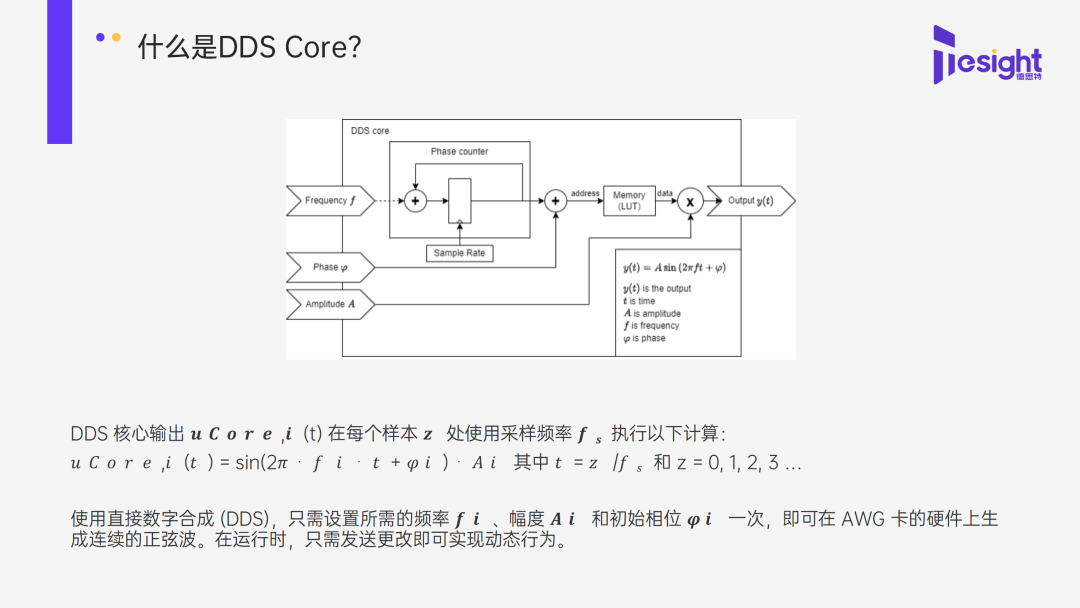











評論