在接下來的幾個(gè)高級(jí)過程節(jié)點(diǎn)的設(shè)備路線圖似乎已經(jīng)相對(duì)清晰。FinFET拓?fù)鋵⒈籊AA(gate-all-around)器件取代,通常使用多個(gè)堆疊通道,金屬柵完全圍繞“納米片”。盡管鰭片由于在鰭片的高度和厚度上的遍歷而表現(xiàn)出改善的柵極至溝道靜電,但堆疊的納米片卻進(jìn)一步改善了這種靜電控制-優(yōu)化了亞閾值泄漏電流。 提議的對(duì)納米片拓?fù)涞臄U(kuò)展采用“forksheet”,如下圖所示。
forksheet研發(fā)的目標(biāo)是消除nFET到pFET器件的間距規(guī)則(用于公共柵極輸入連接),用薄氧化物隔離兩組納米板。晶體管密度獲得這種引人注目的增益的代價(jià)是——柵極再次在三個(gè)側(cè)面上包圍了溝道體積–“ FinFET側(cè)面翻轉(zhuǎn)”是forksheet的一個(gè)常見的相似之處。 盡管后FinFET節(jié)點(diǎn)的大批量制造(HVM)的日期有些不確定,但是可以預(yù)料,這些不斷發(fā)展的納米片/forksheet拓?fù)鋵⒃?024-25年間出現(xiàn)。 目前正在積極進(jìn)行工藝開發(fā)和設(shè)備研究,以尋找無數(shù)納米片的替代品。
假設(shè)“納米”設(shè)備拓?fù)鋵⒅辽儆糜趦蓚€(gè)進(jìn)程節(jié)點(diǎn),如果任何新設(shè)備要在2028-30年達(dá)到HVM,現(xiàn)在就需要積極地進(jìn)行研究。 在最近的IEDM會(huì)議上,Synopsys展示了他們?cè)诖藭r(shí)間范圍內(nèi)針對(duì)“ 1nm”節(jié)點(diǎn)的領(lǐng)先器件替代產(chǎn)品之一的預(yù)測(cè)和設(shè)計(jì)技術(shù)協(xié)同優(yōu)化(DTCO)評(píng)估結(jié)果。本文總結(jié)了他們演講的重點(diǎn)。1nm 節(jié)點(diǎn)下圖描述了最近幾個(gè)工藝節(jié)點(diǎn)的晶體管密度的直線趨勢(shì)。(此圖是Synopsys與IC Knowledge,Inc.合作的一部分。)
關(guān)于這張圖需要注意的幾點(diǎn):
x軸上的節(jié)點(diǎn)名稱代表了從14nm節(jié)點(diǎn)的簡(jiǎn)單過渡,每個(gè)連續(xù)的數(shù)據(jù)點(diǎn)都由0.7X摩爾定律線性乘數(shù)定義(為了便于討論,如果DTCO工藝發(fā)展的目標(biāo)確實(shí)是保持在這條曲線上,那么使用0.7X的命名是合適的。)
每個(gè)節(jié)點(diǎn)上的密度數(shù)據(jù)點(diǎn)代表來自多個(gè)代工廠的指標(biāo)
數(shù)據(jù)點(diǎn)包括對(duì)邏輯和SRAM實(shí)施的單獨(dú)測(cè)量
邏輯密度通常與代工技術(shù)常用的基礎(chǔ)庫單元實(shí)現(xiàn)有關(guān)。例如,一個(gè)2輸入NAND單元的面積反映了單元中4個(gè)器件的使用情況。
接觸的多間距 the contacted poly pitch(CPP)
cell中水平金屬走線的數(shù)量(用于信號(hào)和電源)
cell鄰接隔離間隔(“擴(kuò)散中斷”與單元之間的虛設(shè)柵極捆綁在一起)
另一個(gè)關(guān)鍵的單元維度是一個(gè)(可掃描的)數(shù)據(jù)觸發(fā)器的面積。上面的晶體管密度計(jì)算對(duì)每個(gè)邏輯數(shù)據(jù)點(diǎn)使用了NAND和FF單元的邏輯混合。 特別值得注意的是,在Synopsys對(duì)1nm節(jié)點(diǎn)的預(yù)測(cè)中使用的器件拓?fù)浣Y(jié)構(gòu)的假設(shè)。目前正在積極研究,以便在與該節(jié)點(diǎn)一致的時(shí)間范圍內(nèi)評(píng)估幾種非硅場(chǎng)效應(yīng)器件類型--例如,二維半導(dǎo)體材料(MoS2)和一維碳納米管。為了保持在晶體管密度曲線上的目標(biāo),Synopsys TCAD團(tuán)隊(duì)采用了DTCO工藝定義來實(shí)現(xiàn)3D“互補(bǔ)FET”。下圖展示了CFET的橫截面。
CFET技術(shù)的一個(gè)吸引人的特征是與納米片拓?fù)浣Y(jié)構(gòu)的相似性,后者將在1nm節(jié)點(diǎn)的時(shí)間范圍內(nèi)具有多年的制造經(jīng)驗(yàn)。CFET方法的新穎之處在于pFET和nFET納米片的垂直放置。
CFET拓?fù)淅昧说湫偷腃MOS邏輯應(yīng)用,其中將公共輸入信號(hào)施加到nFET和pFET器件的柵極。(稍后將討論具有僅nFET字線傳輸門的6T SRAM位單元的獨(dú)特情況。)
上圖顯示了pFET納米片如何直接位于nFET納米片下方。在圖中,存在兩個(gè)nFET納米片,比pFET窄,這主要是由于需要空間來接觸pFET源極和漏極節(jié)點(diǎn),因此nFET的寬度減小了。并聯(lián)的兩個(gè)nFET將提供與pFET相當(dāng)?shù)尿?qū)動(dòng)強(qiáng)度。(CFET中的SRAM位單元設(shè)計(jì)采用了不同的策略。)還顯示了有源柵極上的M0接觸(COAG)拓?fù)浣Y(jié)構(gòu),擴(kuò)展了這種最新的工藝增強(qiáng)功能。 CFET器件的處理需要特別注意pFET和nFET的形成。
用于pFET源/漏節(jié)點(diǎn)的SiGe的外延生長(zhǎng)用于在溝道中引入壓縮應(yīng)變,以提高空穴遷移率。然后執(zhí)行pFET柵極氧化物和金屬柵極沉積。隨后,nFET源極/漏極節(jié)點(diǎn)的外延Si生長(zhǎng),隨后的柵極氧化物和金屬柵極沉積必須遵守現(xiàn)有pFET器件施加的材料化學(xué)約束。
埋入式電源軌(Power rails) 請(qǐng)注意,對(duì)于1nm節(jié)點(diǎn)的假設(shè)是,本地VDD和GND分布將由“埋入電軌”(BPR)提供,它們位于基板中的納米片下方。結(jié)果,既需要“淺”(器件)通孔,又需要“深”(BPR)通孔。因此,BPR和過孔的金屬成分是關(guān)鍵的工藝優(yōu)化,以降低寄生接觸電阻。(主要)金屬必須具有低電阻率,并以極薄的勢(shì)壘和襯里材料沉積在溝槽中。
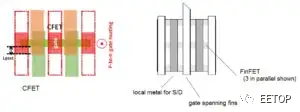
說到寄生,下面的(簡(jiǎn)化)布局圖突出了CFET拓?fù)涞莫?dú)特優(yōu)勢(shì)。CFET器件的三維方向消除了單獨(dú)的nFET和pFET區(qū)域之間的柵極穿越。而且,與FinFET器件布局相比,柵極到源極/漏極局部金屬化層的并行運(yùn)行長(zhǎng)度顯著減少。(圖中顯示了經(jīng)過納米片的較小的柵極長(zhǎng)度擴(kuò)展。)結(jié)果,使用CFET極大地改善了器件的寄生Rgate電阻和Cgs / Cgd電容。CFET SRAM設(shè)計(jì)在CFET工藝中實(shí)現(xiàn)6T SRAM位單元會(huì)引入一些權(quán)衡。Synopsys DTCO團(tuán)隊(duì)選擇了獨(dú)特的設(shè)計(jì)特性,如下圖所示。
1. nFET下拉:pFET上拉比很容易達(dá)到2:1 前面所示的兩個(gè)較小的nFET納米片,其邏輯驅(qū)動(dòng)強(qiáng)度比為1:1,與SRAM位單元中的pFET的寬度相同,驅(qū)動(dòng)力為2:1。(請(qǐng)注意,這可以與FinFET位單元相媲美,其中nFET鰭片的數(shù)量為2而pFET鰭片的數(shù)量為1。) 2. 實(shí)現(xiàn)了一對(duì)修改的nFET傳輸門器件 用于傳輸門(pass gates)的兩個(gè)nFET納米片(略)比下拉電阻弱;柵極僅存在于納米片的三個(gè)側(cè)面上。
這種“三柵極”配置提供了更密集的位單元,并優(yōu)化了傳輸門:下拉nFET器件的相對(duì)強(qiáng)度,以實(shí)現(xiàn)可靠的單元讀取容限。 3. 通過門器件下的pFET納米片現(xiàn)在變成無效的“虛擬”門 4. 內(nèi)部6T單元互連使用唯一的“交叉耦合”層(在M0通孔水平) 在工藝開發(fā)的早期,DTCO分析利用TCAD模擬工具,來表示材料的光刻圖版、材料沉積和(選擇性)蝕刻輪廓。這項(xiàng)早期的優(yōu)化工作提供了對(duì)所需的工藝窗口、預(yù)期的材料尺寸和電學(xué)特性的見解,包括優(yōu)化自由載流子遷移率的溝道應(yīng)變。
后續(xù)的寄生提取,與設(shè)備模型合并,為新工藝提供初步的功率/性能度量,并結(jié)合設(shè)備布局區(qū)域進(jìn)行全面的PPA評(píng)估。下圖提供了上述SRAM位單元的DTCO的可視化分析。總結(jié)在IEDM上,Synopsys TCAD團(tuán)隊(duì)提供了對(duì) "1nm "節(jié)點(diǎn)特性的窺探,該節(jié)點(diǎn)基于CFET器件拓?fù)浣Y(jié)構(gòu),在兩個(gè)nFET納米片下面有一個(gè)pFET納米片。還假設(shè)了埋入式電源軌。光刻假設(shè)是基于利用(高數(shù)值孔徑)EUV--例如,39nm CPP(帶COAG)和19nmM0金屬間距。對(duì)于相對(duì)的PUPG驅(qū)動(dòng)強(qiáng)度和內(nèi)部交叉耦合互連層,都采用了獨(dú)特的SRAM位單元設(shè)計(jì)方法。 這種DTCO分析的結(jié)果表明,1nm CFET節(jié)點(diǎn)可能確實(shí)能夠保持激進(jìn)的晶體管密度,接近10億個(gè)晶體管/平方毫米。
責(zé)任編輯:xj
原文標(biāo)題:關(guān)注 | 10億個(gè)晶體管/mm2 !1nm節(jié)點(diǎn)可以這樣做
文章出處:【微信公眾號(hào):旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
-
芯片
+關(guān)注
關(guān)注
459文章
52481瀏覽量
440582 -
晶體管
+關(guān)注
關(guān)注
77文章
10018瀏覽量
141602 -
1nm
+關(guān)注
關(guān)注
0文章
16瀏覽量
4018
原文標(biāo)題:關(guān)注 | 10億個(gè)晶體管/mm2 !1nm節(jié)點(diǎn)可以這樣做
文章出處:【微信號(hào):wc_ysj,微信公眾號(hào):旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄





 10億個(gè)晶體管/mm2 1nm節(jié)點(diǎn)可以這樣做
10億個(gè)晶體管/mm2 1nm節(jié)點(diǎn)可以這樣做











評(píng)論