隨著時(shí)代的進(jìn)步,微電子產(chǎn)品向便攜化、小型化和高性能方向發(fā)展,BGA(Ball Grid Array)封裝已成為最先進(jìn)的封裝技術(shù)之一。然而,BGA封裝面臨的主要技術(shù)瓶頸在于電子產(chǎn)品的使用過程中,芯片會(huì)產(chǎn)生很多的熱量,使得封裝系統(tǒng)組件溫度升高;由于封裝材料的膨脹系數(shù)不同,溫差變化會(huì)使得封裝整體受到熱應(yīng)力沖擊。在封裝整體焊點(diǎn)的強(qiáng)度較低時(shí),不斷的熱應(yīng)力沖擊會(huì)使焊點(diǎn)產(chǎn)生裂紋,久而久之會(huì)導(dǎo)致封裝整體失效。此外,隨著便攜式電子產(chǎn)品的不斷普及,BGA互連焊點(diǎn)將承受高的應(yīng)變速率損傷(如跌落損傷),這也造成了新的焊點(diǎn)失效模式。
小編認(rèn)為,針對(duì)簡(jiǎn)化的BGA封裝體結(jié)構(gòu)(主要包括芯片、Sn-3.0Ag-0.5Cu焊球以及基板等),利用有限元法對(duì)其溫度場(chǎng)、熱應(yīng)力應(yīng)變以及不同剪切速率下的剪切行為進(jìn)行了模擬分析,也可進(jìn)行相關(guān)的實(shí)驗(yàn)驗(yàn)證,從而為BGA封裝體因溫度、熱應(yīng)力、疲勞以及振動(dòng)沖擊所產(chǎn)生的諸多問題以及電子產(chǎn)品的可靠性分析提供了理論基礎(chǔ)和實(shí)驗(yàn)數(shù)據(jù)。
在溫度場(chǎng)分析方面,對(duì)焊球分別通入電流(I_1=0.5A、I_2=1.5A、I_3=2.5A)后,模擬和實(shí)驗(yàn)結(jié)果均表明,BGA封裝焊點(diǎn)兩側(cè)的芯片端和基板端的溫度都隨著加載電流的增大而增大,并且滿足拋物線規(guī)律;在假設(shè)芯片為唯一發(fā)熱源(功率大小為0.1W)并考慮整個(gè)封裝體內(nèi)部以及與外界的熱傳導(dǎo)和對(duì)流的條件下,3-D與2-DBGA封裝溫度場(chǎng)模擬結(jié)果均表明:焊球的溫度較高,基本和芯片的溫度相接近,基板的溫度較低,這是由于基板的導(dǎo)熱系數(shù)與芯片和焊球相差太大的緣故。在熱應(yīng)力分析方面,不論在穩(wěn)態(tài)溫度場(chǎng)還是熱循環(huán)條件(-40~125℃)下,BGA封裝整體尤其是焊球內(nèi)都有大的位移變化以及應(yīng)力應(yīng)變集中,這主要是由于封裝體內(nèi)各組件材料熱膨脹系數(shù)不匹配的緣故。根據(jù)Coffin-Manson方程,溫度循環(huán)條件下的Sn-3.0Ag-0.5Cu無鉛焊球的最短熱疲勞壽命約為704cycles。
利用SEM觀察分析了不同時(shí)效時(shí)間時(shí)的界面IMC的厚度及形態(tài),并在不同剪切速率下(≤10mm/s)對(duì)BGA球進(jìn)行剪切性能測(cè)試和模擬。實(shí)驗(yàn)結(jié)果表明,隨著時(shí)效時(shí)間的延長(zhǎng),Sn-3.0Ag-0.5Cu/Cu界面IMC的厚度不斷增加,界面形貌由時(shí)效前的貝狀變?yōu)檫B續(xù)平坦的層狀,焊球的剪切強(qiáng)度逐漸減小;隨著剪切速率的增加,焊球的剪切強(qiáng)度增大,并且隨著剪切高度的增加,焊球的剪切強(qiáng)度減小。
封裝可靠性評(píng)價(jià)是鑒定需要重點(diǎn)考核的工作項(xiàng)目。新型封裝應(yīng)用于型號(hào)整機(jī)前,其可靠性應(yīng)針對(duì)應(yīng)用的環(huán)境特點(diǎn)以及整機(jī)對(duì)可靠性的要求進(jìn)行評(píng)價(jià)和驗(yàn)證。如標(biāo)準(zhǔn)JEDEC-JEP150是從器件級(jí)和器件裝聯(lián)后兩個(gè)層級(jí),主要通過HAST和其它試驗(yàn)項(xiàng)目實(shí)現(xiàn)對(duì)smt貼裝器件封裝的可靠性評(píng)價(jià)。
同樣,對(duì)于集成電路封裝的可靠性評(píng)價(jià),也需要從器件封裝自身和裝聯(lián)后器件可靠性兩個(gè)維度開展。器件封裝自身的評(píng)價(jià),主要應(yīng)從封裝的設(shè)計(jì)、結(jié)構(gòu)、材料和工藝等方面進(jìn)行檢測(cè)評(píng)價(jià)和計(jì)算機(jī)仿真分析;而器件裝聯(lián)后的封裝可靠性評(píng)價(jià),主要通過在環(huán)境、機(jī)械等應(yīng)力作用下和計(jì)算機(jī)仿真分析來評(píng)價(jià)整機(jī)的可靠性。同時(shí),不同封裝對(duì)電裝工藝的需求也不盡相同,smt貼片打樣廠商需要根據(jù)封裝結(jié)構(gòu)的特點(diǎn),進(jìn)行裝聯(lián)工藝的適應(yīng)性分析。
編輯:hfy
-
BGA
+關(guān)注
關(guān)注
5文章
565瀏覽量
48131 -
器件封裝
+關(guān)注
關(guān)注
0文章
8瀏覽量
5536
發(fā)布評(píng)論請(qǐng)先 登錄
晶振封裝技術(shù)革命:陶瓷VS金屬封裝如何影響設(shè)備可靠性
提供半導(dǎo)體工藝可靠性測(cè)試-WLR晶圓可靠性測(cè)試
電機(jī)微機(jī)控制系統(tǒng)可靠性分析
BGA封裝焊球推力測(cè)試解析:評(píng)估焊點(diǎn)可靠性的原理與實(shí)操指南

高密度系統(tǒng)級(jí)封裝:技術(shù)躍遷與可靠性破局之路
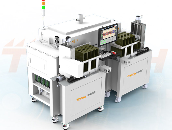
詳解晶圓級(jí)可靠性評(píng)價(jià)技術(shù)

IGBT模塊封裝:高效散熱,可靠性再升級(jí)!

BGA焊盤設(shè)計(jì)與布線

低溫高可靠性錫膏逐步引領(lǐng)趨勢(shì),深受客戶青睞!

BGA芯片封裝凸點(diǎn)工藝:技術(shù)詳解與未來趨勢(shì)

BGA芯片的封裝類型 BGA芯片與其他封裝形式的比較
BGA封裝對(duì)散熱性能的影響
BGA封裝技術(shù)的發(fā)展 BGA封裝的優(yōu)勢(shì)與應(yīng)用
機(jī)械應(yīng)力和熱應(yīng)力下的BGA焊點(diǎn)可靠性






 BGA封裝面臨的主要技術(shù)瓶頸及可靠性
BGA封裝面臨的主要技術(shù)瓶頸及可靠性











評(píng)論