前言:
近年來,封裝技術在半導體領域發揮的作用越來越大,越來越多前道工藝需要完成的步驟被引入后道工藝當中,兩者的界限變得越來越模糊。隨之而來的是,越來越多超越傳統封裝理念的先進封裝技術被提出。
滿足芯片發展需求需要先進封裝
隨著芯片不斷向微型化發展,工藝制程開始向著更小的5nm、3nm推進,已經越來越逼近物理極限,付出的代價也將越來越大,因此摩爾定律屢屢被傳將走到盡頭,迫切需要另辟蹊徑推動技術進步。
先進封裝會成為下一階段半導體技術的重要發展方向。隨著摩爾定律發展趨緩,通過先進封裝技術來滿足系統微型化、多功能化成為了集成電路產業發展的新引擎。
先進封裝技術能夠相對輕松地實現芯片的高密度集成、體積的微型化和更低的成本等需求,符合高端芯片向尺寸更小、性能更高、功耗更低演進的趨勢。

如今AI市場的不斷擴張推動著先進封裝行業的增長,AI芯片組需要運算速度更快的內核、更小巧的外形以及高能效,這些需求驅動著先進封裝市場。
5G技術的普及也在增加先進封裝市場的需求,5G芯片組較依賴先進封裝技術,來實現高性能、小尺寸和低功耗。
先進封裝市場將從當前市場價值升至到超過250億美元,到2026年將超過400億美元,2020年到2026年期間將是增長的高爆期,其年復合增長率將達到8%。

異構整合:治療芯片微縮難題
半導體先進制程紛紛邁入了7納米、5納米,接著開始朝3納米和2納米邁進,電晶體大小也因此不斷接近原子的物理體積限制,電子及物理的限制也讓先進制程的持續微縮與升級難度越來越高。
異構整合概念便應運而生,同時成為IC芯片的創新動能。將兩種不同制程、不同性質的芯片整合在一起。
這增強了功能性,可以對采用不同工藝、不同功能、不同制造商制造的組件進行封裝。
因此,IC代工、制造及半導體設備業者紛紛投入異構整合發展,2.5D、3D封裝、Chiplets等現今熱門的封裝技術,便是基于異構整合的想法。
2.5D封裝:治療芯片生產成本難題
隨著智能手機、AIoT等應用,不僅需要更高的性能,還要保持小體積、低功耗。
在這樣的情況下,必須想辦法將更多的芯片堆積起來使體積再縮小,因此目前封裝技術除了原有的SiP之外,也紛紛朝向立體封裝技術發展,2.5D封裝技術正是其中被人所熟知的一種。
2.5D封裝通常用于ASIC、FPGA、GPU和內存立方體,并最終在高帶寬內存(HBM)處理器集成中流行起來。
扇出型晶圓級封裝(FOWLP)也可歸為2.5D封裝的一種方式。扇出型晶圓級封裝技術的原理,是從半導體裸晶的端點上,拉出需要的電路至重分布層,進而形成封裝。
扇出型晶圓級封裝為晶圓模提供了更多的外部接觸空間,將芯片嵌入環氧模塑料內,然后在晶片表面制造高密度重分布層(RDL)和焊料球,形成重組晶片。
3D封裝技術:直接將芯片堆疊起來
在3DIC封裝中,邏輯模塊堆疊在內存模塊上,而不是創建一個大型的系統片上(SoC),并且模塊通過一個主動交互器連接。
相較于2.5D封裝,3D封裝的原理是在芯片制作電晶體(CMOS)結構,并且直接使用硅穿孔來連結上下不同芯片的電子訊號,以直接將記憶體或其他芯片垂直堆疊在上面。
此項封裝最大的技術挑戰便是,要在芯片內直接制作硅穿孔困難度極高,不過,由于高效能運算、人工智能等應用興起,加上硅通孔(TSV)技術愈來愈成熟,可以看到越來越多的CPU、GPU和記憶體開始采用3D封裝。
Chiplets:摩爾定律瓶頸衍生的技術替代方案
由于電子終端產品朝向高整合趨勢發展,對于高效能芯片需求持續增加,但隨著摩爾定律逐漸趨緩,在持續提升產品性能過程中,如果為了整合新功能芯片模組而增大芯片面積,將會面臨成本提高和低良率問題。
因此,Chiplets成為半導體產業因摩爾定律面臨瓶頸所衍生的技術替代方案。
因為先進制程成本非常高昂,特別是模擬電路、I/O等愈來愈難以隨著制程技術縮小,而Chiplets是將電路分割成獨立的小芯片,并各自強化功能、制程技術及尺寸,最后整合在一起,以克服制程難以微縮的挑戰。
Chiplets允許設計者利用各種各樣的IP而不必考慮它們是在哪個節點或技術上制造;它們可以在硅、玻璃和層壓板等多種材料上建造。
芯片巨頭同時深入探索封裝技術
以臺積電、英特爾、三星為代表的三大芯片巨頭正積極探索先進封裝技術。
臺積電:
·CoWoS是臺積電推出的2.5D封裝技術,被稱為晶圓級封裝,CoWoS針對高端市場,連線數量和封裝尺寸都比較大。
自2012年開始量產CoWoS以來,臺積電就通過這種芯片間共享基板的封裝形式,把多顆芯片封裝到一起,而平面上的裸片通過SiliconInterposer互聯,這樣達到了封裝體積小,傳輸速度高,功耗低,引腳少的效果。
·開發了晶圓級封裝技術——系統整合芯片,是以關鍵的銅到銅接合結構,搭配TSV以實現最先進的3D IC技術,可將多個小芯片整合成一個面積更小與輪廓更薄的系統單晶片。
·在Fan-out和3D先進封裝平臺方面已處于領先地位,其先進封裝技術儼然已成為一項成熟的業務,并為其帶來了可觀的收入。
目前有4座先進的芯片封測工廠,新投產兩座之后,就將增加到6座,在明后兩年投產的兩座芯片封裝工廠,也將采用3D Fabric先進封裝技術。
·臺積電將SoIC、CoWoS、InFO-R、CoW、WoW等先進封裝技術平臺加以整合,統一命名為“TSMC 3D Fabric”。
此平臺將提供芯片連接解決方案,滿足用戶在整合數字芯片、高帶寬存儲芯片及特殊工藝芯片方面的需求。
三星:
·主要布局在面板級扇出型封裝(FOPLP),三星在FOPLP投資已超過4億美元。2018年FOPLP技術實現商用,應用于其自家智能手手表Galaxy Watch的處理器封裝應用中。
·為擴大半導體封裝技術陣容,不僅開發FOPLP,也開發FOWLP技術。還在2019年上半年收購子公司三星電機的半導體封裝PLP事業,不斷加強封裝的實力。
·2019年10月,三星開發出業界首個12層3D-TSV(硅穿孔)技術,這項新創新被認為是大規模生產高性能芯片所面臨的的最具挑戰性的封裝技術之一,因為它需要極高的精度才能通過擁有六萬多個TSV孔的三維配置垂直互連12個DRAM芯片。
英特爾:
·2017年,英特爾推出了EMIB(嵌入式多芯片互連橋接)封裝技術,可將不同類型、不同工藝的芯片IP靈活地組合在一起,類似一個松散的SoC。
·隨后發布了3D封裝技術Foveros,首次在邏輯芯片中實現3D堆疊,對不同種類芯片進行異構集成。
英特爾的3D封裝技術結合了3D和2D堆疊的兩項優勢,英特爾ODI全向互連技術可通過在小芯片之間的布線空隙來實現,而這些是臺積電系統整合單晶片(So IC)技術做不到的。
·最新發布的“混合結合”技術,能夠實現10微米及以下的凸點間距,較Fovreros封裝的25—50微米凸點間距有了明顯提升,并且優化芯片的互連密度、帶寬和功率表現,進一步提升芯片系統的計算效能。
結尾:
先進封裝也成為延續摩爾定律的關鍵技術,一個蘿卜一個坑,先進封裝的發展技術,將有效“治療”目前芯片提升難點,成為擺脫眼下束縛的“良藥”。
責編AJX
-
芯片
+關注
關注
459文章
52465瀏覽量
440280 -
臺積電
+關注
關注
44文章
5751瀏覽量
169688 -
封裝技術
+關注
關注
12文章
578瀏覽量
68582
發布評論請先 登錄
電力電子中的“摩爾定律”(1)

玻璃基板在芯片封裝中的應用
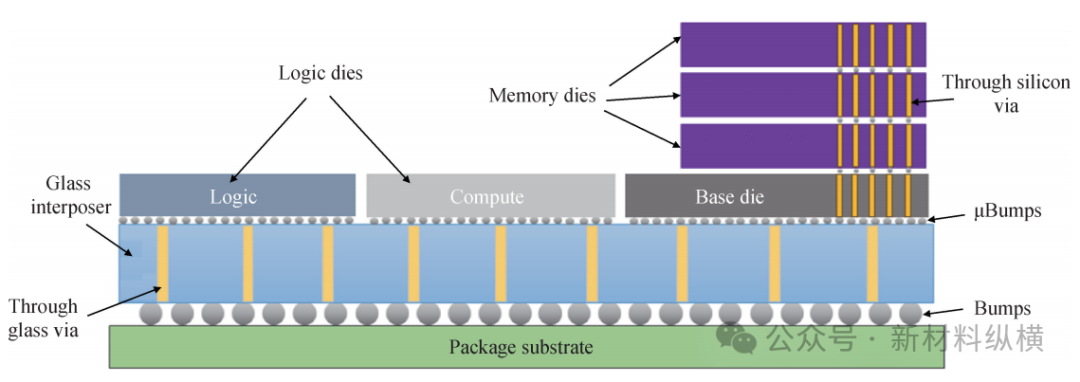
瑞沃微先進封裝:突破摩爾定律枷鎖,助力半導體新飛躍

先進封裝技術:3.5D封裝、AMD、AI訓練降本

混合鍵合中的銅連接:或成摩爾定律救星

石墨烯互連技術:延續摩爾定律的新希望
摩爾定律是什么 影響了我們哪些方面






 先進封裝將成延續摩爾定律的關鍵技術,助力芯片提升
先進封裝將成延續摩爾定律的關鍵技術,助力芯片提升















評論