來源:新材料縱橫
導讀:
自集成電路誕生以來,摩爾定律一直是其發展的核心驅動力。根據摩爾定律,集成電路單位面積上的晶體管數量每18到24個月翻一番,性能也隨之提升。然而,隨著晶體管尺寸的不斷縮小,制造工藝的復雜度和成本急劇上升,摩爾定律的延續面臨巨大挑戰。例如,從22納米工藝制程開始,每一代技術的設計成本增加均超過50%,3納米工藝的總設計成本更是高達15億美元。此外,晶體管成本縮放規律在28納米制程后已經停滯。
在傳統二維芯片設計中,芯片的工作區和引線普遍采用平面布局,這種設計限制了芯片之間的高頻信號傳輸,因為互連線過長導致信號延遲大。為突破這一瓶頸,20世紀80年代,隨著超微加工技術的發展,三維封裝(3D封裝)技術應運而生。3D封裝通過在單一芯片上構建多層電路,利用絕緣層隔離各層電路,并通過穿孔實現層間互連,從而在不增加芯片平面空間的前提下,顯著提升集成度,縮短信號傳輸路徑。
三維封裝技術
近年來,3D封裝技術取得了重大突破。英特爾在2022年的IEEE國際電子器件會議上展示了其3D封裝技術的新進展,該技術可將互連密度再提升10倍。英特爾的Foveros技術是一種3D堆疊芯片技術,能夠以垂直方式堆疊計算模塊,優化成本和能效。此外,英特爾還通過混合鍵合技術將互連間距微縮到3微米,實現了與單片式系統級芯片相似的互連密度。
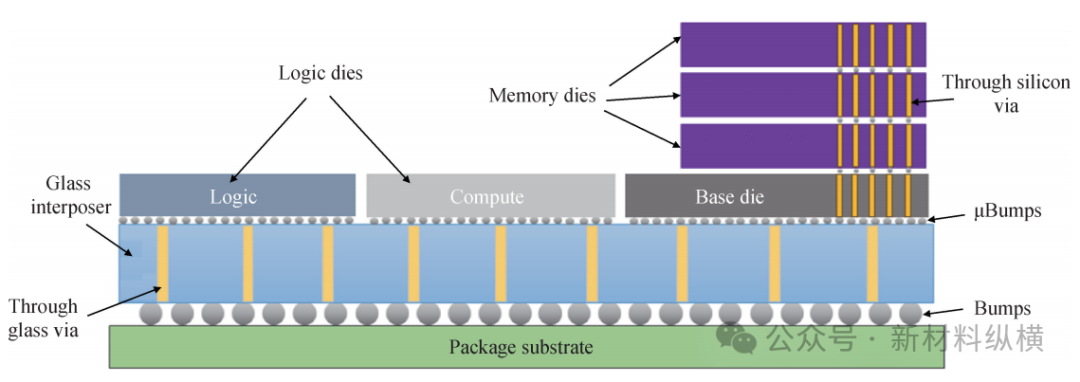
芯片3D封裝結構示意圖
玻璃基板
玻璃因具有熱膨脹系數低、電氣絕緣性能好等優勢,被芯片設計開發者引入芯片封裝領域作為封裝基板使用。玻璃基板為芯片提供了穩定的支撐平臺,可確保封裝過程中芯片不會因基板變形或不平坦而受損。
目前,芯片封裝的基板材料主要包括有機基板、陶瓷基板和玻璃基板三種:
(1)有機基板:具有質量輕、可實現復雜電路設計、工藝流程簡單、生產成本低等優點,但高溫熱穩定性差,易受高溫影響而變形。
(2)陶瓷基板:介電性能穩定,機械性能好,能滿足集成電路的需求,但制造成本較高,且不適用于對輕量化有需求的應用場景。
(3)玻璃基板:具備優異的熱穩定性,能在高溫環境下保持物理形態不變,同時具有優異的電氣絕緣性能,能有效減少信號損耗和串擾,適合高頻應用環境。玻璃基板還具備高機械強度和高平整度,能夠實現高密度互連和精確的層間對準。
三種芯片封裝基板材料的性能參數
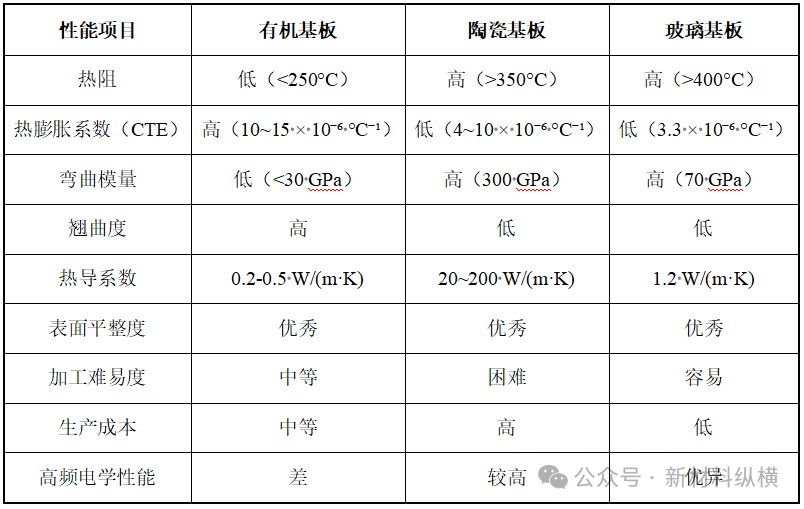
隨著芯片3D封裝技術的發展,硅通孔(rhrough silicon via, TSV)技術和玻璃通孔(through glass via,TGV)技術相繼得到應用。早期的芯片3D封裝是通過TSV技術實現的,TSV具有互連密度、電阻相對小和信號延遲低、工藝技術成熟及機械強度較好等優點,但成本高、散熱管理難及加工過程中可能產生應力等問題限制了其廣泛的應用。TGV因具有電絕緣性能好、高頻衰減小、成本低、熱膨脹系數與硅匹配等優勢,現在已成功應用于射頻封裝、微機電系統(micro-electro-mechanical system, MEMS)封裝領域,將在芯片3D封裝中占據重要地位。
TSV技術和TGV技術的優缺點

玻璃基板在芯片封裝中的應用
1玻璃中介層
玻璃中介層是玻璃基板一種常見應用形式,作為電氣互連層,被廣泛應用于高性能集成電路封裝。玻璃中介層通過TGV技術實現高密度的電氣連接,被認為是有機中介層和硅中介層的有力替代品。
Zhong等將金剛石直接集成到芯片背面,并與玻璃基板進行異質集成,構建了一個高效的散熱系統。該研究采用納米層Cu/Au重結晶的低溫連接技術,將金剛石與硅芯片鍵合,并將此結構封裝到玻璃基板上。玻璃基板作為中介層,其低熱膨脹系數與硅芯片的良好匹配有效減少了熱循環過程中產生的熱應力,同時玻璃基板優異的電氣絕緣性能還可有效降低信號損耗和電氣干擾。
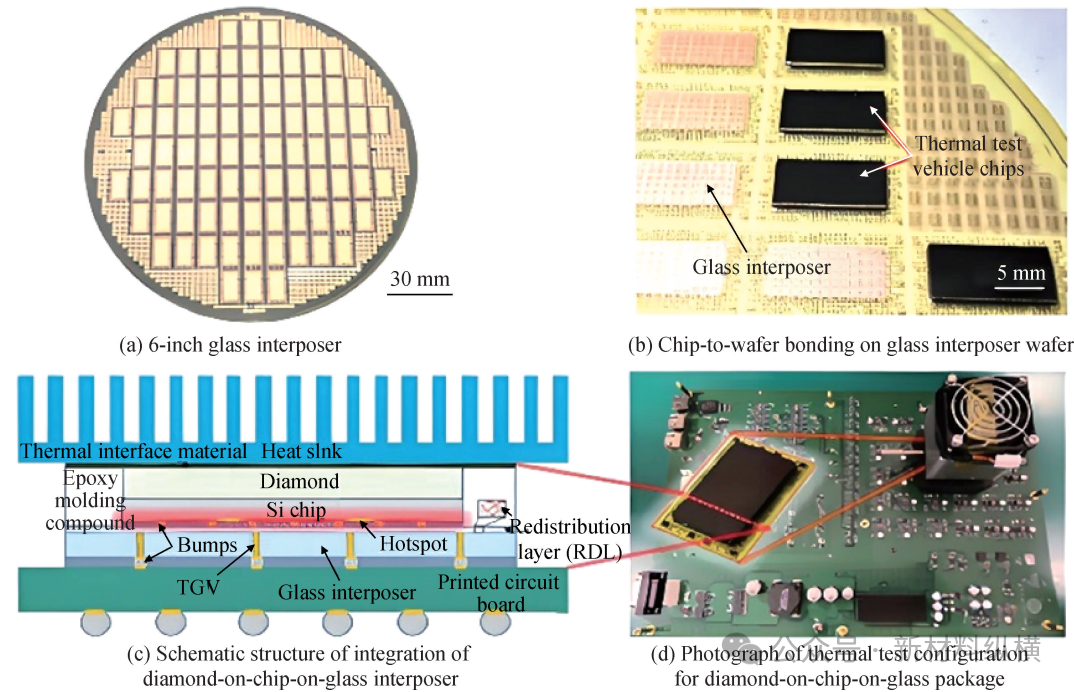
金剛石-芯片-玻璃中介層封裝集成和熱測試
資料來源:ZHONG Y, BAO S C, HE Y M, et al. Heterogeneous integration of diamond-on-chip-on-glass interposer for efficient thermal management[J]. IEEE Electron Device Letters, 2024, 45(3): 448-451.
2扇出型封裝
扇出型封裝是一種先進的半導體封裝技術,通過在芯片周圍重新布線,提高封裝的輸入/輸出引腳數量密度和電性能。玻璃基板在扇出晶圓級封裝和扇出面板級封裝中表現出色,其低熱膨脹系數、高機械強度和優異的電性能使其成為理想選擇。
Liu等提出了一種基于玻璃基板嵌入技術的扇出天線封裝結構,通過在單面或雙面玻璃基板上嵌入再布線層技術來增加設計靈活性和改善天線輻射性能,最終得到了兩種優化的天線設計,一種是具有7.6 GHz帶寬和4.7 dB增益的向上輻射天線;另一種是具有5.3 GHz帶寬和5.2 dB增益的向下輻射天線。玻璃基板在該創新封裝中發揮了關鍵作用,適用于5 毫米波和其他高頻通信應用。
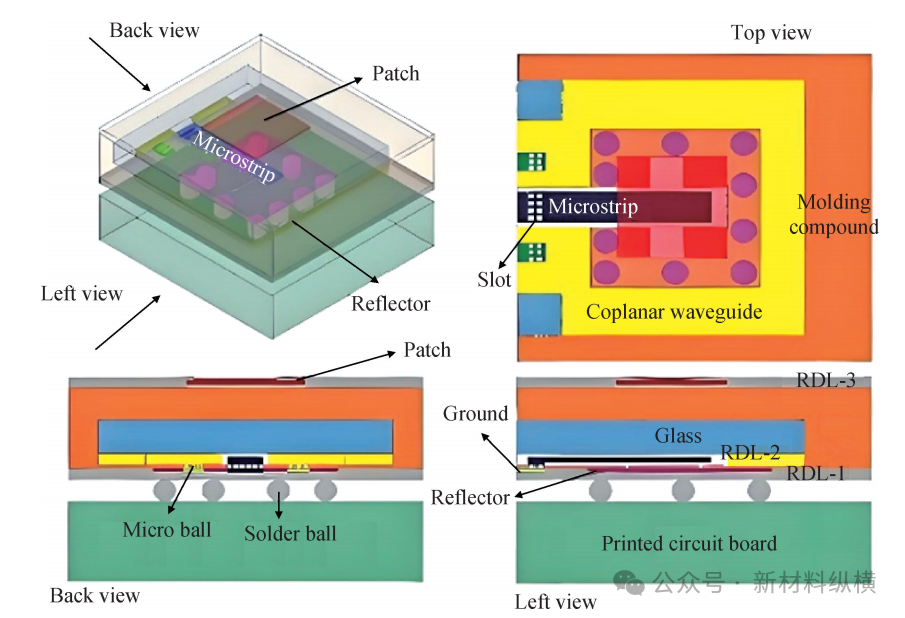
玻璃嵌入式扇出天線封裝結構
資料來源: LIU C H, LU R K, CHUNG H, et al. Glass-embedded fan-out antenna-in-packaging for 5G millimeter wave applications[J]. International Journal of Integrated Engineering, 2022, 14(6): 019.
3微機電系統封裝
微機電系統封裝是確保器件性能和可靠性的關鍵技術。玻璃基板在微機電系統封裝中不僅提供機械保護和電氣絕緣,由于其低熱膨脹系數,還在熱管理方面表現出顯著優勢。
Szyszk等介紹了一種基于MEMS技術的微型四極質譜儀,下圖展示了微型四極質譜儀的模塊布局,其中關鍵部件采用單晶硅制造,并通過硼硅酸鹽玻璃進行封裝和電氣絕緣。該裝置通過3D打印外殼確保機械穩定性、元件對齊和電氣絕緣。這項研究展示了玻璃基板作為電絕緣和結構支撐材料在MEMS器件中的應用,成功實現了小型化、便攜性與合理性能的結合,適用于現場實時分析。
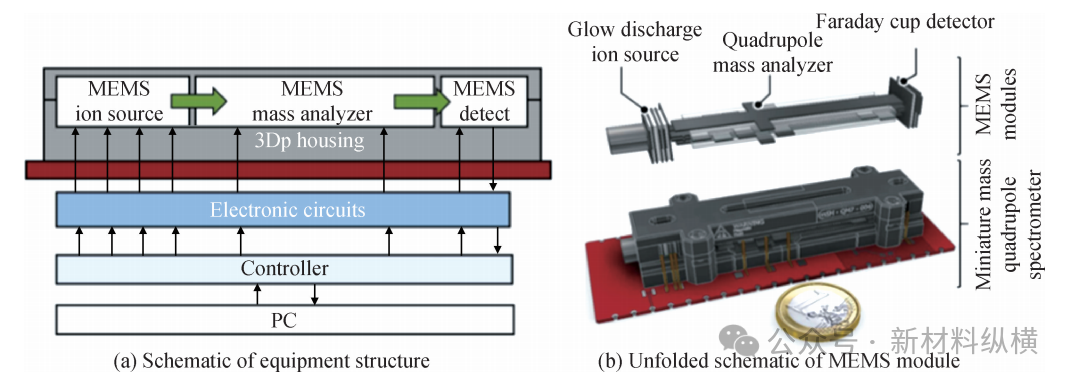
微型四極質譜儀
資料來源: SZYSZKA P, JENDRYKA J, SOBKóW J, et al. MEMS quadrupole mass spectrometer[J]. Sensors and Actuators B: Chemical, 2024, 411: 135712.
玻璃基板成分體系及理化性能要求
1玻璃基板的成分體系
芯片封裝用玻璃基板的成分體系主要包括以下三種主要類型:
1、硼硅酸鹽玻璃體系
硼硅酸鹽玻璃基板通常包含約80%的二氧化硅(SiO?)和12%~13%的氧化硼(B?O?)。這種玻璃體系具有以下特點:
(1)耐熱性好:能夠在高溫環境下保持穩定。
(2)熱膨脹系數低:與硅芯片的熱膨脹系數相匹配,減少了因熱膨脹差異導致的應力和變形。
(3)化學穩定性高:在多種化學環境中表現出良好的耐腐蝕性。
2、鋁硅酸鹽玻璃體系
鋁硅酸鹽玻璃基板主要由二氧化硅(SiO?)和氧化鋁(Al?O?)組成,同時還包含少量的堿金屬氧化物(R?O)和堿土金屬氧化物(RO)。其主要特性包括:
(1)優異的光學性能:適用于需要高透明度的應用場景。
(2)高硬度和低表面張力:能夠抵抗劃傷和磨損,適合高機械強度需求的封裝。
(3)較低的熱膨脹系數:有助于在熱循環過程中保持尺寸穩定。
3、無堿鋁硼硅玻璃體系
無堿鋁硼硅玻璃基板不含或僅含有極少量的堿金屬氧化物(通常質量分數不超過0.1%)。其主要優勢包括:
(1)優異的電絕緣性能:能夠有效防止電信號的干擾和泄漏,特別適合高頻電子器件的封裝。
(2)良好的化學穩定性:在酸、堿和有機溶劑中表現出色,能夠長期保持穩定的物理和化學性能。
(3)高機械強度和低熱膨脹系數:適用于需要高可靠性和尺寸穩定性的微機電系統(MEMS)器件,如加速度計、陀螺儀和壓力傳感器。
2玻璃基板的主要理化性能要求
玻璃基板在芯片封裝中的應用對其理化性能提出了嚴格的要求。這些性能直接影響玻璃基板的加工和使用,進而決定了封裝電子器件的整體綜合性能。
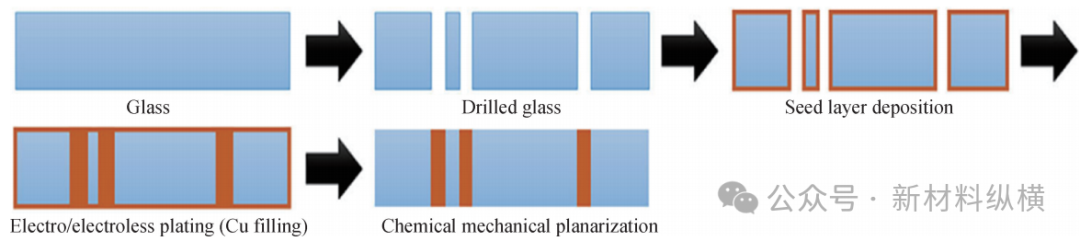
TGV制作工藝過程
玻璃基板理化性能要求

1、介電性能
介電常數:玻璃基板的介電常數應盡可能低,以減少信號延遲和寄生電容,提升高頻信號傳輸的完整性和效率。高頻應用中,低介電常數的玻璃基板更具優勢。
介電損耗:介電損耗正切(tan δ)是衡量材料在電場中能量損失的指標。低介電損耗意味著信號傳輸過程中能量損失少,信號強度和質量更高。
2、熱性能
熱膨脹系數:玻璃基板的熱膨脹系數應與其他封裝材料(如硅芯片)相匹配,以減少熱循環過程中產生的應力和變形。低熱膨脹系數有助于保持封裝結構的尺寸穩定性和可靠性。
熱導率:玻璃基板應具有較高的熱導率,以有效散熱,防止芯片在工作過程中因過熱而損壞。
3、化學性能
耐腐蝕性:玻璃基板應具有良好的耐化學腐蝕性能,特別是在氫氟酸等常用蝕刻劑中的穩定性。這有助于確保玻璃基板在加工和使用過程中的化學穩定性。
化學穩定性:玻璃基板在酸、堿和有機溶劑中應保持穩定的化學性能,以防止材料性能退化。
4、機械性能
密度:玻璃基板的密度應較低,以減輕封裝器件的重量,同時保持足夠的機械強度。
彈性模量:較高的彈性模量能夠確保玻璃基板在封裝過程中保持穩定,減少變形和失效風險。
硬度和耐磨性:高維氏硬度有助于提升玻璃基板的抗劃傷性和耐磨性,延長使用壽命。
斷裂韌性:較高的斷裂韌性能夠防止玻璃基板在受力時出現裂紋,確保封裝的完整性和穩定性。
5、光學性能
透光率:玻璃基板應具有高透光率,以確保光信號的有效傳輸,特別是在光學與電子器件的封裝中。
6、蝕刻性能
蝕刻速率:在玻璃通孔(TGV)加工中,適當的蝕刻速率能夠確保獲得高深寬比、高垂直度的通孔,同時光滑的孔壁能夠降低電阻和電容效應,提升信號傳輸的穩定性和速度。
發展趨勢
(1)優化介電性能
隨著高頻信號傳輸速率不斷提高,進一步降低介電常數和介電損耗的需求愈發迫切。應考慮通過調控玻璃的微觀結構來增強介電性能,從而提高玻璃基板在高頻應用中的表現。
(2)提升機械性能
在頻繁的熱循環和高溫環境下,玻璃基板需要具備更高的機械強度和抗裂性能,以確保長期使用的穩定性。如何通過材料改性或開發新的復合材料體系來增強玻璃基板的韌性和強度,仍是一個重要的技術瓶頸。
(3)改善加工工藝
盡管玻璃通孔(TGV)技術近年來備受關注,但其加工精度和表面質量仍需進一步提升。同時,現有制造工藝的高成本限制了其大規模應用的可行性。因此,優化TGV技術以提高精度并降低成本,已成為當前的關鍵研究方向。
-
集成電路
+關注
關注
5424文章
12048瀏覽量
368382 -
玻璃基板
+關注
關注
1文章
100瀏覽量
10762 -
芯片封裝
+關注
關注
11文章
577瀏覽量
31450 -
三維封裝
+關注
關注
0文章
5瀏覽量
7396
原文標題:玻璃基板在芯片封裝中的應用和性能要求
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 玻璃基板在芯片封裝中的應用
玻璃基板在芯片封裝中的應用

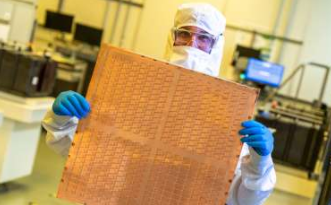
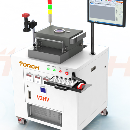
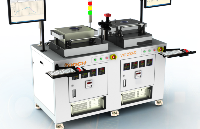

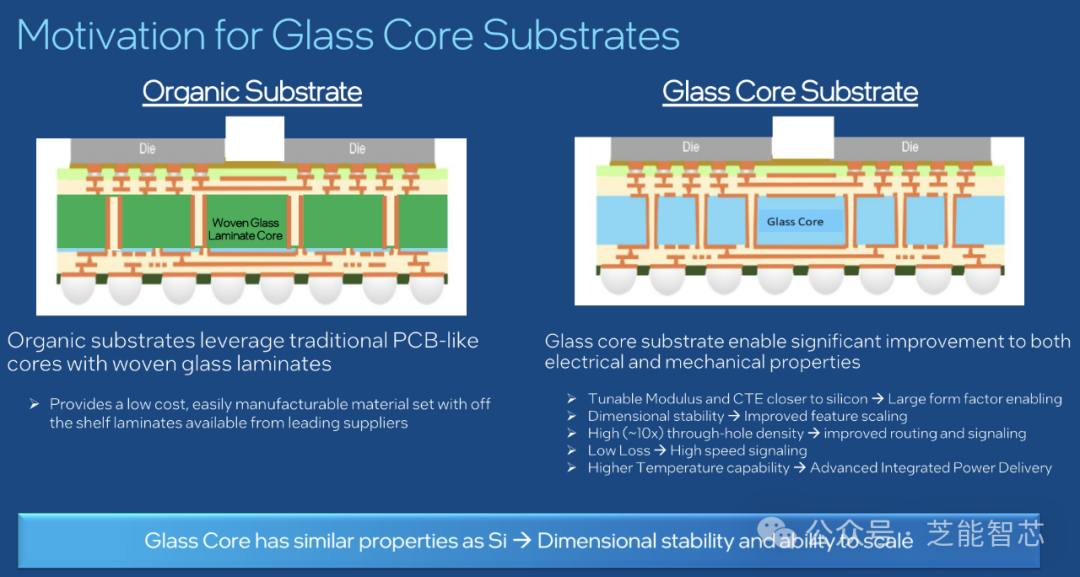














評論