作者: Ernani D. Padilla Emmanuel P. Birog
1.前言
塑封成型工藝是集成電路封裝技術最近幾年取得的一項進步,該技術采用顆粒狀塑封材料封裝芯片,第一道工序是掃描基板上已完成引線鍵合的基板,獲取基板上芯片的總數量,然后按照封裝厚度要求計算所需塑封顆粒材料的數量。
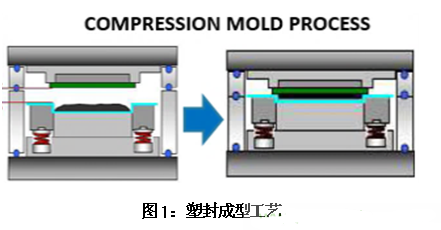
第二步是把模塑顆粒注入到下模具,下模具載體臺面涂有一層脫模劑,將基板引線朝上置于上模具夾具內。下模具抬起合模,把塑封材料壓向基板,達到封裝厚度要求后,下模具停止加壓,如圖1所示。
芯片掃描是塑封成型工藝中最重要的工序,因為這道工序決定了產品封裝的厚度。芯片掃描分為激光掃描和相機掃描兩種類型。激光掃描用于計算大尺寸芯片的數量,而相機掃描用于計算小尺寸芯片的數量。芯片掃描僅覆蓋整個基板的有效區域,但不包括端軌和側軌。圖2所示是實際基板和實際芯片掃描結果。
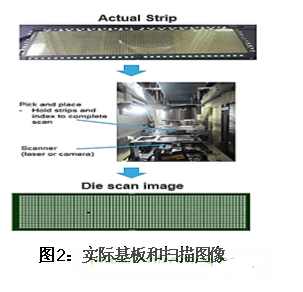
1.1封裝厚度相關問題
芯片掃描方法根據在產品配方中記錄的芯片配置數據,識別產品批次錯誤或配方不正確,防止模具誤操作。如果裝入的產品與產品配方不一致,模具將會發現芯片尺寸不同或芯片垂直高度錯誤。最近推出的新產品的芯片配置數據完全相同,唯一的區別是封裝厚度要求不同,如圖3所示。如果使用封裝厚度高的配方加工封裝厚度低的產品,芯片掃描不會發現錯誤,因為芯片配置相同,反之亦然。
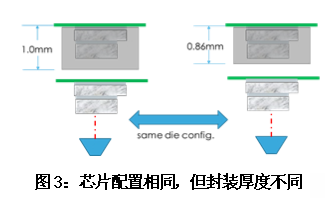
另一個封裝厚度錯誤的問題是裝入產品的引線鍵合存在差異。如果存在錯位芯片,模具壓板平整度將會受到影響,導致塑封材料從壓板四邊縫隙溢出。破損基板的裂縫如果延伸到模具工作區域,將導致塑封材料在合模過程中泄漏,這兩種溢料情況都會導致模塑材料數量減少,無法滿足封裝厚度要求。最壞的情況是,由于封裝很薄,材料不足將導致芯片和引線裸露在封裝外面,如圖4所示。

如何避免錯位芯片和破損基板,改進辦法目前仍在研究中,但是由于模塑材料和多個芯片疊裝工藝都很復雜,改進還有待時日。
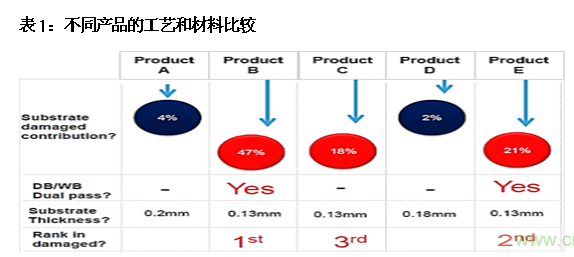
對于基板破損,通過比較不同的產品發現,產品B和E在芯片鍵合和引線鍵合處都有通孔,基板破損發生率最高。多通孔工藝有較高的基板破損風險。對于錯位芯片,只有在上道芯片貼裝工序之后才能處理。在芯片面平整度較低時,可能會發生芯片錯位問題。還值得注意的是,產品A和D的基板較厚,破損率較低。薄基板更容易破損,合模壓力稍大一點就會損壞。下面章節比較表1中不同的產品。
1.2與封裝厚度有關的缺陷率
2018年塑封成型工藝封裝厚度相關缺陷的月均缺陷率為106 ppm,如圖5所示。

模具溢料將會堵塞機臺的真空流道,疏通流道需要停機,抽出阻塞物,這可能會影響生產效率。從2018年停機時間趨勢來看,每月平均停機28個小時,如圖6所示。

1.3目前的模具封裝厚度誤操作控制辦法
當前防止因錯誤程序或裝入錯誤批次而引起的加工錯誤的控制辦法包括在模具上粘貼產品封裝厚度要求,如表2所示。
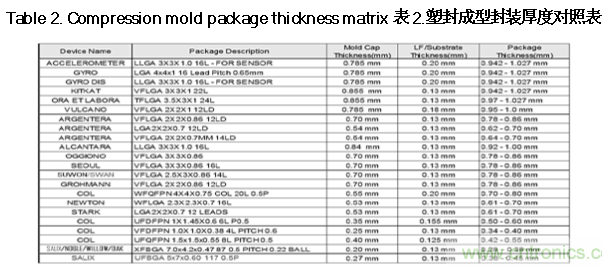
如圖7所示,在每個批次芯片裝入模具之前,檢查每個批次的追溯信息(行程卡)、實際基板和模具配方是否完全一致。
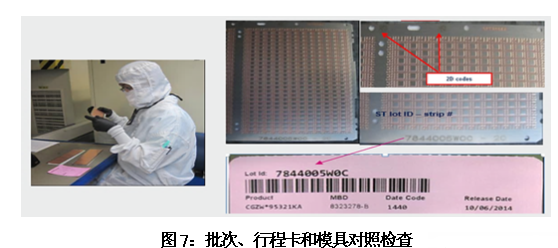
如果某個批次的基板有異常,例如,在上線前發現基板損壞或有錯位芯片,則將圖8所示的標簽貼到該批次基板上,提供可追溯信息,以評估該基板是否可以加工或從不能用于前次模具。

要求操作員使用千分尺測量模壓封裝厚度,從每個批次抽取1塊基板測量,確保不會漏掉封裝厚度錯誤,這是生產操作規范。
1.4在塑封成型中應用人工智能
針對因為配方錯誤或裝入錯誤批次而導致的加工錯誤,芯片掃描范圍被擴大到側軌和端軌,如圖10所示。
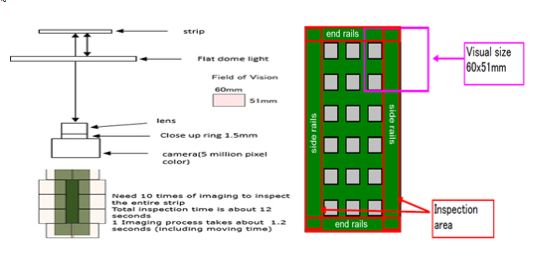
創新的想法是能夠通過光學字符識別(OCR)方法識別基板端軌上的具有唯一性的由字母數字組成的產品材料代碼,然后與所選產品配方中記錄的材料代碼對照檢查。如果成分一致,繼續檢查其余的基板,直到檢查完該批次的所有基板為止;如果不一致,模具將提示錯誤并停機。
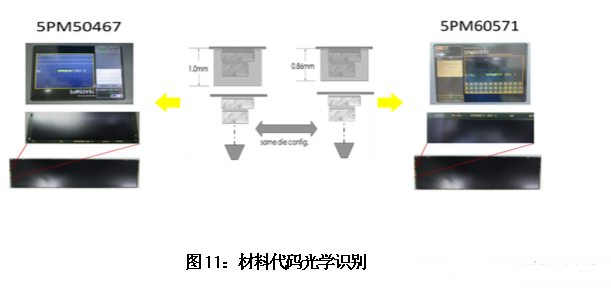
對于損壞的基板或錯位芯片,通過相機或激光掃描側軌和端軌,對比掃描影像與合格產品的影像或輪廓,檢查是否存在異常。如果發現異常,模具將提示發現錯誤并停機。
1.5 相關技術資料概述
為了更好地理解具有唯一性的8位字母數字產品材料代碼放錯識別方法及其關鍵使能技術,本章將簡要介紹各種相關的光學識別技術。光學字符識別是一種前景廣闊的技術,可以將手寫字母或文字轉換為計算機文本。這項技術還是印刷文字數字化常用的一種方法,印刷文字轉換為計算機格式后,可以進行電子編輯、檢索、存儲以及在線顯示。光學字符識別分為多個階段,包括預處理、分類、獲取后處理,前段處理、分段處理、后段處理、特征提取。
1. 多層感知器神經網絡讓光學字符識別成為可能。正常流程是先獲取圖像,然后對其進行預處理和分割。在分割期間,字符被線分開。字符圖像中字符線的列舉對于界定可檢測區間邊界至關重要。分割后的下一步是分離字符,接著時提取特征。為了完成特征提取過程,我們采用了圖像到矩陣映射處理方法,將圖像轉換為2D矩陣。下一步是訓練系統。通過訓練,系統能夠做出高效工作決策,并且在無法預測的環境中產生更好的結果。所提出的系統方案采用多層感知器學習算法。該方法采用金字塔狀結構,這個結構不僅可以用于學習過程,還可以用于分類過程。通過在多層網絡體系結構中應用學習過程算法,突觸權重和閾值可以特定方式更新,使系統執行分類/識別任務的效率更高。突觸權重對于迭代很重要。在迭代過程中,權重被更新為某個整數值。因此,為了識別對象,將其特征數據送入網絡輸入層,生成輸出向量。現在使用這個輸出向量和目標輸出來計算誤差。通過分析所得的輸出值,可以確定字符的識別準確率。該方案識別獨立字符取得91.53%的準確率,成句字符識別準確率達到80.65%。
2. 我們利用模板匹配和反向傳播算法開發出了光學字符識別軟件。模板匹配是最常用的一種光學字符識別技術,主要用于特征提取。因為簡單,容易實現,這項技術很受歡迎。模板匹配又稱關聯。這種方法使用單個字符的像素矩陣提取特征。在測試數據集中使用相關函數R,并將結果存保存在數據庫中。關聯值最高的字符被選為最匹配的字符。反向傳播算法使用反向機制來查找錯誤,并通過向后傳播來減少錯誤。這種方法基于糾錯機制。分組后發現的問題是,存在無法識別的字符,這些無法識別的字符是產生錯誤結果的字符。使用此方法可提高字符識別的正確率。
對于錯位芯片和損壞基板檢測,我們做了相機掃描識別物體的研究,重點研究圖像分辨率增強技術,詳見下文。
3. 有報道稱采用深度神經網絡識別物體取得了非常好的效果,不過,這些方案通常假設,有可用的適合的物體大小和圖像分辨率,這在實際應用中可能無法保證。我們提出的框架是通過圖像增強網絡和對象識別網絡兩個深度神經網絡協作學習,來識別超低分辨率圖像。圖像增強網絡試圖通過使用來自對象識別網絡的協作學習信號,提升分辨率極低圖像的銳度和信息量。針對高分辨率圖像訓練權重的對象識別網絡,積極參與圖像增強網絡的學習過程,還將圖像增強網絡的輸出用作增強學習數據,以提高其超低分辨率圖像的識別性能。通過用各種低分辨率圖像基準數據集做實驗,我們證明了該方法能夠提高圖像重建和分類性能。
在錯位芯片和損壞基板檢測中,我們比較了激光掃描與相機掃描的性能,做了激光掃描在物體檢測中的適用性研究。
4. 低成本3D成像,特別是通過使用激光檢測和測距(LIDAR)成像,對于物體識別、地面測繪和機器視覺等應用非常重要。傳統的飛行時間激光雷達使用掃描激光來獲得目標的光強和距離,這需要窄帶寬的照明光源和高速同步器。無脈沖寬度的3D激光雷達的非掃描產品原型,據我們所知,是業界首次整合單像素成像傳感器和衍射光學元件。壓力感測技術用于測量物體反射的回波脈沖,并重建目標場景的強度圖。衍射光學元件用于提供結構化照明光源,并且可以從激光光斑提取數據,獲得目標場景的深度圖。我們給出了驗證原型識別效果的仿真結果,并例證了在傳統3D成像方法不可用或受限的情況下,使用我們的方案的優越性。這個創新原型在可見光譜以外的波長上具有成本低和結構靈活的優點,并且因為實用而受到高度關注。
2.材料與方法/實驗細節/方法論
2.1材料
我們將使用涵蓋所有可能的情況的產品來驗證芯片掃描軟件升級能否識別配方錯誤和批次誤裝。從封裝厚度要求不同的三種產品中選擇了三個批次,每個批次有20塊基板。產品B和C具有相同的芯片配置,產品A的配置不同于B和C。產品A和C的模套厚度要求相同,而基板厚度不同。具有唯一性的材料代碼是區別不同產品關鍵特征的重要工具,詳見表3。
表3:錯誤配方/批次誤裝評測表
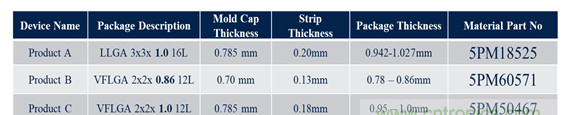
制備有錯位芯片和損傷的芯片基板,模擬模具在芯片掃描過程中能否發現異常。異常位置包括端軌和側軌。對于錯位芯片,使用不同尺寸的芯片測試是否能發現異常。
2.1.1 芯片掃描軟件升級
測試芯片掃描升級軟件能否識別基板端軌上的唯一8位字母數字代碼,如圖12所示。
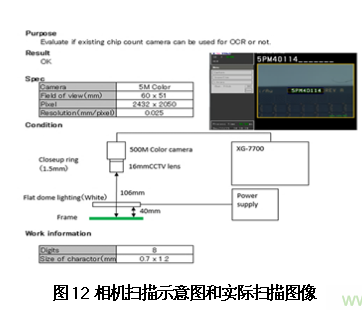
掃描捕獲的信息將與被測產品配方信息對比。如果內容相同,則模具將繼續運行;否則,模具將提升錯誤并停機,如圖13所示。

為了檢測芯片基板上是否有錯位芯片或端軌和側軌是否損壞,我們又開發了基板檢測軟件。這里將使用激光掃描和相機掃描兩種不同的掃描技術測試該軟件的識別能力。
相機掃描是通過比較壞基板與好基板的像素來識別基板是否存在錯位芯片和損壞,如圖14所示。
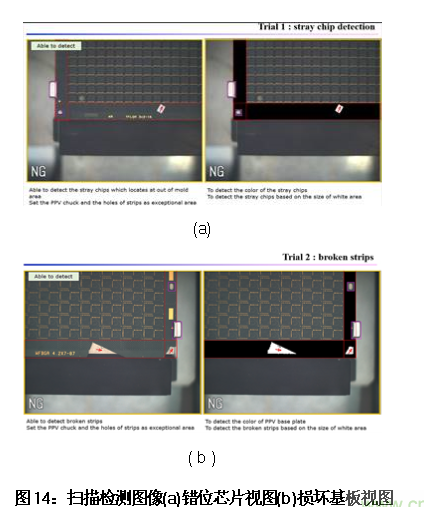
另一種檢測技術是激光掃描,該技術掃描基板表面高度,并將捕獲的圖像與好基板的高度進行對比,如果高度偏差較大或較小,則模具將提示錯誤并停機。測試將使用有錯位芯片和側軌和端軌損壞的基板,如圖15所示。

2.2測試過程
測試目的是比較兩個掃描軟件升級對材料代碼識別和錯位芯片及基板損壞檢測的識別效果。
材料代碼檢測將測試相機能否準確識別不同產品的材料代碼。面臨的挑戰是能否識別所有字母數字的字體大小、樣式和方向。使用20塊基板,隨機插入錯誤材料代碼,板對板測試升級軟件的識別結果是否一致,詳見表4。
表4.材料代碼檢測實驗設計

通過檢測錯位芯片和損壞基板,比較激光掃描和相機掃描的缺陷檢測準確率。使用在端軌和側軌上有不同尺寸和形狀的缺陷的實際基板,測試芯片掃描的準確率;使用不同尺寸的錯位芯片測試掃描靈敏度,如表5所示。
表5.錯位芯片/破損檢測實驗設計

3.1材料代碼識別測試
根據升級軟件檢測每個產品的材料代碼的測試結果,三種測試產品的全部基板的檢測準確率100%。正確和錯誤的物料代碼均被準確識別,如圖16的圖表所示。

測試結果證明,檢測準確率很高,所有被測產品的基板都被正確識別,包括另外10塊材料代碼錯誤的基板。
3.2異常基板識別測試
為了驗證相機掃描和激光掃描哪個方法檢測錯位芯片和損壞基板的效果更好,進行了雙比例檢驗,比較檢測準確度。
對于錯位芯片,使用當次被測產品的兩種不同芯片尺寸進行卡方檢驗,比較激光掃描和相機掃描之間的掃描準確度差異。在置信度為95%,Pvalue值為0.0003時,相機掃描和激光掃描之間的掃描準確度存在顯著差異,如圖17所示。
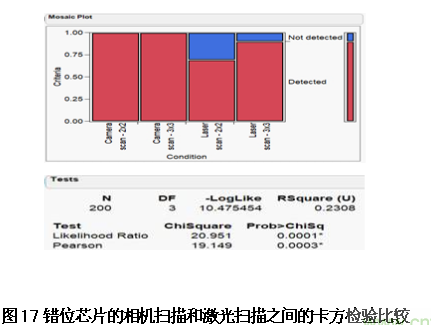
實驗結果證明,即使芯片尺寸很小,相機掃描仍能夠始終如一地發現錯位芯片的存在,因為像素識別對于相機閾值仍然很重要。相反,激光掃描準確度隨著芯片尺寸減小而降低,因為它不能區分由于基板高度和平整度變化而導致的從基板導軌底部向上的高度相對于閾值的的變化。
損壞基板檢測實驗再次使用兩塊損壞特征不同的基板,一塊基板上有缺口,另一塊有裂縫,比較相機掃描和激光掃描的檢測準確度,如圖18所示。在置信度為95%,Pvalue值<0.0001時,相機掃描和激光掃描的識別準確率存在明顯差異。

相機掃描檢測損壞基板的準確率高于激光掃描,同理,錯位芯片檢測也是這種情況。但是,隨著基板損壞的特征從高可見度的缺口變為裂縫時,檢測的準確率也會降低。
3.2 建議
建議進一步開發檢測功能,應對將來兩種產品的材料代碼相同但封裝厚度要求不同的情況。 當前的做法是在基板上雕刻每個產品的附加代碼,包括在產品的8位字母數字識別碼中增加代附加碼。
未來研究方向還可以是評估使用分辨率更高的相機提高檢測準確度,特別是針對損壞基材的裂縫特點和尺寸小于本研究項目所測試的錯位芯片。
應當設法改進錯位芯片和損壞基板兩個問題,因為本項目旨在改進缺陷檢測率,防止殘次產品進入塑封成型工序,預防產品質量問題和故障停機。如果基板不能返工,產品良率仍將會下降。
4. 結論
可以得出這樣的結論,當前芯片掃描相機可以用光學字符識別(OCR)檢測8位字母數字組成的唯一材料代碼,并根據當前所選模具配方的參數發現模具誤裝的產品。
在檢測芯片尺寸、基板缺口方面,相機掃描的準確率高于激光掃描,這是由于激光掃描對基板高度變化過于敏感,難以區分錯位裸片和/或損壞基板。相機掃描不受這些因素影響,而是使用像素數作為檢測參考依據。
編輯:hfy
-
人工智能
+關注
關注
1804文章
48736瀏覽量
246662 -
封裝芯片
+關注
關注
0文章
18瀏覽量
8651
發布評論請先 登錄
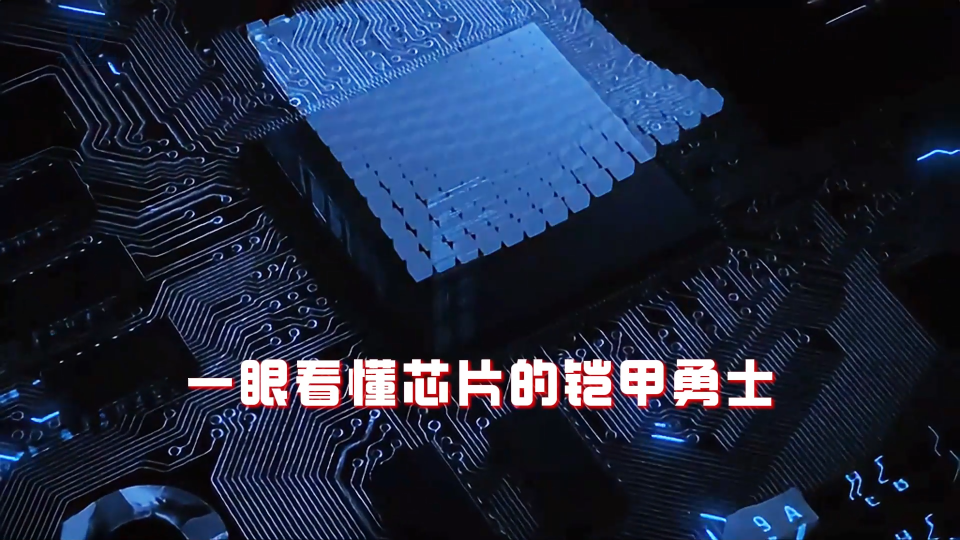
金融界:萬年芯申請基于預真空腔體注塑的芯片塑封專利

聚焦塑封集成電路:焊錫污染如何成為可靠性“絆腳石”?

半導體封裝中的裝片工藝介紹

一文講清芯片封裝中的塑封材料:環氧塑封料(EMC)成分與作用
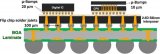
塑封、切筋打彎及封裝散熱工藝設計
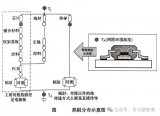
大研智造 解析塑封微攝像頭回流焊濕熱應力失效與激光焊錫機優勢

塑封貼片裝高通流量壓敏電阻(MOV)

芯片制造中的塑封與電鍍






 深度探討采用顆粒狀塑封材料封裝芯片的塑封成型工藝
深度探討采用顆粒狀塑封材料封裝芯片的塑封成型工藝
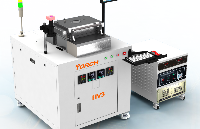













評論