深度反應(yīng)離子刻蝕或DRIE是一種相對(duì)較新的制造技術(shù),已被MEMS社區(qū)廣泛采用。
下面我們來(lái)解讀高縱橫比MEMS制造技術(shù)的4種方法。
1、硅的深度反應(yīng)離子刻蝕
深度反應(yīng)離子刻蝕或DRIE是一種相對(duì)較新的制造技術(shù),已被MEMS社區(qū)廣泛采用。這項(xiàng)技術(shù)可以在硅基板上執(zhí)行非常高的縱橫比蝕刻。蝕刻的孔的側(cè)壁幾乎是垂直的,并且蝕刻深度可以是進(jìn)入硅襯底的數(shù)百甚至數(shù)千微米。
下圖說(shuō)明了如何完成深度反應(yīng)性離子蝕刻。該蝕刻是干式等離子體蝕刻,并使用高密度等離子體來(lái)交替蝕刻硅,并在側(cè)壁上沉積抗蝕刻聚合物層。硅的蝕刻使用SF6化學(xué)方法進(jìn)行,而抗蝕刻聚合物層在側(cè)壁上的沉積則使用C4F8化學(xué)方法。質(zhì)量流控制器在蝕刻期間在這兩種化學(xué)物質(zhì)之間來(lái)回交替。保護(hù)性聚合物層沉積在蝕刻坑的側(cè)壁和底部上,但是蝕刻的各向異性將蝕刻坑底部的聚合物去除的速度比從側(cè)壁去除聚合物的速度快。側(cè)壁不完美或光學(xué)上不光滑,如果在SEM檢查下放大了側(cè)壁,則在側(cè)壁上會(huì)看到典型的搓衣板或扇形花紋。大多數(shù)商用DRIE系統(tǒng)的蝕刻速率為每分鐘1-4微米。DRIE系統(tǒng)是單晶片工具。光刻膠可用作DRIE蝕刻的掩膜層。用光致抗蝕劑和氧化物的選擇性分別為約75∶1和150∶1。對(duì)于晶片穿透蝕刻,將需要相對(duì)較厚的光致抗蝕劑掩模層。蝕刻的長(zhǎng)寬比可以高達(dá)30:1,但實(shí)際上往往為15:1。由于系統(tǒng)中的負(fù)載效應(yīng),工藝配方取決于暴露的硅量,與較小的裸露區(qū)域相比,具有較大的裸露區(qū)域的蝕刻速度要快得多。因此,必須經(jīng)常表征蝕刻的確切掩模特征和深度以獲得理想的結(jié)果。
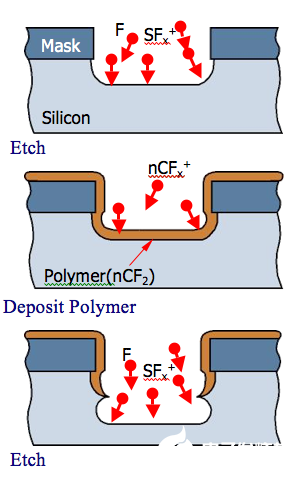
深反應(yīng)離子蝕刻的工作原理圖
下圖是使用DRIE和晶片鍵合制造的MEMS部件的SEM。使用SOI晶片制造該器件,其中,通過(guò)操作晶片執(zhí)行背面蝕刻,停止在掩埋氧化物層上,并且在SOI器件層上執(zhí)行正面DRIE。然后去除掩埋的氧化物以釋放微結(jié)構(gòu),使其自由移動(dòng)。
在SOI晶片上使用雙面DRIE蝕刻技術(shù)制造的MEMS器件的SEM
下圖是使用DRIE技術(shù)制造的硅微結(jié)構(gòu)的截面SEM。可以看出,蝕刻非常深入硅襯底,并且側(cè)壁幾乎是垂直的。
硅晶片橫截面的SEM,展示了可以使用DRIE技術(shù)制造的高縱橫比和深溝槽
2、玻璃的深反應(yīng)離子蝕刻
玻璃基板也可以以高深寬比深蝕刻到材料中,并且該技術(shù)已在MEMS制造中獲得普及。圖10顯示了使用該技術(shù)制成的玻璃結(jié)構(gòu)。高深寬比玻璃蝕刻的典型蝕刻速率為每分鐘250至500nm。取決于光致抗蝕劑的深度,金屬或多晶硅可以用作掩模。
高縱橫比結(jié)構(gòu)的SEM蝕刻到由MNX制造的玻璃基板中
3、利加
另一種流行的高長(zhǎng)徑比微加工技術(shù)稱為L(zhǎng)IGA,這是德國(guó)的縮寫(xiě),意為“LIthographieGalvanoformungAdformung”。這主要是基于非硅的技術(shù),需要使用同步加速器產(chǎn)生的X射線輻射。基本過(guò)程在下圖中概述,并從將X射線輻射敏感的PMMA澆鑄到合適的基材上開(kāi)始。特殊的X射線掩模用于使用X射線選擇性曝光PMMA層。然后開(kāi)發(fā)出PMMA,并將其定義為極其光滑且?guī)缀跬昝来怪钡膫?cè)壁。而且,X射線輻射進(jìn)入PMMA層的穿透深度非常深,并允許通過(guò)非常厚的PMMA層進(jìn)行曝光,最大可達(dá)1mm以上。
LIGA工藝中制造高深寬比MEMS器件的步驟說(shuō)明
發(fā)展之后圖案化的PMMA充當(dāng)聚合物模具,并放置在電鍍?cè)≈校⑶覍㈡囯婂兊絇MMA的開(kāi)放區(qū)域中。然后去除PMMA,從而保留金屬微結(jié)構(gòu)。
采用LIGA技術(shù)制成的高長(zhǎng)寬比高的齒輪
由于LIGA需要特殊的掩模和同步輻射(X射線)輻射源進(jìn)行曝光,因此此過(guò)程的成本相對(duì)較高。降低此過(guò)程制成的微加工零件成本的一種方法變型是將制造的金屬零件(步驟5)重新用作工具插件,以將工具的形狀壓印到聚合物層中(步驟3),然后將金屬電鍍到聚合物模具中(步驟4)并移除聚合物模具(步驟5)。顯然,此步驟順序使每次制造零件時(shí)都不需要同步輻射源,從而顯著降低了工藝成本。該過(guò)程的尺寸控制非常好,并且在刀片磨損之前可以多次使用。
4、熱壓花
在聚合物材料中復(fù)制深高縱橫比結(jié)構(gòu)的過(guò)程是,使用LIGA或類似技術(shù)制造金屬工具嵌件,然后將工具嵌件圖案壓印到聚合物基材中,然后將其用作零件。使用適當(dāng)?shù)闹圃旆椒ǎㄒ院谏幱熬€表示)將倒模制成模具嵌件。將模具插件放入熱壓花系統(tǒng)中,該系統(tǒng)包括一個(gè)可在其中抽真空的腔室。將基材和聚合物加熱到聚合物材料的玻璃化轉(zhuǎn)變溫度Tg以上,并將模具插件壓入聚合物基材中。真空對(duì)于聚合物如實(shí)地復(fù)制模具嵌件中的特征至關(guān)重要,因?yàn)榉駝t空氣會(huì)被截留在兩個(gè)表面之間,從而導(dǎo)致特征變形。
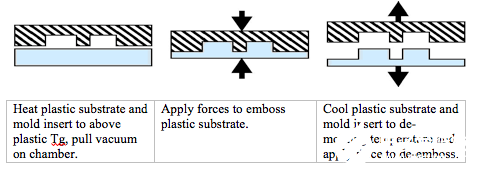
創(chuàng)建微型設(shè)備的熱壓花過(guò)程示意圖。(由CNRI的MNX提供)
使用過(guò)程中熱壓花平臺(tái)的照片
隨后,將基板冷卻至聚合物材料的玻璃化轉(zhuǎn)變溫度以下,并施加力以使基板脫模。如圖15所示,熱壓花可以成功地復(fù)制復(fù)雜的,深的和高長(zhǎng)寬比的特征。通過(guò)非常好的尺寸控制,此過(guò)程可以將印記壓印到數(shù)百微米深的聚合物中。該方法的優(yōu)點(diǎn)是,與使用其他技術(shù)制造的相同結(jié)構(gòu)相比,單個(gè)聚合物部件的成本可以非常低。由于壓倒性的成本優(yōu)勢(shì)和出色的性能,
將塑料基板和模具插件加熱到塑料Tg上方,在腔室上抽真空。施加力以壓花塑料基材。冷卻塑料基板和模具插件以達(dá)到脫模溫度,并施加力進(jìn)行脫模。
下圖在MNX上使用熱壓印技術(shù)在塑料基板上制成的各種小型測(cè)試結(jié)構(gòu)的SEM。塑料微結(jié)構(gòu)的高度接近300微米,最小的特征直徑約為25微米。
自新型冠狀病毒肺炎疫情爆發(fā)以來(lái),傳感器專家網(wǎng)一直密切關(guān)注疫情進(jìn)展,根據(jù)國(guó)家及地方政府的最新調(diào)控與安排,為更好的服務(wù)相關(guān)企業(yè),在疫情期間,傳感器專家網(wǎng)免費(fèi)發(fā)布企業(yè)相關(guān)文章,免費(fèi)成為傳感器專家網(wǎng)認(rèn)證作者,請(qǐng)點(diǎn)擊認(rèn)證,大家同心協(xié)力,抗擊疫情,為早日打贏這場(chǎng)防控攻堅(jiān)戰(zhàn)貢獻(xiàn)自己的一份力量。
-
mems
+關(guān)注
關(guān)注
129文章
4155瀏覽量
194206 -
SOI
+關(guān)注
關(guān)注
4文章
78瀏覽量
17999
發(fā)布評(píng)論請(qǐng)先 登錄
智慧工廠核心技術(shù),縱橫智控?cái)?shù)據(jù)采集與遠(yuǎn)程監(jiān)控解決方案

ADGM1004帶集成驅(qū)動(dòng)器的0 Hz至13 GHz、2.5kV HBM ESD SP4T MEMS開(kāi)關(guān)技術(shù)手冊(cè)

ADGM1144 0 Hz/DC至18 GHz、SP4T、MEMS開(kāi)關(guān)技術(shù)手冊(cè)
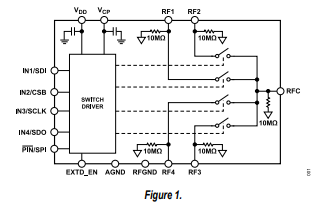
從晶圓到芯片:MEMS傳感器是這樣被制造出來(lái)的!(20+高清大圖)
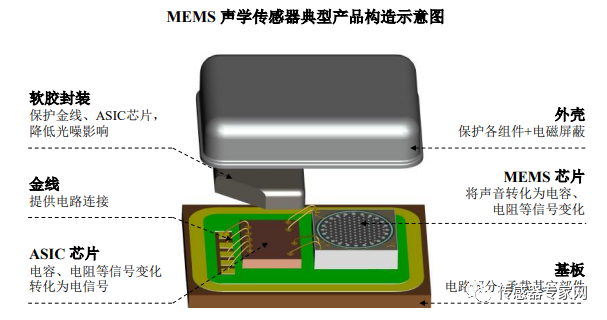
博世正式發(fā)布全新駕駛輔助品牌—博世縱橫輔助駕駛及其產(chǎn)品矩陣

午芯芯科技國(guó)產(chǎn)電容式MEMS壓力傳感器芯片突破卡脖子技術(shù)

2025電子設(shè)計(jì)與制造技術(shù)研討會(huì)
用平面錐制造100μm深10μm寬的高縱橫比硅通孔

海譜納米首次實(shí)現(xiàn)基于MEMS技術(shù)的短波紅外高光譜相機(jī)的量產(chǎn)

MEMS傳感器:微制造革命的藝術(shù)與科技交響

激光微納制造技術(shù)
AMEYA360:士蘭微“MEMS器件及其制造方法”專利獲授權(quán)
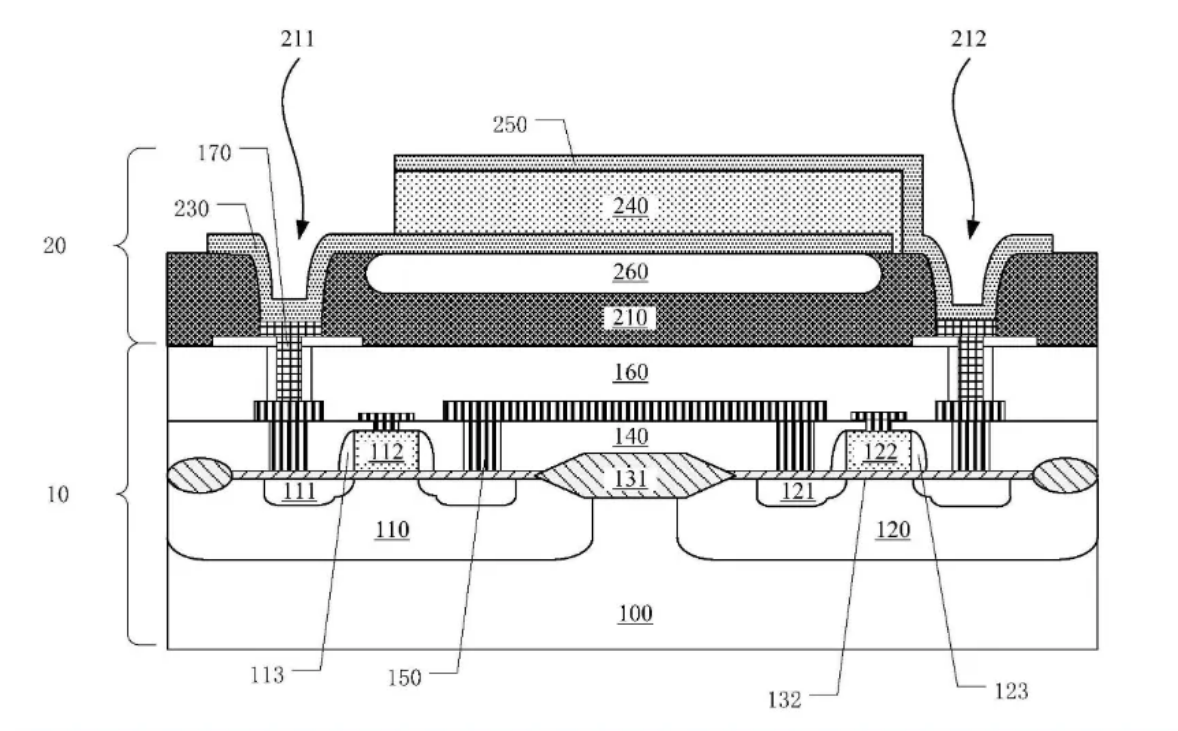
你可能看不懂的硬核傳感器知識(shí):MEMS芯片制造工藝流程
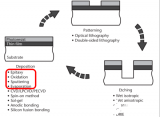





 4種高縱橫比MEMS制造技術(shù)詳解
4種高縱橫比MEMS制造技術(shù)詳解












評(píng)論