經(jīng)常聽說(shuō),高端光刻機(jī)不僅昂貴而且還都是國(guó)外的,那么什么是光刻機(jī)呢?上篇我們聊了從原材料到拋光晶片的制成過(guò)程,今天我們就來(lái)聊聊什么是光刻~
第一步驟的晶體生長(zhǎng)機(jī)晶片的制造,我們上篇已經(jīng)聊過(guò)了。今天我們要聊的是光刻,我們先簡(jiǎn)單聊一聊硅的氧化(熱氧化),刻蝕的話我們后面再講。
硅的氧化
其中包含了在分立器件和集成電路制造過(guò)程中遇到的四類薄膜:熱氧化膜、電介質(zhì)膜、多晶硅膜及金屬膜。圖中,柵氧化層和場(chǎng)氧化層都是采用熱氧化的方法生成,因?yàn)橹挥袩嵫趸軌蛱峁┳畹徒缑嫦葳迕芏鹊母哔|(zhì)量氧化層。
熱氧化
半導(dǎo)體的氧化有很多方法,比如熱氧化法、電化學(xué)陽(yáng)極氧化法和等離子化學(xué)汽相淀積法。當(dāng)中,熱氧化法是硅基器件制造中最常見(jiàn)也是最重要的方法和關(guān)鍵工藝。
組成包括:一個(gè)電阻加熱氧化爐,一個(gè)圓筒型熔融石英管。開槽的石英舟放在石英管中,石英槽用來(lái)垂直擺放硅片,一個(gè)注入口用來(lái)注入高純度干燥氧氣或者高純水蒸氣(即干氧氧化法和濕氧氧化:兩者反應(yīng)方程式不一樣,干氧氧化生成的氧化層電性能較好,但是生成速度會(huì)比濕氧氧化要慢。所以,相對(duì)較薄的氧化層我們一般采用干氧氧化;相對(duì)較厚的則采用濕氧氧化)。
氧化溫度一般維持在 900~1200℃。其中,需要控制溫度從低溫線性上升到氧化所需的溫度,避免溫度的突變帶來(lái)硅片發(fā)生形變的風(fēng)險(xiǎn),同時(shí)氧化過(guò)程中需要講溫度維持在一定的范圍,氧化完成后也要線性地降低溫度。
由熱氧化法生成的二氧化硅是一個(gè)正四面體結(jié)構(gòu)。硅原子位于四面體的中心位置,四個(gè)氧原子分別位于四面體的四個(gè)頂點(diǎn)。并且此類二氧化硅屬于非結(jié)晶結(jié)構(gòu),密度較低,會(huì)使各種雜質(zhì)進(jìn)入并容易擴(kuò)散到整個(gè)氧化硅層。
在熱氧化過(guò)程中,硅表面附近的雜質(zhì)濃度會(huì)形成再分布。我們把硅中雜質(zhì)平衡密度和二氧化硅中的雜質(zhì)平衡密度的比值稱為分凝系數(shù) k。二氧化硅中摻雜雜質(zhì)的再分布很少具有電活性,但是硅中的摻雜雜質(zhì)的再分布在氧化過(guò)程和器件制造過(guò)程中卻起著重要作用。
SiO2 的掩模特性
二氧化硅層可以在溫度上升時(shí)對(duì)雜質(zhì)擴(kuò)散提供掩模作用。不論是雜質(zhì)的預(yù)淀積,或者是離子注入、化學(xué)擴(kuò)散等技術(shù),一般都會(huì)導(dǎo)致在氧化物表面或者附近生成摻雜雜質(zhì)源。在隨后的高溫工藝步驟中,在氧化掩模區(qū)域中的擴(kuò)散必須足夠的慢,以阻止摻雜雜質(zhì)通過(guò)氧化掩模層向硅的表面擴(kuò)散。氧化掩模層的厚度一般通過(guò)實(shí)驗(yàn)測(cè)試的方法來(lái)獲得,主要是在特定的溫度和時(shí)間下,不能使低摻雜的硅襯底發(fā)生反型(典型的氧化掩模層厚度在 0.5um~1um)。總之,二氧化硅是高質(zhì)量的絕緣材料,在硅片上可以通過(guò)熱生長(zhǎng)的方法形成二氧化硅層,它可以在雜質(zhì)注入和擴(kuò)散中作為阻擋層。
目前,針對(duì) 45 納米以下的高端光刻機(jī)市場(chǎng),荷蘭 ASML 市場(chǎng)占有率達(dá)到 80%,同時(shí) ASML 可以說(shuō)是唯一一家有能力提供 7 納米的光刻機(jī)廠商。國(guó)內(nèi)光刻機(jī)的研究目前還屬于提高階段,去年中國(guó)科學(xué)院光電技術(shù)研究所推出了 22 納米的光刻機(jī),大大推動(dòng)了國(guó)產(chǎn)光刻機(jī)的發(fā)展。那么接下來(lái)帶大家來(lái)了解什么是所謂的光刻?
光刻
光刻,就是講掩膜上的幾何圖形轉(zhuǎn)移到涂在半導(dǎo)體晶片表面的敏光薄層材料(也就是我們說(shuō)的光刻膠)上的工藝。這些幾何圖形確定了集成電路中的各種區(qū)域,比如離子注入?yún)^(qū),接觸窗口和引線鍵合區(qū)等等。但是由光刻工藝造成的光刻膠上的圖形只是電路圖形的印模,為了產(chǎn)生電路圖形,我們還需要再一次將光刻膠上的圖形轉(zhuǎn)移到光刻膠下面的各層當(dāng)中去,這一過(guò)程也就是我們所說(shuō)的刻蝕。
今天我們主要聊聊光刻的以下幾個(gè)部分:曝光裝置、掩模、光刻膠以及結(jié)語(yǔ)。
曝光裝置
圖形的轉(zhuǎn)移主要是通過(guò)曝光設(shè)備來(lái)完成的。而曝光設(shè)備的性能主要取決于三個(gè)部分:分辨率、對(duì)準(zhǔn)精度和生產(chǎn)效率。分辨率指的是能夠精確轉(zhuǎn)移到半導(dǎo)體表面光刻膠上的最小特征尺寸值;對(duì)準(zhǔn)精度指的是各個(gè)掩模和先前可在硅片上的圖形互相套準(zhǔn)的準(zhǔn)確度;生產(chǎn)效率指的是掩模在固定時(shí)間內(nèi)所能曝光的硅片數(shù)量。以上三點(diǎn)是衡量曝光設(shè)備性能的主要參數(shù)。
基本的曝光方法分為兩種:遮蔽式和投影式。
遮蔽式曝光:
遮蔽式又可以根據(jù)掩模和硅片之間的距離分為接觸式曝光和接近式曝光兩種。接觸式曝光中,當(dāng)掩模和硅片接觸時(shí),硅片上的灰塵粒子或者硅渣會(huì)嵌入到掩膜中,對(duì)掩模造成永久性的損傷,在后續(xù)使用中會(huì)造成曝光的每個(gè)硅片上都會(huì)留下缺陷。
避免上述的弊端,可以采樣接近式曝光,即掩模和硅片之間留有一個(gè)小的間隙,通常在 10~50um。但是這樣的壞處會(huì)分辨率相應(yīng)地降低。
投影式曝光:
為了遮蔽式曝光的一些弊端,出現(xiàn)了所謂的投影式曝光法。把掩模上的圖形投影到涂有光刻膠的硅片上,為了提高分辨率,每次只曝光掩模的一小部分,然后用掃描或者分步重復(fù)的方法將整個(gè)掩模曝光到硅片上。
由于每次曝光一小部分,可以將掩模圖案進(jìn)行縮小投影到硅片上,縮小倍數(shù)取決于使用的透鏡和掩模的能力。這樣的投影曝光可以在不重新設(shè)計(jì)透鏡的前提下曝光更大的晶片。
掩模
制作掩模類似于我們制作 PCB,首先利用繪制軟件完整地繪制出具有電學(xué)功能的電路圖形,然后利用電子束光刻系統(tǒng)將圖形直接轉(zhuǎn)移到對(duì)電子束敏感的掩模上。掩模由鍍鉻玻璃板組成,電路圖形首先被轉(zhuǎn)移到對(duì)電子束敏感的掩模上,然后再被轉(zhuǎn)移到下面的鍍鉻層上,得到最終的掩模。對(duì)于集成電路的制造一般會(huì)分為若干個(gè)掩模層,例如隔離區(qū)一層,柵極區(qū)一層等,可能多大幾十層。掩模的一個(gè)重要指標(biāo)是缺陷密度。在制作掩模的過(guò)程中或者在以后的圖像曝光過(guò)程中,都會(huì)給掩膜帶來(lái)缺陷。這樣的話便會(huì)影響到器件的成品率。
光刻膠
光刻膠又稱為抗蝕劑,是一種對(duì)輻照敏感的化合物,根據(jù)其輻照的響應(yīng)特性我們分為正性和負(fù)性。正膠由三種成分組成:感光劑、樹脂基片和有機(jī)溶劑。在曝光前,感光劑是不溶于顯影液的,曝光后,曝光區(qū)內(nèi)的感光劑由于吸收了光照能量而導(dǎo)致其化學(xué)結(jié)構(gòu)發(fā)生變化,在顯影液中變得可以溶解。顯影后,曝光區(qū)內(nèi)的光刻膠被去掉。
負(fù)膠是一種含有感光劑的聚合物。曝光后,感光劑吸收光照能量并轉(zhuǎn)變?yōu)榛瘜W(xué)能而引起鏈反應(yīng),使得聚合物分子間發(fā)生交聯(lián)。交聯(lián)聚合物具有較高的分子量而變得不溶于顯影液。經(jīng)過(guò)顯影后,未曝光得部分被溶解。負(fù)膠得一個(gè)主要缺點(diǎn)是在顯影時(shí)光刻膠會(huì)吸收顯影液溶劑而膨脹,從而限制了負(fù)膠得分辨率。
結(jié)語(yǔ)
隨著集成電路集成度越來(lái)越高,尺寸越來(lái)越小(亞微米級(jí)到納米級(jí)),光刻設(shè)備和光刻工藝也在不斷地提高。更高的分辨率、更深的聚焦深度以及更大的曝光范圍一直面臨著不同的挑戰(zhàn)。通過(guò)縮短曝光裝置的波長(zhǎng)、開發(fā)新型的光刻膠,發(fā)展掩模的性能(一種增強(qiáng)分辨率的相移掩模 PSM),多種曝光方法(比如電子束曝光、X 射線曝光、離子束曝光和超紫外線(我們說(shuō)地 EUV)曝光)等等手段來(lái)提升光刻工藝。光刻在半導(dǎo)體發(fā)展中的重要性也日益顯著,但迫于難度也是使得其出現(xiàn)部分壟斷,也造就了我們這樣一個(gè)執(zhí)著攻堅(jiān)的國(guó)家,雖然前路艱難,但是未來(lái)仍可期!
責(zé)任編輯:wv
-
集成電路
+關(guān)注
關(guān)注
5418文章
11942瀏覽量
367066 -
光刻
+關(guān)注
關(guān)注
8文章
337瀏覽量
30585
發(fā)布評(píng)論請(qǐng)先 登錄
光刻膠剝離液及其制備方法及白光干涉儀在光刻圖形的測(cè)量

電子直寫光刻機(jī)駐極體圓筒聚焦電極
光刻圖形轉(zhuǎn)化軟件免費(fèi)試用
芯片制造:光刻工藝原理與流程

光刻機(jī)的分類與原理

光刻掩膜技術(shù)介紹
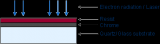
用來(lái)提高光刻機(jī)分辨率的浸潤(rùn)式光刻技術(shù)介紹

一文看懂光刻膠的堅(jiān)膜工藝及物理特性和常見(jiàn)光刻膠
光刻掩膜和光刻模具的關(guān)系
光刻掩膜版制作流程
光刻工藝的基本知識(shí)

光刻膠的硬烘烤技術(shù)






 什么是光刻
什么是光刻











評(píng)論