本技術簡介討論了IC封裝的熱設計技術,例如QFN,DFN和MLP,它們包含一個裸露的散熱墊。
大多數設計人員現在都非常熟悉集成 - 除了元件的電源,接地和信號連接外,還包含“裸露焊盤”或“散熱焊盤”的電路封裝。這些導熱墊與各種封裝縮寫相關聯 - QFN(四方扁平無引腳),DFN(雙扁平無引線),MLF(微引線框架),MLP(微引線框封裝)和LLP(無引線引線框封裝) ,僅舉幾例。
以下是一個例子:ADI公司的LFCSP(引腳架構芯片級封裝)音頻功率放大器(部件號SSM2211):
熱墊組件的一個主要優點是,不足為奇的是,提高了熱性能。
包裝內部是半導體芯片,該芯片包含在工作期間產生熱量的電路。在模具下面(并連接到它)是導熱墊;熱量可以很容易地從芯片流到導熱墊,因此芯片可以在不超過最大結溫的情況下耗散更多功率 - 當然,假設PCB設計人員確保熱量可以很容易地從導熱墊流到周圍環境環境。
QFN封裝的正確熱設計通常基于在PCB焊接到導熱墊的部分中使用過孔。如果您有足夠的可用電路板空間,則更簡單的方法是使用大型銅區域,其中包括與導熱墊的連接。不幸的是,這只適用于雙行包:

當你的組件有所有四個端子(通常情況下),您唯一的選擇是過孔。 (順便說一句,端子最好稱為“焊盤”,因為封裝底部的扁平裸露金屬不能精確地描述為引腳或引線。)過孔將熱量從導熱墊傳導到其他PCB層,從那里到周圍的環境。但是出現了一些問題:
有多少個過孔?
通孔間距應該是多少?
我如何確保過孔不會干擾焊接過程嗎?
過孔的數量當然取決于導熱墊的尺寸以及您對熱傳遞的關注程度。如果您預計沒有高溫應力且沒有顯著的功耗,您可以完全忘記過孔并假設典型的封裝到環境熱路徑就足夠了。但在大多數情況下,過孔是有幫助的;如果您的操作功率高于最初預期,它們就是保險,它們可以通過保持零件的內部溫度更穩定來幫助提高性能。
專家們的共識似乎如下:過孔應該是間距為中心距約1.2 mm,通孔直徑為0.25至0.33 mm。
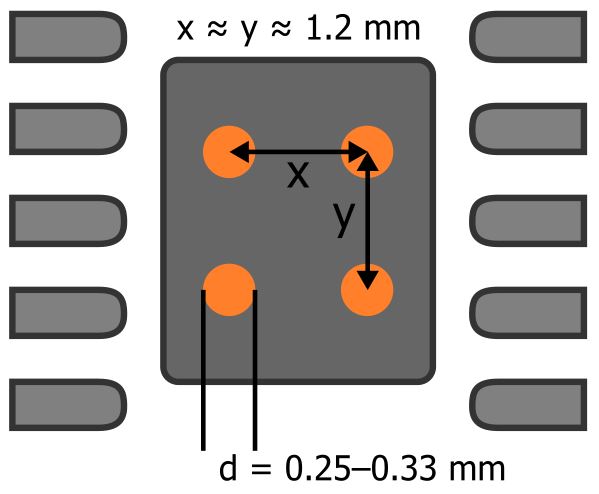
如果想要最大限度地提高散熱性能,過孔的數量就會成為幾何問題 - 也就是說,在保持建議的尺寸和間距的同時,您可以選擇多少過孔。
否QFN布局的討論將是完整的,不會出現焊料芯吸問題。毛細管作用將熔化的焊料吸入通孔,可能會使元件焊料不足或在PCB的另一側產生焊料凸點。
您可以通過使用最小的推薦通孔尺寸來緩解問題,但是真正的解決方案是改變通孔本身,以阻止焊料流動。這里的選項,以提高性能(以及因此成本)的順序,是帳篷,封蓋/堵塞和填充。與PCB工廠的對話可以幫助您確定哪種方法最適合您的應用。
-
IC封裝
+關注
關注
4文章
187瀏覽量
27119 -
熱設計
+關注
關注
11文章
132瀏覽量
26912
發布評論請先 登錄
帶你一文了解芯片開封技術
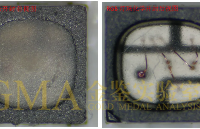
GaNPX?和PDFN封裝器件的熱設計
一文了解玻璃通孔(TGV)技術
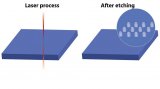
一文解析多芯片封裝技術
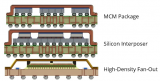
帶你一文了解什么是引線鍵合(WireBonding)技術?

什么是IC封裝?






 一文了解IC封裝的熱設計技術
一文了解IC封裝的熱設計技術

















評論