在本文中,我們?cè)敿?xì)研究了AlGaN的濕法刻蝕特性。特別地,我們研究了m面刻面形成和AlN摩爾分?jǐn)?shù)對(duì)蝕刻速率的依賴關(guān)系。我們還研究了氮化鋁摩爾分?jǐn)?shù)差異較大的紫外發(fā)光二極管結(jié)構(gòu)的濕法刻蝕特性。
2021-12-13 14:58:12 1270
1270 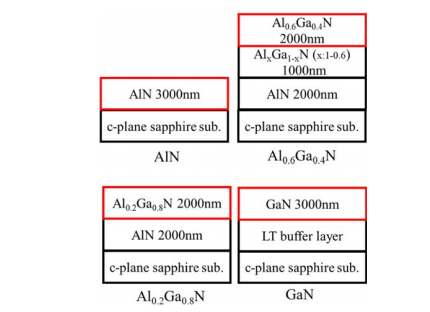
引言 橢偏光譜(SE)、原子力顯微鏡(AFM)、X射線光電子能譜(XPS)、潤(rùn)濕性和光致發(fā)光(PL)測(cè)量研究了HF水 溶液中化學(xué)清洗的GaP(OOl)表面。SE數(shù)據(jù)清楚地表明,溶液在浸入樣品后(W1
2021-12-22 17:30:40 1612
1612 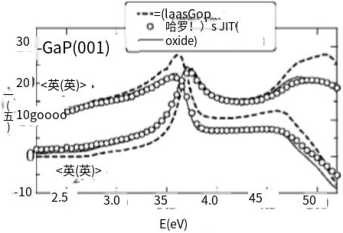
引言 用多能氬離子輻照x射線切割鈮酸鋰單晶,產(chǎn)生厚度為400納米的均勻損傷表面層,研究其在HF水溶液中的腐蝕行為。使用不同的酸溫度和濃度,表明可以通過將溫度從24℃提高到55℃來提高蝕刻速率,同時(shí)
2021-12-23 16:36:59 1300
1300 引言 化學(xué)蝕刻是通過與強(qiáng)化學(xué)溶液接觸來控制工件材料的溶解。該過程可以應(yīng)用于任何材料。銅是利用化學(xué)腐蝕工藝制造微電子元件、微工程結(jié)構(gòu)和精密零件中廣泛使用的工程材料之一。在這項(xiàng)研究中,銅在50℃用兩種
2021-12-29 13:21:46 2087
2087 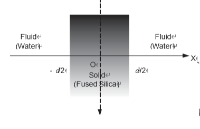
摘要 在印刷和蝕刻生產(chǎn)厚金屬膜中的精密圖案時(shí),需要對(duì)化學(xué)蝕刻劑有基本的了解,以實(shí)現(xiàn)工藝優(yōu)化和工藝控制。 為了蝕刻純鋁電路,研究了正磷酸、多磷酸和氯化鐵的配方。 研究的目的是確定蝕刻速率和圖案定義對(duì)正
2022-01-07 15:07:48 1129
1129 
摘要 我們?nèi)A林科納研究了正磷酸、聚磷酸、和鐵(III)氯化物蝕刻劑對(duì)工藝條件變化的敏感性,以確定該蝕刻劑系統(tǒng)在純鋁電路光刻制造中的潛在生產(chǎn)應(yīng)用。溫度變化、正磷酸濃度、多磷酸濃度的影響。檢測(cè)了酸濃度
2022-01-07 15:40:12 1194
1194 
被劃分為與晶體表面的不同狀態(tài)和各種蝕刻機(jī)制相對(duì)應(yīng)的部分。蝕刻后的晶體表面的形狀與同一溶液中沿同一方向蝕刻的凹槽的輪廓密切相關(guān)。 介紹 本文研究(100)砷化鎵在硫酸、過氧化氫和水溶液中的化學(xué)蝕刻具有重要的技術(shù)和科學(xué)意義。該解決方案通常用于
2022-01-25 10:32:24 2215
2215 
是該晶格中唯一光滑的面,其他面可能只是因?yàn)楸砻嬷亟ǘ枪饣摹Mㄟ^這種方式,我們解釋了在001方向上KOH:H20中的最小值。實(shí)驗(yàn)對(duì)HF:HN03溶液中接近001的最小蝕刻率的形狀和從各向同異性向各向異性蝕刻的過渡進(jìn)行了兩個(gè)關(guān)鍵預(yù)測(cè)。
2022-01-25 13:51:11 1721
1721 
硅的各向異性蝕刻是指定向依賴的蝕刻,通常通過堿性蝕刻劑如水溶液氫氧化鉀,TMAH和其他羥化物如氫氧化鈉。由于蝕刻速率對(duì)晶體取向、蝕刻劑濃度和溫度的強(qiáng)烈依賴性,可以以高度可控和可重復(fù)的方式制備多種
2022-03-08 14:07:25 1768
1768 
在本研究中,我們?cè)O(shè)計(jì)了一個(gè)150mm晶片的濕蝕刻槽來防止硅片的背面蝕刻,并演示了優(yōu)化的工藝配方,使各向異性濕蝕刻的背面沒有任何損傷,我們還提出了300mm晶圓處理用濕浴槽的設(shè)計(jì),作為一種很有前途的工藝發(fā)展。
2022-03-28 11:01:49 1943
1943 
本文研究了氫氧化鉀、TMAH(C6H4(OH)2)溶液中氫氧化銨(四甲基銨)和EDP(乙烯二胺(NH2(CH2)2NH2)的濃度和溫度對(duì)硅表面的影響,制作了光滑的垂直墻和懸吊梳式結(jié)構(gòu)。
2022-04-26 14:08:17 2514
2514 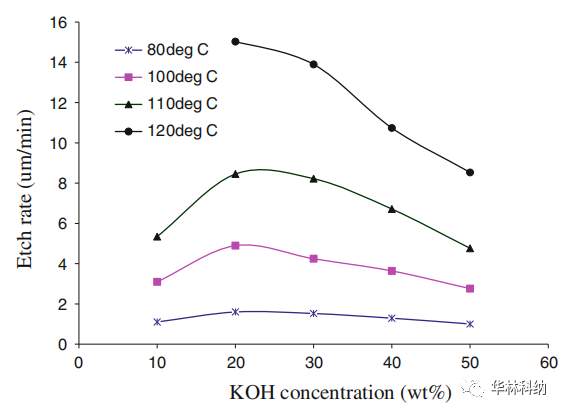
以形成非球面表面。 我們使用 100 525 μm的硅晶片,在正面上具有1 μm的SiO2掩模,在背面上具有保護(hù)性的氮化物層。用于整個(gè)過程的蝕刻劑是85℃的33重量%的KOH:H2O溶液。 我們?cè)O(shè)計(jì)了許多
2022-05-11 14:49:58 712
712 
項(xiàng)工作中,使用光刻和蝕刻技術(shù)將晶體硅(c- Si)晶片深度蝕刻至厚度小于20 μm。使用SPR 220-7.0和SU-8光刻膠,使用四甲基氫氧化銨(TMAH)濕法各向異性蝕刻和基于等離子體的反應(yīng)離子蝕刻(RIE)。二氧化硅用作TMAH蝕刻的制造層。4英寸c-Si晶片的TMAH蝕刻在80℃的溫度
2022-06-10 17:22:58 7362
7362 
。二氧化硅通過分別用于微米和納米鰭的光和電子束光刻形成圖案,隨后在氫氟酸中進(jìn)行濕法蝕刻。使用用異丙醇(IPA)稀釋的四甲基氫氧化銨(TMAH)以及具有表面活性劑(Triton-X-100)的硅摻雜TMAH
2022-07-08 15:46:16 1092
1092 
蝕刻機(jī)理 諸如KOH-、NaOH-或TMAH-溶液的強(qiáng)含水堿性介質(zhì)蝕刻晶體硅通孔 硅+ 2 OH- + 2 H O ?硅(OH) + H ?二氧化硅(OH) 2- + 2 H 因?yàn)椴煌娴腟i原子
2022-07-11 16:07:22 1342
1342 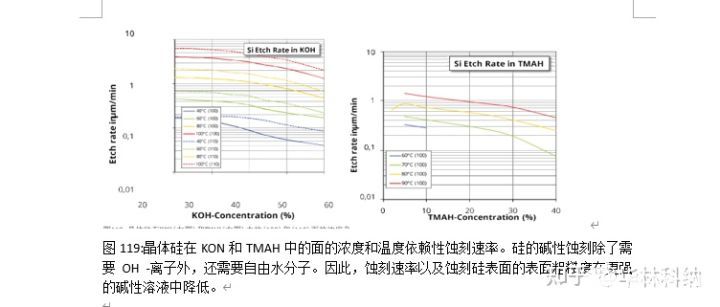
他方向上的蝕刻速度快,而各向同性蝕刻(如HF)會(huì)向所有方向侵蝕。使用KOH工藝是因?yàn)槠湓谥圃熘械目芍貜?fù)性和均勻性,同時(shí)保持了較低的生產(chǎn)成本。異丙醇(IPA)經(jīng)常添加到溶液中,以改變從{110}壁到{100}壁的選擇性,并提高表面光滑度。 氧化物和氮化物
2022-07-14 16:06:06 2774
2774 
為了在基板上形成功能性的MEMS結(jié)構(gòu),必須蝕刻先前沉積的薄膜和/或基板本身。通常,蝕刻過程分為兩類:浸入化學(xué)溶液后材料溶解的濕法蝕刻干蝕刻,其中使用反應(yīng)性離子或氣相蝕刻劑濺射或溶解材料在下文中,我們將簡(jiǎn)要討論最流行的濕法和干法蝕刻技術(shù)。
2021-01-09 10:17:20
PCB制作工藝中的堿性氯化銅蝕刻液1.特性1)適用于圖形電鍍金屬抗蝕層,如鍍覆金、鎳、錫鉛合金,錫鎳合金及錫的印制板的蝕刻。 2)蝕刻速率快,側(cè)蝕小,溶銅能力高,蝕刻速率容易控制。 3)蝕刻液可以
2018-02-09 09:26:59
蝕問題,蝕刻后的導(dǎo)線側(cè)壁接近垂直。 3)溫度:溫度對(duì)蝕刻液特性的影響比較大,通常在化學(xué)反應(yīng)過程中,溫度對(duì)加速溶液的流動(dòng)性和減小蝕刻液的粘度,提高蝕刻速率起著很重要的作用。但溫度過高,也容易引起蝕刻液
2018-09-11 15:19:38
化學(xué)反應(yīng)過程中,溫度對(duì)加速溶液的流動(dòng)性和減小蝕刻液的粘度,提高蝕刻速率起著很重要的作用。但溫度過高,也容易引起蝕刻液中一些化學(xué)成份揮發(fā),造成蝕刻液中化學(xué)組份比例失調(diào),同時(shí)溫度過高,可能會(huì)造成高聚物抗
2013-10-31 10:52:34
給定值時(shí),溶液便會(huì)自動(dòng)進(jìn)行添加。 在與此相關(guān)的化學(xué)蝕刻(亦稱之為光化學(xué)蝕刻或PCH)領(lǐng)域中,研究工作已經(jīng)開始,并達(dá)到了蝕刻機(jī)結(jié)構(gòu)設(shè)計(jì)的階段。在這種方法中,所使用的溶液為二價(jià)銅,不是氨-銅蝕刻。它將
2018-11-26 16:58:50
1.問題:印制電路中蝕刻速率降低 原因: 由于工藝參數(shù)控制不當(dāng)引起的 解決方法: 按工藝要求進(jìn)行檢查及調(diào)整溫度、噴淋壓力、溶液比重、PH值和氯化銨的含量等工藝參數(shù)到工藝規(guī)定值。 2.
2018-09-19 16:00:15
計(jì)控制系統(tǒng)。當(dāng)自動(dòng)測(cè)得的PH結(jié)果低于給定值時(shí),溶液便會(huì)自動(dòng)進(jìn)行添加。 在與此相關(guān)的化學(xué)蝕刻(亦稱之為光化學(xué)蝕刻或PCH)領(lǐng)域中,研究工作已經(jīng)開始,并達(dá)到了蝕刻機(jī)結(jié)構(gòu)設(shè)計(jì)的階段。在這種方法中,所
2018-09-13 15:46:18
重要材料的濕法腐蝕,即氧化鋅、氮化鎵和碳化硅。雖然氧化鋅很容易在許多酸溶液中蝕刻,包括硝酸/鹽酸和氫氟酸/硝酸,在非酸性乙酰丙酮中,第三族氮化物和碳化硅很難濕法蝕刻,通常使用干法蝕刻。已經(jīng)研究了用于氮化
2021-10-14 11:48:31
晶體學(xué)和濕蝕刻的性質(zhì)? 濕的在基于KOH的化學(xué)中,GaN 的化學(xué)蝕刻具有高度的各向異性,能夠形成垂直和光滑的多面納米結(jié)構(gòu)。文章全部詳情,請(qǐng)加V獲取:hlknch / xzl1019? 我們 可以
2021-07-08 13:09:52
常見的加工方法進(jìn)行。對(duì)于我們的第一步,我們使用了幾種不同的處理方法,包括氯基等離子體中的反應(yīng)離子蝕刻、KOH 溶液中的 PEC 蝕刻和切割。第二步是通過浸入能夠在晶體學(xué)上蝕刻 GaN 的化學(xué)品中完成
2021-07-07 10:24:07
發(fā)射極感興趣,這可以避免AlGaAs 的氧化和深能級(jí)問題。用于器件制造的關(guān)鍵技術(shù)操作之一是濕化學(xué)蝕刻。在我們之前的論文中,我們介紹了一組在 HC1:C H3COOH:H2O2(所謂的 KKI)溶液中
2021-07-09 10:23:37
問題,因?yàn)樯婕暗膿p害很低。此外,它們比干法蝕刻方法更便宜且不復(fù)雜。另一個(gè)重要的優(yōu)點(diǎn)是濕法蝕刻可以選擇性地去除不同的材料。本文介紹了n型氮化鎵在幾種電解質(zhì)水溶液中(光)電化學(xué)行為的基礎(chǔ)研究結(jié)果,以及在
2021-10-13 14:43:35
損傷并平滑垂直側(cè)壁。圖中。 在 TMAH 溶液中化學(xué)拋光不同時(shí)間后的 GaN m 面和 a 面?zhèn)缺诘?SEM 圖像。(a) 六方纖鋅礦結(jié)構(gòu)的晶胞示意圖。(b) 鳥瞰圖(傾斜于20°) ICP 干法蝕刻
2021-07-09 10:21:36
μm 的 3''、4'' 和 6''硅晶片進(jìn)行了 KOH 和 TMAH 溶液的蝕刻實(shí)驗(yàn)分別是納米制造中心。3''晶片被雙面拋光并在熱氧化層上分別在60/40nm的兩側(cè)具有氮化層以獲得掩模窗口。4 英寸
2021-07-19 11:03:23
測(cè)得的PH結(jié)果低于給定值時(shí),溶液便會(huì)自動(dòng)進(jìn)行添加。在與此相關(guān)的化學(xué)蝕刻(亦稱之為光化學(xué)蝕刻或PCH)領(lǐng)域中,研究工作已經(jīng)開始,并達(dá)到了蝕刻機(jī)結(jié)構(gòu)設(shè)計(jì)的階段。在這種方法中,所使用的溶液為二價(jià)銅,不是氨-銅
2018-04-05 19:27:39
摘要:在印制電路制作過程中,蝕刻是決定電路板最終性能的最重要步驟之一。所以,研究印制電路的蝕刻過程具有很強(qiáng)的指導(dǎo)意義,特別是對(duì)于精細(xì)線路。本文將在一定假設(shè)的基礎(chǔ)上建立模型,并以流體力學(xué)為理論基礎(chǔ)
2018-09-10 15:56:56
蝕刻 浸入蝕刻是一種半槳技術(shù),它只需一個(gè)裝滿蝕刻洛液的槽,把板子整個(gè)浸入到溶液中,如圖1所示。板子需要保持浸入直至蝕刻完成,這就需要很長(zhǎng)的蝕刻時(shí)間,且蝕刻速度非常緩慢。可以通過加熱蝕刻溶液的方法來
2018-09-11 15:27:47
﹐就是盡速讓金屬表面不斷地接觸新鮮的蝕刻液。 在氨性蝕刻中﹐假定所有參數(shù)不變﹐那么蝕刻的速率將主要由蝕刻液中的氨(NH3)來決定。因此, 使用新鮮溶液與蝕刻表面相互作用﹐其主要目的有兩個(gè)﹕沖掉剛產(chǎn)生的銅
2017-06-23 16:01:38
濕法蝕刻工藝的原理是使用化學(xué)溶液將固體材料轉(zhuǎn)化為液體化合物。選擇性非常高,因?yàn)樗没瘜W(xué)藥品可以非常精確地適應(yīng)各個(gè)薄膜。對(duì)于大多數(shù)解決方案,選擇性大于100:1。
2021-01-08 10:12:57
我司是做濕法蝕刻藥水的,所以在濕法這塊有很多年的研究。所以有遇到濕法蝕刻問題歡迎提問,很愿意為大家解答。謝謝!QQ:278116740
2017-05-08 09:58:09
用交替微波加熱法快速制備CeO2/C復(fù)合材料,進(jìn)而制備Pt-CeO2/C。用電化學(xué)方法研究了甲醇、乙醇、甘油和乙二醇在KOH溶液中在Pt/C或Pt-CeO2/C電極上的電化學(xué)氧化性能。結(jié)果顯示負(fù)載在
2011-03-11 12:31:25
適當(dāng)?shù)那鍧嵒驅(qū)?b class="flag-6" style="color: red">溶液進(jìn)行補(bǔ)加。 蝕刻過程中應(yīng)注意的問題 減少側(cè)蝕和突沿﹐提高蝕刻系數(shù) 側(cè)蝕會(huì)產(chǎn)生突沿。通常印制板在蝕刻液中的時(shí)間越長(zhǎng),側(cè)蝕的情況越嚴(yán)重。側(cè)蝕將嚴(yán)重影響印制導(dǎo)線的精度,嚴(yán)重的側(cè)蝕將不
2017-06-24 11:56:41
的PH結(jié)果低于給定值時(shí),溶液便會(huì)自動(dòng)進(jìn)行添加。 在與此相關(guān)的化學(xué)蝕刻(亦稱之為光化學(xué)蝕刻或PCH)領(lǐng)域中,研究工作已經(jīng)開始,并達(dá)到了蝕刻機(jī)結(jié)構(gòu)設(shè)計(jì)的階段。在這種方法中,所使用的溶液為二價(jià)銅,不是氨-銅
2018-09-19 15:39:21
,不再呈光亮銀白的金屬色。采用循環(huán)伏安法研究鎳在堿性溶液中的電化學(xué)活性。研究發(fā)現(xiàn):鎳片的電化學(xué)性能受到溶液濃度、電勢(shì)掃描范圍、掃描速度等因素的影響,并且具有較強(qiáng)的規(guī)律性。電磁干擾測(cè)試儀器:http://www.hyxyyq.com/wz/news/xpxx/90.html系統(tǒng)集成:http://www.oitek.com.cn
2017-09-15 10:09:37
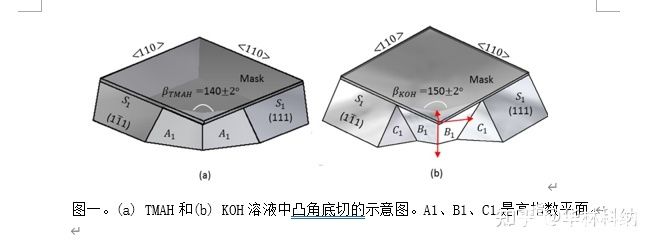



 電子發(fā)燒友App
電子發(fā)燒友App









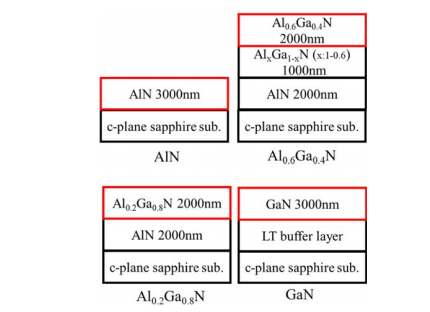
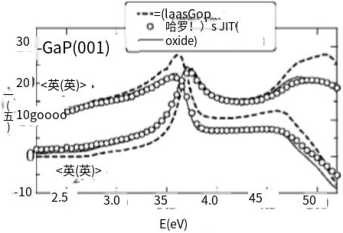
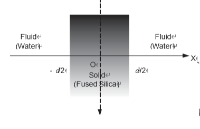






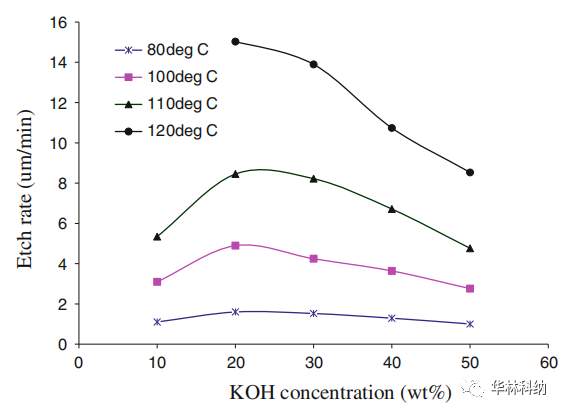



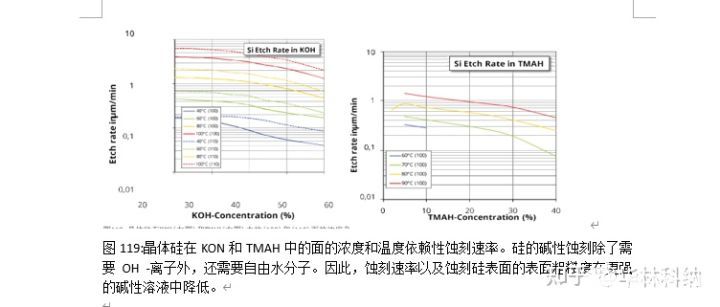

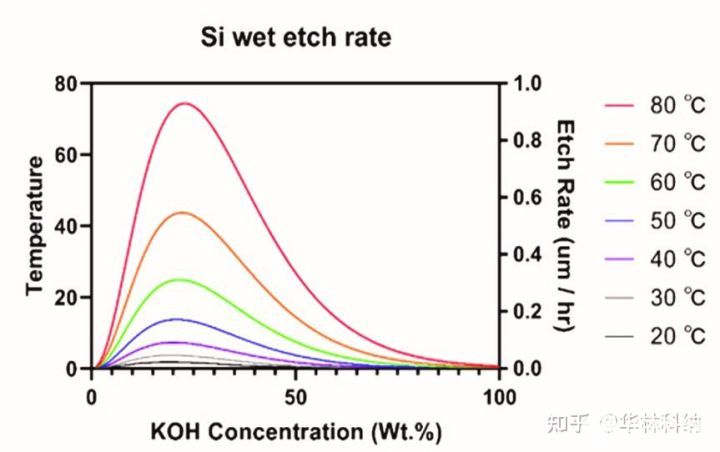
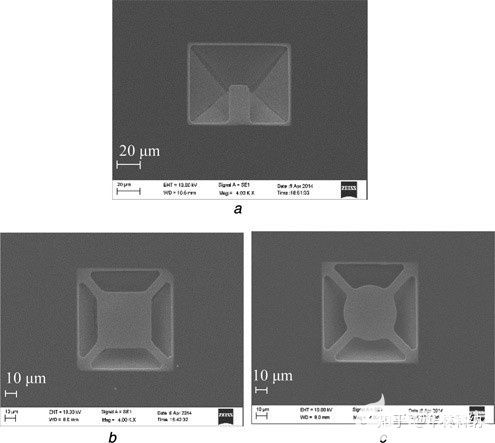

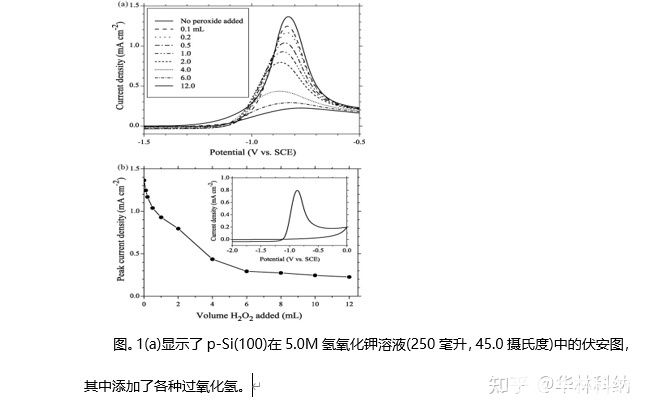

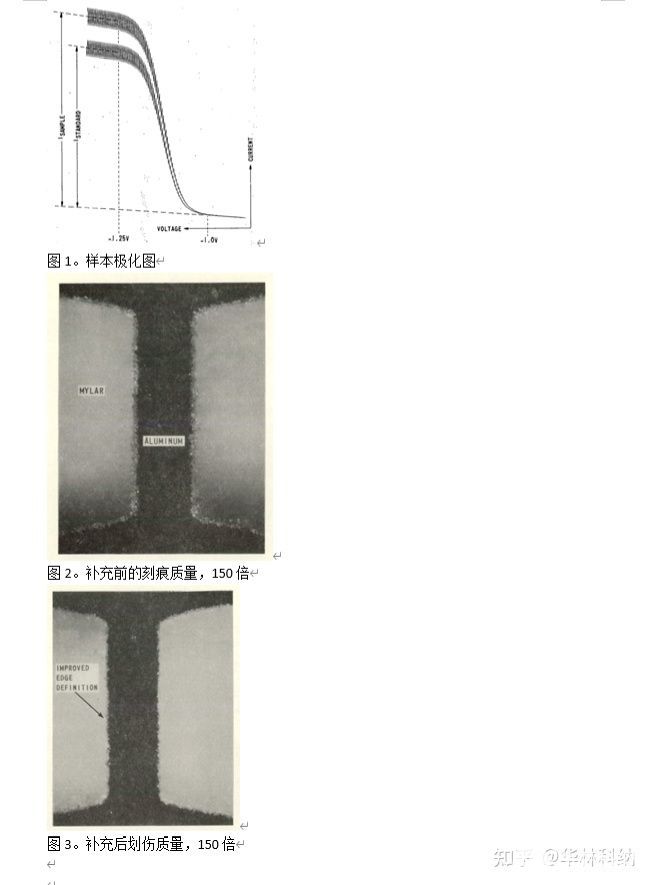

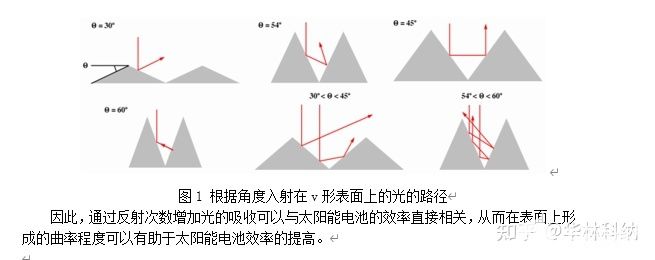


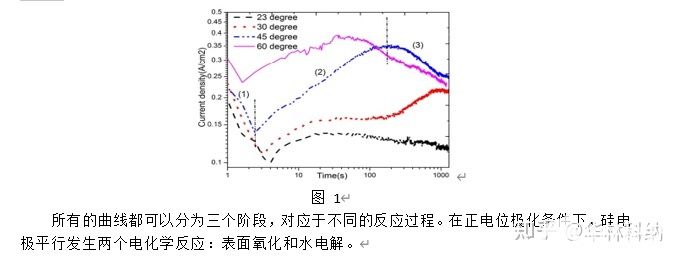

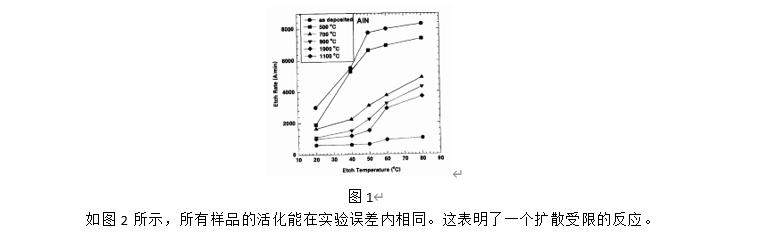

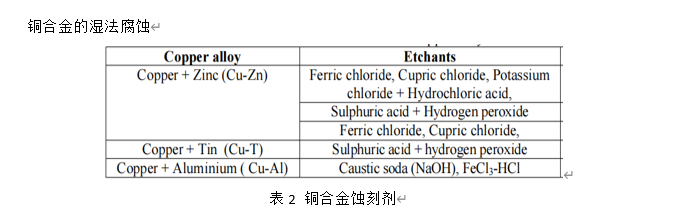

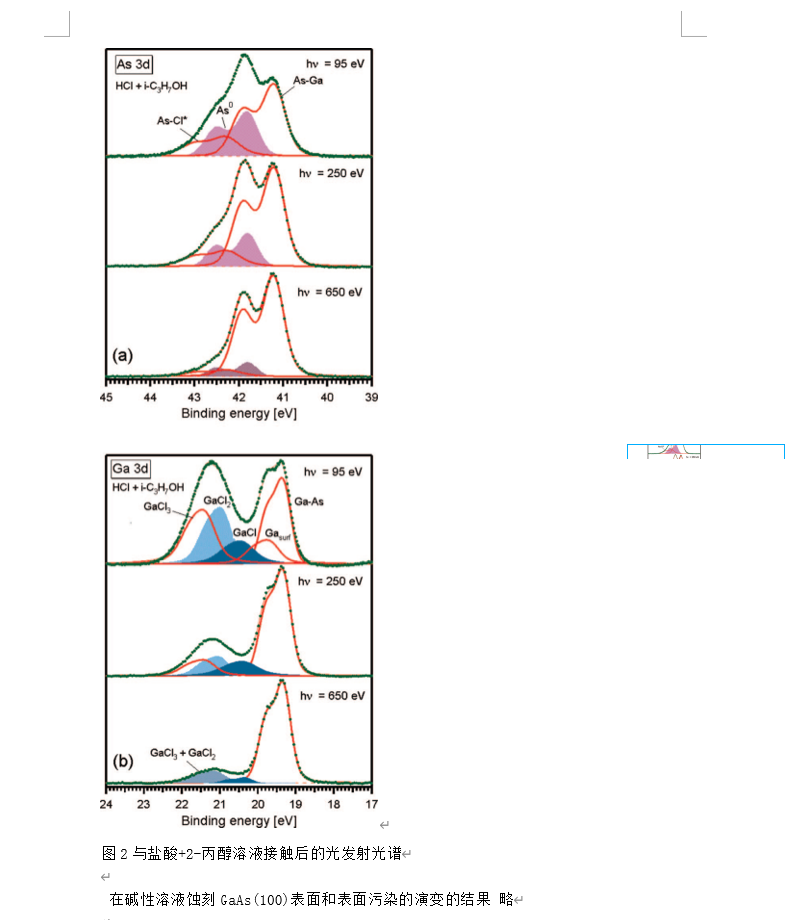



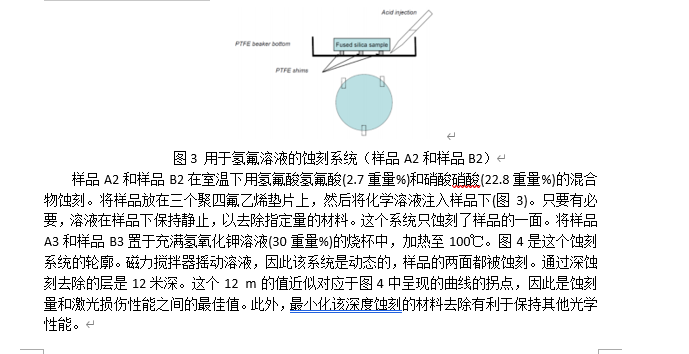


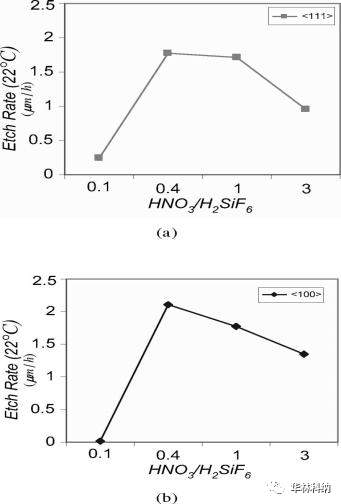
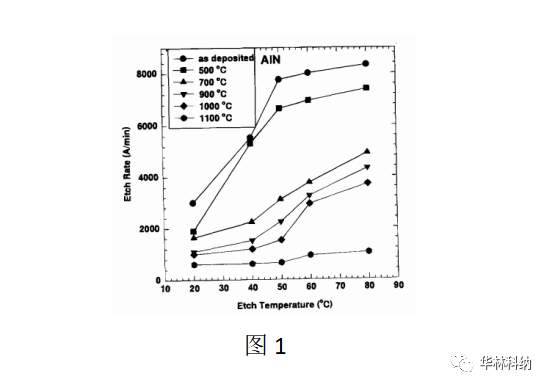
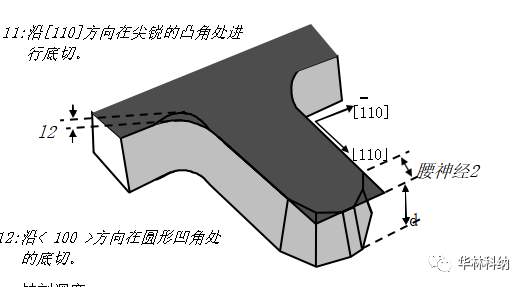




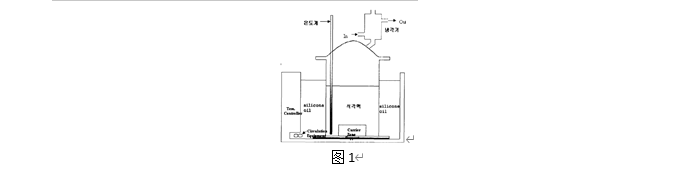
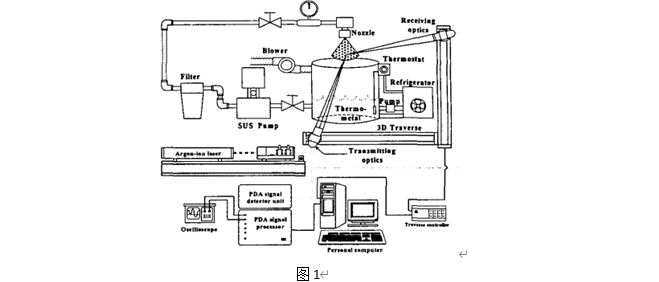

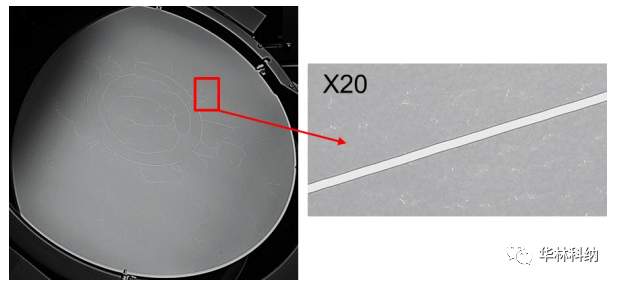
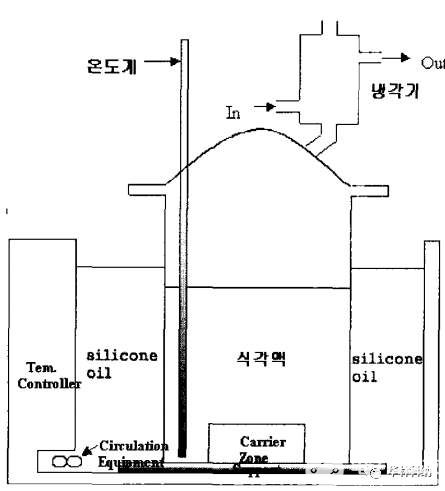
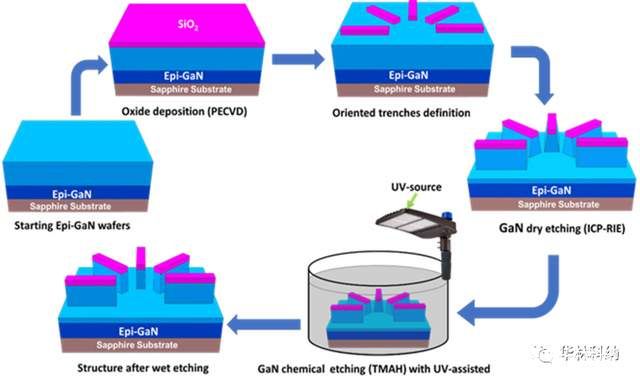
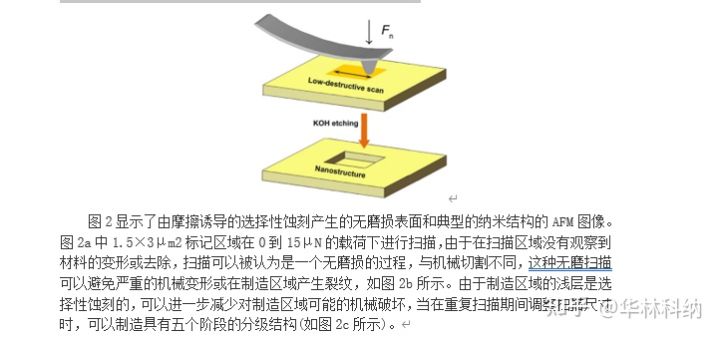
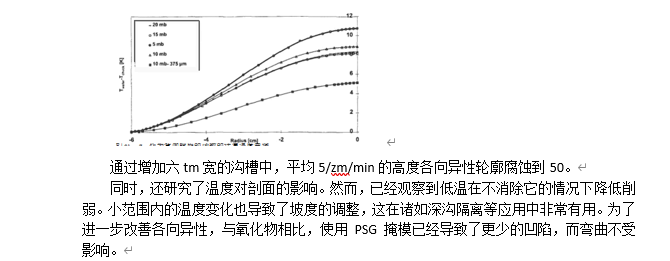

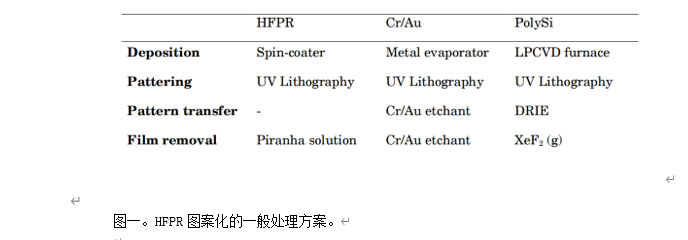
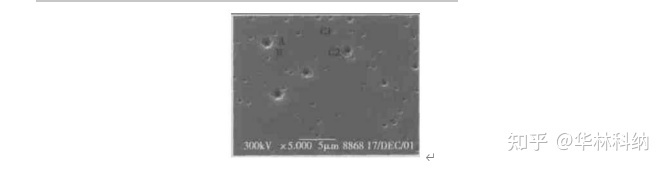

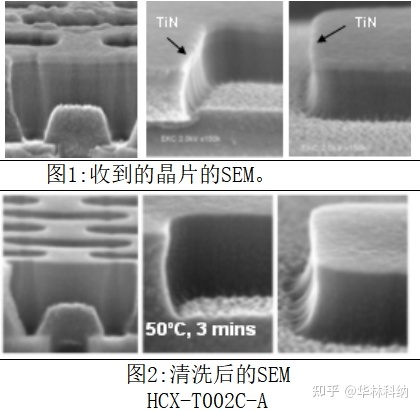



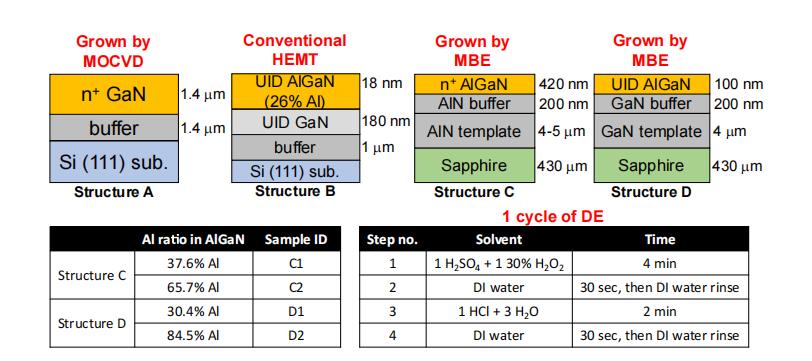










評(píng)論