引用
本文介紹了我們?nèi)A林科納半導(dǎo)體研究了取向硅在氫氧化鉀水溶液中的各向異性腐蝕特性和凸角底切機(jī)理。首先,確定控制底切的蝕刻前沿的晶面,并測量它們的蝕刻速率。然后,基于測量數(shù)據(jù),檢驗(yàn)了凸角補(bǔ)償技術(shù)的幾種方法。傳統(tǒng)上,方向光束用于補(bǔ)償凸角上的底切。發(fā)現(xiàn)這種方法對于銳角凸角產(chǎn)生良好的結(jié)果,但是導(dǎo)致在鈍角凸角上出現(xiàn)具有晶面的大的殘余結(jié)構(gòu)。為了緩解這個(gè)問題,基于測量的蝕刻前平面,開發(fā)了使用三角形和菱形圖案的新的拐角補(bǔ)償方法。詳細(xì)評估了所提出的拐角補(bǔ)償圖案在減少底切和殘留物方面的有效性。發(fā)現(xiàn)對于鈍角凸角,菱形角補(bǔ)償提供了最好的結(jié)果,對于銳角凸角,菱形和波束圖案都是有效的。
介紹
建立硅在KOH水溶液中的Ekh作用
雖然已有許多關(guān)于取向硅的腐蝕速率的報(bào)道,但參考文獻(xiàn)中的數(shù)據(jù)。6-10的差異相當(dāng)大。因此,蝕刻速率在進(jìn)行實(shí)驗(yàn)之前,必須確定晶面及其比例。
選擇氫氧化鉀(KOH)作為蝕刻劑是因?yàn)樗母哌x擇性和相對無毒性。在隨后的實(shí)驗(yàn)中使用了兩種蝕刻條件:70℃下的40% KOH水溶液蝕刻和80℃下的50% KOH水溶液蝕刻。注意,所用的KOH薄片是85% KOH和15% HCO的混合物,按重量計(jì)。因此,在這些條件下,蝕刻劑的真實(shí)重量百分比分別為34和42.5重量%。在手稿的其余部分,85%的KOH薄片(即40%和50%的KOH水溶液)的重量百分比在正文中注明。在圖和表中,為了清楚起見,陳述了KOH百分比的兩種類型的表達(dá)。本實(shí)驗(yàn)中使用的取向硅片是雙面拋光的n型4 in。厚度為525 * 25微米、電阻率為10到30鋁厘米的晶片。
為了獲得高縱橫比并使蝕刻掩模下不希望的橫向蝕刻最小化,將光掩模與(111)晶面精確對準(zhǔn)是非常重要的。為了精確對準(zhǔn),使用扇形對準(zhǔn)目標(biāo)圖案,該圖案由4 mm長、20 pm寬、跨度為-5°至+5°的光束組成。每個(gè)波束該目標(biāo)圖案的每一個(gè)以0.1度的角度彼此散開。在充分蝕刻該扇形圖案之后,可以確定精度在0.05以內(nèi)的適當(dāng)對準(zhǔn)方向。該方向是真正的1晶體方向,并且光掩模應(yīng)該平行于該晶體方向?qū)?zhǔn)。
對于KOH蝕刻掩模,在500的熱生長緩沖氧化物層上使用1500的化學(xué)計(jì)量低壓化學(xué)氣相沉積(LPCVD)氮化物膜。氧化層生長采用濕氧化法,在1000°C下進(jìn)行37分鐘,每分鐘4500標(biāo)準(zhǔn)立方厘米(sccm)的氫氣和200 seem的三氯乙烷,在此之前在相同條件下進(jìn)行3分鐘的預(yù)氧化,除了預(yù)氧化階段不使用氫氣。通過分解100 seem的NH沉積氮化物膜,并且30 seem的二氯硅烷在300毫托和785℃下處理45分鐘。請注意,這些配方改編自我們研究所使用的標(biāo)準(zhǔn)CMOS工藝。


討論
在用于測試的三種拐角補(bǔ)償圖案中,新開發(fā)的菱形圖案為鈍角凸角提供了最好的結(jié)果。這與波束圖案三角形圖案的結(jié)果相比,用菱形圖案獲得的結(jié)果具有更清晰的輪廓,幾乎沒有或沒有殘余結(jié)構(gòu)。基于這些結(jié)果,可以得出結(jié)論,在本文考慮的三種補(bǔ)償模式中,菱形角補(bǔ)償模式是鈍角的唯一可行選擇。
在銳角凸角上,光束模式和菱形模式都產(chǎn)生良好的結(jié)果。這里引用的四幅圖具有不同的形狀,因此,應(yīng)該根據(jù)應(yīng)用的具體需要來確定選擇哪種補(bǔ)償模式。
頂側(cè)的底切補(bǔ)償和底側(cè)的殘余結(jié)構(gòu)的減少之間的權(quán)衡仍然是一個(gè)問題。這種情況可以通過從兩側(cè)蝕刻水來緩解,假設(shè)光掩模可以在水的兩側(cè)精確對準(zhǔn)。另一個(gè)好處是,雙面蝕刻技術(shù)可以使用較小的補(bǔ)償圖案。
最后,三角形拐角補(bǔ)償圖案通過不允許任何底切侵蝕發(fā)生而在頂側(cè)產(chǎn)生最尖銳的特征。不幸的是,在這種情況下,使用雙面蝕刻技術(shù)并不能有效消除殘余結(jié)構(gòu),因?yàn)闅堄嘟Y(jié)構(gòu)的高度太大了。減小三角形圖案的尺寸是可能的,但是根據(jù)我們的計(jì)算,三角形圖案的面積需求仍然大于菱形圖案的面積需求。
結(jié)論
本文介紹了取向硅在KOH水溶液中的腐蝕特性。平行四邊形蝕刻考慮由四個(gè)側(cè)面上的面和頂部和底部的面限定的臺(tái)面結(jié)構(gòu)。為了防止凸角上的底切,研究了幾種補(bǔ)償方法。首先考慮用光束的常規(guī)補(bǔ)償方法,但是結(jié)果顯示在鈍角上有大的殘余結(jié)構(gòu)。因此,提出并檢驗(yàn)了一種新的三角形拐角補(bǔ)償方法,該方法基于控制底切的測量的蝕刻前平面。三角形由面限定的圖案在頂側(cè)產(chǎn)生非常尖銳的結(jié)構(gòu),幾乎完美地補(bǔ)償了底切。然而,底切的發(fā)明在底側(cè)導(dǎo)致大的不想要的殘余結(jié)構(gòu)。作為底切和殘余結(jié)構(gòu)之間的折衷,提出并評估了菱形角補(bǔ)償圖案。在此方法中,菱形以平行四邊形凸結(jié)構(gòu)的頂點(diǎn)為中心,并包含在由確定的三角形內(nèi)。
審核編輯:符乾江
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28569瀏覽量
232412 -
化學(xué)
+關(guān)注
關(guān)注
1文章
83瀏覽量
19719 -
制造工藝
+關(guān)注
關(guān)注
2文章
198瀏覽量
20256
發(fā)布評論請先 登錄
什么是高選擇性蝕刻
想做好 PCB 板蝕刻?先搞懂這些影響因素

深入探討 PCB 制造技術(shù):化學(xué)蝕刻
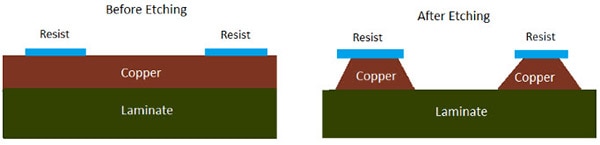
選擇性激光蝕刻中蝕刻劑對玻璃通孔錐角和選擇性有什么影響

蝕刻基礎(chǔ)知識(shí)

干法刻蝕的概念、碳硅反應(yīng)離子刻蝕以及ICP的應(yīng)用

芯片濕法蝕刻工藝
Chemtronics將為第8代OLED面板建造顯示器后端蝕刻工廠
濕法蝕刻的發(fā)展

泛林集團(tuán)推出第三代低溫電介質(zhì)蝕刻技術(shù)Lam Cryo 3.0,助力3D NAND邁向千層新紀(jì)元
泛林集團(tuán)推出第三代低溫介質(zhì)蝕刻技術(shù)Lam Cyro 3.0
VCSEL激光在蝕刻和光刻中的應(yīng)用與前景
玻璃基電路板的蝕刻和側(cè)蝕技術(shù)
玻璃電路板表面微蝕刻工藝
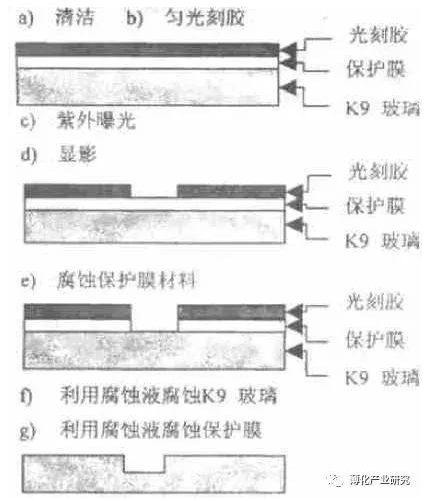





 硅KOH蝕刻:凸角蝕刻特性研究
硅KOH蝕刻:凸角蝕刻特性研究











評論