隨著電子技術的不斷發展和進步,電子產品開始朝著輕量化,薄型化,小型化和先進功能的方向發展。經過幾代升級,芯片封裝技術使芯片面積與封裝面積之比約為1,其中BGA(球柵陣列)已成為一種已進入實用階段的高密度封裝技術。如何保證BGA焊接質量的可靠性,如何檢測BGA的質量以及如何對有缺陷的BGA進行返工對BGA SMT(表面貼裝技術)組件至關重要,所有制造商必須完全了解其解決方案將在本文中討論。
BGA封裝技術
BGA封裝在底部包含許多球形凸起管或在上表面。由于凸塊,封裝體和基座之間實現了互連。作為一種先進的封裝技術,BGA具有較大的引線空間和較短的引線,通過分布I/O端,在封裝體底部起到球或柱的作用。
基于不同的封裝材料,BGA元件可分為PBGA(塑料BGA),CBGA(陶瓷BGA),CCBGA(陶瓷柱BGA),TBGA(帶BGA)和CSP(芯片級封裝)。
QFP(四方扁平封裝)組件,BGA組件具有以下屬性:
a。 I/O端間距很大,BGA可以保持更多的I/O端。
b。更高的封裝可靠性,更低的焊接缺陷和更堅固的焊點。
c。 BGA芯片在焊點之間具有較大的間距,因此對準和焊接不會因對準放大系統而變得困難。 BGA焊接的共面性得到保證,因為焊料會在熔化后自動補償芯片和PCB之間的平面誤差。由于焊接點較小,自感和互感較低,因此具有優異的電氣特性和頻率特性。
f。能夠實現自動自對準和焊接接頭之間的張力,從而實現出色的自定心效果,從而實現高可靠性。它的主要缺點在于它們的檢查和返工相對難以進行。
BGA裝配
魚骨圖關于含有BGA組分的PCB板制造過程中元素的說明如下所示。
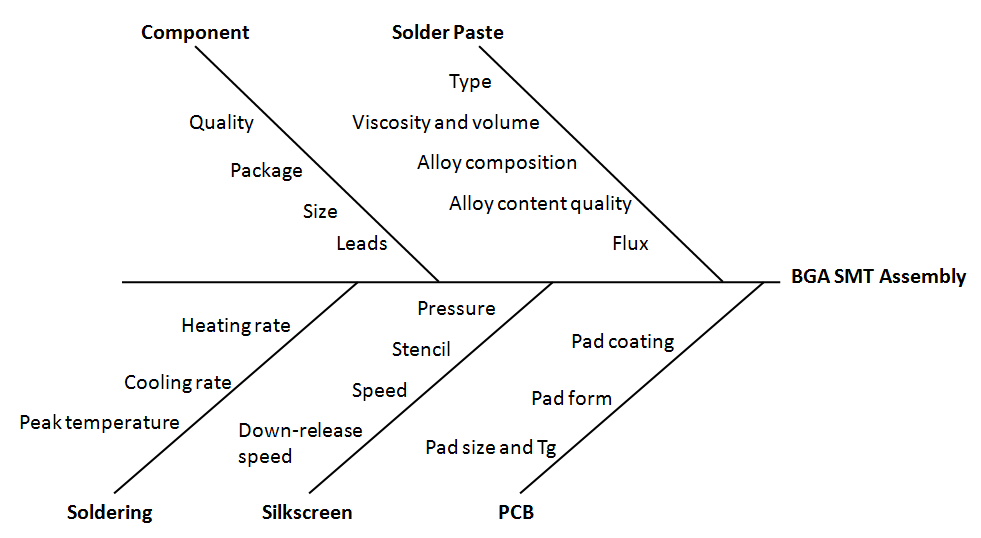
根據上述魚骨,BGA SMT與焊膏,元件,PCB,絲網印刷和焊接緊密相關,其中焊接項目是回流焊接過程中最難處理的。
影響回流焊接的關鍵因素在于溫度曲線設定。具體方法是在位于PCB背面的BGA中心的某個焊盤位置打開一個孔,然后將熱電偶探針穿過PCB板底部的孔,并將其粘在焊盤的背面并固定用高溫膠帶。接下來,將參數設置良好的回流焊溫度曲線測試儀與托盤和探頭一起放入回流焊爐中。經過比較和分析,得到最佳溫度曲線。
回流溫度曲線由四個階段組成:預熱階段,保溫階段,回流階段和冷卻階段。加熱過程和溫度曲線應使封裝達到回流溫度,然后在焊球與焊盤產生的金屬間化合物熔化后回落到焊盤的溫度。加熱不一致會導致封裝不均勻地掉落或傾向于回流焊接的一側或一角,導致非共面性和焊接不充分。
BGA方面也應強調以下兩個方面。焊接:
a。預烘烤
塑料包裝通常會吸收濕氣。如果芯片在吸收空氣中的濕氣后立即被加熱,則水分擴散將導致芯片內部的空腔。因此,塑料包裝的一般烘烤條件在100°C下持續6到8小時。
b。氧化
在應用之前,應檢查BGA組件以確保其引腳清潔并且不會發生氧化。
BGA檢驗方法
a。 BGA缺陷和檢查方法
焊接后,BGA組件可能會因組件,組裝設備,環境和焊接技術而出現不同的缺陷。領先的BGA缺陷包括未對準,松動焊接,開路,冷焊,橋接,短路和空腔。此外,BGA焊球可能還存在一些問題,例如缺失或掉落以及尺寸不均勻。對于BGA檢測,由于焊球低于芯片,因此在焊接后很難判斷焊接質量。傳統的目視檢查無法確定焊接接頭內是否有缺陷或空洞。必須使用專業的檢測設備來清楚地判斷焊點的質量。
在SMT組裝中利用BGA組件后,通常所依賴的檢查方法包括電氣測試,邊界掃描和X射線檢查。傳統的電氣測試能夠掃描開路和短路缺陷。邊界掃描技術取決于基于邊界掃描設計的檢查端口,可以訪問邊界連接器上的每個焊點,從而可以檢查組件上的開路和短路。雖然邊界掃描能夠檢查比電氣測試更廣泛的隱形焊點,但這兩種方法僅測試電氣性能而不會達到焊接質量檢查。為了保證和提高制造工藝的質量,必須依靠其他方法進行焊接質量檢查,尤其是那些看不見的焊點。 AXI(自動X射線檢測)可以有效地解決問題,并且可以進行實時監控,以確保過程控制的質量和實時反饋。
灣最佳BGA焊點標準
最佳BGA焊點應光滑,邊界清晰,無空隙,直徑,體積,灰度和對比度應保持在所有焊點之間完全對齊,不產生焊球。與最佳BGA焊點的標準相比,合格的BGA焊點具有更低的要求。
?不對中。 X射線檢查裝置能夠清楚地指示BGA焊球是否與PCB板上的焊盤位置精確兼容。可以允許小于25%的位移。
?松散的焊接接頭。 BGA焊接不允許松動的焊接接頭。
?開路和冷焊接接頭。當焊料不與相應的焊盤接觸或焊料不良流動時,可能會發生開路和冷焊接接頭。 BGA焊接不允許開路和冷焊接接頭。
?橋接和短路。當焊料過量或不適當地放置時,可能會發生橋接和短路。至于BGA焊點,不允許橋接和短路。
?腔。有關腔的問題有點復雜。 X射線檢查裝置能夠在BGA部件組件上展示空腔。以下提示可作為判斷標準:
1、產生空腔的原因
①在焊接BGA焊球之前可以使用空腔,這可能來自焊球制造或焊膏成分。
②如果通孔是設計為墊下,外部空氣通過孔進入熔化焊球,冷卻后形成空腔。
③焊盤表面有不良涂層或焊盤污染。
④回流焊溫度曲線設置不合適。
2、空腔的最佳標準
空腔中的空氣可能會產生收縮和膨脹的應力效應。空洞發生的地方將是應力集中,這可能是應力裂縫的根本原因。帶有空腔的BGA焊接接頭可能會導致技術問題,例如失效。根據IPC對BGA焊點規定的標準,焊盤上的空腔不應比焊球面積大10%,即空腔直徑不應大于焊球直徑的30%。
-
BGA
+關注
關注
5文章
566瀏覽量
48146 -
PCB打樣
+關注
關注
17文章
2972瀏覽量
22359 -
華強PCB
+關注
關注
8文章
1831瀏覽量
28440 -
華強pcb線路板打樣
+關注
關注
5文章
14629瀏覽量
43742
發布評論請先 登錄
PCBA 工程師必看!BGA 焊接質量如何決定整塊電路板的 “生死”?
BGA芯片的焊接技術與流程
BGA芯片的封裝類型 BGA芯片與其他封裝形式的比較
BGA封裝與SMT技術的關系
BGA封裝的測試與驗證方法
BGA封裝常見故障及解決方法
BGA封裝技術的發展 BGA封裝的優勢與應用
BGA焊接產生不飽滿焊點的原因和解決方法






 BGA封裝技術的焊接和檢驗方法
BGA封裝技術的焊接和檢驗方法
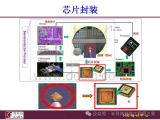











評論