3G提高了通信速度,4G改變了我們的生活,5G時(shí)代則因?yàn)榧夹g(shù)的革命性,整個(gè)社會(huì)形態(tài)與商業(yè)形態(tài)都被深刻影響,對于芯片封裝測試領(lǐng)域同樣也帶來了許多新的技術(shù)革新......
11月上旬,2018中國集成電路產(chǎn)業(yè)促進(jìn)大會(huì)的5G通信芯片主題論壇上,Qorvo亞太區(qū)客戶質(zhì)量工程總監(jiān)周寅便用示例詳細(xì)介紹了傳統(tǒng)的芯片封裝測試工藝流程與5G芯片封裝技術(shù)演進(jìn)路線。
Qorvo亞太區(qū)客戶質(zhì)量工程總監(jiān)周寅發(fā)表演講
Qorvo是全球少數(shù)能夠整合所有射頻全方位解決方案的公司,主要業(yè)務(wù)領(lǐng)域包括移動(dòng)終端、基站芯片和航空航天等。工欲善其事,必先利其器,兩年前新投入運(yùn)營的德州工廠是Qorvo全球范圍內(nèi)最大的組裝、封裝和測試運(yùn)營中心,補(bǔ)充了Qorvo現(xiàn)有的北京制造業(yè)務(wù), 并與Qorvo北京工廠組成Qorvo中國制造中心,共同合力支撐全球的生產(chǎn)運(yùn)營。
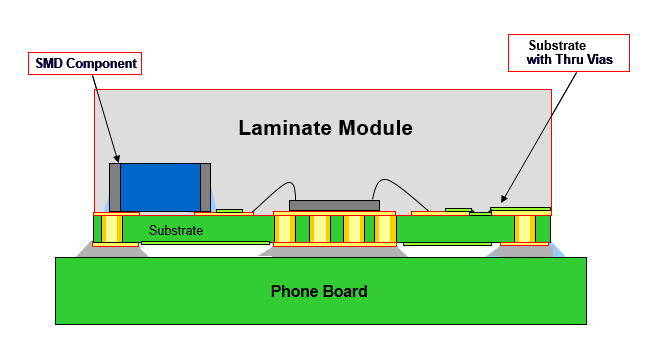
這一種很典型的十幾年前一種基于基板(Substrate)的層壓封裝結(jié)構(gòu)模型(Laminate Module Package),它大致上可分為幾個(gè)步驟:首先在基板表面貼裝SMT的被動(dòng)元件,也就是我們平時(shí)常用到的電容、電感等。第二步貼主動(dòng)元件,就是中間部分的晶圓,它實(shí)現(xiàn)芯片的大部分電路功能。這兩步做完之后,需要連接電路,以前一般用金線、銅線、鋁線進(jìn)行連接,以實(shí)現(xiàn)芯片的電路功能。做完這三步后,芯片的功能便基本實(shí)現(xiàn)了,接下來還要用一些材料,比如陶瓷或聚脂,對芯片塑封以確保可靠性。這就是封裝最基本、最簡單的一套流程。
1晶圓研磨和切割工藝
2倒裝芯片貼裝工藝
在芯片里貼被動(dòng)元件與在電路板上貼元件類似,刷上焊錫膏,把被動(dòng)元件焊接到基板上面,實(shí)現(xiàn)它的連接功能,唯一的區(qū)別只是它用到的SMD元件會(huì)更小。今后的趨勢是分立元件會(huì)更多地集成在芯片里,外圍不會(huì)有太多元件。
作為功率放大的器件,需要高功率的、高帶寬的材料,比如砷化鎵、氮化鎵,也需要一些低頻的功率器件,共同做在晶圓上。每一片晶圓,可能包含許多直徑大概0.1到0.5毫米的小晶片,我們稱之為die。對晶圓的專用機(jī)器會(huì)使用環(huán)氧樹脂將晶圓粘接到目標(biāo)表面,令目標(biāo)與晶圓進(jìn)行導(dǎo)電導(dǎo)熱的連接。環(huán)氧樹脂材料對die和die之間的距離有一定限制,隨著晶圓越做越小,也可能用到一些其它新材料,例如導(dǎo)電薄膜,從而使芯片的集成度提高。
3引線鍵合工藝
焊線(Wire Bond)將芯片上的電路連接起來。現(xiàn)在焊線的方式會(huì)用到一個(gè)mil(千分之一英寸,約0.0254mm)的金線,隨著成本控制和其它一些生產(chǎn)考量,也會(huì)用到合金、鋁線或其它一些焊線材料。不同的die之間互相用這種線進(jìn)行連接。
雖然采用焊線的芯片,基板設(shè)計(jì)靈活度較高,但焊線制約了封裝的尺寸。隨著頻段越來越寬、頻譜越來越復(fù)雜,焊線技術(shù)已不太適用消費(fèi)電子產(chǎn)品,尤其是可穿戴設(shè)備。現(xiàn)在常用銅柱凸點(diǎn)倒裝的方式實(shí)現(xiàn)芯片內(nèi)的連接。
最終我們利用環(huán)氧樹脂、二氧化硅或其它材料對芯片進(jìn)行塑封,以實(shí)現(xiàn)產(chǎn)品的可靠性,比如防潮、防震這些功能。塑封完成后會(huì)在芯片上面激光打碼,留下一些基本信息,通過這些信息就可以追溯芯片的生產(chǎn)記錄。打碼后會(huì)將整版芯片切割成單個(gè)芯片包裝。
5切割工藝
6檢驗(yàn)
包括磁阻檢測、整板測試、干式烘焙測試、晶圓探測等。
//射頻芯片封裝模式的不斷演進(jìn)//
縱觀芯片封裝模式的演進(jìn),5-10年前器件的封裝更多的是用Wire Bond間隔的模式,通過晶片貼到類似于傳統(tǒng)意義的PCB的基板上,達(dá)到厚度更薄密度更高。又或者是Wire Bond間隔的多個(gè)晶片及表面貼裝元件的混裝方式,能夠把wafer的其它一些功能,比如控制模塊、電源管理模塊、filter,包括開關(guān),全部封裝在里邊。
5年前的封裝模式現(xiàn)在很多主流的手機(jī)和基站產(chǎn)品仍在使用,更多用的是倒貼的方式。接下來的封裝,集成度會(huì)越來越高。系統(tǒng)級封裝(System In a Package)可將多種功能芯片,包括處理器、存儲(chǔ)器等功能芯片集成在一個(gè)封裝內(nèi),從而實(shí)現(xiàn)一個(gè)基本完整的功能。
此外,5G推動(dòng)芯片向更高集成度、更小尺寸和更高的性能發(fā)展,新的封裝技術(shù)要求設(shè)計(jì)和制造能力的不斷提升。周寅最后指出,QorvoRF Fusion 射頻前端模塊,實(shí)現(xiàn)了功能集成上的突破,可將中頻/高頻模塊整合到一起。通過采用 Qorvo 獨(dú)有的內(nèi)核功能組合,可提升性能,降低功耗和解決方案整體的尺寸大小,同時(shí)提供更高的載波聚合容量,滿足5G時(shí)代智能手機(jī)制造商日益增長的全球覆蓋需求。
-
芯片
+關(guān)注
關(guān)注
459文章
52192瀏覽量
436264 -
晶圓
+關(guān)注
關(guān)注
52文章
5124瀏覽量
129170 -
5G
+關(guān)注
關(guān)注
1360文章
48735瀏覽量
570379
原文標(biāo)題:行業(yè) | 讀懂了傳統(tǒng)芯片封裝測試工藝,5G時(shí)代又有哪些新的技術(shù)革新挑戰(zhàn)?
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
熱門5G路由器參數(shù)對比,華為智選Brovi 5G CPE 5 VS SUNCOMM SDX75
5G 時(shí)代,TNC 連接器標(biāo)準(zhǔn)如何升級?

如何提升裝備聯(lián)網(wǎng)率,打造5G智能工廠

表面貼裝技術(shù)(SMT):推動(dòng)電子制造的變革
5G網(wǎng)絡(luò)中,信令測試儀如何幫助提升用戶體驗(yàn)?
SMT技術(shù):電子產(chǎn)品微型化的推動(dòng)者
5G 時(shí)代 TNC 插頭的創(chuàng)新變革與發(fā)展

6G通信技術(shù)對比5G有哪些不同?
翱捷科技發(fā)布5G RedCap芯片平臺ASR1903系列
長電科技不斷突破封測難題 點(diǎn)亮5G通信新時(shí)代
ARM技術(shù)是什么?國內(nèi)有哪些ARM廠家呢?一起來了解一下!
高通積極推動(dòng)5G Advanced與AI融合發(fā)展
華為5g技術(shù)介紹 華為5g技術(shù)的優(yōu)勢
國產(chǎn)FPGA的發(fā)展前景是什么?
封裝技術(shù)在5G時(shí)代的創(chuàng)新與應(yīng)用
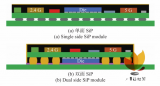





 5G推動(dòng)芯片性能發(fā)展 封裝技術(shù)和制造能力不斷提升
5G推動(dòng)芯片性能發(fā)展 封裝技術(shù)和制造能力不斷提升










評論