bga芯片拆卸方法
1)記位:由于BGA器件不像QFP/SOP封裝器件那樣引腳外露,為了避免拆取后裝回定位不準(zhǔn),一般須在拆取前對IC位置作標(biāo)記。
通常BGA器件都在其定位區(qū)有標(biāo)志線印制在PCB上,形狀如直角標(biāo)或短虛線。如果沒有此類標(biāo)志,可在IC四面沿IC邊角貼上膠紙,形成與IC面積相等的方框作為標(biāo)記。另外,可借助IC旁邊小的器件及過孔、表層印制線路來參照定位。
2)加助焊劑:為使焊錫熔化較快,同時(shí)也使熱量均勻傳布,應(yīng)在BGA芯片四周抹上少許助焊劑。
3)熱風(fēng)槍拆取:取下熱風(fēng)槍的風(fēng)嘴,將溫度調(diào)至300~400℃,風(fēng)速調(diào)在2~3擋之間。開始加熱時(shí)將機(jī)板斜量,使助焊劑充分注入芯片焊盤的各個(gè)錫球之間。然后將熱風(fēng)槍在BGA芯片上方2~3cm處均勻搖晃,持續(xù)加熱1min左右,當(dāng)芯片底下向外泛泡時(shí),再用鑷子輕碰芯片上下邊沿,如果能觸動(dòng),即可在加熱的同時(shí)通過夾取芯片使其脫離PCB焊盤。
4)清理工作:拆下BGA芯片后的焊盤上和線路板上都有余錫,此時(shí),可在線路板上加上適量的助焊劑,用電烙鐵將板上多余的錫去除,并且可適當(dāng)上錫使線路板的每個(gè)焊點(diǎn)腳光滑圓潤,然后用天那水洗凈晾干。
對于拆下的芯片,建議不要將表面的焊錫清除。如果某處焊錫過大,可在表面加上助焊劑,再用烙鐵清除,然后用天那水洗凈。如果發(fā)現(xiàn)PCB焊盤或芯片底盤I/O連接腳有氧化現(xiàn)象,可甩電烙鐵打松香再點(diǎn)錫擦去氧化層。
bga芯片拆卸注意事項(xiàng)
1)助焊劑不能過少,否則會因“干吹”而損壞芯片。
2)熱風(fēng)槍加熱芯片時(shí)必須加熱均勻,不然會使錫珠熔化不一致而托起芯片時(shí),撬落電路板上的焊盤點(diǎn)銅箔,造成整板報(bào)廢。
3)取下芯片時(shí)注意周圍的元器件,以防移位而增加不必要的麻煩。
4)拆芯片前,應(yīng)先拆下周圍的“怕熱器件”,如SIM卡座、后備電池等。
-
BGA
+關(guān)注
關(guān)注
5文章
566瀏覽量
48148 -
BGA芯片
+關(guān)注
關(guān)注
1文章
33瀏覽量
13760
發(fā)布評論請先 登錄
揭秘BGA芯片植球技巧,打造完美電子連接!
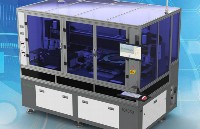
BGA芯片對電路板設(shè)計(jì)的影響
BGA芯片在汽車電子中的應(yīng)用
常見BGA芯片故障及解決方案
BGA芯片的測試方法與標(biāo)準(zhǔn)
BGA芯片的焊接技術(shù)與流程
BGA芯片的封裝類型 BGA芯片與其他封裝形式的比較
BGA芯片的定義和原理
BGA封裝的測試與驗(yàn)證方法
BGA封裝常見故障及解決方法
BGA焊接產(chǎn)生不飽滿焊點(diǎn)的原因和解決方法






 bga芯片拆卸方法
bga芯片拆卸方法












評論