LED芯片失效原理
由于環(huán)境中存在不同程度的靜電,通過(guò)靜電感應(yīng)或直接轉(zhuǎn)移等形式LED芯片的PN結(jié)兩端會(huì)積聚一定數(shù)量的極性相反的靜電電荷,形成不同程度的靜電電壓。當(dāng)靜電電壓超過(guò)LED的承受值時(shí),靜電電荷將以極短的時(shí)間(納秒)在LED芯片的兩個(gè)電極間放電,從而產(chǎn)生熱量。在LED芯片內(nèi)部的導(dǎo)電層、PN結(jié)發(fā)光層形成1400℃以上的高溫,高溫導(dǎo)致局部熔融成小孔,從而造成LED漏電、變暗、死燈,短路等現(xiàn)象。
被靜電擊損后的LED,嚴(yán)重的往往會(huì)造成死燈、漏電。輕微的靜電損傷,LED一般沒(méi)有什么異常,但此時(shí),該LED已經(jīng)有一定的隱患,當(dāng)它受到二次靜電損傷時(shí),那就會(huì)出現(xiàn)暗亮、死燈、漏電的機(jī)率增大。通過(guò)案例分析總結(jié),當(dāng)LED芯片受到輕微的、未被覺(jué)察的靜電損傷,這時(shí)候需要掃描電鏡放大到一萬(wàn)倍以上進(jìn)一步確診,以防更高機(jī)率的失效事故發(fā)生。
led芯片失效原因
1、芯片抗靜電能力差
LED燈珠的抗靜電指標(biāo)高低取決于LED發(fā)光芯片本身,與封裝材料預(yù)計(jì)封裝工藝基本無(wú)關(guān),或者說(shuō)影響因素很小,很細(xì)微;LED燈更容易遭受靜電損傷,這與兩個(gè)引腳間距有關(guān)系,LED芯片裸晶的兩個(gè)電極間距非常小,一般是一百微米以?xún)?nèi)吧,而LED引腳則是兩毫米左右,當(dāng)靜電電荷要轉(zhuǎn)移時(shí),間距越大,越容易形成大的電位差,也就是高的電壓。所以,封成LED燈后往往更容易出現(xiàn)靜電損傷事故。
2、芯片外延缺陷
LED外延片在高溫長(zhǎng)晶過(guò)程中,襯底、MOCVD反應(yīng)腔內(nèi)殘留的沉積物、外圍氣體和Mo源都會(huì)引入雜質(zhì),這些雜質(zhì)會(huì)滲入磊晶層,阻止氮化鎵晶體成核,形成各種各樣的外延缺陷,最終在外延層表面形成微小坑洞,這些也會(huì)嚴(yán)重影響外延片薄膜材料的晶體質(zhì)量和性能。
3、芯片化學(xué)物殘余
電極加工是制作LED芯片的關(guān)鍵工序,包括清洗、蒸鍍、黃光、化學(xué)蝕刻、熔合、研磨,會(huì)接觸到很多化學(xué)清洗劑,如果芯片清洗不夠干凈,會(huì)使有害化學(xué)物殘余。這些有害化學(xué)物會(huì)在LED通電時(shí),與電極發(fā)生電化學(xué)反應(yīng),導(dǎo)致死燈、光衰、暗亮、發(fā)黑等現(xiàn)象出現(xiàn)。因此,芯片化學(xué)物殘留引發(fā)后期高溫導(dǎo)致的焊點(diǎn)開(kāi)路性死燈通常封裝廠很難發(fā)現(xiàn),芯片廠一般會(huì)一筆帶過(guò)而封裝廠只能提升焊線工藝,因此判斷芯片表面的化學(xué)物殘留對(duì)LED封裝廠來(lái)說(shuō)至關(guān)重要。
4、芯片的受損
LED芯片的受損會(huì)直接導(dǎo)致LED失效,因此提高LED芯片的可靠性至關(guān)重要。蒸鍍過(guò)程中有時(shí)需用彈簧夾固定芯片,因此會(huì)產(chǎn)生夾痕。黃光作業(yè)若顯影不完全及光罩有破洞會(huì)使發(fā)光區(qū)有殘余多出的金屬。晶粒在前段制程中,各項(xiàng)制程如清洗、蒸鍍、黃光、化學(xué)蝕刻、熔合、研磨等作業(yè)都必須使用鑷子及花籃、載具等,因此會(huì)有晶粒電極刮傷的情況發(fā)生。
-
led
+關(guān)注
關(guān)注
242文章
23673瀏覽量
670297 -
LED芯片
+關(guān)注
關(guān)注
40文章
622瀏覽量
85067
發(fā)布評(píng)論請(qǐng)先 登錄
離子研磨在芯片失效分析中的應(yīng)用

LED芯片質(zhì)量檢測(cè)技術(shù)之X-ray檢測(cè)

柵極驅(qū)動(dòng)芯片LM5112失效問(wèn)題
芯片失效分析的方法和流程
LED失效分析重要手段——光熱分布檢測(cè)
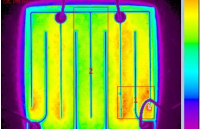
芯片失效機(jī)理之閂鎖效應(yīng)
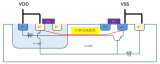
芯片的失效性分析與應(yīng)對(duì)方法

電路失效模式:LED失效模式分析

從外觀到參數(shù),芯片失效的檢測(cè)方法

FIB技術(shù):芯片失效分析的關(guān)鍵工具

IV測(cè)試助力解芯片失效原因

季豐對(duì)存儲(chǔ)器芯片的失效分析方法步驟
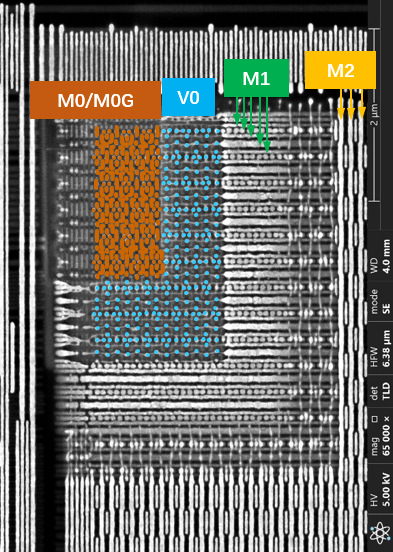
芯片失效分析中常見(jiàn)的測(cè)試設(shè)備及其特點(diǎn)
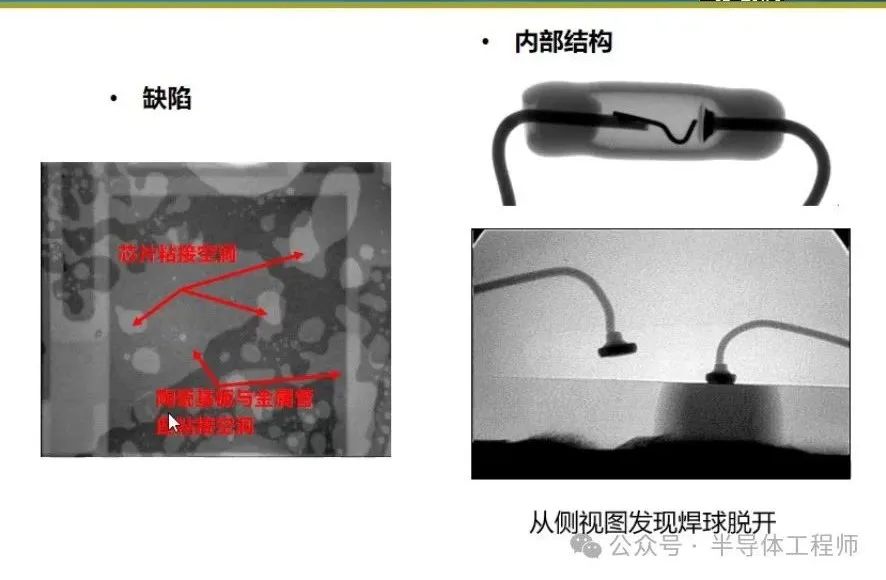





 led芯片失效原理
led芯片失效原理











評(píng)論