你知道嗎?一次失效=30萬報廢?
如果只是錢的話還是小事,嚴重的話可能影響生命安全!——對智能駕駛芯片來說,焊點脫落的緊急情況不亞于剎車失控。
中國電動汽車產業正加速崛起,正處于彎道超車的好機會,我們使用的智能手機、智能手表等消費電子也越來也智能了。然而,高性能芯片封裝卻面臨兩大挑戰:
第一,高溫下芯片、焊點與基板的熱膨脹差異,易導致焊點斷裂,芯片失效;
第二,跌落或震動沖擊,尤其對尺寸高達500×500毫米的智能駕駛芯片來說,稍有顛簸就可能引發焊點脫落,一旦失效,將嚴重威脅自動駕駛系統的安全。
這些可不是簡單的“死機”,而是瞬間從“酷”變“危險”!
面對這些痛點,世強推出了高Tg、低CTE、高可靠性的底部填充方案,全面提升芯片封裝可靠性。
1.精密無縫填充:支持BGA、QFN等高密度封裝,借助毛細作用實現360°無死角滲透,全面覆蓋千余引腳,完美適配超薄、精細化的芯片封裝趨勢。
2.超高可靠性:通過柔性填充,有效緩解熱膨脹差異與震動沖擊,保護焊點,大幅度降低芯片失效風險。
3.優異材料與高適應性:固化速度快,高玻璃化轉變溫度,低粘度,耐濕熱性能強,低模量與低CTE設計顯著減少封裝應力,使芯片在高低溫循環中表現出色,確保長期可靠性。
為滿足多樣化需求,世強除了提供全面填充、邊角綁定兩種方案之外,也推出了可返修膠水,加熱后膠體可剝離,便于芯片檢修與重新焊接,降低返修成本,提升生產效率。
從手機攝像頭模組到智能駕駛芯片,從掃地機器人到電控系統,世強提供的底填膠方案廣泛應用于消費電子、汽車、工業等領域,已經幫助蘋果、特斯拉、英偉達等頭部客戶實現了高可靠性封裝。性能對標國際頂尖,并且兼顧成本優勢。
關于世強硬創:
全球領先的硬件創新研發及供應服務平臺,獲1000多家知名原廠授權代理,鏈接100萬工程師,為ICT、工業自動化、汽車電子、消費電子、物聯網等行業提供IC、元件、電氣、電機、材料、儀器等從方案設計、選型到采購的一站式服務,是電子行業的首選研發與采購平臺。
審核編輯 黃宇
-
封裝
+關注
關注
128文章
8724瀏覽量
145658 -
BGA
+關注
關注
5文章
574瀏覽量
48988 -
qfn
+關注
關注
3文章
210瀏覽量
57149
發布評論請先 登錄
三防漆7大死角終結者!PCBA防水新工藝如何實現360°零盲區防護

安達發APS:工廠的‘時間管理大師’,拖延癥終結者!

手動檢測的終結者:機器人氣密性測試設備來襲
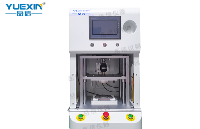
BGA芯片的封裝類型 BGA芯片與其他封裝形式的比較
不同BGA封裝類型的特性介紹
BGA封裝與SMT技術的關系
BGA封裝的測試與驗證方法
BGA封裝對散熱性能的影響
BGA封裝與其他封裝形式比較
BGA封裝技術的發展 BGA封裝的優勢與應用
針對 BGA 封裝的 PCB Layout 關鍵建議






 BGA/QFN封裝難題終結者:360°無死角滲透,返修成本直降
BGA/QFN封裝難題終結者:360°無死角滲透,返修成本直降












評論