來源:芯片封裝綜述
FOPLP 技術目前仍面臨諸多挑戰,包括:芯片偏移、面板翹曲、RDL工藝能力、配套設備和材料、市場應用等方面。
(1)Die 偏移
在尺寸規格方面,方形面板的尺寸一直在增加。目前,方形板的尺寸包括300x300mm、510mmx415mm、515mmx510mm、600mmx600mm、615x625mm、620mmx750mm、700mmx700mm、800x600mm、800x800mm。雖然大尺寸方形面板的成本較低,但更大的尺寸也更容易導致面板翹曲,從而影響精度和芯片偏移,導致良率降低。在molding過程中產生的芯片偏移給RDL分布帶來了非常嚴重的問題。molding過程中芯片位移形成的結構如下圖所示。
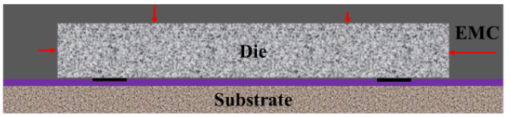
處于流動狀態的EMC會從各個方向對粘貼在面板上的芯片產生沖擊力。這些集中在芯片上的沖擊力大小不相等,從而引發芯片偏移,進而導致需要對覆蓋在EMC層表面的RDL層進行重新布局。同時,在molding過程中,每個芯片都會產生不同的位移,這又使得每個芯片都需要特定的初始RDL層分布,以滿足其電氣要求。在模型構建過程中,理想的芯片分布情況如下圖所示,每個芯片都仍附著在面板上,并由EMC以非常有序的方式封裝,且芯片1至芯片4均未出現芯片位移。
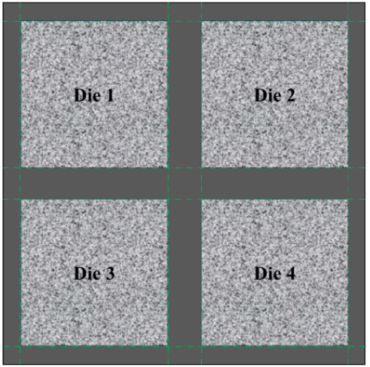
芯片偏移的模型如下圖所示,芯片1至芯片4均因molding過程中EMC流動的沖擊力而產生了不同程度的位移。芯片1在水平方向上發生了右轉位移,芯片2在垂直方向上發生了上移位移,芯片3則發生了順時針旋轉位移。相比之下,芯片4具有由水平方向位移、垂直方向位移和旋轉組成的模塊化芯片偏移。換言之,嵌入EMC層中的芯片在建模過程中具有不同的芯片偏移。
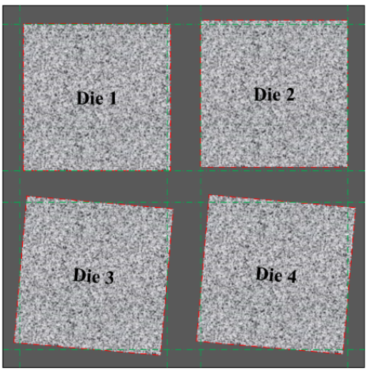
在molding過程中由于各種芯片偏移而導致的RDL層覆蓋在EMC層上時,分布情況異常復雜。為了解決這一棘手問題,引入了自動光學檢查(AOI)流程,以判斷在各種芯片偏移的情況下每個焊盤的確切位置,然后根據AOI結果創建新的RDL lay-out。隨后,根據新的第一RDL層lay-out形成完整的RDL層。如下圖所示,在沒有任何芯片偏移的情況下,每個焊盤周圍的第一RDL層分布完全相同,且每個焊盤的第一RDL層分布的端點位置是固定的。
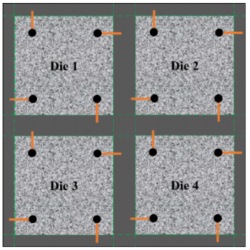
雖然基于建模過程中產生的各種芯片偏移,但引入AOI流程和新的第一RDL層lay-out后,可以覆蓋嵌入EMC層中各種芯片偏移情況的每個pad。如下圖所示,若不進行pad位移校正,每個pad周圍的第一RDL層分布將是不同的,且每個pad的第一RDL層分布的端點將是隨機的。
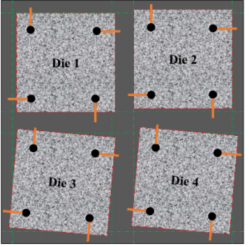
如下圖所示,經過pad位移校正后,每個pad周圍的第一RDL層分布雖然各不相同,但每個pad與第一RDL層分配的端點也是固定的。
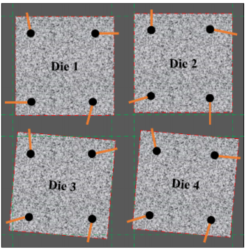
與理想模型相比,上圖所示的每個pad的首個RDL層分布的端點并未改變,從而能夠確保后續的鈍化層圖案化以及RDL層分布可按照最初設計保持不變。
(2)面板翹曲
在FOWLP封裝過程中,由于熱應力和機械應力的累積,會導致重構晶圓翹曲,這會影響后續掩模板光刻工藝的加工精度,并限制布線層密度的提升。而對于FOPLP技術,隨著面板尺寸的增大,面板翹曲問題變得更為顯著,因此在需要極高平整度的工藝階段,如物理氣相沉積(PVD)和光刻階段,可能會被迫中斷封裝流程。翹曲產生的應力很容易集中在中間層或焊點處,導致焊球開裂脫落、中間層分層等問題。在FOPLP技術中,面板翹曲的主要原因被廣泛認為是EMC固化過程中由不同材料的熱膨脹系數(CTE)不匹配導致。此外,還發現了許多其他因素也可能影響面板翹曲,這些因素包括硅的各向異性、EMC的粘彈性和松弛效應、重力、固化后的工藝環境,特別是在溫度急劇變化的工藝環境中,如植球等。 面板尺寸越大,產生的翹曲變形就越顯著。在FOPLP封裝中,面板翹曲已成為限制其發展的重要問題。為了盡可能減小面板翹曲帶來的影響,在每一個加熱工序后都引入了個平整化處理步驟(也稱翹曲矯正、翹曲整平)。
(3)RDL工藝能力
就FOPLP技術的RDL工藝而言,線寬和線距目前已達到10μm/10μm,也有制造商采用5μm到2μm不等的工藝。未來趨勢是朝著與晶圓級封裝相同的工藝能力發展,甚至可能突破面板級封裝的物理限制,達到1μm。如果我們真的能夠實現5μm/5μm線寬/線距的量產,該技術將足以擴展到更多需要高性能、散熱和效率的高端應用中,尤其是涉及有源和無源器件的多芯片和異構異質集成。為了在FOPLP中獲得更高的分辨率,高密度RDL(線寬/線距小于5μm)仍需要克服未來的技術挑戰。例如在FOPLP技術過程中,如何在大面積面板上實現均勻的蝕刻速率和大面積的電鍍均勻性,使線寬/線距從20μm/20μm逐步降至15μm/15μm,進而達到10μm/10μm,仍是一個巨大的挑戰。
-
芯片
+關注
關注
460文章
52529瀏覽量
441288 -
封裝
+關注
關注
128文章
8694瀏覽量
145556 -
工藝
+關注
關注
4文章
685瀏覽量
29467 -
emc
+關注
關注
172文章
4171瀏覽量
187073
原文標題:FOPLP工藝面臨的挑戰
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 FOPLP工藝面臨的挑戰
FOPLP工藝面臨的挑戰











評論