文章來源:老虎說芯
原文作者:老虎說芯
本文介紹了半導體制造中平坦化工藝存在的缺陷。
CMP是半導體制造中關鍵的平坦化工藝,它通過機械磨削和化學腐蝕相結合的方式,去除材料以實現平坦化。然而,由于其復雜性,CMP工藝中可能會出現多種缺陷。這些缺陷通常可以分為機械、化學和表面特性相關的類別。
CMP工藝中的缺陷多種多樣,涵蓋了機械、化學以及表面特性等多個方面。這些缺陷不僅會影響當前的平坦化效果,還會對后續的集成電路制造工藝產生深遠的影響。通過深入理解這些缺陷的成因,并采取針對性的工藝優化措施,可以顯著提高CMP工藝的良率和可靠性。
1. 機械相關的缺陷
劃痕(Scratches):
原因:劃痕是CMP工藝中最常見的機械缺陷之一。它通常是由于拋光液中的大顆粒或拋光墊上的硬質雜質在研磨過程中對晶圓表面造成的。
影響:劃痕會導致晶圓表面的結構受損,可能影響后續的光刻和蝕刻工藝,導致電路失效。
控制措施:可以通過使用更高純度的拋光液、更頻繁地更換拋光墊、以及優化工藝參數來減少劃痕的產生。
顆粒沾污(Particle Contamination):
原因:在CMP過程中,拋光液中的顆粒物可能附著在晶圓表面,無法完全清除。
影響:這些顆粒可能會成為電路失效的種子,尤其是在后續工藝中,可能導致短路或開路等問題。
控制措施:通過優化清洗步驟、使用高效過濾系統、以及優化拋光液的成分可以減少顆粒沾污。
2. 化學相關的缺陷
非均勻腐蝕(Non-uniform Etching):
原因:在CMP過程中,如果拋光液的化學成分分布不均,或是化學反應速度不均勻,可能導致晶圓表面局部腐蝕程度不同。
影響:非均勻腐蝕會導致表面平整度差,從而影響后續光刻精度,最終影響器件性能。
控制措施:通過優化拋光液的成分、流速、以及拋光墊的壓力分布,可以提高腐蝕的均勻性。
表面化學污染(Surface Chemical Contamination):
原因:拋光液或拋光墊中含有的化學物質可能在CMP后殘留在晶圓表面。
影響:這些殘留化學物質可能導致后續工藝中的缺陷,例如光刻膠無法正常涂覆或蝕刻不均勻。
控制措施:通過優化清洗工藝、使用適當的化學清洗劑、以及控制拋光液的化學成分,可以減少表面化學污染。
3. 表面特性相關的缺陷
全局平坦度問題(Global Planarity Issues):
原因:全局平坦度問題可能由于CMP過程中材料去除不均勻、拋光墊磨損不均或壓力分布不均導致。
影響:全局平坦度問題會影響整個晶圓的平整度,從而影響后續多層布線工藝的精度。
控制措施:可以通過優化拋光墊的選擇、調節壓力分布、以及實時監控材料去除速率來改善全局平坦度。
表面粗糙度(Surface Roughness):
原因:CMP過程中,如果拋光墊或拋光液的特性不合適,可能導致晶圓表面出現微小的粗糙度。
影響:表面粗糙度過大會影響后續光刻工藝的分辨率,導致器件性能下降。
控制措施:通過選擇合適的拋光墊和拋光液、優化拋光參數,可以降低表面粗糙度。
-
CMP
+關注
關注
6文章
157瀏覽量
26692 -
缺陷
+關注
關注
0文章
12瀏覽量
12192 -
晶圓制造
+關注
關注
7文章
294瀏覽量
24624
原文標題:晶圓制造CMP缺陷淺析
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
半導體國產替代材料 | CMP化學機械拋光(Chemical Mechanical Planarization)

全球CMP拋光液大廠突發斷供?附CMP拋光材料企業盤點與投資邏輯(21361字)

PanDao:確認缺陷等級并用于加工
PEEK與PPS注塑CMP固定環的性能對比與工藝優化

一文搞懂波峰焊工藝及缺陷預防
化學機械拋光技術(CMP)的深度探索
如何使用cmp進行數據庫管理的技巧
cmp與其他數據處理工具的比較
cmp在數據處理中的應用 如何優化cmp性能
CMP的平坦化機理、市場現狀與未來展望

A/B型缺陷和D/V類缺陷介紹






 CMP工藝中的缺陷類型
CMP工藝中的缺陷類型

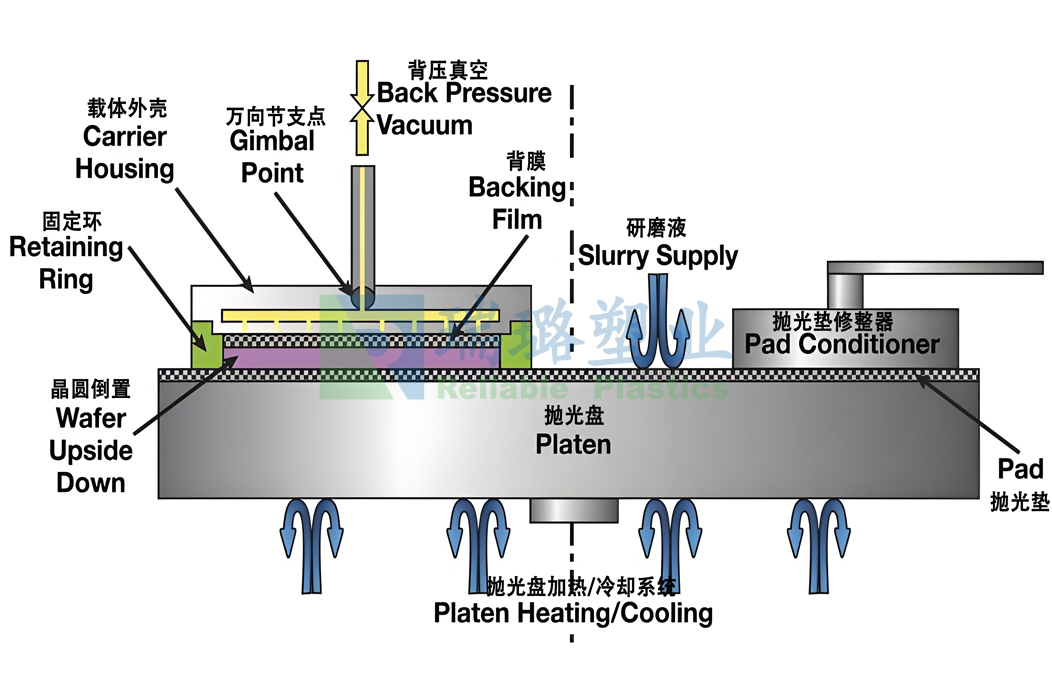










評論