TGV(Through Glass Via)和TSV(Through Silicon Via)是兩種用于實(shí)現(xiàn)不同層面之間電氣連接的技術(shù)。
TGV技術(shù)通過(guò)在玻璃基板上制作垂直貫通的微小通孔,并在通孔中填充導(dǎo)電材料,實(shí)現(xiàn)電氣連接。TGV以高品質(zhì)硼硅玻璃、石英玻璃為基材,通過(guò)一系列工藝步驟如種子層濺射、電鍍填充、化學(xué)機(jī)械平坦化等實(shí)現(xiàn)3D互聯(lián)。這種技術(shù)具有優(yōu)良的高頻電學(xué)特性,機(jī)械穩(wěn)定性強(qiáng),且制作成本相對(duì)較低。TGV在光通信、射頻、微波、微機(jī)電系統(tǒng)、微流體器件和三維集成領(lǐng)域有廣泛的應(yīng)用前景。
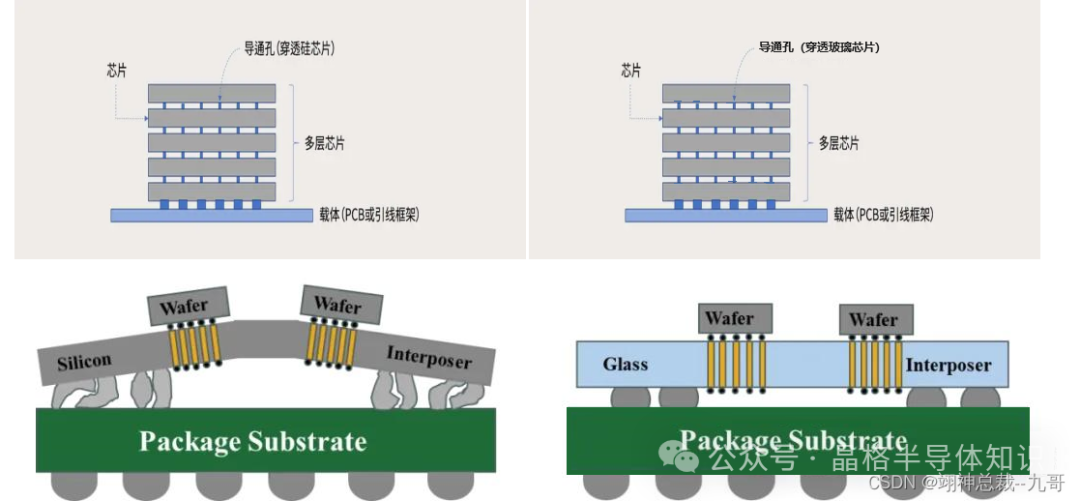
TSV技術(shù)則是在硅晶圓上制作垂直貫通的微小通孔,并在通孔中填充導(dǎo)電材料,實(shí)現(xiàn)芯片內(nèi)部不同層面之間的電氣連接。這種技術(shù)能夠顯著提高芯片內(nèi)部的互連密度,降低信號(hào)傳輸延遲,提高系統(tǒng)的整體性能。TSV技術(shù)廣泛應(yīng)用于存儲(chǔ)器、處理器、圖像傳感器等高性能芯片中,如用于堆疊式DRAM的制作,實(shí)現(xiàn)更高的存儲(chǔ)容量和更快的數(shù)據(jù)傳輸速度。
TGV的主要工藝步驟包括:
1. 基板準(zhǔn)備:選擇合適的玻璃基板,基板需要具備良好的尺寸穩(wěn)定性、熱膨脹系數(shù)匹配性和電學(xué)性能。
2. 孔洞制作:通過(guò)激光加工、化學(xué)腐蝕或機(jī)械加工等方法,在玻璃基板上制作微小孔洞,用于連接芯片和外部電路。
3. 金屬填充:在孔洞中填充金屬材料,通常使用銅、銀或金等導(dǎo)電性能良好的材料。
4. 磨平與拋光:通過(guò)研磨和拋光等工藝,將填充金屬與基板表面磨平,確保信號(hào)傳輸?shù)目煽啃院头庋b的平整度。
5. 電鍍:在填充金屬的表面進(jìn)行電鍍,增加導(dǎo)電性能和保護(hù)層。
6. 后處理:進(jìn)行封裝后的檢測(cè)和測(cè)試,確保TGV封裝的質(zhì)量和可靠性,并進(jìn)行封裝外觀的檢查和包裝工藝的處理。
晶格半導(dǎo)體-提供高純度單晶硅、多晶硅材料,并可定制加工各種類型硅部件、硅筒、硅電極、硅環(huán)、硅錠、硅管、硅毛坯材料。17826693981
而TSV的主要工藝步驟則包括:
1. 硅基底準(zhǔn)備:通常以覆蓋有二氧化硅(SiO?)層的硅基底開始,這層SiO?可以通過(guò)熱氧化或等離子體增強(qiáng)化學(xué)氣相沉積(PECVD)方法形成。
2. 光刻:在SiO?層上涂布光刻膠,然后通過(guò)曝光和顯影步驟進(jìn)行圖案化,以定義硅蝕刻的區(qū)域。
3. 硅蝕刻:使用光刻圖案作為掩模,在硅基底中蝕刻出通孔。
4. 去除光刻膠:蝕刻完成后,去除光刻膠,為接下來(lái)的層沉積步驟做準(zhǔn)備。
5. 沉積絕緣層和阻擋層:在孔壁上沉積一層二氧化硅作為絕緣層,防止電子竄擾;然后沉積一層導(dǎo)電的阻擋層,以便后續(xù)的銅鍍層能更好地附著,并防止電子遷移。
6. 銅電鍍:在絕緣層和阻擋層上進(jìn)行銅鍍層,填充TSV孔洞。
7. 退火:電鍍完成后,進(jìn)行退火工序,釋放應(yīng)力。
玻璃,尤其是用于電路板的玻璃基材,因其高硬度、高溫穩(wěn)定性、低熱膨脹系數(shù)和優(yōu)異的絕緣性能而表現(xiàn)出色。這些特性使得玻璃基材電路板能夠在高溫環(huán)境下穩(wěn)定工作,并具備較好的機(jī)械強(qiáng)度和穩(wěn)定性。在信號(hào)完整性方面,玻璃基材的低介電常數(shù)和低損耗角正切意味著信號(hào)在電路板上傳輸時(shí)損耗較小,從而提供了更好的信號(hào)完整性和較低的信號(hào)衰減。
硅,作為半導(dǎo)體材料,在微電子行業(yè)中占據(jù)核心地位。硅基芯片和器件的制造對(duì)于現(xiàn)代電子設(shè)備至關(guān)重要。在信號(hào)完整性方面,硅材料的高純度、穩(wěn)定性和可控性是關(guān)鍵因素。通過(guò)精確的工藝控制和設(shè)計(jì),硅基芯片能夠?qū)崿F(xiàn)高速、低噪聲和低失真的信號(hào)傳輸,確保信號(hào)的完整性和準(zhǔn)確性。
TSV和TGV 工藝成本
TSV(Through Silicon Via,硅通孔)和TGV(一種玻璃基巨量互通技術(shù))是兩種不同的封裝技術(shù),它們各自具有獨(dú)特的成本結(jié)構(gòu)和特點(diǎn)。
TSV技術(shù)的成本結(jié)構(gòu)中,通孔蝕刻占比最高,達(dá)到44%,其次是通孔填充和減薄,分別為25%和24%。TSV為HBM核心工藝,成本占比接近30%,在HBM的3D封裝中成本占比最高。此外,TSV形成和顯露的成本占比也相對(duì)較高,超過(guò)了前/后道工藝的成本占比。
相較之下,TGV技術(shù)是對(duì)TSV的升級(jí),其制作成本相較于硅基轉(zhuǎn)接板只有1/8。這主要得益于TGV技術(shù)無(wú)需制作絕緣層,降低了工藝復(fù)雜度和加工成本。此外,玻璃材料的優(yōu)良電學(xué)、熱學(xué)和力學(xué)性能也使其在應(yīng)用中具有顯著優(yōu)勢(shì)。TGV技術(shù)作為應(yīng)用于晶圓級(jí)封裝領(lǐng)域的新興縱向互連技術(shù),有望實(shí)現(xiàn)芯片之間距離最短、間距最小的互聯(lián)。
-
芯片
+關(guān)注
關(guān)注
459文章
52355瀏覽量
438709 -
工藝
+關(guān)注
關(guān)注
4文章
679瀏覽量
29352 -
玻璃基板
+關(guān)注
關(guān)注
1文章
100瀏覽量
10740 -
TSV
+關(guān)注
關(guān)注
4文章
121瀏覽量
81877
原文標(biāo)題:什么是TGV和TSV技術(shù)
文章出處:【微信號(hào):深圳市賽姆烯金科技有限公司,微信公眾號(hào):深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
TSV工藝流程與電學(xué)特性研究

先進(jìn)封裝之TSV及TGV技術(shù)初探

玻璃基板時(shí)代,TGV技術(shù)引領(lǐng)基板封裝
TGV2566-SM MMIC VCO
3D封裝與硅通孔(TSV)工藝技術(shù)

什么是TSV封裝?TSV封裝有哪些應(yīng)用領(lǐng)域?
TSV關(guān)鍵工藝設(shè)備及特點(diǎn)
TSV的工藝流程和關(guān)鍵技術(shù)綜述
先進(jìn)封裝之TSV及TGV技術(shù)初探(二)
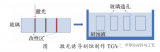
開啟高性能芯片新紀(jì)元:TSV與TGV技術(shù)解析

一文了解玻璃通孔(TGV)技術(shù)
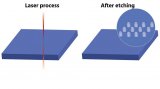
玻璃通孔(TGV)技術(shù)深度解析
TGV技術(shù)中成孔和填孔工藝新進(jìn)展
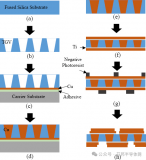
TSV以及博世工藝介紹






 TGV和TSV技術(shù)的主要工藝步驟
TGV和TSV技術(shù)的主要工藝步驟












評(píng)論