文章來源:老虎說芯
原文作者:老虎說芯
本文介紹了封裝中打線鍵合的概念、流程、關(guān)鍵點與可靠性等。
一、什么是打線鍵合(Wire Bonding)?
打線鍵合就是將芯片上的電信號從芯片內(nèi)部“引出來”的關(guān)鍵步驟。我們要用極細(xì)的金屬線(多為金線、鋁線或銅線)將芯片的焊盤(bond pad)和支架(如引線框架或基板)之間做電連接。
可以理解為:
“芯片是大腦,但得靠血管(引線)把信號輸送出去,不然再聰明也干不了事。”
二、打線鍵合的核心目的:
建立電連接:芯片內(nèi)部與封裝外部間的信號通道
提供可靠性:滿足電性能、機(jī)械穩(wěn)定性要求
保證生產(chǎn)良率:為后續(xù)封裝打好基礎(chǔ)
三、打線鍵合的類型
雖然有多種方式(例如熱壓鍵合、超聲鍵合、熱超聲復(fù)合鍵合等),這里我們主要講的是熱超聲金線球焊(Ball Bonding),這是最常見的一種,特別適合鋁焊盤+金線的組合。
四、打線鍵合的完整9步流程
步驟 1:準(zhǔn)備金線
金線從打線機(jī)線軸中牽出,經(jīng)過打線劈刀(Capillary)底部,露出短短的線尾。
步驟 2:形成“自由空氣球”(FAB)
打線機(jī)會用“放電”的方式,在金線尾部打出一個金球。這個球是在空氣中自然形成的,因此叫自由空氣球(Free Air Ball)。就像是用電火花把金線的尾端熔掉形成一個金珠。
步驟 3:壓球到芯片焊盤
劈刀帶著金球?qū)?zhǔn)芯片上的焊盤(bond pad),緩緩向下壓,讓金球和焊盤貼合。
步驟 4:完成第一個鍵合點(金球鍵合)
壓好后,打線機(jī)會開始施加:一定的壓力、一定量的超聲波振動能量、控制作用時間。這樣做的目的是讓金球與芯片焊盤之間的金屬發(fā)生塑性變形+微觀摩擦焊接,最終牢牢焊在一起。
步驟 5:拉金線
劈刀抬起,同時拉動金線,從芯片焊盤開始畫出一段弧形線,將線帶到目標(biāo)點:支架的焊盤(lead/frame pad 或 PCB pad)。
步驟 6:壓線到支架焊盤
劈刀移動到支架焊盤位置,再次往下壓線。
步驟 7:形成第二個鍵合點(魚尾鍵合)
再次施加:壓力、超聲能量、時間控制。這次不是壓球,而是將金線壓成“魚尾”狀貼附到支架焊盤上,完成第二端焊接。
步驟 8:切線并保留線尾
劈刀繼續(xù)抬起,并在移動中切斷金線,在支架焊盤上留下“魚尾”,同時在劈刀口留下新的線尾,為下一根線準(zhǔn)備。
步驟 9:循環(huán)進(jìn)行下一根線的鍵合
回到第1步,周而復(fù)始,直到所有焊盤都連線完成。
五、打線工藝的四大核心參數(shù)
| 溫度(Bond Temp) | 提高金屬塑性,改善焊接效果 | 一般為100~150°C |
| 壓力(Bond Force) | 保證足夠接觸和變形 | 太小焊不牢,太大會壓壞焊盤 |
| 超聲能量(Ultrasonic Power) | 引發(fā)金屬分子間摩擦/擴(kuò)散 | 控制能量大小避免“虛焊”或“飛線” |
| 超聲時間(Bond Time) | 決定超聲作用時長 | 配合能量使用,不能太短或太長 |
| 參數(shù) | 作用 | 舉例說明 |
|---|
六、打線質(zhì)量的關(guān)鍵控制點
金球尺寸控制:
金球直徑通常為60μm
厚度約20μm
太大易短路,太小焊接不牢
接合強(qiáng)度測試:
剪切力(Shear/Push Force):芯片端金球推力 >20克
拉力(Pull Force):整條線拉斷前應(yīng) >109克力
這些測試是驗證焊點強(qiáng)度是否達(dá)標(biāo)的標(biāo)準(zhǔn)動作,不能忽略。
七、環(huán)境和工藝注意事項
1. 濕氣控制:
若打線作業(yè)延遲超72小時,要進(jìn)行低溫烘焙,把吸附的濕氣烤掉。否則在封裝注塑(Molding)時,水汽膨脹會導(dǎo)致封裝開裂或界面脫層
2. 表面潔凈性:
焊盤若有污染或氧化層,會直接導(dǎo)致打線失敗(金球脫落、魚尾不粘)
必要時可使用等離子清洗機(jī)進(jìn)行表面活化處理,恢復(fù)焊接性
八、打線后的可靠性隱患有哪些?
| 金球脫落 | 焊盤氧化、溫度低、超聲不足 | 表面清潔、調(diào)整參數(shù) |
| 金線斷裂 | 金線受損、弧度過大 | 優(yōu)化拉線路徑、換線材 |
| 魚尾翹起 | 壓力不足、支架氧化 | 加壓、清洗支架表面 |
| 接觸電阻大 | 焊點不飽滿、焊接不牢 | 調(diào)整球徑、超聲能量 |
| 問題現(xiàn)象 | 可能原因 | 解決辦法 |
|---|
九、打線在整個封裝流程的位置
1. 晶圓切割 → 2. 芯片貼片 → 3. 銀膠烘焙 → 4. 打線鍵合 → 5. 封裝成型 → 6. 電性測試 → 7. 成品分選
總結(jié)
打線鍵合是芯片封裝中最細(xì)致、最關(guān)鍵的工序之一,涉及機(jī)械精度、材料性能、熱/超聲參數(shù)控制等多方面的綜合考量。金線雖細(xì)如發(fā)絲,但卻承擔(dān)著整個芯片與外部世界溝通的重任。
-
芯片封裝
+關(guān)注
關(guān)注
11文章
578瀏覽量
31473 -
焊盤
+關(guān)注
關(guān)注
6文章
591瀏覽量
38909 -
鍵合
+關(guān)注
關(guān)注
0文章
82瀏覽量
8106
原文標(biāo)題:芯片封裝中的打線鍵合(Wire Bonding)
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
介紹芯片鍵合(die bonding)工藝
芯片封裝鍵合技術(shù)各種微互連方式簡介教程
芯片封裝與芯片打線
優(yōu)化封裝之鍵合線封裝中的兩個主要不連續(xù)區(qū)
如何優(yōu)化封裝以滿足SerDes應(yīng)用鍵合線封裝規(guī)范?
芯片封裝中銅絲鍵合技術(shù)

鍵合線等效電阻的IGBT模塊老化失效研究
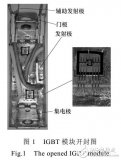
優(yōu)化封裝以滿足SerDes應(yīng)用鍵合線封裝規(guī)范

芯片封裝鍵合技術(shù)工藝流程以及優(yōu)缺點介紹

芯片封裝中的四種鍵合方式:技術(shù)演進(jìn)與產(chǎn)業(yè)應(yīng)用






 芯片封裝中的打線鍵合介紹
芯片封裝中的打線鍵合介紹

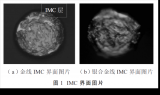













評論