為了加速影像數(shù)據(jù)處理, 業(yè)界研發(fā)了在互補(bǔ)金屬氧化物半導(dǎo)體(CMOS)影像傳感器中配備嵌入式動(dòng)態(tài)隨機(jī)存取存儲(chǔ)器(DRAM),推出了配備DRAM的三層堆疊式CMOS影像傳感器,SONY是最早發(fā)布這一產(chǎn)品的廠家,這款型號(hào)為IMX400的三層堆疊式感光元件(Exmor RS)是專為智能手機(jī)而打造的。
SONY的堆疊式CMOS傳感器元件
Sony的Xperia XZ Premium和Xperia XZ兩款旗艦級(jí)智能手機(jī)搭載了具有960fps畫面更新率的Motion Eye相機(jī)模組。
這款三層堆疊的CMOS影像傳感器(CIS)被面對(duì)背地安裝在DRAM上,使得DRAM與影像訊號(hào)處理器(ISP)面對(duì)面接在一起。
Sony三層堆疊式CMOS影像傳感器的芯片橫截面
Sony在其較早的19Mp影像傳感器中使用雙模擬/數(shù)位轉(zhuǎn)換器(ADC),為畫素資料進(jìn)行數(shù)字化。而今,該公司使用4層ADC的結(jié)構(gòu)提高讀取速度,同時(shí)也改善了處理能力。DRAM則用于暫時(shí)儲(chǔ)存高速數(shù)據(jù),然后再以傳感器介面的最佳速率輸出。該設(shè)計(jì)使其能以1/120秒讀取1,930萬畫素的靜態(tài)影像,而在影片模式下可達(dá)到1,000fps的畫面更新率,較以往產(chǎn)品的靜態(tài)影像與動(dòng)態(tài)影片分別提高了4倍和8倍的速度。Sony可說是再次將手機(jī)相機(jī)的功能推至極限。
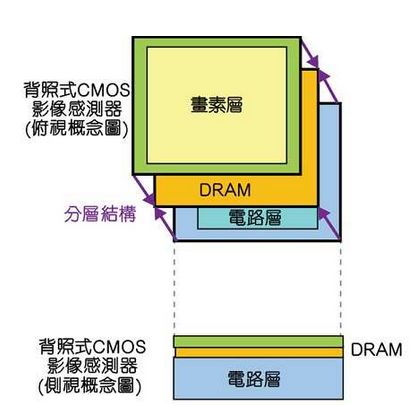
Sony新開發(fā)配備DRAM的三層堆疊式CMOS影像傳感器
3D堆疊技術(shù)
3D 堆疊技術(shù)是把不同功能的芯片或結(jié)構(gòu), 通過堆疊技術(shù)和過孔互連等微機(jī)械加工技術(shù), 使其在 Z軸方向上形成立體集成和信號(hào)連通以及圓片級(jí)、芯片級(jí)、硅帽封裝等封裝和可靠性技術(shù)為目標(biāo)的三維立體堆疊加工技術(shù), 用于微系統(tǒng)集成, 是繼片上系統(tǒng)( SOC) 、多芯片模塊( MCM ) 之后發(fā)展起來的系統(tǒng)級(jí)封裝( SiP/ SoP) 的先進(jìn)制造新技術(shù)。
微電子的模塊已經(jīng)實(shí)現(xiàn)3D圓片級(jí)封裝( WLP)的 系統(tǒng)級(jí)封 裝( SiP )技術(shù),例如, CIS RF模塊、M EM S封裝、標(biāo)準(zhǔn)器件封裝,已有量產(chǎn), 2009年開始3D TSV堆疊時(shí)代( 3D TSV Stack Era )的到來,模塊化芯片、閃存及DRAM ,通過堆疊以獲得增強(qiáng)的內(nèi)存容量。
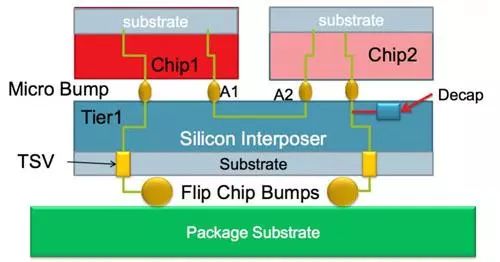
3D堆疊的主要形式和分類
目前有多種基于 3D 堆疊方法, 主要包括: 芯片與芯片的堆疊( D2D) 、芯片與圓片的堆疊( D2W ) 以及圓片與圓片的堆疊( W2W)。
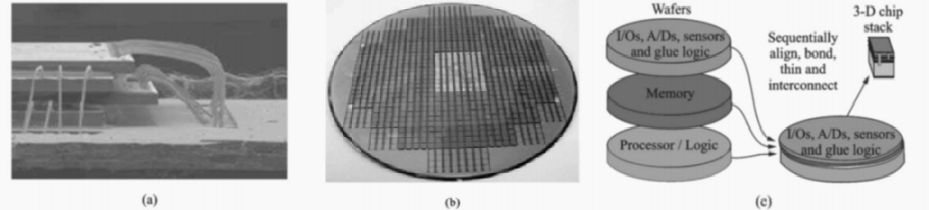
D2D堆疊方式是當(dāng)前系統(tǒng)級(jí)封裝( SiP)方式的主要互聯(lián)方式,該堆疊方法主要利用引線鍵合的方式,實(shí)現(xiàn)3D方向芯片間的互聯(lián),如圖( a)所示。D2D方式雖然可以實(shí)現(xiàn)3D堆疊,提高系統(tǒng)集成度,但由于主要使用引線鍵合方式互聯(lián),限制了系統(tǒng)集成度進(jìn)一步提高,并由于引線會(huì)引入寄生效應(yīng),降低了3D系統(tǒng)的性能;
D2W堆疊方式利用芯片分別與圓片相應(yīng)功能位置實(shí)現(xiàn)3D堆疊,如圖( b)所示,該種方式主要利用flip-chip(倒裝)方式和bump(置球)鍵合方式,實(shí)現(xiàn)芯片與圓片電極的互聯(lián),該方式與D2D方式相比,具有更高的互聯(lián)密度和性能,并且與高性能的flip-chip鍵合機(jī)配合,可以獲得較高的生產(chǎn)效率;
W2W堆疊方式利用圓片與圓片鍵合,實(shí)現(xiàn)3D堆疊,在圓片鍵合過程中,利用TSV實(shí)現(xiàn)信號(hào)的互聯(lián),如圖( c)所示,該種方式具有互聯(lián)密度高、成本低并且可同時(shí)實(shí)現(xiàn)圓片級(jí)封裝( WLP)的優(yōu)點(diǎn),可以實(shí)現(xiàn)AD、I/ O、傳感器等多功能器件的混合集成。
對(duì)于D2W和W2W堆疊方式,從生產(chǎn)效率的角度, W 2W方式效率最高,但從成品率角度考慮,由于D2W方式可以通過篩選,實(shí)現(xiàn)合格芯片( Know good die, KGD)之間的堆疊,因此成品率較高;而W2W方式,無法通過實(shí)現(xiàn)事先篩選,會(huì)嚴(yán)重影響堆疊的成品率。
對(duì)于W2W堆疊方式,必須嚴(yán)格控制芯片及3D堆疊工藝的成品率,否則,隨著堆疊層數(shù)的增加,成品率將大幅下降。 對(duì)于一個(gè)需要3層的堆疊工藝來說,必須將圓片成品率及層疊成品率均控制在98%以上,才可能獲得90%以上的3D堆疊成品率。
層間互聯(lián)技術(shù)——TSV
從微電子技術(shù)的發(fā)展趨勢(shì)看,基于TSV技術(shù)的3D堆疊技術(shù),將是微電子技術(shù)發(fā)展的必然趨勢(shì),但也面臨許多技術(shù)挑戰(zhàn),如TSV技術(shù)、超薄片加工技術(shù)(臨時(shí)鍵合、減薄等)、異質(zhì)鍵合技術(shù)、層間對(duì)準(zhǔn)技術(shù)等等,其中, TSV技術(shù)最為關(guān)鍵。
穿透硅通孔( TSV)將在先進(jìn)的三維集成電路( 3D IC)設(shè)計(jì)中提供多層芯片之間的互連功能,是通過在芯片和芯片之間、晶圓和晶圓之間制作垂直導(dǎo)通,實(shí)現(xiàn)芯片之間互連的最新技術(shù)。與以往的IC封裝鍵合和使用凸點(diǎn)的疊加技術(shù)不同, TSV能夠使芯片在三維方向堆疊的密度最大、外形尺寸最小,并且大大改善芯片速度和降低功耗的性能。
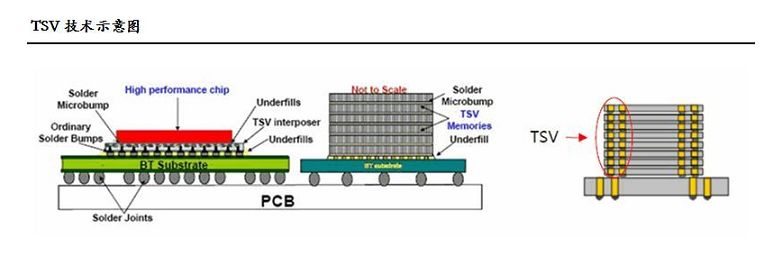
采用硅通孔技術(shù)( TSVs)的堆疊器件
TSV與目前應(yīng)用于多層互連的通孔有所不同,一方面TSV通孔的直徑通常僅為為1~100 μm ,深度10~400 μm,為集成電路或者其他多功能器件的高密度混合集成提供可能;另一方面,它們不僅需要穿透組成疊層電路的各種材料,還需要穿透很厚的硅襯底,因此對(duì)通孔的刻蝕技術(shù)具有較高的要求。目前制造商們正在考慮的多種三維集成方案,也需要多種尺寸的T SV與之配合。 等離子刻蝕技術(shù)已經(jīng)廣泛應(yīng)用于存儲(chǔ)器和MEM S生產(chǎn)的深硅刻蝕工藝,同樣也非常適合于制造TSV。
利用3D堆疊技術(shù)實(shí)現(xiàn)微系統(tǒng),是未來發(fā)展的必然趨勢(shì),是突破摩爾定律發(fā)展的必然選擇。其中利用MEMS技術(shù)實(shí)現(xiàn)TSV互連,是該技術(shù)的核心技術(shù),必須重點(diǎn)解決與突破。
-
傳感器
+關(guān)注
關(guān)注
2562文章
52504瀏覽量
763269 -
CMOS
+關(guān)注
關(guān)注
58文章
5978瀏覽量
238004 -
TSV
+關(guān)注
關(guān)注
4文章
119瀏覽量
81829
原文標(biāo)題:CMOS圖像傳感器的3D堆疊技術(shù)
文章出處:【微信號(hào):WW_CGQJS,微信公眾號(hào):傳感器技術(shù)】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
索尼內(nèi)嵌DRAM緩存CMOS傳感器曝光 Xperia旗艦機(jī)首發(fā)
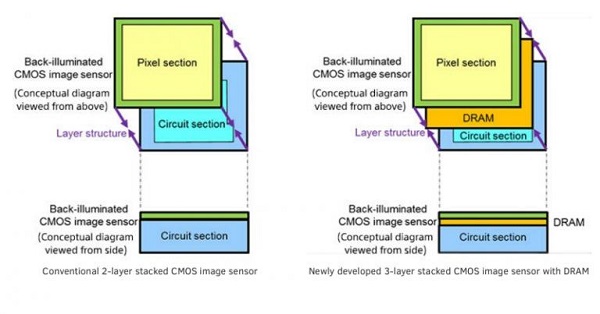
索尼圖像傳感器三層堆疊技術(shù)揭秘詳解
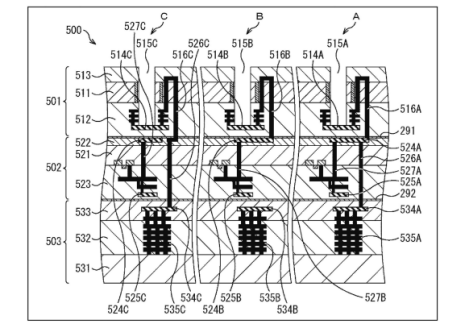
堆疊圖像傳感器在圖像傳感器架構(gòu)演進(jìn)方面的最新成果
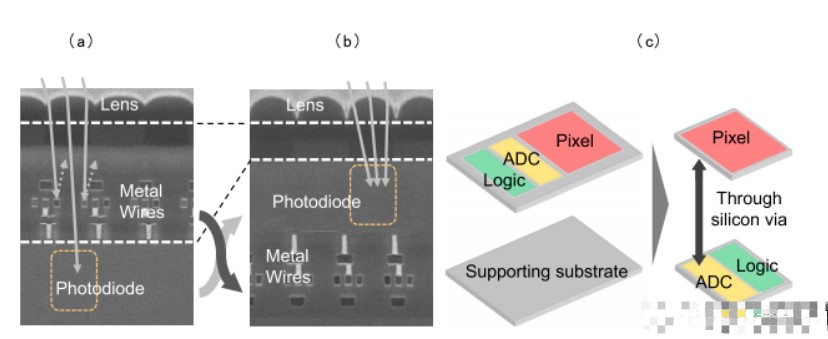
iPhone15機(jī)型基本敲定,融入靈動(dòng)島和堆疊式攝像頭
Cypress新型CMOS影像傳感器飛上太空
給你們好看!小米6發(fā)布時(shí)間曝光:驍龍835+三層堆疊式相機(jī) 可你還是搶不到啊
每秒可拍攝1000張照片——三星三層堆疊式圖像傳感器
佳能新專利:堆疊CMOS傳感器,讓相機(jī)擁有更快的數(shù)據(jù)處理速度
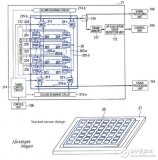
三星官網(wǎng)介紹一個(gè)全新的ISOCELL傳感器:能拍攝960幀的慢動(dòng)作視頻

三星電子推出新款圖像傳感器 可實(shí)現(xiàn)每秒960幀的超級(jí)慢動(dòng)作攝影
尼康成功開發(fā)全新堆疊式CMOS傳感器
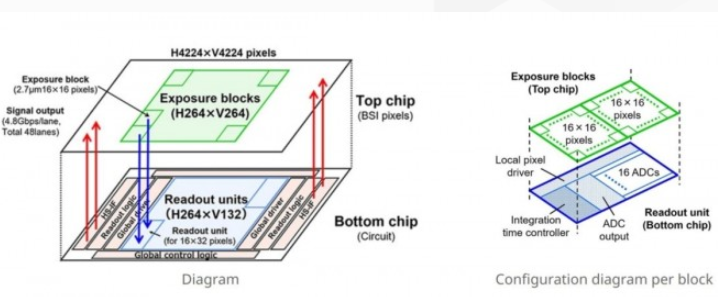
堆疊式圖像傳感器的發(fā)展
豪威集團(tuán)重磅推出三層堆疊式BSI 全局快門(GS)圖像傳感器OG0TB
消息稱三星正為蘋果iPhone開發(fā)三層堆疊式相機(jī)傳感器






 配備DRAM的三層堆疊式CMOS影像傳感器介紹
配備DRAM的三層堆疊式CMOS影像傳感器介紹










評(píng)論