北京航天控制儀器研究所
胡啟方、李男男、梅崴、楊博、邢朝洋
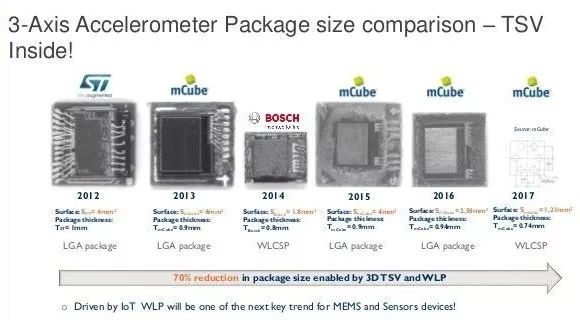
1、概述
微電子技術(shù)的發(fā)展方向是更高的集成度、更小體積、更低功耗、更低的成本。在超越摩爾時(shí)代(More than Moore),為了滿(mǎn)足微電子器件的集成度的進(jìn)一步提高 ,出現(xiàn)了同構(gòu)堆疊集成、異構(gòu)集成等三維集成技術(shù)。MEMS慣性微系統(tǒng)的三維集成技術(shù)是將傳統(tǒng)MINU(微型慣性測(cè)量系統(tǒng))的MEMS加速度計(jì)、MEMS陀螺儀、接口電路芯片、中央控制芯片等組件通過(guò)TSV轉(zhuǎn)接技術(shù),在硅基板上進(jìn)行互聯(lián)以及三維堆疊集成,最終實(shí)現(xiàn)MEMS慣性微系統(tǒng)在封裝內(nèi)集成。MEMS慣性器件的全硅化工藝技術(shù)以及圓片級(jí)真空封裝工藝技術(shù)是下一代微型慣性芯片的發(fā)展方向。MEMS慣性器件采用全硅化工藝加工可以最大程度的抑制由于材料熱失配應(yīng)力導(dǎo)致的零位漂移、標(biāo)度因數(shù)漂移,提高M(jìn)EMS慣性器件的溫度穩(wěn)定性。而采用MEMS圓片級(jí)真空封裝對(duì)MEMS慣性器件進(jìn)行零級(jí)封裝有利于降低MEMS器件的整體體積、成本,實(shí)現(xiàn)倒裝焊、提高成品率。采用基于TSV的MEMS慣性器件三維集成技術(shù)還能夠減少M(fèi)EMS結(jié)構(gòu)和ASIC電路的互聯(lián)路徑,穩(wěn)定MEMS慣性器件前級(jí)的寄生參數(shù)并抑制前級(jí)千擾噪聲 。
2、軍事需求分析
微小型系統(tǒng)(微納衛(wèi)星、微小型飛行器、微小型地面機(jī)器人及微小型水下航行器等)以及低成本制導(dǎo)武器(批量大、成本低、制導(dǎo)精度較高的各類(lèi)靈巧彈藥、精確制導(dǎo)炸彈和戰(zhàn)術(shù)導(dǎo)彈)等是未來(lái)軍事高科技的重要發(fā)展方向之一,是取得未來(lái)高技術(shù)條件下戰(zhàn)爭(zhēng)勝利的重要手段。微小型導(dǎo)航、制導(dǎo)與控制系統(tǒng)是新一代微小型系統(tǒng)發(fā)展以及低成本制導(dǎo)武器的核心技術(shù),也是制約其廣泛使用主要瓶頸之一。硅基MEMS微慣性器件,以及結(jié)合微系統(tǒng)集成制造技術(shù)制作的微慣性測(cè)量單元(Micro Inertial Measurement Unit,MIMU),體積小 成本低 、精度較高且便于大批量生產(chǎn),微小型導(dǎo)航制導(dǎo)系統(tǒng)的共性核心技術(shù)。在精確制導(dǎo)化武器裝備以及民用領(lǐng)域具備很大廣闊的應(yīng)用需求,是當(dāng)前國(guó)際研究熱點(diǎn)。
MEMS慣性器件與IC工藝兼容的生產(chǎn)方式?jīng)Q定了其具有靈活的封裝形式,但同時(shí)MEMS的封裝不像IC封裝那樣有相對(duì)統(tǒng)一的封裝標(biāo)準(zhǔn)、外形尺寸等。其集成方式發(fā)展的初期階段的技術(shù)特征包括硅-玻璃鍵合MEMS工藝方案、管殼級(jí)真空/氣密封裝、以及PCB板集成 。近年來(lái),MEMS慣性導(dǎo)航系統(tǒng)的發(fā)展體現(xiàn)在MEMS慣性器件的全硅化、器件的圓片級(jí)真空/氣密封裝、電路ASIC化、初步實(shí)現(xiàn)了慣性器件的SoC集成以及慣導(dǎo)系統(tǒng)的SiP集成。未來(lái)MEMS集成慣導(dǎo)系統(tǒng)在微納衛(wèi)星、月球車(chē)、火星車(chē)、運(yùn)載火箭、以及小型戰(zhàn)術(shù)武器中的應(yīng)用對(duì)MEMS慣導(dǎo)系統(tǒng)的超高集成度、超低功耗、小體積、抗輻照性能、以及可批量制造性等方面提出更高的要求,MEMS封裝正在從2.5D向3D方向發(fā)展。
圖1 3D集成MEMS慣性器件的軍事需求領(lǐng)域
3、國(guó)內(nèi)外研究概況、水平和發(fā)展趨勢(shì)
美國(guó)國(guó)防部高級(jí)研究計(jì)劃局(DARPA)在2012年對(duì)美國(guó)各類(lèi)武器載體中對(duì)慣性導(dǎo)航制導(dǎo)/組合導(dǎo)航系統(tǒng)的應(yīng)用現(xiàn)狀與未來(lái)需求進(jìn)行了分析。根據(jù)分析,超過(guò)10s工作時(shí)間的武器平臺(tái)的導(dǎo)航制導(dǎo)現(xiàn)在均使用GPS輔助,包括工作時(shí)間超過(guò)1h直至24h的單兵個(gè)人導(dǎo)航系統(tǒng)。GPS在實(shí)際使用中極可能被嚴(yán)重干擾或完全阻塞,而使得GPS輔助的導(dǎo)航系統(tǒng)無(wú)法完成任務(wù)。這些需求都要求在未來(lái)的武器平臺(tái)中使用一種全自主的、不依賴(lài)任何外部輔助手段的高集成度微型慣性導(dǎo)航/制導(dǎo)系統(tǒng)。根據(jù)這些分析,DARPA已經(jīng)啟動(dòng)了一系列的高集成度導(dǎo)航制導(dǎo)微系統(tǒng)研究計(jì)劃,微慣性導(dǎo)航系統(tǒng)的集成制造技術(shù)是其中極為重要的研究方向。
為了滿(mǎn)足小型化、輕質(zhì)化、高性能、高可靠MEMS慣性發(fā)展需求,國(guó)際上普遍采用全硅基3D晶圓級(jí)封裝(3D-WLP)技術(shù),以實(shí)現(xiàn)高質(zhì)量批量化生產(chǎn)。瑞典 Silex在2008年推出的標(biāo)準(zhǔn)硅通孔工藝,并作為MEMS陀螺儀、加速度計(jì)WLP的標(biāo)準(zhǔn)技術(shù),如圖2所示。其通孔采用絕緣物填埋技術(shù),用重滲雜低阻硅作為電極導(dǎo)體,導(dǎo)通電阻在1D量級(jí),能夠?qū)崿F(xiàn)可靠的真空/氣密圓片級(jí)封裝,至今仍是慣性MEMS器件的主流WLP技術(shù)。
圖2 瑞典Silex用TSV工藝制作的WLP系統(tǒng)集成
加拿大的DALSA是北美技術(shù)實(shí)力完備的代工企業(yè),為美國(guó)和加拿大各個(gè)高校和研發(fā)機(jī)構(gòu)提供代工服務(wù),也推出自己的標(biāo)準(zhǔn)金屬導(dǎo)體填埋TSV技術(shù)。并開(kāi)發(fā)出10軸集成的慣性器件的標(biāo)準(zhǔn)工藝方案,可同時(shí)在同一芯片上同時(shí)實(shí)現(xiàn)真空、氣密和用于氣壓計(jì)的引氣孔,如圖3所示。
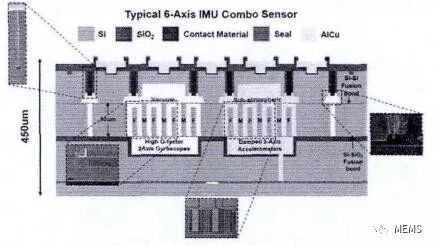
圖3 6軸慣性器件集成制造的TSV和WLP
一種高度集成化的MEMS圓片級(jí)真空方案是利用ASIC芯片作為MEMS器件圓片級(jí)真空封裝的蓋板,如圖4所示。ASIC芯片在流片時(shí)需要制作電極引出(I/O)所需的TSV通孔,而ASIC蓋板和MEMS芯片焊接面同樣需要制備TSV接觸孔并制作鍵合焊料環(huán)。此技術(shù)方案的優(yōu)點(diǎn)在于高度的集成化,不需要通過(guò)TSV轉(zhuǎn)接板直接實(shí)現(xiàn)MEMS-IC的縱向堆疊集成。然而,該技術(shù)方案的先天不足是,ASIC的MEMS芯片的面積需要保持一致,而IC技術(shù)按比例縮小的速度要遠(yuǎn)超過(guò)MEMS技術(shù),可以要求兩者的芯片面積保持一致會(huì)導(dǎo)致芯片面積浪費(fèi)以及成本提高。此外,ASIC流片的晶圓尺寸已經(jīng)達(dá)到12英寸,而MEMS芯片的流片尺寸一般為4~8英寸,在進(jìn)行圓片級(jí)真空封裝鍵合存在困難。此技術(shù)比較適合MEMS和IC在同種工藝條件下,同一代工廠流片,并且MEMS的器件成品率要達(dá)到IC的成品率水平,同時(shí)MEMS器件的精度要求不能過(guò)高。因此,比較適合消費(fèi)類(lèi)電子類(lèi)的MEMS慣性器件,而不適合對(duì)性能有較高要求的軍用MEMS慣性器件。
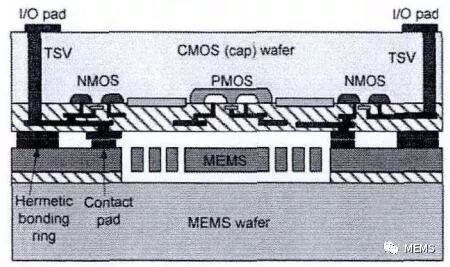
圖4 MEMS-IC單片集成圓片級(jí)真空封裝方案
美國(guó)InvenSense公司給出了一種類(lèi)似的MEMS-IC單片集成式的MEMS圓片級(jí)真空封裝的技術(shù)方案,如圖5所示。其特點(diǎn)在于不使用TSV作為MEMS器件電極引出方案,而是直接采用ASIC中的金屬引線(xiàn)作為跨越封裝內(nèi)外的電學(xué)引出導(dǎo)線(xiàn)。比上述方案具有一定的先進(jìn)性,但是同樣不適合軍用高性能MEMS器件的圓片級(jí)真空封裝。
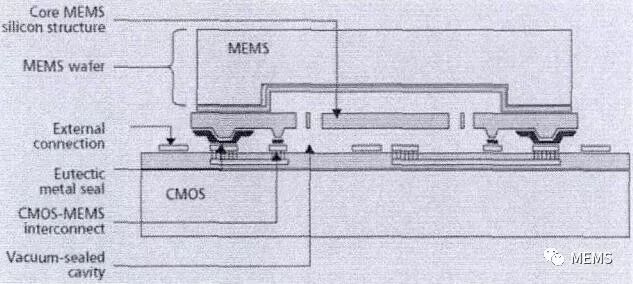
圖5 美國(guó)InvenSense公司單片集成MEMS-IC圓片級(jí)真空封裝方案
瑞典AAC Microtec提出了一種基于雙面銅電鍍的TSV蓋板圓片級(jí)真空封裝方案(XiVIA),如圖6所示。其特點(diǎn)在于和常規(guī)TSV相比該技術(shù)可以在厚度為300~800微米的硅片上制作穿通硅片的MEMS圓片級(jí)真空封裝蓋板,因此蓋板的剛度較大,比較適合用于慣性MEMS器件的真空封裝。然而,該技術(shù)采用銅電鍍制作TSV電極引出子,同時(shí)作為氣密封裝填充材料,因此和普通金屬化TSV技術(shù)同樣存在長(zhǎng)期可靠性問(wèn)題。特別是在軍用全溫環(huán)境下,電鍍金屬和硅襯底的結(jié)合緊密度直接影響器件的漏率和長(zhǎng)期真空度。
圖6 AAC Microtec公司XiVIA圓片級(jí)真空封裝方案
Silex公司提出了一種基于玻璃熔融回流技術(shù)的MEMS圓片級(jí)真空封裝蓋板的新型加工工藝技術(shù),如圖7所示。其技術(shù)特點(diǎn)是在硅片上刻蝕形成單晶硅TSV硅柱陣列并在四周形成隔離環(huán)。利用陽(yáng)極鍵合在刻蝕面鍵合一片硼硅玻璃片并使隔離環(huán)內(nèi)形成真空。將鍵合后的硅-玻璃片在高溫退火爐中加熱至玻璃熔融,并在真空的作用下回流至TSV硅柱四周的真空隔離環(huán)中。經(jīng)過(guò)后續(xù)的硅減薄、玻璃減薄、CMP拋光、植BGA球等工藝流程,最終形成可用于MEMS器件圓片級(jí)真空封裝的蓋板。該項(xiàng)工藝技術(shù)的優(yōu)點(diǎn)在于可以有效的增加TSV四周的絕緣介質(zhì)層厚度,從而有效的減少各個(gè)引腳之間的寄生電容。然而該項(xiàng)工藝的整體工藝流程極為復(fù)雜,導(dǎo)致采用該技術(shù)的MEMS器件流片成品率都較低。
圖7 Silex公司Sil-Via圓片級(jí)真空封裝技術(shù)
美國(guó)ADI公司給出了一種基于玻璃通孔(TGV)的MEMS圓片級(jí)真空封裝工藝方案,如圖8所示。其特點(diǎn)是通過(guò)腐蝕玻璃形成通孔,并用金屬回填通孔。其優(yōu)勢(shì)在于不需要制備絕緣介質(zhì)層,并且各個(gè)電極間的絕緣性很好。其劣勢(shì)在于無(wú)法實(shí)現(xiàn)高真寬比的TGV,無(wú)法克服玻璃和硅材料之間的熱失配應(yīng)力。
圖8 美國(guó)ADI公司基于TGV的MEMS圓片級(jí)真空封裝方案
國(guó)際慣性MEMS領(lǐng)域領(lǐng)先企業(yè)、研究機(jī)構(gòu)等如德國(guó)Bosch公司、美國(guó)mCube公司、德國(guó)弗朗恩霍夫研究所等,對(duì)慣性MEMS三維集成技術(shù)開(kāi)展了一系列的研究,一些技術(shù)也取得產(chǎn)品化突破,慣性MEMS三維集成技術(shù)的優(yōu)勢(shì)和應(yīng)用價(jià)值備受業(yè)界重視。就國(guó)際上己經(jīng)公開(kāi)的慣性MEMS三維集成技術(shù)而言,大致可以劃分為3種,一種是慣性MEMS芯片與MEMS專(zhuān)用ASIC芯片層疊、利用引線(xiàn)鍵合方式實(shí)現(xiàn)兩顆芯片之間電氣連接,一種是在制造過(guò)程中慣性MEMS圓片與MEMS專(zhuān)用集成電路IC圓片兩者鍵合實(shí)現(xiàn)芯片層疊與電氣連接,一種是基于TSV技術(shù)的慣性MEMS三維集成。下面將對(duì)上述3種慣性MEMS三維集成技術(shù)做進(jìn)一步介紹。
圖9是Maxim公司開(kāi)發(fā)的三軸MEMS陀螺儀,產(chǎn)品采用LGA封裝,產(chǎn)品體積為3 mm x 3 mm x 0.9 mm。其中MEMS陀螺儀芯片采用了奧地利Sensor Dyanamic公司和德國(guó)弗勞恩霍夫研究所合作開(kāi)發(fā)的PSM-X2表面工藝制作MEMS陀螺儀芯片,采用AuSi共晶鍵合工藝實(shí)現(xiàn)MEMS陀螺儀芯片真空封裝。
圖9 Maxim公司開(kāi)發(fā)三軸MEMS陀螺儀產(chǎn)品
圖10是美國(guó)InvenSense公司開(kāi)發(fā)的MPU-6500六軸IMU產(chǎn)品,采用24 I/O端口QFN封裝,I/O端口節(jié)距0.5 mm。該款產(chǎn)品通過(guò)AlGe鍵合工藝MEMS陀螺儀結(jié)構(gòu)層圓片鍵合至MEMS專(zhuān)用集成電路IC圓片上,借助Ge鍵合層MEMS陀螺儀結(jié)構(gòu)層與MEMS專(zhuān)用集成電路之間實(shí)現(xiàn)電氣連接,封帽覆蓋MEMS陀螺儀結(jié)構(gòu)層,MEMS專(zhuān)用集成電路通過(guò)粘接固定在QFN襯底上、引線(xiàn)鍵合實(shí)現(xiàn)與QFN襯底之間電氣連接,產(chǎn)品體積僅為4 mm x 4 mm x 0.9 mm。
圖10 InvenSense公司開(kāi)發(fā)的六軸IMU產(chǎn)品
從上述兩個(gè)例子可以發(fā)現(xiàn),新鍵合工藝、芯片層疊、圓片級(jí)真空封裝成為慣性MEMS器件尺寸減小、集成度提高的有效技術(shù)手段。值得注意的是,無(wú)論是芯片層疊、引線(xiàn)鍵合方式的還是MEMS專(zhuān)用IC圓片與慣性MEMS圓片/封帽三者圓片級(jí)鍵合集成的方式,MEMS專(zhuān)用ASIC芯片工藝制程/尺寸都需要兼顧考慮慣性MEMS結(jié)構(gòu)設(shè)計(jì),可以說(shuō)MEMS專(zhuān)用ASIC芯片、慣性MEMS芯片及兩者三維集成工藝是融為一體化的。
TSV技術(shù)應(yīng)用與發(fā)展推動(dòng)了基于TSV的慣性MEMS三維集成技術(shù)研究,為慣性MEMS三維集成提供新的技術(shù)途徑。國(guó)際上已經(jīng)公開(kāi)的技術(shù)方案中,可以細(xì)分為三種情況,第一種是TSV互連工藝與慣性MEMS結(jié)構(gòu)層制作工藝融合,形成圓片級(jí)封裝形式,第二種是TSV互連工藝與MEMS專(zhuān)用ASIC圓片制作工藝融合,形成圓片級(jí)封裝形式,第三種是TSV轉(zhuǎn)接板技術(shù)形式,慣性MEMS芯片、MEMS專(zhuān)用ASIC芯片在TSV轉(zhuǎn)接板上組裝形成慣性MEMS三維集成模塊。下面將對(duì)基于TSV互連的慣性MEMS三維集成技術(shù)進(jìn)行介紹。
圖11 mCube公司開(kāi)發(fā)的三軸MEMS加速度計(jì)產(chǎn)品
圖11是美國(guó)mCube公司開(kāi)發(fā)的三軸MEMS加速度計(jì)芯片橫切面電子掃描顯微鏡照片,該款產(chǎn)品于2013年推向市場(chǎng),是當(dāng)時(shí)國(guó)際上最小的三軸MEMS加速度計(jì),面積僅為2mm^2 。該款產(chǎn)品通過(guò)Al-Ge鍵合工藝使MEMS加速度計(jì)結(jié)構(gòu)層圓片鍵合在MEMS專(zhuān)用集成電路IC圓片襯底上,MEMS加速度計(jì)結(jié)構(gòu)層中存在硅通孔,硅通孔內(nèi)填充的金屬鎢,借此鎢TSV互連實(shí)現(xiàn)MEMS加速度計(jì)結(jié)構(gòu)層與處于襯底位置的MEMS專(zhuān)用IC實(shí)現(xiàn)電氣連接,封帽圓片通過(guò)鍵合工藝實(shí)現(xiàn)MEMS加速度計(jì)結(jié)構(gòu)的局部氣密性封裝。從中可以發(fā)現(xiàn),在此集成方案中TSV互連與慣性MEMS器件設(shè)計(jì)/加工緊密相關(guān),慣性MEMS專(zhuān)用IC圓片與慣性MEMS結(jié)構(gòu)圓片也是密切相關(guān)的,三者構(gòu)成一個(gè)有機(jī)整體,慣性MEMS專(zhuān)用IC設(shè)計(jì)與慣性MEMS結(jié)構(gòu)設(shè)計(jì)互相影響。
圖12 Bosch公司開(kāi)發(fā)的WLCSP封裝的MEMS三軸加速度計(jì)
圖12是德國(guó)Bosch公司開(kāi)發(fā)MEMS三軸加速度計(jì)芯片,與美國(guó)mCube公司的開(kāi)發(fā)的技術(shù)存在明顯差別,該三維集成方案中MEMS專(zhuān)用IC采用Via-Middle技術(shù)制作了銅TSV,MEMS加速度計(jì)芯片與MEMS專(zhuān)用集成電路IC層疊,采用圓片級(jí)小尺寸封裝技術(shù),體積僅為1.2 mm x 1.5 mm x 0.8 mm。
綜合兩者可以發(fā)現(xiàn)TSV互連、圓片鍵合結(jié)合成為實(shí)現(xiàn)慣性MEMS三維集成有效方法,是推動(dòng)慣性MEMS小型化、立體化集成的有效技術(shù)途徑,同時(shí),TSV互連、慣性MEMS設(shè)計(jì)/制造、慣性MEMS專(zhuān) 用IC芯片設(shè)計(jì)/制造及三者構(gòu)成一個(gè)有機(jī)整體,需要互相配合,在這 一 點(diǎn)上,具有一 定封閉性,技術(shù)門(mén)檻高。
圖13 德國(guó)弗勞恩霍夫研究所提出的慣性MEMS三維集成TSV轉(zhuǎn)接板技術(shù)概念
圖13是德國(guó)弗勞恩霍夫研究所在2014年國(guó)際頂級(jí)學(xué)術(shù)會(huì)議ECTC報(bào)道的基于TSV轉(zhuǎn)接板的慣性MEMS三維集成技術(shù)概念,該項(xiàng)目得到了歐盟政府部門(mén)的支持,其核心思想是利用TSV轉(zhuǎn)接板作為公共襯底平臺(tái)一TSV硅轉(zhuǎn)接板指含有TSV互連的硅圓片、上下表面制作有重新布線(xiàn)層,利用微凸點(diǎn)在TSV轉(zhuǎn)接板上組裝慣性MEMS芯片、MEMS專(zhuān)用IC芯片,這樣可以發(fā)揮TSV轉(zhuǎn)接板在熱膨脹系數(shù)失配、線(xiàn)寬匹配等方面優(yōu)勢(shì),釋放傳統(tǒng)慣性MEMS三維集成技術(shù)對(duì)MEMS專(zhuān)用IC可選工藝制程方面的束縛,為慣性MEMS芯片的低應(yīng)力組裝提供設(shè)計(jì)空間,允許更多功能芯片集成,具有開(kāi)放性的特點(diǎn)、優(yōu)點(diǎn)。
德國(guó)弗勞恩霍夫研究所提出的慣性MEMS三維集成技術(shù)概念采用了傳統(tǒng)銅TSV轉(zhuǎn)接板技術(shù),由于慣性MEMS芯片的厚度一般在300μm以上,為了匹配慣性MEMS芯片與TSV轉(zhuǎn)接板的機(jī)械強(qiáng)度,TSV轉(zhuǎn)接板的厚度設(shè)計(jì)≥200μm,同時(shí)由于銅TSV互連與周?chē)枰r底的熱膨脹系數(shù)失配,銅TSV互連直徑控制在≤20μm,TSV互連的深寬比≥10,這對(duì)目前TSV技術(shù)是個(gè)較大挑戰(zhàn)。而且,包含大量銅TSV互連的硅轉(zhuǎn)接板也會(huì)惡化其與慣性MEMS芯片之間的熱應(yīng)力失配。為了克服傳統(tǒng)銅TSV轉(zhuǎn)接板在慣性MEMS芯片三維集成應(yīng)用的上述問(wèn)題,德國(guó)弗勞恩霍夫研究所提出了針對(duì)基于TSV轉(zhuǎn)接板的三維集成應(yīng)用的慣性MEMS器件設(shè)計(jì)與制作工藝平臺(tái),該慣性MEMS器件采用玻璃漿料圓片鍵合實(shí)現(xiàn)圓片級(jí)封裝,采用了周?chē)諝怆姎飧綦x的微導(dǎo)電柱實(shí)現(xiàn)慣 性MEMS器件內(nèi)部功能結(jié)構(gòu)與外部的電氣連接。慣性MEMS器件通過(guò)空氣隔離的微導(dǎo)電柱倒裝焊鍵合固定在TSV轉(zhuǎn)接板上,空氣隔離的微導(dǎo)電柱子用來(lái)解決慣性MEMS器件與TSV轉(zhuǎn)接板之間熱 應(yīng)力失配問(wèn)題。圖14是基于空氣電學(xué)隔離微導(dǎo)電柱的慣性MEMS器件制作工藝流程圖。圖15是加工慣性MEMS器件,圖16是加工的慣性MEMS器件上空氣電器隔離的微導(dǎo)電金屬柱。
圖14 基于空氣電學(xué)隔離微導(dǎo)電柱的慣性MEMS器件制作工藝流程圖
圖15 基于空氣隔離的微導(dǎo)電柱的慣性MEMS器件
圖16 空氣隔離的微導(dǎo)電柱設(shè)計(jì)與加工實(shí)物照片
4、展望與思考
從國(guó)外領(lǐng)先慣性MEMS研究機(jī)構(gòu)的研究成果可以發(fā)現(xiàn),慣性MEMS器件模塊頂層設(shè)計(jì)以及MEMS芯片的工藝設(shè)計(jì)、MEMS專(zhuān)用ASIC芯片設(shè)計(jì)、慣性MEMS芯片與MEMS專(zhuān)用IC芯片集成工藝設(shè)計(jì)等環(huán)節(jié)的協(xié)同對(duì)于慣性MEMS器件整體性能至關(guān)重要,慣性MEMS三維集成技術(shù)研究是慣性MEMS領(lǐng)域研究的一個(gè)重要環(huán)節(jié),對(duì)于拉動(dòng)慣性MEMS器件研究水平、推動(dòng)慣性MEMS應(yīng)用發(fā)展具有重要意義。
慣性MEMS三維集成TSV互連技術(shù)通過(guò)提供垂直貫穿慣性MEMS芯片或MEMS專(zhuān)用集成電路IC芯片的TSV互連為兩者層疊式立體化集成提供了便利,更重要的,為兩者立體化集成和圓片級(jí)封裝的一體化提供了設(shè)計(jì)空間,有效的降低了慣性MEMS三維集成模塊的體積/重量、提高了集成度。
慣性MEMS三維集成TSV轉(zhuǎn)接板技術(shù)通過(guò)為慣性MEMS芯片、MEMS專(zhuān)用IC芯片等提供公共襯底平臺(tái) ,具有提供與慣性MEMS芯片或MEMS專(zhuān)用IC芯片相匹配的線(xiàn)寬 、低熱膨脹系數(shù)失配的優(yōu)點(diǎn),可以有效降低慣性MEMS三維集成模塊體積、重量 、熱應(yīng)力水平等。更重要的,基于TSV轉(zhuǎn)接板的慣性MEMS三維集成技術(shù)對(duì)慣性MEMS芯片、MEMS專(zhuān)用IC芯片工藝制程影響小,允許其他采用不同工藝制程的功能芯片集成TSV轉(zhuǎn)接板襯底上,開(kāi)放性好。在這一 點(diǎn)上,符合未來(lái)慣性MEMS三維集成多功能融合趨勢(shì)需求,將成為未來(lái)慣性MEMS三維集成TSV互連技術(shù)發(fā)展的重要方向。
近些年,國(guó)內(nèi)清華大學(xué)、北京大學(xué)、東南大學(xué)、航天13所、航天33所、兵器科學(xué)研究院、中電13所、航空618所等高校科研院所對(duì)慣性MEMS器件開(kāi)展了系統(tǒng)深入研究,取得了穩(wěn)定的進(jìn)步,建立了獨(dú)具特色的慣性MEMS器件加工工藝,慣性MEMS器件部分指標(biāo)達(dá)到或接近國(guó)際水平,目前處于應(yīng)用突破階段。而在慣性MEMS器件三維集成TSV互連技術(shù)方面的研究相對(duì)落后、與國(guó)外存在較大差距,亟需開(kāi)展慣性MEMS三維集成技術(shù)方面的研究以加速慣性MEMS器件的應(yīng)用與發(fā)展。北京大學(xué)對(duì)TSV互連與μBump、多層存儲(chǔ)器芯片堆疊等TSV三維集成關(guān)鍵技術(shù)開(kāi)展了研究,在ECTC等國(guó)際學(xué)術(shù)會(huì)議上發(fā)表論文多篇,申請(qǐng)了多項(xiàng)發(fā)明專(zhuān)利,初步展示了開(kāi)展慣性MEMS三維集成TSV互連技術(shù)研究的潛力。
綜合考慮基于TSV的慣性MEMS三維集成技術(shù)的特點(diǎn)與發(fā)展趨勢(shì)、國(guó)內(nèi)慣性MEMS器件及TSV互連技術(shù)研究布局與特點(diǎn),基于TSV轉(zhuǎn)接板的慣性MEMS三維集成技術(shù)將是國(guó)內(nèi)開(kāi)展慣性MEMS三維集成研究的優(yōu)選切入點(diǎn),它對(duì)國(guó)內(nèi)慣性MEMS器件技術(shù)途徑?jīng)_擊小,有利于保持并提升慣性MEMS器件研究水平,又可以整合慣性MEMS器件、MEMS專(zhuān)用IC等環(huán)節(jié)研究力量,完善慣性MEMS器件研究產(chǎn)業(yè)鏈。
-
集成電路
+關(guān)注
關(guān)注
5417文章
11942瀏覽量
367013 -
mems
+關(guān)注
關(guān)注
129文章
4059瀏覽量
192718
原文標(biāo)題:MEMS慣性器件全硅圓片級(jí)真空封裝技術(shù)進(jìn)展
文章出處:【微信號(hào):MEMSensor,微信公眾號(hào):MEMS】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
MEMS器件的封裝級(jí)設(shè)計(jì)
什么是晶圓級(jí)封裝?
世界級(jí)專(zhuān)家為你解讀:晶圓級(jí)三維系統(tǒng)集成技術(shù)
晶圓級(jí)芯片封裝有什么優(yōu)點(diǎn)?
晶圓封裝有哪些優(yōu)缺點(diǎn)?
基于熔焊的MEMS真空封裝研究
市場(chǎng)分析:MEMS封裝朝向晶圓級(jí)發(fā)展
基于BCB鍵合的MEMS加速度計(jì)圓片級(jí)封裝工藝

MEMS掃描鏡光學(xué)性能的圓片級(jí)自動(dòng)檢測(cè)系統(tǒng)設(shè)計(jì)_喬大勇
MEMS封裝的新趨勢(shì)
用于MEMS器件的先進(jìn)晶圓級(jí)封裝解決方案
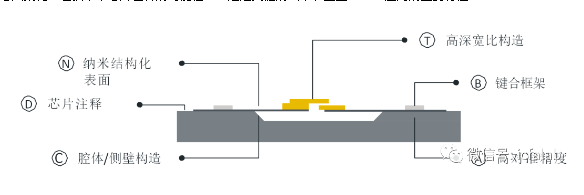
圓片級(jí)芯片尺寸封裝工藝流程與技術(shù)






 單片集成MEMS-IC圓片級(jí)真空封裝方應(yīng)用設(shè)計(jì)
單片集成MEMS-IC圓片級(jí)真空封裝方應(yīng)用設(shè)計(jì)












評(píng)論