在SMT貼片加工的流水線上,焊點缺陷就像隱藏的“地雷”,輕則導致設備故障,重則引發批量返工。這些缺陷中,超過六成與錫膏的選擇和使用緊密相關。從焊點間的“非法牽手”到焊盤上的“糧食短缺”,每一種問題都有其獨特的誘因和解決之道。接下來傲牛科技的工程師帶大家來逐一解析,看看錫膏在其中扮演了怎樣的角色,如何構建安全防線,防患于未然。
一、焊點缺陷中的“錫膏印記”:五大典型現象及成因解析
1、橋連短路:焊點間的“非法牽手”
在顯微鏡下,橋連短路的焊點就像焊盤間多出的“連接線”。這往往是因為錫膏的粘度太低,像稀湯一樣在印刷后自然擴散,或是鋼網開孔過大、下錫量超標,多余的焊料在高溫下流淌到相鄰焊盤。
2、虛焊/假焊:焊點的“表面功夫”
虛焊和假焊則更具迷惑性,焊點表面看似完好,內部卻因助焊劑活性不足、焊盤氧化層未被清除,或是錫膏粘度太高導致上錫量不足,形成“表面功夫”,導致焊點外觀完整但內部未完全熔合,或輕輕觸碰即脫落。
3、漏印/缺錫:焊盤的“糧食短缺”
漏印缺錫在小焊盤上尤為明顯,可能是錫膏顆粒太粗無法通過細網孔,或是粘度過高堵塞鋼網,導致焊盤“吃不飽”。助焊劑中觸變劑失效,也可能導致錫膏在鋼網中形成“結團”。
4、焊點空洞:焊點內的“隱形氣泡”
焊點空洞則是隱藏的“殺手”,會導致降低機械強度和散熱能力。X射線才能發現的內部氣泡,多因錫膏吸濕受潮,或是助焊劑溶劑在預熱階段爆沸,將空氣包裹進焊點。鋼網開孔內壁粗糙(Ra>1μm),脫模時卷入空氣也可導致焊點空洞。
5、錫球/焊料飛濺:焊盤外的“多余焊點”
焊盤周圍的錫球,可引發短路或絕緣失效。一般是由于助焊劑活性過強,焊接時反應劇烈而導致旱澇飛濺。焊粉表面氧化膜破裂,熔融時內部氣體突然“炸開”。還有可能是回流焊升溫速率過快(>3℃/s),助焊劑爆沸推動焊料濺出。
二、從源頭到過程:構建錫膏管控的 “三道防線”
1、要避免錫膏成為缺陷源頭,材料選型是第一道關。
不同焊點間距對錫膏顆粒度有嚴格要求:常規焊盤適合T5級(15-25μm)顆粒,細間距需T6級(5-15μm)確保網孔填充,超細間距則要用T7級(2-11μm)搭配超薄鋼網。
助焊劑活性也要按需選擇,普通消費電子用中等活性的RA級即可,汽車醫療等高端領域則需低殘留的RMA級,鹵素含量必須嚴格控制。驗廠時一定要核對 MSDS 報告,確保粘度、氧化度等關鍵指標達標。
2、工藝優化是第二道防線,讓錫膏在印刷和焊接中“乖乖聽話”。
印刷環節的刮刀壓力和速度至關重要,5-8N/mm的壓力既能填滿網孔又不致錫膏外溢,細間距焊接速度需降至20mm/s,給錫膏充足的填充時間。回流焊的溫度曲線就像錫膏的“成長軌跡”:預熱階段以不超過2℃/s 的速率升溫,讓助焊劑勻速揮發;回流段峰值溫度控制在錫膏熔點加15-20℃,確保充分熔合;冷卻段以2-3℃/s 快速固化,減少焊料流動風險。
3、過程管控則是貫穿始終的“守護者”。
錫膏的存儲和使用需要“精準呵護”:未開封的錫膏應在5-10℃的冷藏環境中存放,避免溫度波動;開封后要標注時間,4小時內用完,剩余錫膏密封冷藏并在24小時內回用,回溫時需靜置3小時,防止冷凝水影響活性。生產中還要建立實時檢測閉環,首件用3D SPI掃描錫膏厚度,過程中每2 小時用顯微鏡觀察焊點截面,每周用X射線檢測空洞率,確保每個環節都在掌控之中。
三、跳出錫膏看缺陷:多維度排查保良率
當然,錫膏不能背下所有的鍋。元件偏移可能是貼片機吸嘴磨損或視覺定位偏差,需要每日校準精度至±10μm。焊盤氧化多因存儲濕度太高,可通過等離子清洗預處理。助焊劑殘留腐蝕則可能是清洗工藝不到位,高可靠性產品建議直接選用免洗無鹵錫膏。只有將錫膏管控與設備維護、環境控制結合起來,才能形成完整的質量防線。
SMT加工中的焊點缺陷排查,本質上是對材料、工藝、管理的全面考驗。錫膏雖小,卻串聯起從印刷到焊接的關鍵環節。通過精準匹配焊點需求選擇合適的錫膏,輔以嚴格的制程管控和實時檢測,就能將錫膏相關缺陷率大幅降低。記住,沒有完美的錫膏,只有最適配的選擇——從顆粒度到活性,從存儲到焊接,每一個細節的用心,最終都會轉化為焊點的可靠與產品的穩定。
-
smt
+關注
關注
42文章
3011瀏覽量
71172 -
錫膏
+關注
關注
1文章
923瀏覽量
17279 -
焊盤
+關注
關注
6文章
586瀏覽量
38669 -
助焊劑
+關注
關注
3文章
135瀏覽量
11487 -
焊點
+關注
關注
0文章
136瀏覽量
13007
發布評論請先 登錄





 SMT貼片加工常見缺陷排查:哪些是錫膏“惹的禍”,如何精準解決?
SMT貼片加工常見缺陷排查:哪些是錫膏“惹的禍”,如何精準解決?
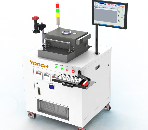






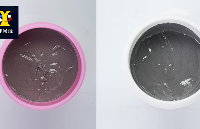

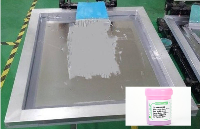













評論