摘要:
基于Ansys有限元軟件,采用三級子模型技術對多層銅互連結構芯片進行了三維建模。研究了10層銅互連結構總體互連線介電材料的彈性模量和熱膨脹系數對銅互連結構熱應力的影響,在此基礎上對總體互連線介電材料的選擇進行優化。結果表明,總體互連線介電材料的熱膨脹系數對銅互連結構的熱應力影響較小,而彈性模量對其影響較大;各層介電材料熱應力與彈性模量成正比,SiN界面熱應力與彈性模量成反比。最后,為了降低銅互連結構關鍵位置熱應力,通過選用不同參數材料組合對總體互連線介電材料的選取進行優化,提高了銅互連結構可靠性。
0引言
隨著集成電路制造技術進入數十納米級,金屬互連線的寬度不斷減小、層數不斷增加,更細更長的金屬互連線的電阻-電容(RC)延遲時間已無法忽略,因此采用銅、低介電常數(low-k)介電材料代替鋁、二氧化硅來降低RC延遲[1-2]。在多層銅互連結構中,封裝過程中因芯片與基板間的熱膨脹系數不匹配而產生熱應力,直接耦合到low-k介質中驅動界面分層[3],引發可靠性問題。對low-k介質熱應力的可靠性研究備受關注。
目前,國內外學者們的研究內容是封裝過程中芯片與基板間的熱膨脹系數不匹配引發的互連可靠性,即芯片封裝交互作用[3-11]。X.F.Zhang等人采用了四層銅互連結構,通過計算裂紋擴展的能量釋放率研究了介電材料屬性對能量釋放率的影響[3-4]。S.Raghavan等人計算銅互連結構裂紋擴展的能量釋放率,得出能量釋放率最大的位置區域[5]。C.J.Uchibori等人采用四層銅互連結構,使用SiO2分別替代M4層介電材料low-k、SiOC層,能量釋放率降低了34%、35%[6-7]。L.L.Mercado等人通過計算裂紋J積分研究了銅互連結構介電材料、互連層數對裂紋擴展的影響[8]。L.Lin等人研究了銅柱、焊料、PI開口等尺寸參數對銅互連結構熱應力的影響[9-10]。M.W.Lee等人研究了硅層厚度、基板厚度、PI層厚度、銅柱高度、焊點數量等對銅互連結構low-k層熱應力的影響[11]。
在銅互連結構中,互連級與封裝級的尺寸相差較大,直接對其建模仿真會占用巨大計算資源。采用多級子模型技術可有效解決這一問題。對于銅互連結構,可采用四級子模型技術進行建模[3-4,6-7],但計算精度不高。也可采用二級子模型技術建模[8-9],但需總體模型精細網格來保證子模型的計算精度。
本文提出了一種降低銅互連結構關鍵位置熱應力的優化方法。綜合考慮計算資源和精度,本文采用三級子模型技術進行結構建模。采用針對10層銅互連結構,研究不同的總體互連線介電材料對銅互連結構介電材料熱應力的影響。在此基礎上,進一步對總體互連線介電材料進行優化,降低超低介電常數(ultralow-k,ULK)和SiN界面熱應力,最終提高了銅互連結構的可靠性。
1建模與參數選擇
本文使用對稱邊界條件約束對稱模型中心點的所有自由度,禁止產生剛性位移。基于有限元軟件,本文采用三級子模型技術,建立了銅互連結構芯片的三維模型,有限元模型如圖1所示。
考慮到芯片對稱性,采用芯片的1/4結構建模,第一級模型如圖1(a)所示。銅互連結構部分比整個芯片模型的基板和硅層的厚度都薄很多,構建第一級模型時采用均勻等效層替代銅互連結構,使銅互連結構參與芯片整體模型的形變,該方法的精度不受影響[9-10,12]。第一級模型包括PI層、鈍化層、等效層、銅焊點、基板、硅層等,它們的尺寸如表1所示[13-14]。
第二級模型主要針對關鍵焊點區域,其建模區域源自第一級模型的求解結果,即熱應力值最大區域,如圖1(b)所示。第二級模型區域位于距芯片最遠處的焊點位置,模型邊界條件是將第一級模型計算的位移場通過插值,施加到切割邊界處,切割邊界需遠離熱應力集中區域。第二級模型包括部分硅、部分基板、銅焊點、PI層、鈍化層,其中銅焊點包括銅柱、焊料、正八邊形鋁焊盤和銅焊盤。采用均勻等效層替代銅互連結構。
第三級模型是是銅互連結構模型,如圖1(c)所示,其包括10層。模型邊界條件是將第二級模型位移場通過插值,施加到切割邊界處。M1~M8層使用ULK作為介電材料。
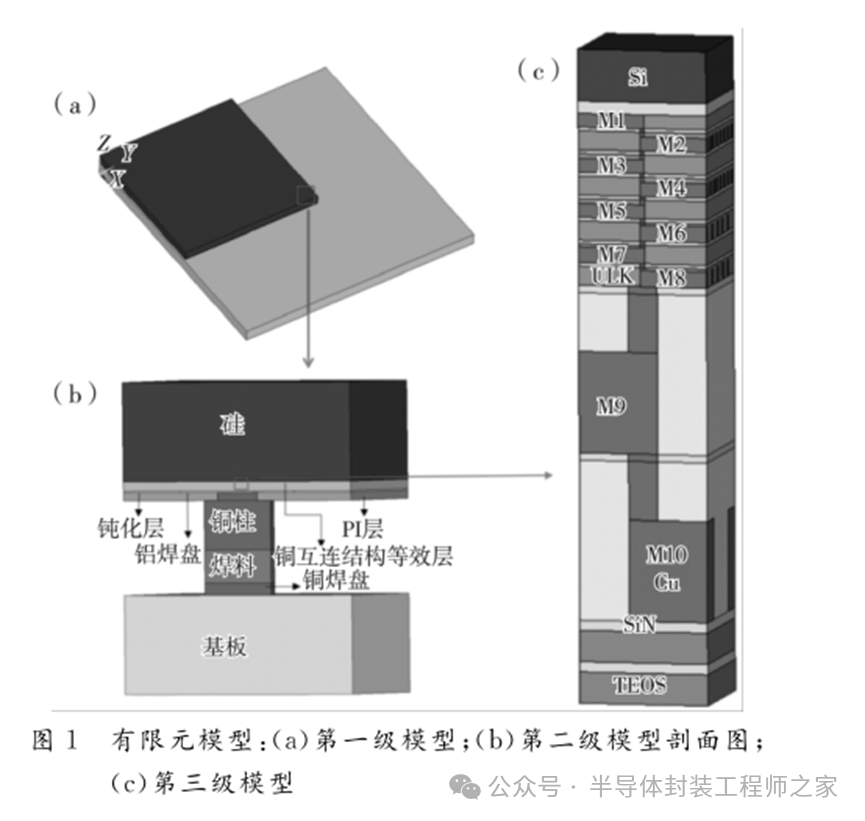
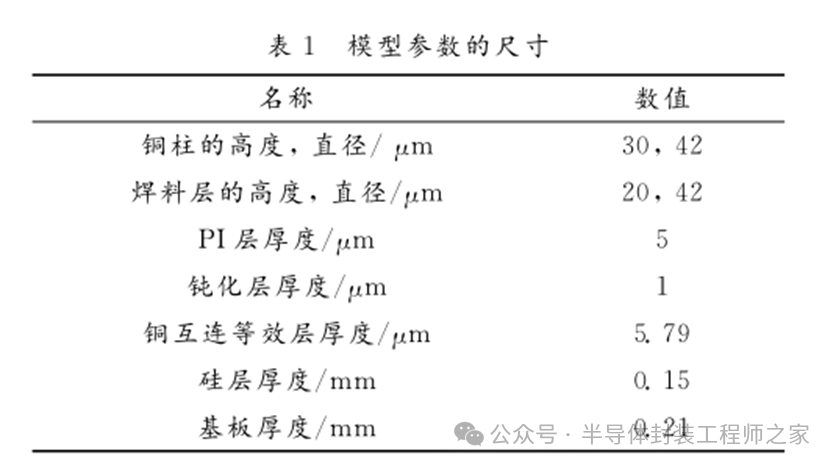
在芯片封裝交互作用研究中,常采用芯片回流焊的溫度作為載荷。雖然回流焊過程中峰值溫度遠低于制作工藝的峰值溫度,但是,芯片封裝交互作用在low-k界面產生的能量釋放率遠遠大于制作工藝產生的能量釋放率,且大于low-k界面的臨界能量釋放率[15]。因此,芯片封裝交互作用會導致銅互連結構low-k界面的斷裂、分層,引發可靠性問題。將回流焊的溫度作為最高溫度載荷,因填充膠會緩解銅互連結構的熱應力,所以本文仿真模型沒有使用填充膠。假設封裝過程中整體溫度變化均勻,220℃回流焊溫度設為焊料的熱應力自由溫度,溫度以1℃/s的速率降至室溫25℃。本文使用的材料屬性如表2所示[7,10-11,17]。

2結果分析與討論
本文第一級模型的形變及第二級模型熱應力分布圖如圖2所示。
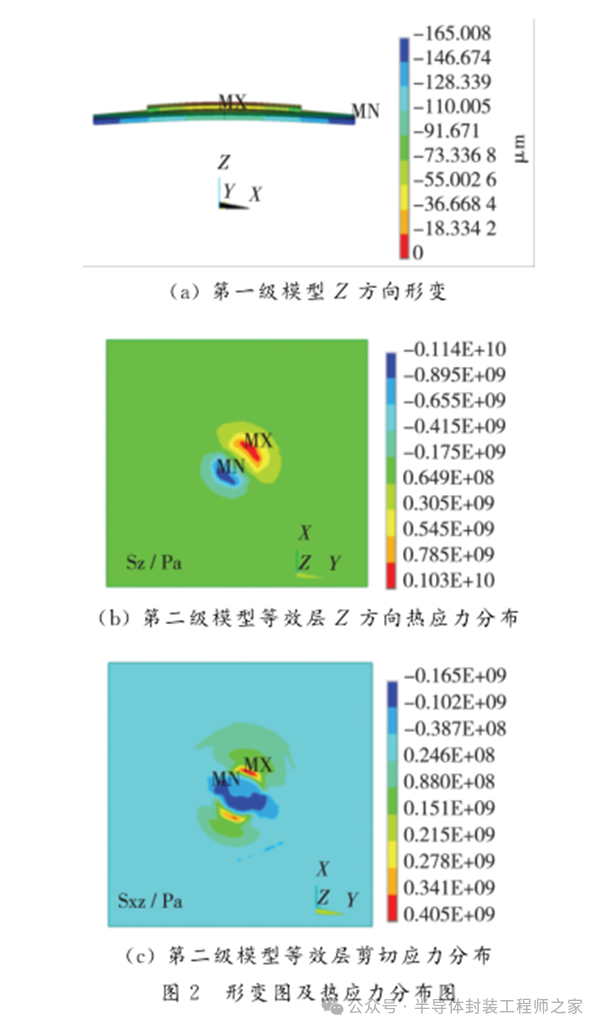
溫度載荷作用后第一級模型Z方向形變如圖2(a)所示。可以看出,封裝芯片的形變呈中間凸起狀,基板邊角部分的形變大于芯片邊角部分。基板邊角承受了最大的形變。原因是,基板的熱膨脹系數(16×10-6·℃-1~23×10-6·℃-1)比硅大得多,且硅和基板在所有材料中的占比最大,降溫過程中基板收縮的速度比硅快得多,所以引起模型的形變呈凸起狀。
第二級模型等效層Z方向的熱應力分布如圖2(b)所示。圖中,紅色部分是拉應力,為正值,藍色部分是壓縮應力,為負值。等效層受拉應力的作用區域大于壓縮應力。
第二級模型等效層剪切應力分如圖2(c)所示。可以看出,在封裝過程中,等效層同樣受剪切應力的影響,但其最大值小于Z方向熱應力值。可知,銅互連結構Z方向熱應力占據主導地位。根據材料力學最大拉應力強度理論,需通過第一主應力對銅互連結構進行研究。
2.1總體互連線介電材料的彈性模量和熱膨脹系數對熱應力的影響
不同MSQ材料用于總體互連線介電材料時的第一主應力分布如圖3所示。采用三級子模型技術對10層銅互連結構進行分析。M1~M8層介電材料使用ULK。M9、M10層為總體互連線,介電材料使用不同的MSQ材料(假設),材料參數如表3所示[3]。
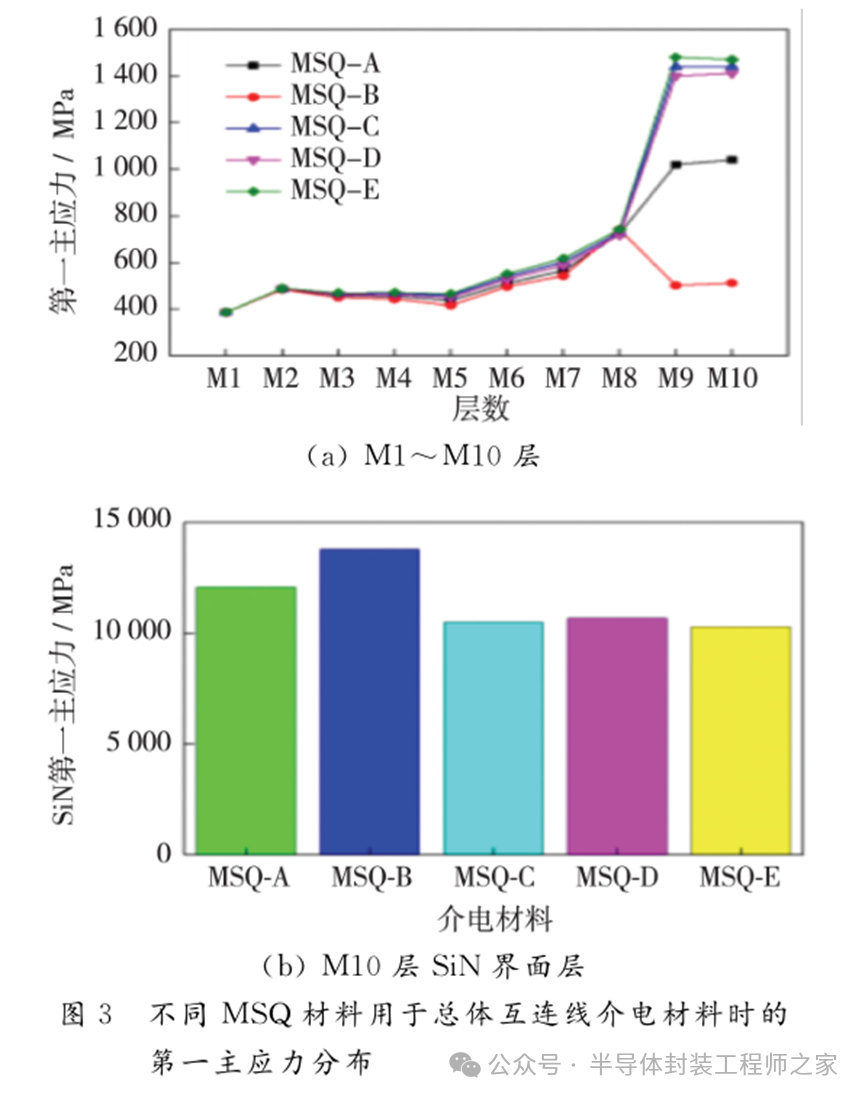

圖3(a)所示為M1~M10層介電材料的熱應力分布。可以看出,總體互連線使用不同介電材料時,對M1~M8層使用ULK時,熱應力值很小,變化趨勢相同,熱應力均在M8層時達到最大值。原因是,銅焊點的熱應力值很大,M8層離銅焊點的距離更近,易產生集中熱應力而引發可靠性問題,M1層的熱應力值最小、安全。不同MSQ作總體互連線介電材料時,M9層與M10層的熱應力值基本相同,但隨著材料參數的變化,熱應力值整體明顯變化。MSQ材料熱膨脹系數相同時,彈性模量越小,熱應力值越小。如MSQ-B中M9層的熱應力值小于M8層,原因是MSQ-B與ULK的彈性模量值相差較大,ULK抵抗形變能力比MSQ-B強,導致ULK熱應力較大。MSQ材料彈性模量相同時,隨著熱膨脹系數的變化,熱應力變化并不明顯。可知,M9層、M10層的熱應力取決于其彈性模量。
圖3(b)所示為M10層頂部相鄰的SiN界面層的熱應力分布。可以看出,MSQ-B作總體互連線介電材料時,SiN界面層的熱應力值最大;MSQ材料熱膨脹系數不變時,SiN界面層熱應力與MSQ材料的彈性模量成反比;熱膨脹系數對SiN界面層的熱應力影響較小。SiN界面層的熱應力值明顯比M1~M10層大。原因是,MSQ介電材料的彈性模量比SiN界面層小得多,其抗變形能力很弱,導致M10層頂部相鄰的SiN界面層出現熱應力集中現象,引起SiN界面分層、斷裂,從而影響銅互連結構的可靠性。
綜上可知,總體互連線介電材料的熱膨脹系數對M9、M10層和SiN界面層的熱應力影響較小,但對彈性模量的影響較大。根據胡克定理σ=εE(σ、ε表示應力和應變,E表示彈性模量),溫度載荷下形變取決于不同材料的熱膨脹系數失配,則總體模型形變取決于芯片與基板間的熱膨脹系數失配。銅互連結構在總體模型中占比很小,其對總體模型形變的影響很小,所以總體互連線介電材料的熱膨脹系數對M9、M10層的熱應力影響不大,彈性模量對熱應力的影響較大。M9、M10層熱應力與總體互連線介電材料的彈性模量成正比,SiN界面層的熱應力與彈性模量成反比。
2.2不同的總體互連線介電材料對銅互連結構熱應力的影響
通常采用USG、SiO2、FSG等材料作銅互連結構的總體互連線介電材料[7,10,17]。M1~M9層介電材料及SiN界面層的第一主應力分布如圖4所示。
USG、SiO2、FSG和MSQ分別作總體互連線介電材料時,M1~M8層(ULK)的熱應力分布如圖4(a)所示。可以看出,彈性模量越大,各層熱應力值越大,M1層熱應力值最小。M1~M2層熱應力值迅速增大,之后M2~M5層熱應力緩慢變化。原因是,M2層比M1層厚,且M2~M5層厚度相等。從M6層開始,熱應力值呈迅速增加的趨勢,M8層熱應力達到最大值。ULK材料的機械特性低、粘附性差,過大熱應力引起銅互連結構的分層、斷裂。因此,M8層是易發生斷裂失效的關鍵位置之一。

對于不同的總體互連線介電材料,M9層與M10層的熱應力值基本相同(從圖3(a)可知),因此圖4(b)只給出了M9層和與M10層相鄰SiN界面層的熱應力對比。顯然,與M10相鄰SiN界面層的熱應力值遠大于M9層。可知,與M10相鄰SiN界面層也是易發生失效的關鍵位置之一。
從MSQ、FSG到SiO2,它們的彈性模量不斷增大,SiN界面熱應力不斷減小。USG介電材料的彈性模量雖最大,但其SiN界面熱應力值卻不是最小、略大于SiO2、FSG,這源于USG有較大的熱膨脹系數而引起的較大熱應力。
對于不同的總體互連線介電材料,M9層熱應力值從大到小的排序為:USG>SiO2>FSG>MSQ。從圖4(a)可知,M8層熱應力從大到小的排序為:USG>SiO2>FSG>MSQ,表明M8層熱應力值與M9層熱應力密切相關。為了減小M8層熱應力,需使用彈性模量較小的介電材料,但這又使得SiN界面層熱應力值較大。因此,需要進一步對總體互連線介電材料選取進行優化。
2.3總體互連線介電材料的選擇優化
從上述分析可知,為了提高銅互連結構的可靠性,不僅要減小SiN界面層熱應力,還要降低M8層(ULK)熱應力值。對這兩類熱應力影響最大的是M9層、M10層介電材料的參數。介電材料及SiN界面層第一主應力分布如圖5所示。
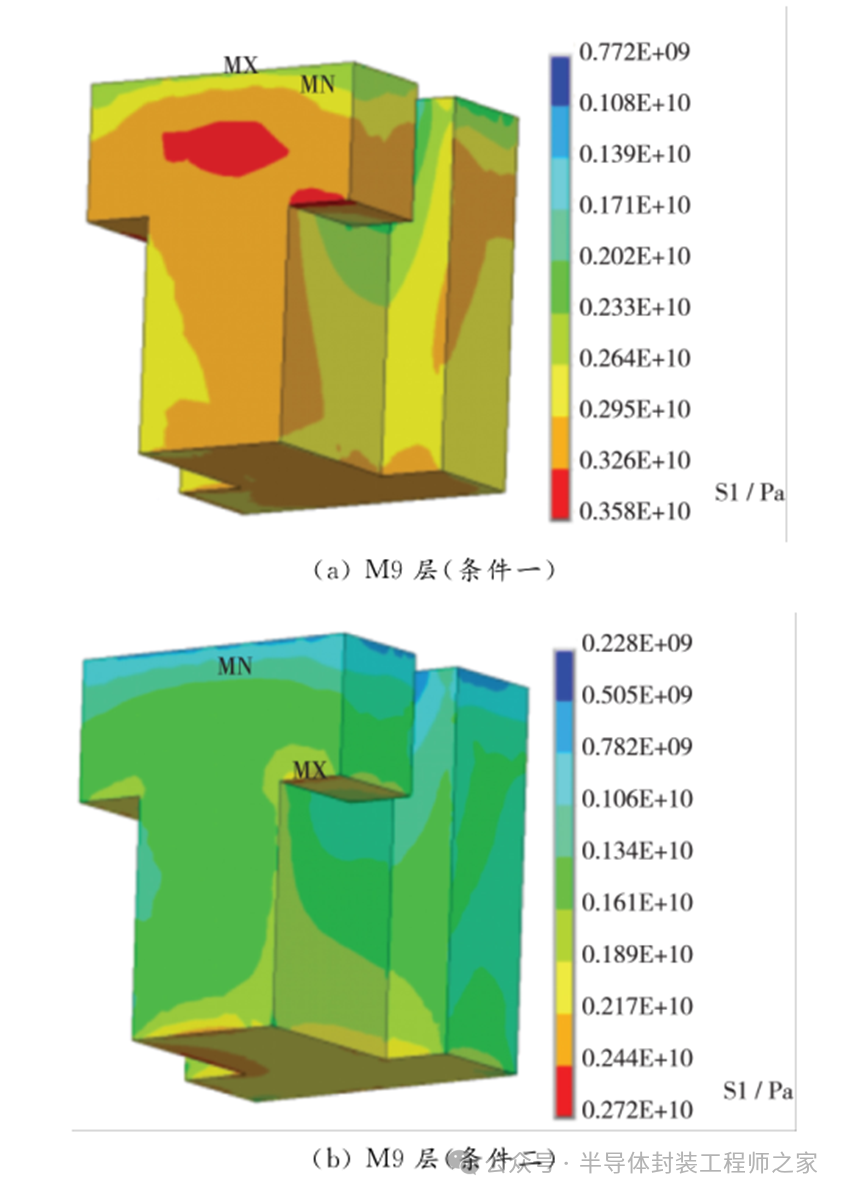
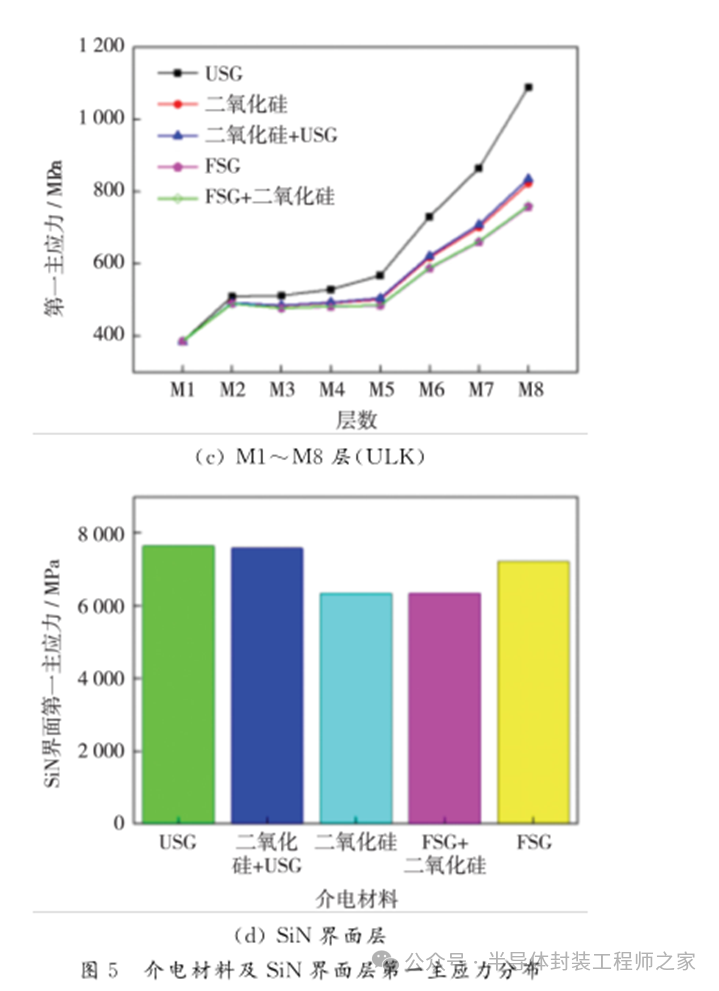
圖中,“USG”表示M9、M10層均使用USG,“SiO2”表示M9、M10層均使用SiO2。“SiO2+USG”表示M9層使用SiO2、M10層使用USG,“FSG+SiO2”表示M9層使用FSG、M10使用SiO2。以此類推。
采用“USG”時,M9層(條件一)的熱應力分布如圖5(a)所示。可以看出,熱應力最大值位于M9層的邊界區。該區域與M8層相鄰,造成M8層熱應力值增加,易引發可靠性問題。
采用“SiO2+USG”時,M9層(條件二)的熱應力分布如圖5(b)所示。可以看出,M9層熱應力值遠小于圖5(a)的熱應力值,最大熱應力值位于M9層中間位置,距離M8層較遠,其對M8層熱應力的影響降低。這表明,對M9、M10層的優化有助于降低關鍵位置的熱應力。
M9、M10層使用不同介電材料組合時,M1~M8層(ULK)熱應力分布如圖5(c)所示。可以看出,與采用“USG”相比,采用“SiO2+USG”時熱應力值明顯降低,而采用“FSG+SiO2”時熱應力值進一步降低。采用“SiO2+USG”時,M1~M8層熱應力值與采用“SiO2”時熱應力值基本相等。采用“FSG+SiO2”時,M1~M8層熱應力值與采用“FSG”時熱應力值基本相等。這表明,M1~M8層熱應力值取決于M9層介電材料,與M10層介電材料關系不大。M9層選擇彈性模量較小的介電材料時,能有效降低M8層熱應力值。
M9、M10層使用不同介電材料組合時,SiN界面層熱應力分布如圖5(d)所示。可以看出,采用“SiO2+USG”時,SiN界面層熱應力值與采用“USG”時熱應力值基本相等;采用“FSG+SiO2”時,SiN界面層熱應力值與采用“SiO2”時熱應力值基本相等。因此,SiN界面層熱應力值與M9層介電材料的關系不大,取決于M10層介電材料。M9、M10層選擇合適的介電材料,有利于提高銅互連結構的可靠性。采用“FSG+SiO2”時,M8層、SiN界面的熱應力值都達到最小值。
3結論
基于Ansys有限元分析軟件,以10層銅互連結構為研究對象,采用三級子模型技術對多層銅互連結構芯片進行三維建模。仿真分析了總體互連線介電材料的彈性模量、熱膨脹系數對銅互連結構熱應力的影響。結果表明,銅互連結構的熱應力取決于總體互連線介電材料的彈性模量,而與其熱膨脹系數關系不大。為了提高銅互連結構的可靠性,不僅要減小SiN界面層熱應力,還要降低M8層(ULK)熱應力值。最后,對M9層、M10層的介電材料進行優化,降低銅互連結構關鍵位置的熱應力,提高器件可靠性。
-
回流焊
+關注
關注
14文章
498瀏覽量
17343 -
熱應力
+關注
關注
0文章
11瀏覽量
10836 -
介電材料
+關注
關注
0文章
18瀏覽量
7200
原文標題:銅互連結構熱應力分析及介電材料選擇優化
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
Low-κ介電材料,突破半導體封裝瓶頸的“隱形核心”
村田電容0805的COG介電材料有什么特點?
高壓放大器在電致動介電彈性體圓柱驅動器中的應用

佰力博HTS1000高溫介電測試系統特點與測量流程

研究透視:芯片-互連材料

一文了解晶圓級封裝中的垂直互連結構

基于介電電泳的選擇性液滴萃取微流體裝置用于單細胞分析
機械應力和熱應力下的BGA焊點可靠性

安泰ATA-7030高壓放大器在介電彈性體智能材料中的應用






 優化銅互連結構的熱應力分析與介電材料選擇
優化銅互連結構的熱應力分析與介電材料選擇
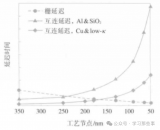

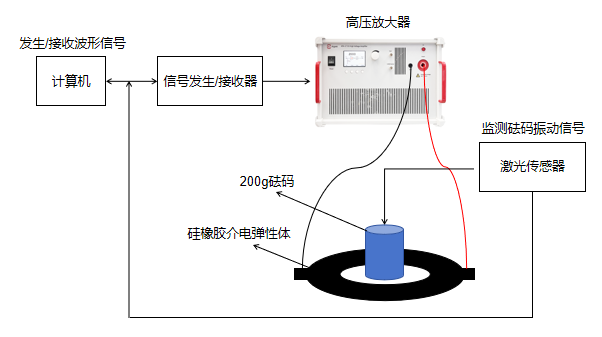













評論