CPM核心板,采用BGA封裝,減少了連接器使用,有效降低成本。但批量生產(chǎn)時(shí)需嚴(yán)格工藝控制以確保質(zhì)量,建議使用回流焊。接下來(lái),將詳細(xì)闡述相關(guān)工藝要求。
 ?鋼網(wǎng)和焊盤(pán)設(shè)計(jì)
?鋼網(wǎng)和焊盤(pán)設(shè)計(jì)
BGA核心板封裝的焊盤(pán)均為圓形焊盤(pán),如圖1所示,焊盤(pán)Paste mask 層和Top層為直徑為0.61mm,Solder mask是直徑為0.6608mm的圓,即外擴(kuò)2mil。鋼網(wǎng)的尺寸要開(kāi)到和模塊 TOP 層一樣大小,即直徑為0.61mm的圓,鋼網(wǎng)推薦厚度為0.12-0.15mm。

圖1 焊盤(pán)P.S.光盤(pán)資料內(nèi)有核心板的AD封裝庫(kù),無(wú)需自己另外設(shè)計(jì)。
 ?存儲(chǔ)要求
?存儲(chǔ)要求
溫度< 40°C,相對(duì)濕度< 90%(RH),真空包裝且密封良好的情況下,確保12個(gè)月的可焊接性要求。
 ?潮敏特性
?潮敏特性
- 潮濕敏感等級(jí)為3級(jí);
- 拆封后,在環(huán)境條件為溫度< 30°C和相對(duì)濕度< 60%(RH)情況下168小時(shí)內(nèi)進(jìn)行安裝;如不滿足上述條件需進(jìn)行烘烤;?烘烤參數(shù)如表1所示。
表1模塊貼片前烘烤參數(shù)表

 ?回流焊接
?回流焊接
BGA核心板回流焊接需要滿足一定的溫度條件,具體如圖2所示。表2中的回流焊接要求中參數(shù)僅供參考,不保證可獲得最佳焊接效果,實(shí)際應(yīng)用中由于各自的焊料、PCB布局、器件要求等不同,建議使用者采用試驗(yàn)設(shè)計(jì)方法來(lái)獲得優(yōu)化參數(shù)。
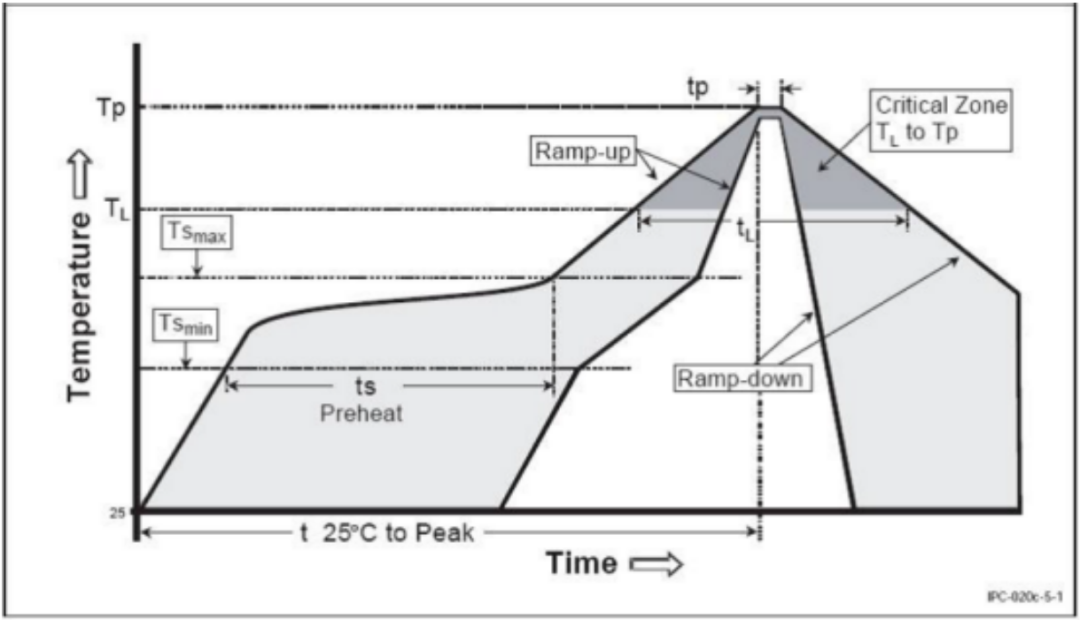
圖2回流焊接溫度曲線
表2回流焊接要求
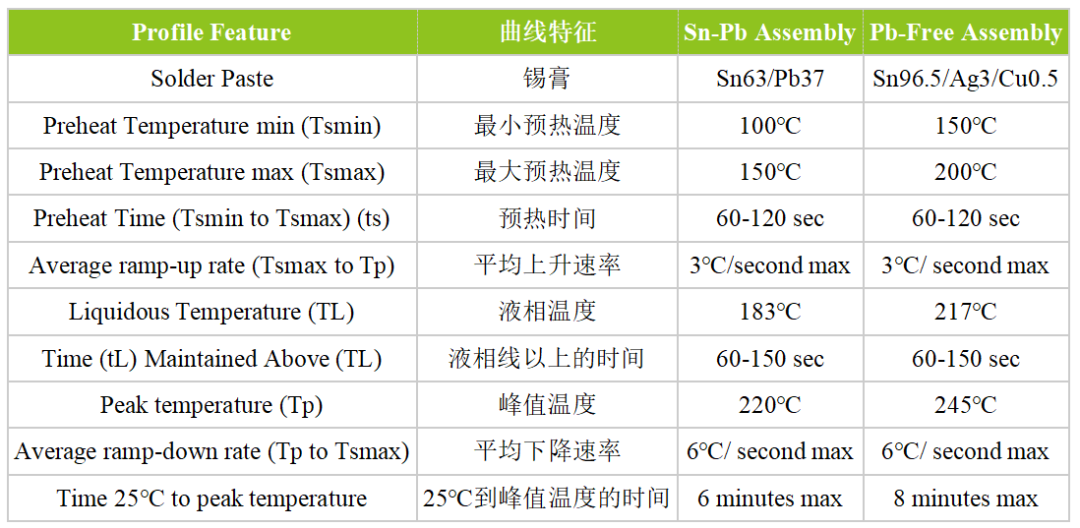
 ?ZLG首款百元內(nèi)64位1G主頻工業(yè)級(jí)核心板
?ZLG首款百元內(nèi)64位1G主頻工業(yè)級(jí)核心板
ZLG致遠(yuǎn)電子創(chuàng)新推出超小型CPM核心板,采用 BGA 封裝形式,集成處理器、DDR內(nèi)存及NorFlash,并配備外置電源模塊。用戶可依根據(jù)產(chǎn)品需求靈活搭配不同容量的EMMC存儲(chǔ)器,實(shí)現(xiàn)定制化配置。CPM核心板繼承了易開(kāi)發(fā)、高穩(wěn)定性的傳統(tǒng)優(yōu)勢(shì),并在靈活性與性價(jià)比上取得新突破,為用戶帶來(lái)更多元化的應(yīng)用體驗(yàn)。
-
貼裝
+關(guān)注
關(guān)注
0文章
93瀏覽量
17076 -
BGA
+關(guān)注
關(guān)注
5文章
565瀏覽量
48131 -
CPM
+關(guān)注
關(guān)注
0文章
13瀏覽量
7847 -
核心板
+關(guān)注
關(guān)注
5文章
1104瀏覽量
30619
發(fā)布評(píng)論請(qǐng)先 登錄
飛凌嵌入式-ELFBOARD ELF 2硬件知識(shí)分享-核心板
飛凌嵌入式-ELFBOARD ELF 2的硬件知識(shí)分享--核心板
什么是核心板?核心板有何優(yōu)勢(shì)
表面貼裝印制板設(shè)計(jì)要求
表面貼裝印制板的設(shè)計(jì)技巧

表面怎樣來(lái)貼裝印刷板
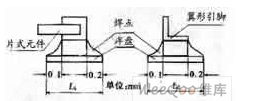
高頻核心板設(shè)計(jì)的技巧有哪些

MT6762_MT6765核心板硬件手冊(cè)
ARM核心板有哪些不同之處?

CPM核心板應(yīng)用之eMMC硬件設(shè)計(jì)指導(dǎo)

CPM核心板應(yīng)用之電源硬件設(shè)計(jì)指導(dǎo)

基于RK3576開(kāi)發(fā)板的硬件量產(chǎn)指導(dǎo)






 CPM核心板應(yīng)用之量產(chǎn)貼裝指導(dǎo)
CPM核心板應(yīng)用之量產(chǎn)貼裝指導(dǎo)










評(píng)論