在智能手機(jī)性能日益強(qiáng)大的今天,應(yīng)用處理器(AP)的散熱問題成為了制約其性能釋放的關(guān)鍵因素。為了應(yīng)對(duì)這一挑戰(zhàn),三星電子正全力以赴,開發(fā)一項(xiàng)名為FOWLP-HPB的革新性芯片封裝技術(shù),旨在從根本上解決AP過熱問題,為未來的Exynos芯片提供強(qiáng)有力的散熱保障。
技術(shù)背景與命名
FOWLP-HPB,全稱“扇出晶圓級(jí)封裝-熱路徑塊”(Fan-Out Wafer Level Packaging with Heat Path Block),是三星芯片部門高級(jí)封裝(AVP)業(yè)務(wù)團(tuán)隊(duì)精心研發(fā)的成果。這項(xiàng)技術(shù)不僅融合了先進(jìn)的扇出晶圓級(jí)封裝(FOWLP)技術(shù),還創(chuàng)新性地引入了熱路徑塊(HPB)設(shè)計(jì),為移動(dòng)SoC的散熱問題提供了全新的解決方案。
技術(shù)亮點(diǎn)
FOWLP技術(shù)基礎(chǔ)
FOWLP是一種先進(jìn)的封裝技術(shù),它允許在晶圓級(jí)別上進(jìn)行封裝,極大地提高了芯片的集成度和散熱效率。相比傳統(tǒng)封裝方式,F(xiàn)OWLP技術(shù)能夠更有效地管理芯片內(nèi)部的熱量分布,減少熱阻,從而提升整體性能。
HPB散熱模塊
HPB(Heat Path Block)作為FOWLP-HPB技術(shù)的核心,是一種已在服務(wù)器和PC領(lǐng)域廣泛應(yīng)用的散熱技術(shù)。然而,由于智能手機(jī)的體積和厚度限制,HPB技術(shù)一直未能在移動(dòng)SoC上得到廣泛應(yīng)用。三星此次創(chuàng)新地將HPB引入智能手機(jī)芯片封裝中,通過在SoC頂部附加一個(gè)熱路徑塊,直接將處理器產(chǎn)生的熱量高效導(dǎo)出,顯著提升了散熱能力。
與傳統(tǒng)的VC(Vapor Chamber,均熱板)散熱方式不同,HPB更加專注于提升處理器的局部散熱能力,確保熱量能夠迅速、有效地從處理器核心區(qū)域散發(fā)出去。同時(shí),HPB的設(shè)計(jì)還考慮到了內(nèi)存等周邊組件的布局,將它們安裝在HPB旁邊,既保證了散熱效果,又優(yōu)化了整體封裝結(jié)構(gòu)。
應(yīng)用前景與后續(xù)發(fā)展
據(jù)三星官方透露,F(xiàn)OWLP-HPB技術(shù)計(jì)劃在今年第四季度完成開發(fā)并進(jìn)入批量生產(chǎn)階段。該技術(shù)將首先應(yīng)用于三星自家的Exynos 2500處理器上,預(yù)計(jì)能夠顯著提升其性能表現(xiàn),解決因過熱而導(dǎo)致的性能瓶頸問題。
作為后續(xù)產(chǎn)品,三星團(tuán)隊(duì)還在積極研發(fā)一種可以安裝多個(gè)芯片的FOWLP系統(tǒng)級(jí)封裝(SIP)技術(shù)。這項(xiàng)技術(shù)預(yù)計(jì)在2025年第四季度推出,將進(jìn)一步推動(dòng)智能手機(jī)芯片封裝的集成化和高效化。屆時(shí),F(xiàn)OWLP-SiP技術(shù)將支持多個(gè)芯片和HPB的協(xié)同工作,為智能手機(jī)提供更加全面、高效的散熱解決方案。
結(jié)語
三星FOWLP-HPB技術(shù)的問世,標(biāo)志著智能手機(jī)芯片封裝技術(shù)的一次重大革新。通過引入HPB散熱模塊,三星成功解決了移動(dòng)SoC過熱這一長(zhǎng)期存在的難題,為智能手機(jī)性能的進(jìn)一步提升奠定了堅(jiān)實(shí)基礎(chǔ)。隨著技術(shù)的不斷成熟和普及,我們有理由相信,未來的智能手機(jī)將擁有更加出色的性能和更加持久的續(xù)航能力,為用戶帶來更加極致的使用體驗(yàn)。
-
處理器
+關(guān)注
關(guān)注
68文章
19890瀏覽量
235128 -
智能手機(jī)
+關(guān)注
關(guān)注
66文章
18624瀏覽量
183804 -
三星
+關(guān)注
關(guān)注
1文章
1698瀏覽量
32712
發(fā)布評(píng)論請(qǐng)先 登錄
回收三星S21指紋排線 適用于三星系列指紋模組
詳細(xì)解讀三星的先進(jìn)封裝技術(shù)
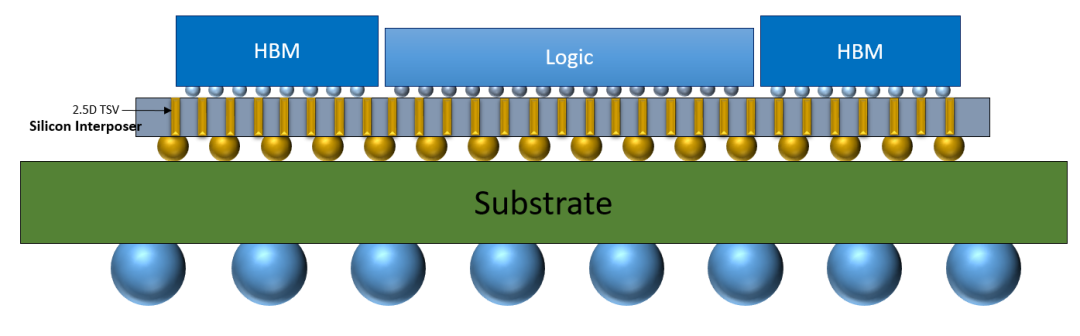
三星在4nm邏輯芯片上實(shí)現(xiàn)40%以上的測(cè)試良率
三星貼片電容封裝與體積大小對(duì)照詳解






 三星FOWLP-HPB技術(shù):革新芯片封裝,解決AP過熱難題
三星FOWLP-HPB技術(shù):革新芯片封裝,解決AP過熱難題












評(píng)論