1.IGBT結構
IGBT在結構上類似于MOSFET,其不同點在于IGBT是在N溝道功率MOSFET的N+基板(漏極)上增加了一個 P+基板(IGBT 的集電極),形成PN 結 J1,并由此引出漏極,柵極和源極則完全與MOSFET相似。如下圖所示。
2.IGBT結構原理介紹
正是由于 IGBT 是在 N 溝道MOSFET 的N+基板上加一層P+基板,形成了四層結構,由N+基板上加一層P+基板,形成了四層結構,由PNP-NPN晶體管構成 IGBT。但是,NPN晶體管和發射極由于鋁電極短路,設計時盡可能使NPN 晶體管不起作用。所以說,IGBT 的基本工作與NPN 晶體管無關,可以認為是將 N 溝道MOSFET作為輸入極,PNP晶體管作為輸出極的單向達林頓管。
N+區稱為源區,附于其上的電極稱為源極。器件的控制區為柵區,附于其上的電極稱為柵極。溝道在緊靠柵區邊界形成。在漏、源極之間的 P 型區(包括 P+和 P?區,溝道在該區域形成)稱為亞溝道區(Subchannel Region)。而在漏區另一側的 P+區稱為漏注入區(Drain Injector),它是 IGBT 特有的功能區,與漏區和亞溝道區一起形成 PNP 雙極晶體管,起發射極的作用,向漏極注入空穴,進行導電調制,以降低器件的通態電壓。附于漏注入區上的電極稱為漏極。為了兼顧長期以來人們的習慣,IEC 規定:源極引出的電極端子(含電極端)稱為發射極端(子),漏極引出的電極端(子)稱為集電極端(子),柵極引出的電極端(子)稱為柵極端(子)。
IGBT 在一個正向的驅動電壓作用下時,一塊 P 導通型的硅材料會形成一個導電溝道。這時,導電的載流子為電子(多子)。在驅動電壓消失后,該器件處于截止狀態(自截止)。IGBT 在大多數情況下采用垂直式結構,柵極和發射極均位于芯片上表面,而芯片底面則構成了集電極。負載電流在溝道之外垂直通過芯片。IGBT 具有平面式柵極結構,也就是說,在導通狀態下導電溝道是橫向的(水平的)。
平面柵極(在現代高密度晶體管中發展為雙重擴散柵極)仍是目前 IGBT 中占統治地位的柵極結構。平面式 IGBT結構是從微電子技術移植而來的,其集電極由 P+阱區構成,位于芯片表面。負載電流水平地流經芯片。借助于一個氧化層,N區可以與襯底相互隔離,從而有可能將多個相互絕緣的 IGBT與其他器件一起集成于一個芯片上。
由于平面式晶體管的電流密度僅能達到垂直式結構的30%,因而明顯地需要更大的安裝面積,所以,平面式晶體管主要用在復雜的單芯片電路中。從構造上來看,IGBT 由眾多的硅微單元組成。每25px2芯片上的單元數可達 1 × 10^5(高耐壓 IGBT)。
3.IGBT過熱和過流的區別
半導體器件承受電流的能力受熱約束或者增益(跨導)的限制,當電流超過熱能力后,IGBT 的跨導達到最大值。而在芯片面積相同的雙極型晶體管中,當電流在工作范圍以內時,雙極型晶體管的增益將大大降低。IGBT與功率MOSFET 一樣是無“增益限制”的。
當電流非常大時,IGBT 的跨導減小,如在短路狀態下,隨著溫度升高,跨導進一步減小,這樣可保護 IGBT。當柵極電壓為 15V 時,在短路狀態下,IR 公司標準 IGBT的電流密度可達 10~20A/mm2。如此高的跨導使IGBT具有非常好的開關特性和導通特性。
-
MOSFET
+關注
關注
150文章
8449瀏覽量
219498 -
IGBT
+關注
關注
1278文章
4051瀏覽量
254068 -
NPN晶體管
+關注
關注
3文章
42瀏覽量
10928 -
載流子
+關注
關注
0文章
135瀏覽量
7858 -
驅動電壓
+關注
關注
0文章
94瀏覽量
13697
發布評論請先 登錄
IGBT內部結構和拆解
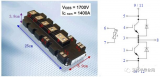
簡述IGBT模塊的內部結構與電路圖分析
一文詳解IGBT模塊內部結構
IGBT內部結構
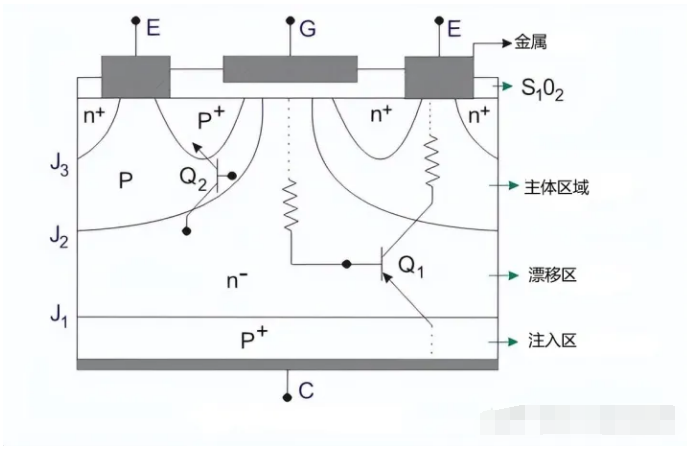





 IGBT內部結構過熱和過流的區別
IGBT內部結構過熱和過流的區別

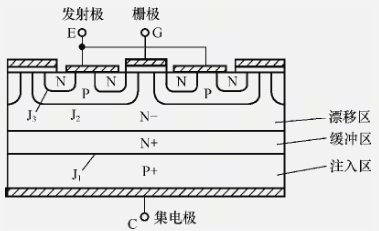




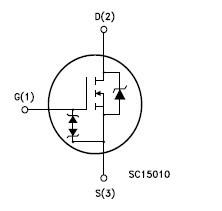
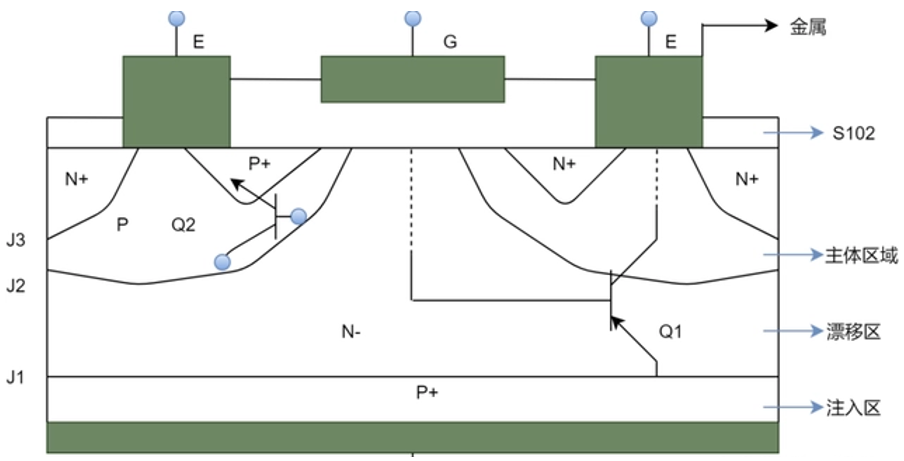










評論