SiC MOSFET器件存在可靠性問題,成為產業發展瓶頸。SiC MOSFET器件可靠性制造存在諸多 難題,其中柵氧及其界面缺陷成為業界關注的焦點。
第九屆國際第三代半導體論壇(IFWS)&第二十屆中國國際半導體照明論壇(SSLCHINA)在廈門國際會議中心召開。期間,“碳化功率器件及其封裝技術分會“上,大連理工大學教授王德君帶來了”碳化功率器件及其封裝技術“的主題報告,分享了”SiC MOSFET器件可靠性問題及其根源“、”SiC 半導體表面缺陷的遺傳效應“、 ”SiC 半導體表面處理效果“、 ”表面處理優化SiC MOS器件可靠性“等內容。
其研究基于表界面缺陷研究, 提升SiC MOS器件性能穩定性可靠性。推進了測試分析診斷、柵氧/金屬工藝優化、制造技術及裝備、測試技術及儀器等工作。SiC MOSFET 器件可靠性和應用失效的根源:器件的偏壓溫度應力不穩定性(BTI)問題。BTI本質上與SiC半導體柵氧界面/近界面缺陷直接相關。


對于SiC MOSFET器件可靠性問題及其根源,涉及SiC MOS器件電學特性及柵氧缺陷分析,SiC MOS器件柵氧化技術解決方案,SiC 半導體器件可靠性制造技術及裝備,半導體器件測試技術及儀器。開發了SiC MOS器件柵氧化新技術,實現了在大場強高溫長時間應力作用下的器件穩定性。明晰了N、H、O、Cl等多種元素在SiC半導體氧化和界面缺陷鈍化中的作用及缺陷物理機制。為產業優化柵氧工藝制程提供了理論和技術基礎。
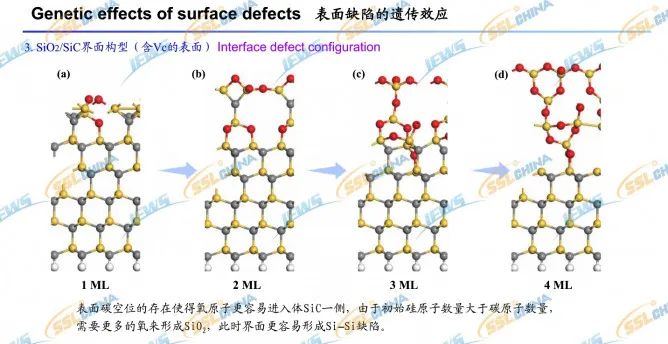
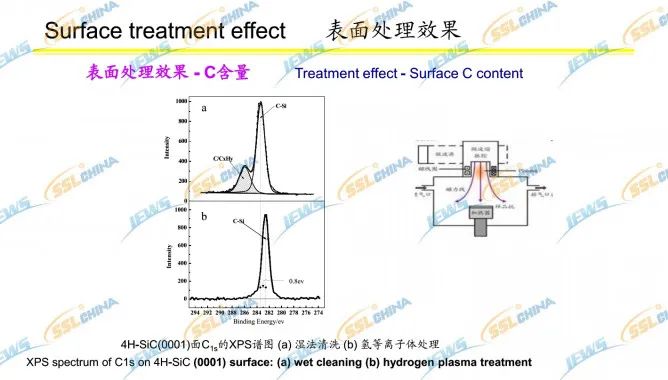
SiC 半導體表面缺陷的遺傳效應研究方面,涉及表面缺陷構型、表面初始氧化構型(氧覆蓋度為1 ML),SiO2/SiC界面構型(含Ci的表面),SiO2/SiC界面構型(含CSi的表面),SiO2/SiC界面構型(含Vc的表面)。

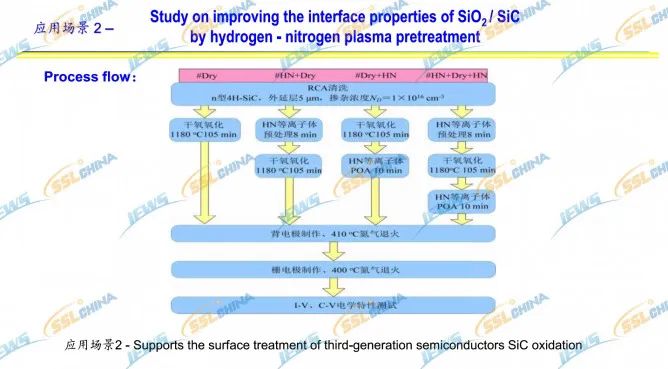
表面處理優化SiC MOS器件可靠性方面,涉及歐姆電極工藝前襯底處理,SiC歐姆電極性能優化。刻蝕后處理,SiC MOS器件性能優化。外延前處理,改善外延質量。柵氧先進技術應用。其中,開展了柵介質工藝優化的初步研究,分析界面鈍 化技術對柵介質可靠性的影響。結果表明,表面界面鈍化對提高柵介質性能及可靠性具有一定的改善效果。
審核編輯:劉清
-
MOSFET
+關注
關注
150文章
8270瀏覽量
218521 -
半導體
+關注
關注
335文章
28615瀏覽量
232630 -
SiC
+關注
關注
31文章
3157瀏覽量
64449
原文標題:王德君教授: 提升SiC MOS 器件性能可靠性的表面優化途徑
文章出處:【微信號:第三代半導體產業,微信公眾號:第三代半導體產業】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
提供半導體工藝可靠性測試-WLR晶圓可靠性測試
SiC碳化硅MOSFET驅動電壓的限制源于柵氧可靠性與器件性能之間的權衡
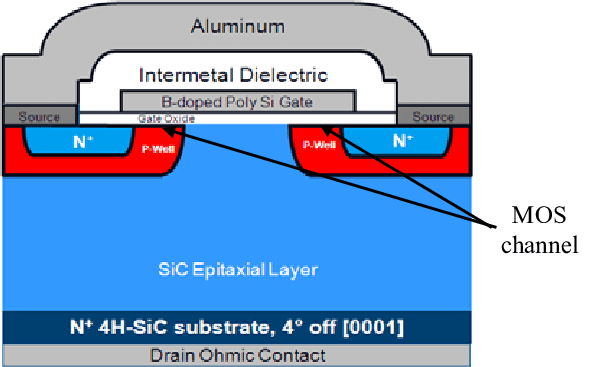
電機微機控制系統可靠性分析
保障汽車安全:PCBA可靠性提升的關鍵要素
國產MOS管質量與可靠性優勢剖析

質量亂象:未通過可靠性關鍵實驗的國產SiC功率模塊應用隱患與后果
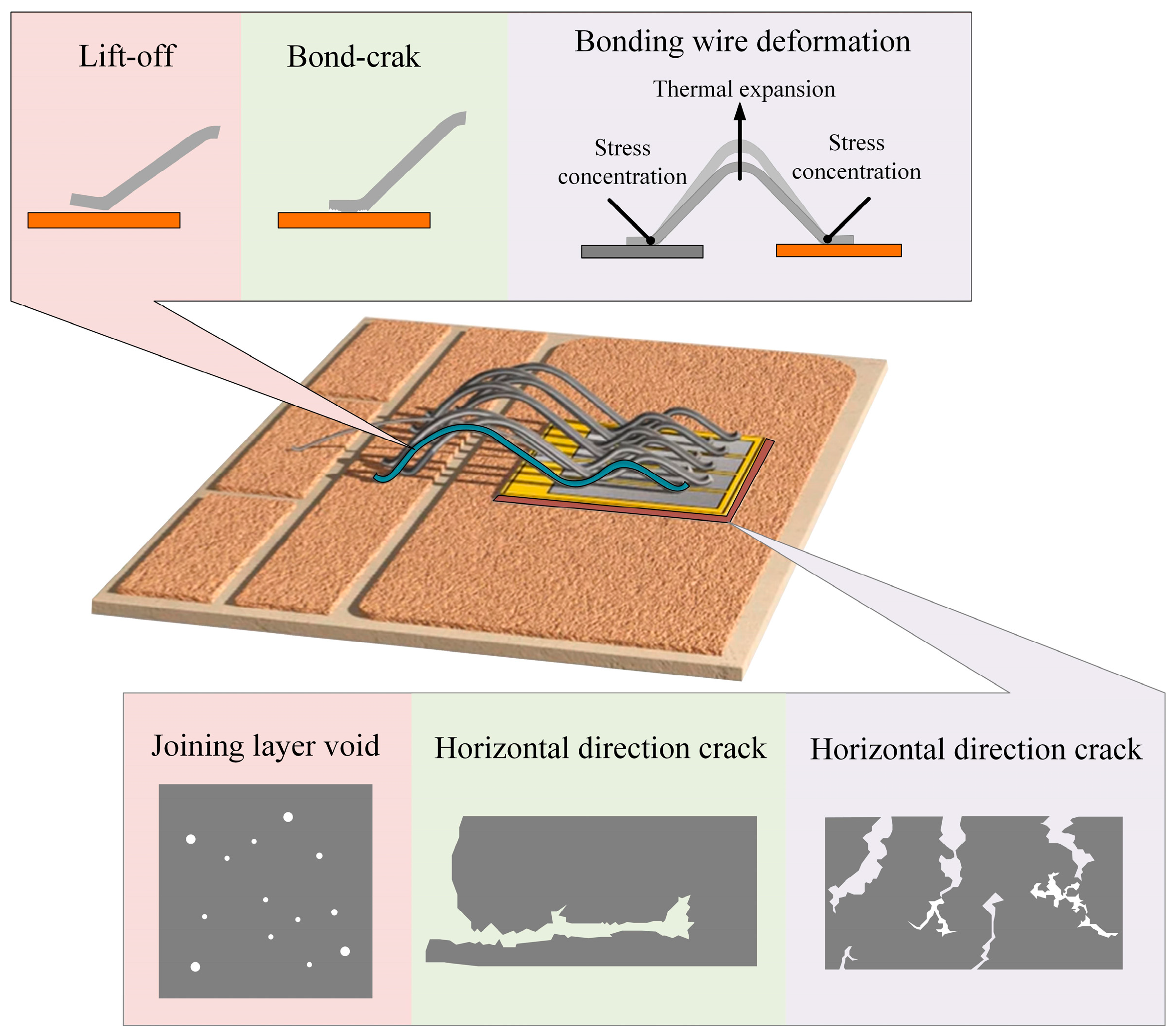
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
瞻芯電子參與編制SiC MOSFET可靠性和動態開關測試標準






 提升SiC MOS器件性能可靠性的表面優化途徑
提升SiC MOS器件性能可靠性的表面優化途徑




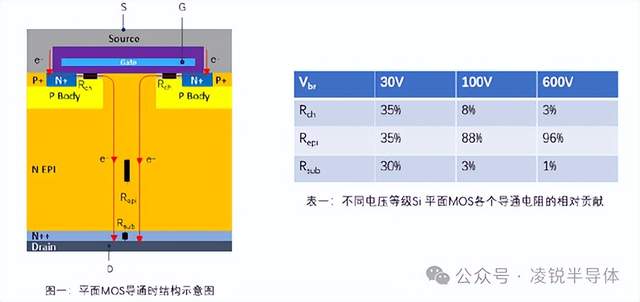
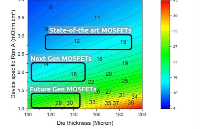










評論