一、半導體封裝技術(shù)簡介
從事半導體行業(yè),尤其是半導體封裝行業(yè)的人,總繞不開幾種封裝工藝,那就是芯片粘接、引線鍵合、倒裝連接技術(shù)。
尤其以引線鍵合(Wire Bonding)及倒裝連接(Flip Chip Bonding)最為常見,因為載帶連接技術(shù)(TAB)有一定的局限性,封裝上逐漸淘汰了這種技術(shù)。
倒裝芯片技術(shù)是通過芯片上的凸點直接將元器件朝下互連到基板、載體或者電路板上。引線鍵合的連接方式是將芯片的正面朝上,通過引線(通常是金線)將芯片與線路板連接。

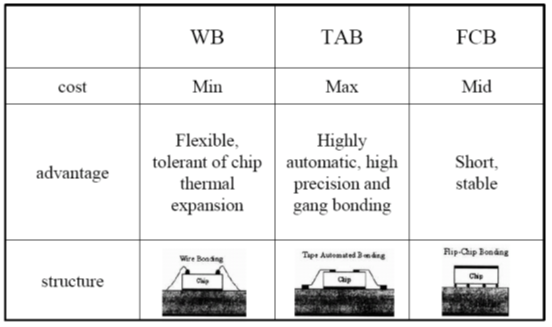
引線鍵合、載帶連接、倒裝連接各有特點。其中倒裝連接以結(jié)構(gòu)緊湊,可靠性高在封裝行業(yè)應用越來越廣泛。
二、什么是倒裝芯片技術(shù)?
伴隨半導體芯片體積的逐漸減小,對芯片封裝技術(shù)要求越來越高,封裝技術(shù)向著晶圓及封裝發(fā)展。

在對傳統(tǒng)芯片進行封裝時,通常是將晶圓進行切割成Die,再對每一個Die進行封裝,伴隨封裝技術(shù)的成熟,在最新的半導體封裝中,將封裝工藝與半導體工藝進行融合,在晶圓上對芯片進行統(tǒng)一封裝,再切割形成可靠性更高的獨立芯片。
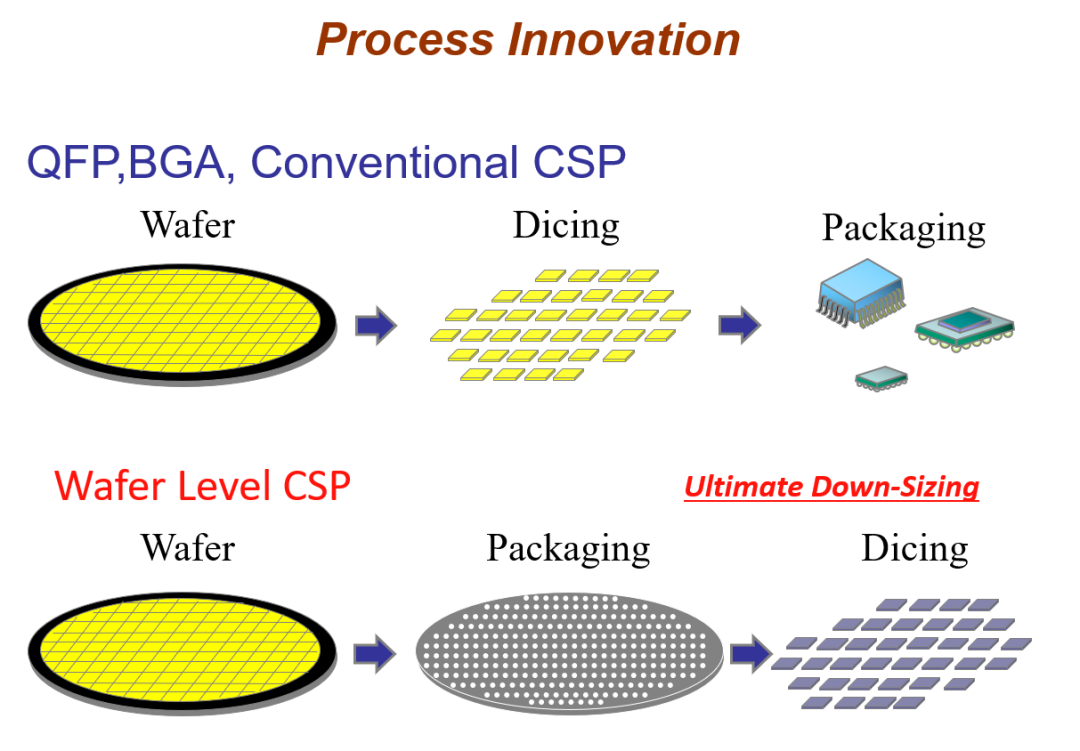
隨著倒裝技術(shù)的成熟應用,目前全世界的倒裝芯片消耗量超過年60萬片,且以約50%的速度增長,3%的晶圓封裝用于倒裝芯片凸點技術(shù),幾年后可望超過20%。
倒裝芯片元件主要用于半導體設(shè)備,有些元件,如無源濾波器,探測天線,存儲器裝備也開始使用倒裝芯片技術(shù),由于芯片直接通過凸點直接連接基板和載體上。因此,更確切的說,倒裝芯片也叫DCA(Direct Chip Attach),下圖中CPU及內(nèi)存條等電子產(chǎn)品是最常見的應用倒裝芯片技術(shù)的器件。
下圖是內(nèi)存條中存儲芯片通過倒裝技術(shù)與線路板連接,芯片與電路板中間通過填充膠固定。
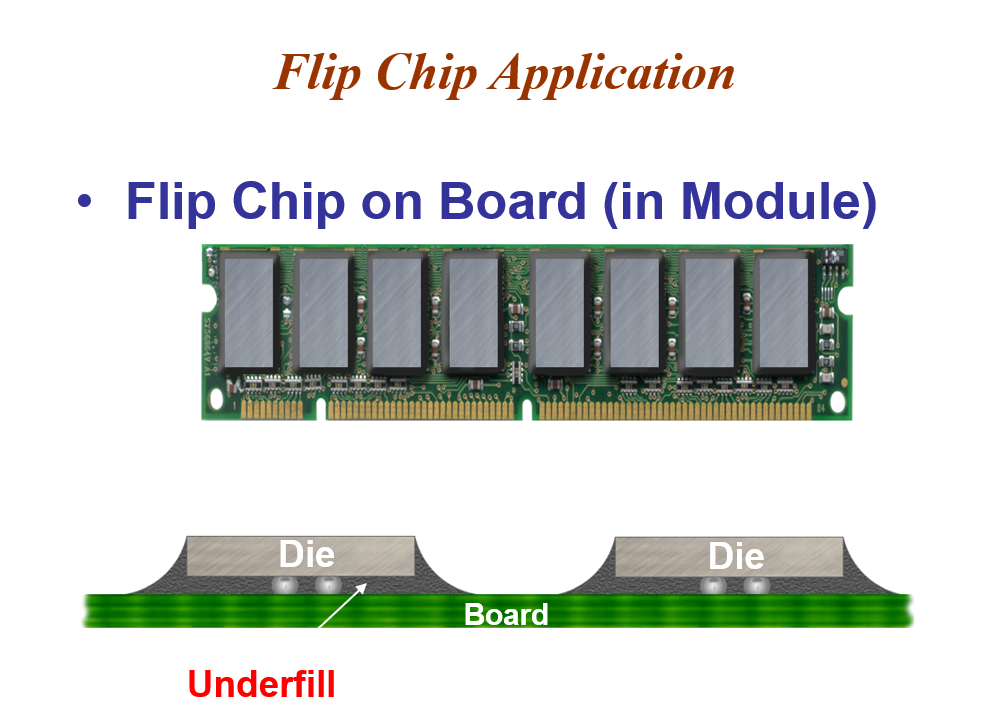
在典型的倒裝芯片封裝中, 芯片通過3到5個密耳(1mil=25um)厚的焊料凸點連接到芯片載體上,底部填充材料用來保護焊料凸點。
下圖是一張典型的倒裝連接圖,芯片與下方的基板采用倒裝方式連接:
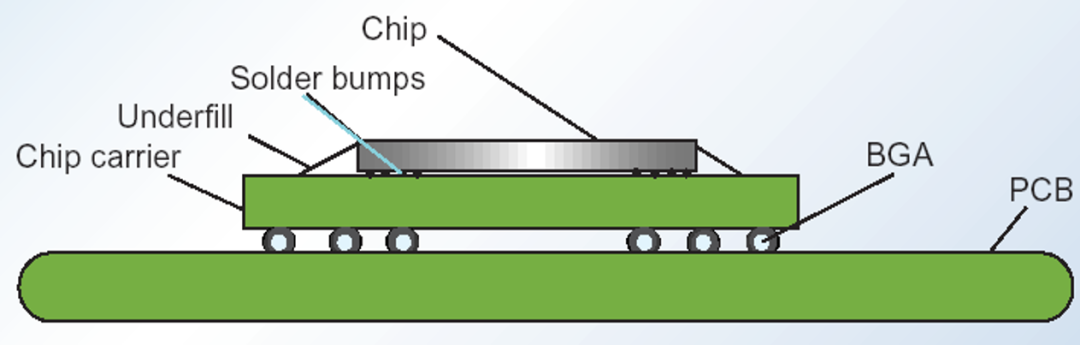
三、倒裝技術(shù)技術(shù)細節(jié)


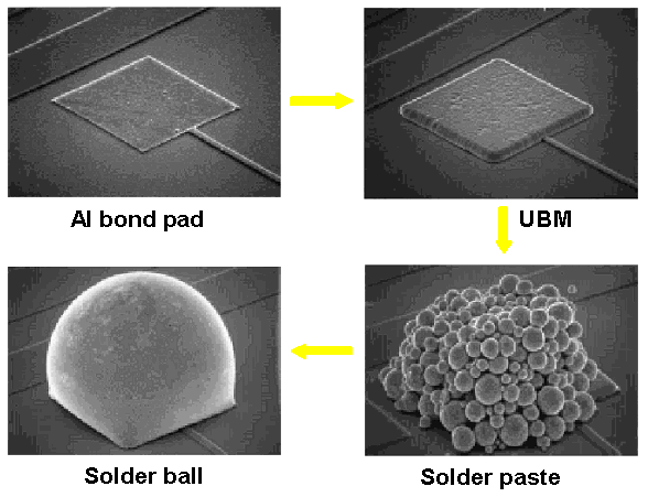
其中電鍍焊料凸點的具體形成過程如下圖:
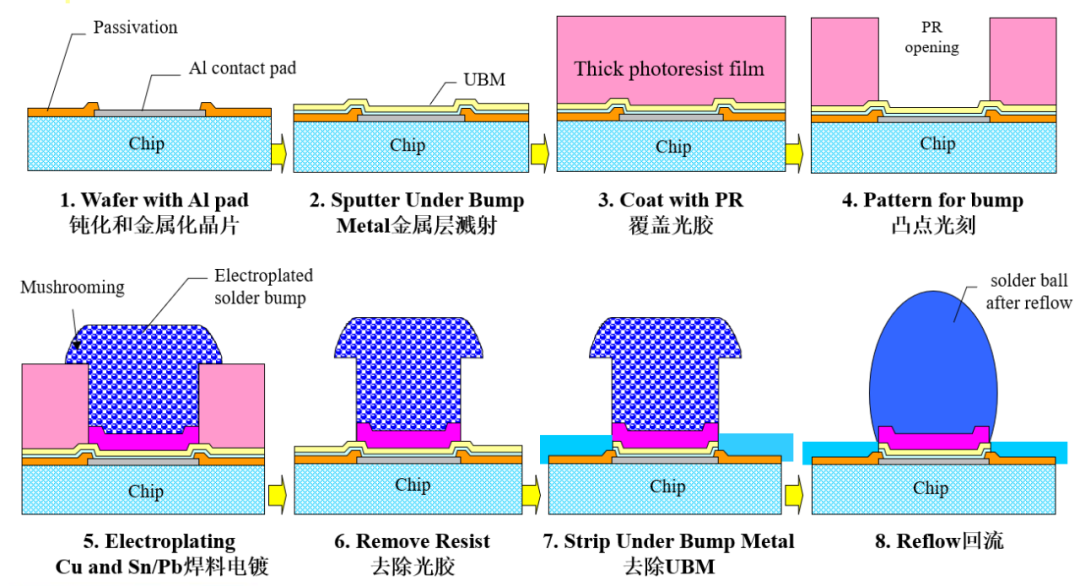

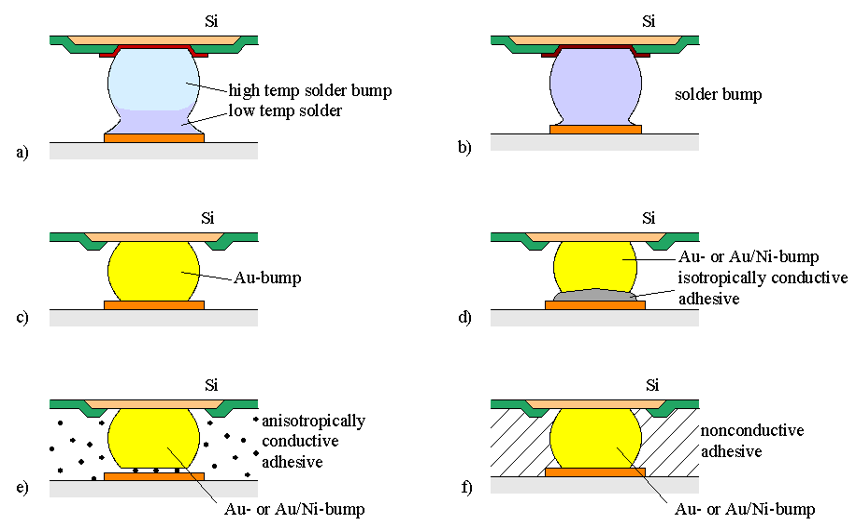
芯片表面形成的凸點在掃描電鏡下觀察到的外觀如下圖所示:
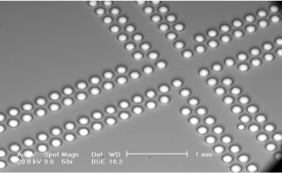
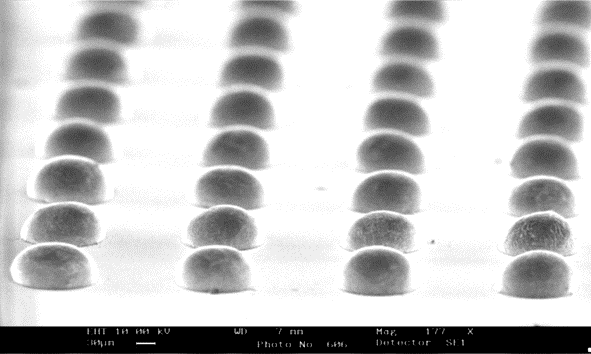
下圖中的左圖是回流(高溫)前的凸點狀態(tài),右圖是經(jīng)高溫后的凸點狀態(tài),經(jīng)高溫后凸點融化成球形。
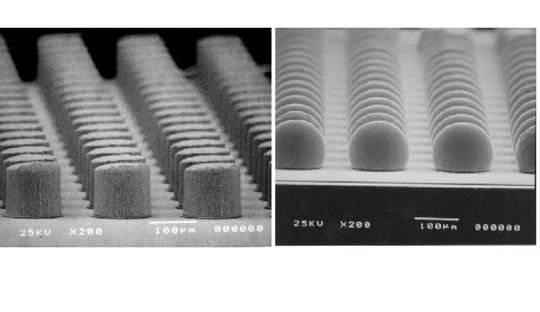
化學鍍UBM和絲網(wǎng)印刷工藝(Electroless UBM and Stencil Printing)是工業(yè)應用中低成本倒裝焊凸點制備方法。
以下是絲網(wǎng)印刷凸點制作流程(Stencil Printing Process Flow)及完成后的凸點形貌:
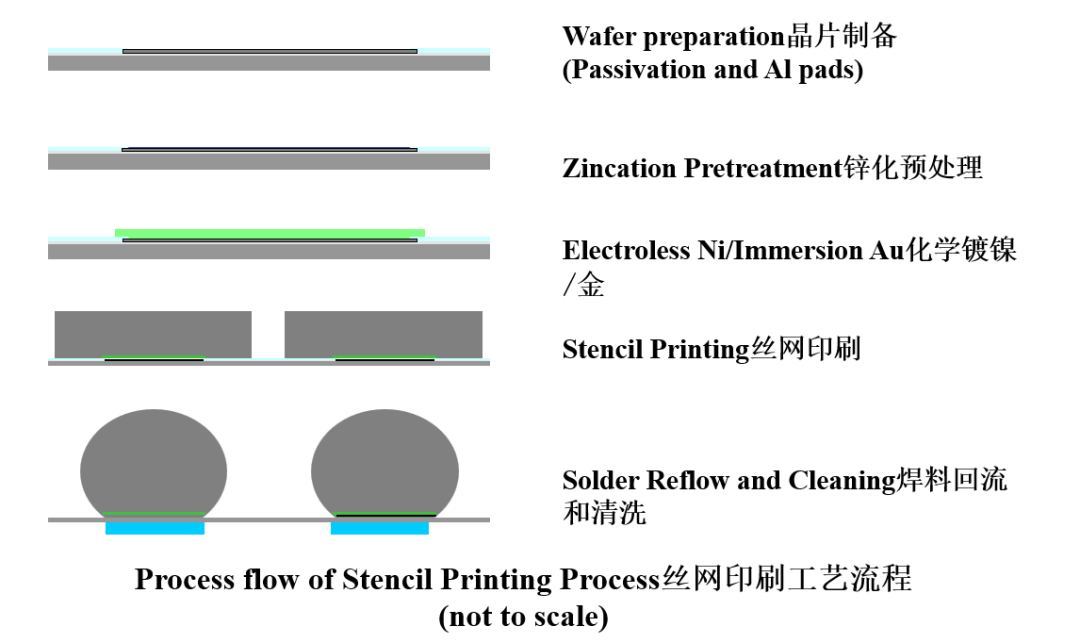


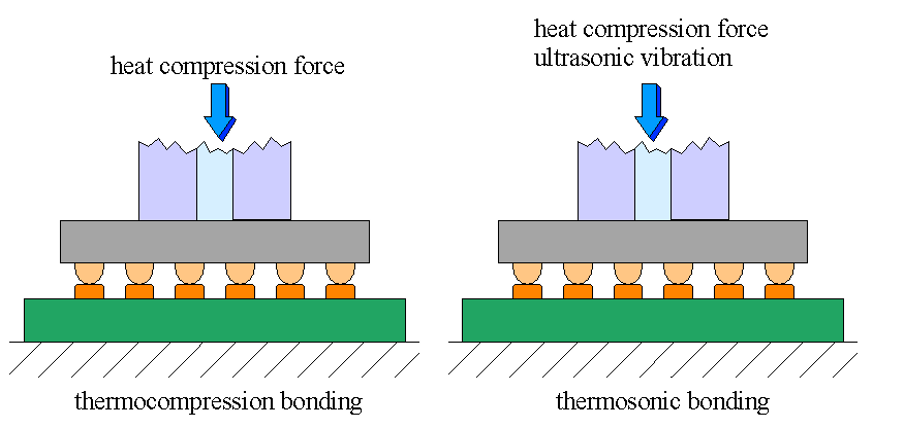
第四步:底部填充與固化
倒裝連接后已完成了芯片與基板的連接,為了提高倒裝穩(wěn)定性,會在倒裝后的芯片與基板之間采用填充膠加固,填膠工藝如下圖所示:
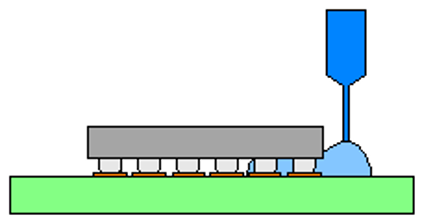

 ?
?
(c)性能增加: 短的互連距離減小了電感、電阻以及電容,保證了信號延遲減少、較好的高頻率、以及從晶片背面較好的熱通道。
(d)提高了可靠性:大芯片的環(huán)氧填充確保了高可靠性。倒裝芯片可減少三分之二的互連引腳數(shù)。

審核編輯:劉清
-
存儲器
+關(guān)注
關(guān)注
38文章
7649瀏覽量
167346 -
連接器
+關(guān)注
關(guān)注
99文章
15382瀏覽量
140455 -
半導體封裝
+關(guān)注
關(guān)注
4文章
293瀏覽量
14460 -
無源濾波器
+關(guān)注
關(guān)注
4文章
80瀏覽量
15474 -
倒裝芯片
+關(guān)注
關(guān)注
1文章
106瀏覽量
16606
原文標題:倒裝芯片技術(shù)—Flip Chip Bonding
文章出處:【微信號:半導體封裝工程師之家,微信公眾號:半導體封裝工程師之家】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
什么是倒裝芯片 倒裝芯片技術(shù)的優(yōu)點 倒裝芯片封裝工藝流程

倒裝芯片和晶片級封裝技術(shù)及其應用
倒裝芯片應用的設(shè)計規(guī)則
所有VIRTEX-6的半導體安裝技術(shù),是倒裝芯片安裝技術(shù)的芯片嗎
SMT環(huán)境中倒裝芯片工藝與技術(shù)應用
倒裝芯片的材料有哪些應該如何設(shè)計

什么是倒裝芯片?倒裝芯片封裝技術(shù)原理圖解






 什么是倒裝芯片技術(shù)?倒裝芯片的技術(shù)細節(jié)有哪些呢?
什么是倒裝芯片技術(shù)?倒裝芯片的技術(shù)細節(jié)有哪些呢?

















評論