“封裝工藝(Encapsulation Process)”用于進行包裝密封,是指用某種材料包裹半導體芯片以保護其免受外部環境影響,這一步驟同時也是為保護物件所具有的“輕、薄、短、小”特征而設計。封裝工藝(Encapsulation Process) 大體上可分為密封法(Hermetic)和模塑法(Molding):密封法(Hermetic)指附接陶瓷板或金屬蓋板進行密封;模塑法(Molding)指先熔化再固化塑料環氧材料(Epoxy)進行密封。在這兩種方法中, 目前很少使用密封法(Hermetic),而多采用使用環氧樹脂模塑料的模塑法(Molding)。就用樹脂填充半導體的方法而言,模塑工藝可以再分為傳遞模塑和壓縮模塑。今天我們先簡單了解一下封裝工藝(Encapsulation Process),隨后再深入了解模塑法。
※封裝、密封、氣封等詞語具有類似含義。本文中,封裝所指的范疇更大,而密封僅限于模塑。
1. 采用膠囊密封材料(Encapsulant)進行包裝密封(package Encapsulation)

圖1. 密封法(Hermetic)和模塑法(Molding)的比較
采用陶瓷或金屬來密封包裝具有經久耐用的優點。因此,這種方法主要應用于特殊領域的設備,如國防和醫療保健等。典型的產品類型包括CPU、可擦除可編程只讀存儲器(Erasable Programmable Read Only Memory,簡稱EPROM、非易失半導體存儲芯片)和電力晶體管(用于電力行業的大功率輸出晶體管)。
密封法可靠性極高,但價格昂貴。因而大多采用使用環氧樹脂模塑料的模塑法。隨著塑料原料中水分和內部空隙等缺陷的不斷改善,塑料的應用范圍正在迅速擴大。就EPROM而言,幾乎在所有情況下都采用塑料材料進行密封,并且大多數的包裝都采用塑料材料,包括動態隨機存取存儲器(DRAM)、中央處理器(CPU)和NAND閃存。
為了便于理解,此處簡單解釋一下,密封法類似于將在工廠預先生產的混凝土板貼到建筑物外墻的方法,而模塑法類似于在施工現場制作模板并澆筑混凝土的方法。雖然模塑法靈活性提高了,但是相比于密封法,其造成混凝土中出現孔隙的可能性更高。
2. 模塑材料:環氧樹脂模塑料(Epoxy Molding Compound,簡稱EMC)
環氧樹脂模塑料(Epoxy Molding Compound,簡稱EMC)作為一種塑料,是半導體后端工藝所需的基本功能材料之一。EMC主要原料為樹脂基材料,其余成份為填料(Filler)和硬化劑。粉末狀環氧樹脂熔化后,在175℃溶解成凝膠狀態時,粘度會變小。當溫度降低后,環氧樹脂固化,粘度與溫度成反比增加。當溫度進一步降低時,環氧樹脂與周圍的印刷電路板(Printed Circuit Board,簡稱PCB)、引線框(Lead Frame)、導線、晶片等牢固粘結,成為硬度非常高的材料。這種材料叫做熱固性環氧樹脂。重要的一點是,材料固化后,當半導體投入使用時,若溫度波動,EMC能夠隨著芯片一同膨脹和收縮。另外,此類材料便于向外散熱,這一點也很重要。因此,可以說此類混合材料的性質決定了EMC的可靠性。
3. 模塑(Molding)工藝類型
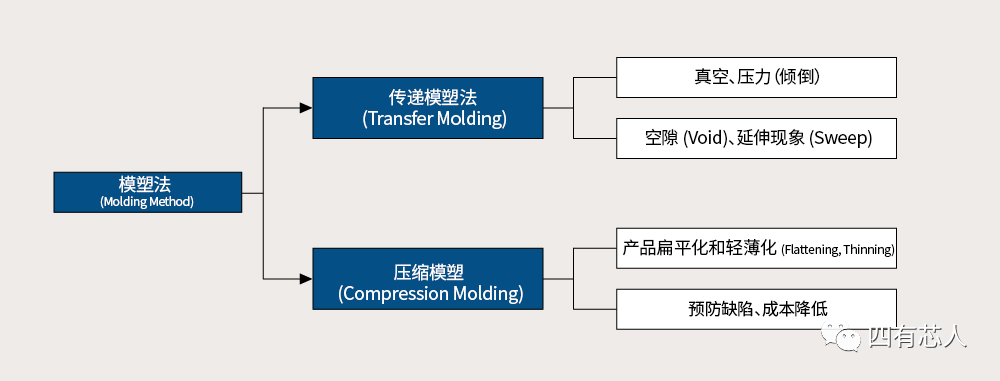
圖2. 模塑(Molding)工藝:傳遞模塑(Transfer Molding)和壓縮模塑(Compression Molding)
模塑(Mold)就是把一件東西做成某種形狀。當進行半導體模塑(Molding)時,會將EMC熔化并注入空腔(Cavity)。負責成型的工具是模塑的關鍵,即模塑板。模塑法包括傳遞模塑法(Transfer Molding)(舊方法)、真空模塑法(Compression Molding)(改進后的方法,可彌補傳遞成型缺點)和壓縮模塑(朝下垂直面向晶片)。
3-1.傳遞模塑(Transfer Molding)
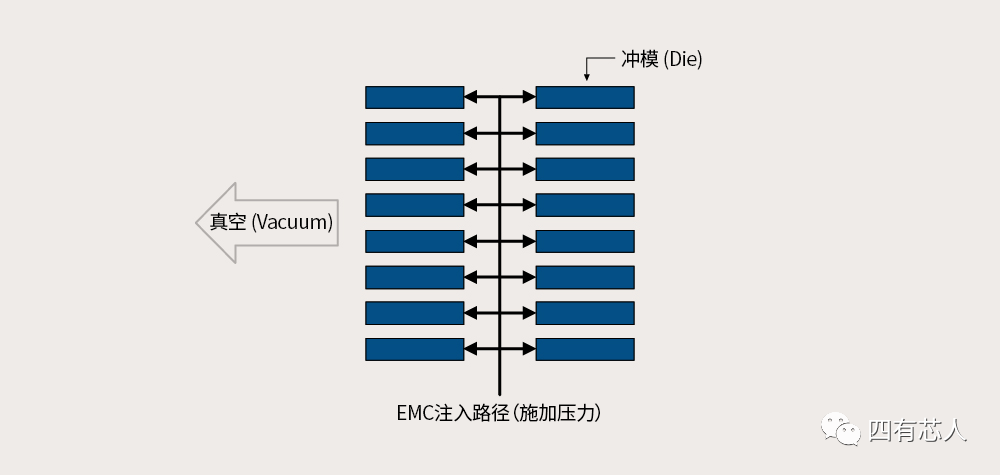
圖3. 傳遞模塑(Transfer Molding)
傳遞模塑法采用樹脂,屬于早期的模塑方法。在這種方法中,將環氧樹脂熔化為凝膠狀態,然后強制施加一定的壓力(Plunging)(傾倒),使其流過多個狹窄的路徑。隨著芯片越來越小,層次越來越多,引線鍵合結構(Wire Bonding)變得越來越復雜,環氧樹脂在模塑過程中不能均勻鋪開,導致成型不完整或空隙(Prosity)(或孔隙)增加。換句話說,環氧樹脂的速度控制變得更加困難。
為了解決這個問題,當移動環氧樹脂通過一條狹窄的路徑時,一種能形成真空并將其從另一側拉出的方法來控制環氧樹脂的速度被采用。此外,人們正在嘗試各種方法來減少空隙,以確保環氧樹脂能夠均勻鋪開。
3-2.壓縮模塑(Compression Molding)
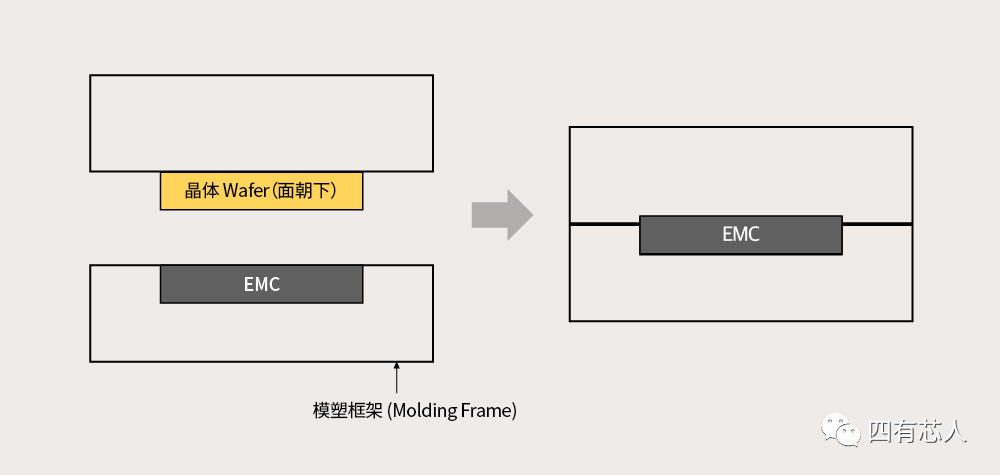
圖4. 壓縮模塑(Compression Molding)
隨著芯片層數的增加(多芯片封裝,Multi Chip Package, 簡稱MCP)和引線鍵合變得更加復雜,傳遞模塑法的局限性逐漸顯露出來。尤其是,為了降低成本,載體(印刷電路板或引線框架)的尺寸變大,因此傳遞模塑變得更加困難。與此同時,由于環氧樹脂難以穿透復雜的結構并進一步鋪開,因此需要一種新的模塑方法。
壓縮模塑法是一種能夠克服傳遞模塑法局限性的新方法。采用這一方法時,EMC被放入模具中,然后再進行熔化。采用壓縮模塑法時,不需要將環氧樹脂轉移到很遠的地方。這種模塑方法需要將晶片垂直向下放置在凝膠狀環氧樹脂上。從而減少了諸如空隙和延伸現象等缺陷,并且通過減少不必要的環氧樹脂的使用而有益于環境。
在使用環氧樹脂進行半導體模塑時,傳遞模塑法和壓縮模塑法被同時采用。由于壓縮模塑法具有缺陷檢測、成本低廉和環境影響小等優點,因此更受供應商青睞。隨著客戶對產品扁平化和輕薄化的需求不斷增加,預計壓縮模塑法將在未來得到更積極的應用。
-
芯片
+關注
關注
459文章
52119瀏覽量
435627 -
半導體
+關注
關注
335文章
28547瀏覽量
231988 -
封裝工藝
+關注
關注
3文章
64瀏覽量
8109
原文標題:封裝工藝(Encapsulation Process)——一種密封包裝方式
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
招聘半導體封裝工程師
招聘人才 封裝工藝工程師
新型封裝工藝介紹
半導體生產封裝工藝簡介
半導體封裝工藝面臨的挑戰






 半導體封裝工藝之模塑工藝類型
半導體封裝工藝之模塑工藝類型




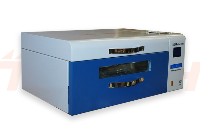











評論