系統(tǒng)芯片 (Sxstem on Chip,SoC)通過(guò)軟硬件結(jié)合的設(shè)計(jì)和驗(yàn)證方法,利用芯核復(fù)用及先進(jìn)制造工藝,將多個(gè)原本獨(dú)立的功能(如邏輯電路、存儲(chǔ)器、混合信號(hào)和微處理器等)集成到單一芯片上,具有高集成度、高速度、體積小、成本低、功耗低等優(yōu)點(diǎn)。系統(tǒng)級(jí)封裝( System in Package, SiP)與SoC 不同的是,SiP 是采用不同芯片進(jìn)行并排或疊加的封裝方式,而 SoC 則是將多個(gè)功能模塊集成在單芯片上。
SoC 設(shè)計(jì)是一種基于嵌人式芯核的設(shè)計(jì),其測(cè)試的關(guān)鍵是核復(fù)用帶來(lái)的核測(cè)試復(fù)用問(wèn)題。另外,SoC 集成了不同來(lái)源、不同類型、不同設(shè)計(jì)的芯核,測(cè)試時(shí)還需要解決測(cè)試數(shù)據(jù)輸人和輸出的有效傳輸、嵌人式芯核互異性等問(wèn)題;此外在內(nèi)核測(cè)試的基礎(chǔ)上,還要完成芯核互連和系統(tǒng)級(jí)測(cè)試。圖所示的是 SoC 內(nèi)嵌芯核測(cè)試訪問(wèn)機(jī)制。由圖可見(jiàn),它是通過(guò)訪問(wèn)測(cè)試殼實(shí)現(xiàn)對(duì)芯核的測(cè)試存取的。
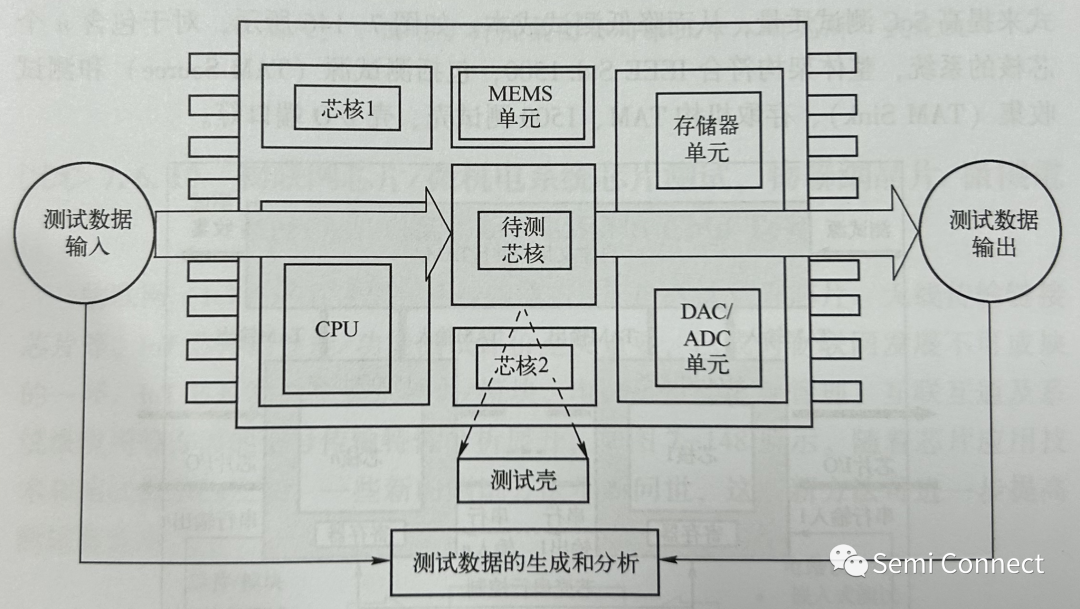
為了解決基于核的SoC 測(cè)試問(wèn)題,必須建立 SoC 測(cè)試隔離、測(cè)試存取、測(cè)試控制和測(cè)試觀察的規(guī)范和標(biāo)準(zhǔn),如IEEE制定的 IEEE Std. 1149.1 (Test AccessPort and Boundary - Scan Architecture , IEEE Std. 1500 ( Testability Method forEmbedded Core - based Integrated Circuits) F IEEE Std. 1450 ( Test InterfaceLanguage ( STIL) for Digital Test Vector Data)等一系列的標(biāo)準(zhǔn)。
TEEE Std. 1149. 1 標(biāo)準(zhǔn)自1990年公布以來(lái),邊界掃描技術(shù)已被廣泛接受和重視。掃描鏈將邏輯測(cè)試存取端子整合到電路內(nèi)部,通過(guò)掃描操作提供可控制性和可觀測(cè)性的人口,使電路的物理測(cè)試存取端子得以簡(jiǎn)化。在此基礎(chǔ)上,JTAC還推出了 IBEE Std. 1149.4(用于數(shù)模混合電路)和IEEE Std. 1149.7(減少了測(cè)試引腳)等標(biāo)準(zhǔn)。
IEEE Std. 1450 標(biāo)準(zhǔn)旨在提供一個(gè)通用的測(cè)試向量圖形描述語(yǔ)言,該語(yǔ)言在EDA 仿真工具和 ATE 上不需要轉(zhuǎn)換即可使用. 建立了 EDA 和 ATE 之間的無(wú)縫鏈接。其中,IEEE Std. P1450.1 提出了標(biāo)準(zhǔn)測(cè)試接口語(yǔ)言(Standard TestInterface Language),該語(yǔ)言將替代傳統(tǒng) BDA 仿真的 VCD、WGL波形文件等。
IEEE Std. 1500 提出了一種可擴(kuò)展的標(biāo)準(zhǔn)架構(gòu),適用于實(shí)現(xiàn)嵌人式內(nèi)核和相關(guān)電路的測(cè)試復(fù)用和集成。IEEE Std. 1500 提出的標(biāo)準(zhǔn)架構(gòu)具有串行和并行測(cè)試訪問(wèn)機(jī)制(Test Access Mechanism),以及豐富的指令集,可用于 SoC 內(nèi)核互連和系統(tǒng)測(cè)試。此外,IBBE Std. 1500 定義丁支持內(nèi)核隔離和保護(hù)的特性,通過(guò)改進(jìn)設(shè)計(jì)文件自動(dòng)轉(zhuǎn)化效率,促進(jìn)可測(cè)性測(cè)試設(shè)計(jì) (DFT)技術(shù),以區(qū)通過(guò)改進(jìn)訪問(wèn)方式來(lái)提高 SoC 測(cè)試質(zhì)量,從而降低測(cè)試成本。如圖所示,對(duì)于包含幾個(gè)芯核的系統(tǒng),整體架構(gòu)符合 IEEE Std. 1500,包括測(cè)試源(TAM Source)和測(cè)試收集(TAM Sink)、存取機(jī)構(gòu)TAM、1500 測(cè)試殼、殼V/0端口等。
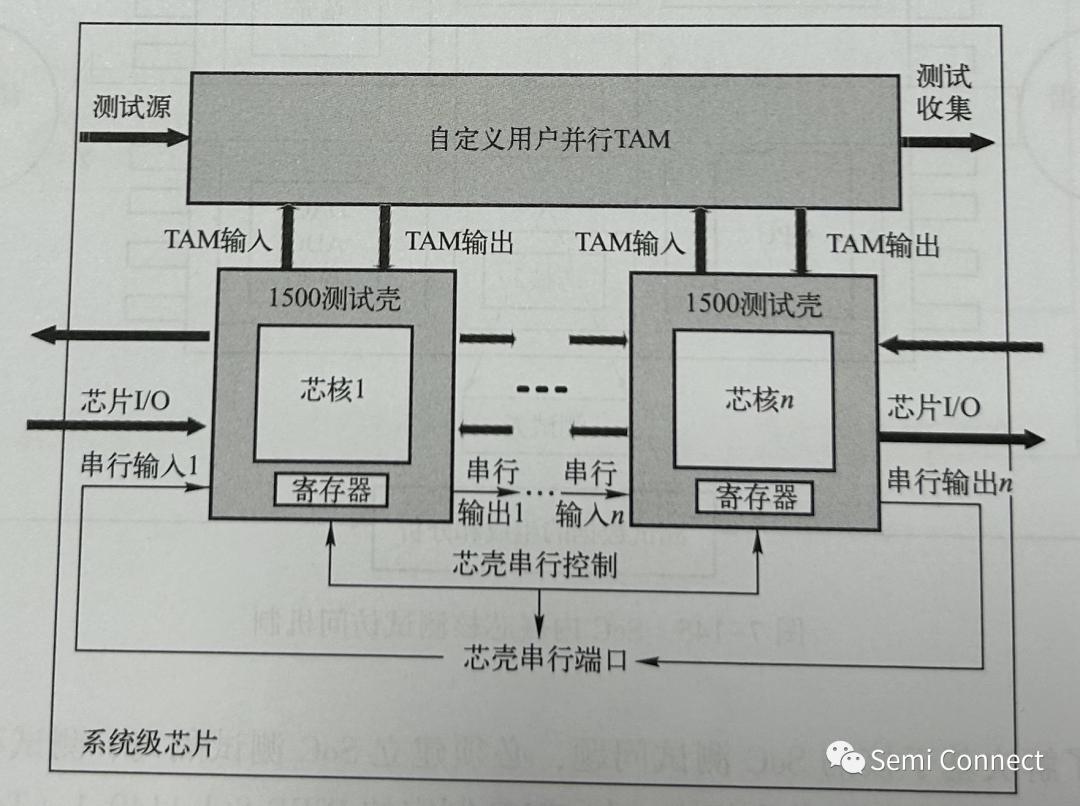
IEEE 標(biāo)準(zhǔn)可有效地解決 SoC 的測(cè)試實(shí)現(xiàn)。SoC測(cè)試的另一個(gè)問(wèn)題是測(cè)試成本。降低SoC測(cè)試成本的有效方法是減少測(cè)試時(shí)間,這一點(diǎn)可采用并發(fā)測(cè)試測(cè)試調(diào)度和測(cè)試壓縮等方法得以實(shí)現(xiàn)。并發(fā)測(cè)試通過(guò)同時(shí)對(duì)被測(cè) SOC 中的多個(gè)功能模塊進(jìn)行測(cè)試,從而將測(cè)試時(shí)間減少到最長(zhǎng)單路徑時(shí)間。
測(cè)試調(diào)度通過(guò)合理分配嵌人式芯核的測(cè)試集和測(cè)試存取機(jī)制,從而達(dá)到多核測(cè)試、減少總線冗余時(shí)間和避免測(cè)試沖突的目的。SoC 集成度和復(fù)雜度的日益提高,以及高故障覆蓋率的需求,導(dǎo)致測(cè)試數(shù)據(jù)日益劇增,測(cè)試壓縮通過(guò)設(shè)計(jì)優(yōu)化測(cè)試激勵(lì)響應(yīng)壓縮方法和測(cè)試策略,達(dá)到減少測(cè)試存儲(chǔ)通道數(shù)據(jù)量、降低測(cè)試功耗和縮短測(cè)試時(shí)間的效果。圖所示的是測(cè)試優(yōu)化方法和目標(biāo)。

審核編輯:劉清
-
邏輯電路
+關(guān)注
關(guān)注
13文章
502瀏覽量
43176 -
存儲(chǔ)器
+關(guān)注
關(guān)注
38文章
7634瀏覽量
166405 -
微處理器
+關(guān)注
關(guān)注
11文章
2370瀏覽量
83848 -
SoC設(shè)計(jì)
+關(guān)注
關(guān)注
1文章
151瀏覽量
19074 -
sip封裝
+關(guān)注
關(guān)注
4文章
66瀏覽量
15697
原文標(biāo)題:系統(tǒng)芯片測(cè)試,系統(tǒng)晶片測(cè)試, SoC Test
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
Smiths Interconnect正式推出高性能Volta系列探針頭,用于晶片級(jí)芯片封裝測(cè)試
VirtualLab:用于微結(jié)構(gòu)晶片檢測(cè)的光學(xué)系統(tǒng)

223 暴力拆解芯片,看看里面的晶片長(zhǎng)啥樣暴力拆解芯片,看看里面的晶片長(zhǎng)啥樣


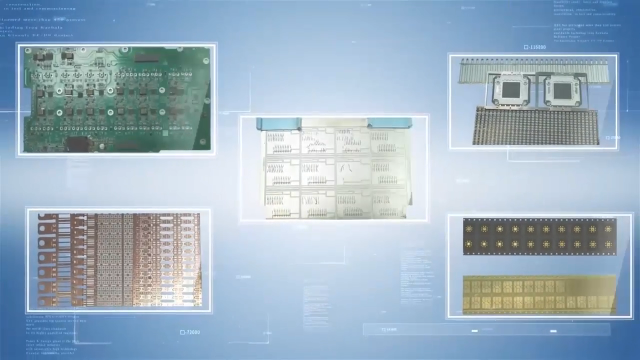
晶片推拉力測(cè)試機(jī)設(shè)備焊接強(qiáng)度推拉力測(cè)試儀#晶片推力測(cè)試 #焊接強(qiáng)度 #推拉力

晶片推力測(cè)試QFP引腳焊點(diǎn)焊接強(qiáng)度測(cè)試芯片焊接強(qiáng)度測(cè)試儀#推拉力測(cè)試機(jī) #測(cè)試芯片
晶片驗(yàn)證測(cè)試及失效分析pdf
***國(guó)家晶片系統(tǒng)設(shè)計(jì)中心VHDL培訓(xùn)教材
晶片邊緣蝕刻機(jī)及其蝕刻方法
倒裝芯片和晶片級(jí)封裝技術(shù)及其應(yīng)用
半導(dǎo)體工藝—晶片清洗工藝評(píng)估
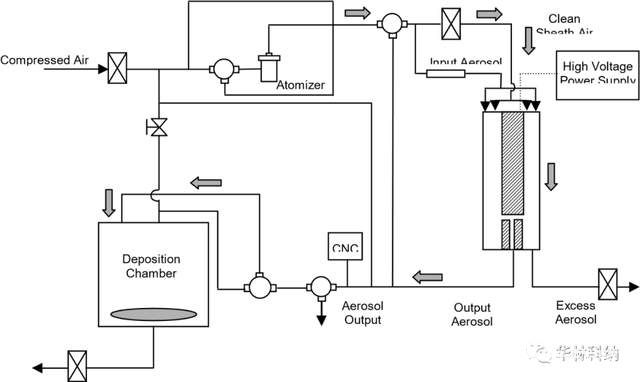
LED封裝晶片便攜式推拉力測(cè)試機(jī)






 系統(tǒng)芯片與晶片測(cè)試
系統(tǒng)芯片與晶片測(cè)試










評(píng)論