離子注入是一種向襯底中引入可控制數量的雜質,以改變其電學性能的方法。它是一個物理過程,不發生化學反應。離子注入在現代硅片制造過程中有廣泛應用,其中最主要的用途是摻雜半導體,離子注入能夠重復控制雜質的濃度和深度。下面簡要描述離子注入的原理和優缺點:
1、阻滯機制
當離子轟擊進入硅襯底后,與晶格原子碰撞將逐漸失去能量,最后停留在硅襯底內。有兩種阻滯機制,一種是注入的離子與晶格原子的原子核發生碰撞,經過這種碰撞將引起明顯的散射并將能量轉移給晶格原子,這種過程稱為原子核阻滯,在這種“硬”碰撞過程中,晶格原子可以獲得足夠的能量而從晶格束縛能中脫離出來,這將引起晶體結構的混亂和損傷。另一種阻滯過程為入射離子與晶格電子產生碰撞,在電子碰撞過程中,入射離子的路徑幾乎不變,能量轉換非常小,而且晶體結構的損傷也可以忽略。這種“軟”碰撞稱為電子阻滯。總阻滯力,即離子在襯底內移動單位距離時的能量損失,可以表示為:
Stotal=Sn+Se
其中,Sn為原子核阻滯力;Se為電子阻滯力。圖1說明了阻滯機制,圖2則顯示了阻滯力與離子速率的關系。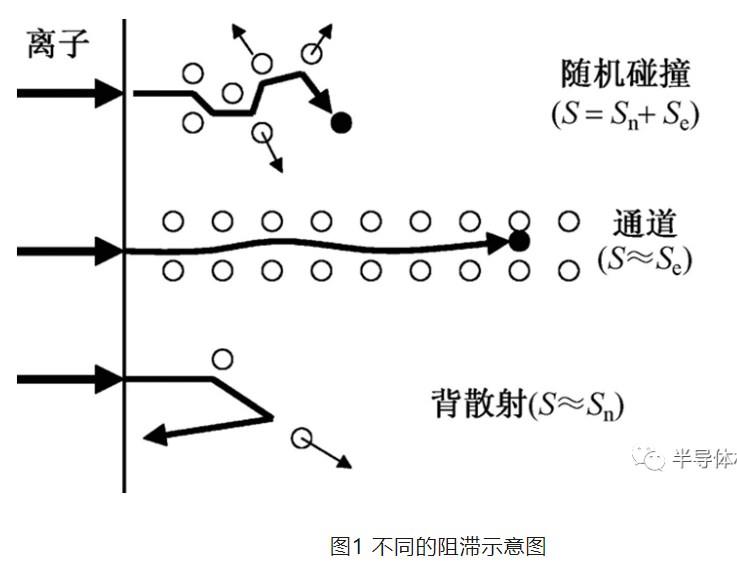

離子注入過程的離子能量范圍從極淺結(Ultra-Shallow Junction,USJ)的0.1keV低能量到阱區注入的1MeV高能量,這個能量范圍如圖2中的I區域所示。從圖的最左邊可以看出對于低能量與高原子序數的離子注入過程,主要的阻滯機制為原子核阻滯。對于高能量、低原子序數的離子注入,電子阻滯機制比較重要。
2、離子射程
帶能量的離子穿過標靶后逐漸通過與襯底原子碰撞失去能量,并最后停留在襯底中。圖3顯示了離子在襯底內的軌跡和離子的投影射程。一般情況下,離子的能量越高,就越能深入襯底。然而,即使具有相同的注入能量,所有離子也無法在襯底內剛好停留在相同的深度,因為每個離子與不同的原子產生撞擊。投影離子射程通常都有一個分布區域(見圖4)。具有較高能量的離子束可以穿透到襯底較深的位置,所以有較長的投影離子射程。因為較小的離子有較小的碰撞截面,所以較小的離子可以進入襯底和遮蔽層材料較深的位置。圖5說明了硅襯底內的硼、磷、砷和銻離子在不同離子能量等級時的投影射程。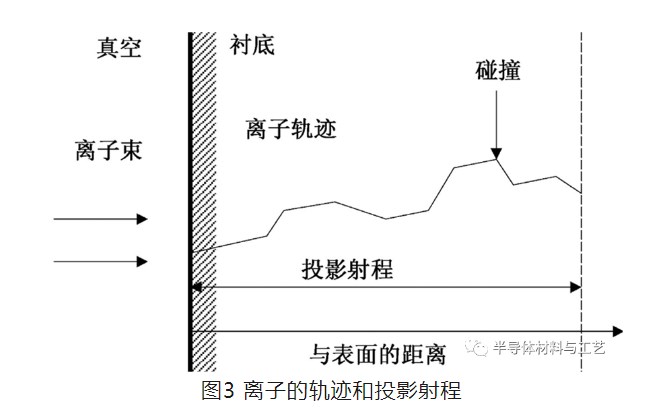

投影離子射程是離子注入技術的一個重要參數,因為它可以表明某一種摻雜物結深所需的離子能量,也能決定離子注入過程中所需的注入阻擋層厚度。圖6顯示了不同的阻擋層材料對200keV摻雜離子所需的厚度。可以看出,當離子能量為200keV時,硼離子需要最厚的遮蔽層。這是因為硼具有最低的原子序數、最小的原子尺寸和最大的投影離子射程,所以具有比任何其他摻雜離子更深的注入停留位置。對于低原子序數的原子,例如硼,高能量時的主要阻滯機制是電子阻滯,原子核阻滯是高原子序數摻雜物原子的主要阻滯機制。同樣,有最高原子序數的摻雜離子銻,具有最高的阻滯力和最短的投影射程,因此需要最薄的遮蔽層材料。
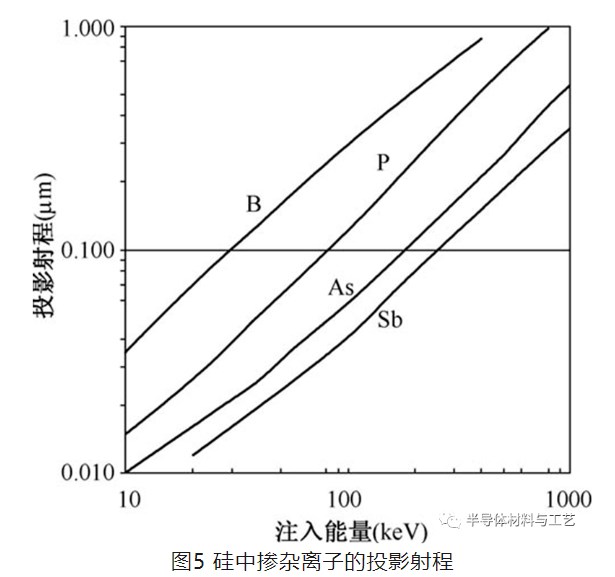
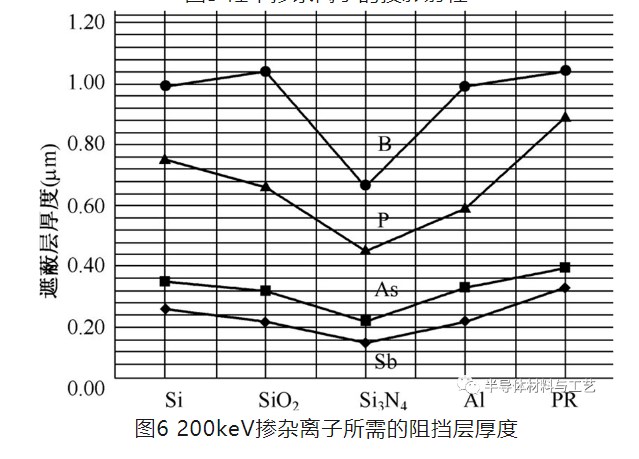
3、通道效應
離子在非晶態材料內的投影射程通常遵循高斯分布,即所謂的常態分布。單晶硅中的晶格原子整齊排列,而且在特定的角度具有很多通道。如果一個離子以正確的注入角度進入通道,它只要具有很少的能量就可以行進很長的距離(見圖7)。這個效應稱為通道效應。通道效應將使離子穿透到單晶硅襯底深處,并在常態摻雜物分布曲線上出現“尾狀”。如圖8所示,這部分并不是想要的摻雜物分布輪廓,因為它將影響元器件的性能。有幾種方法可以減小通道效應。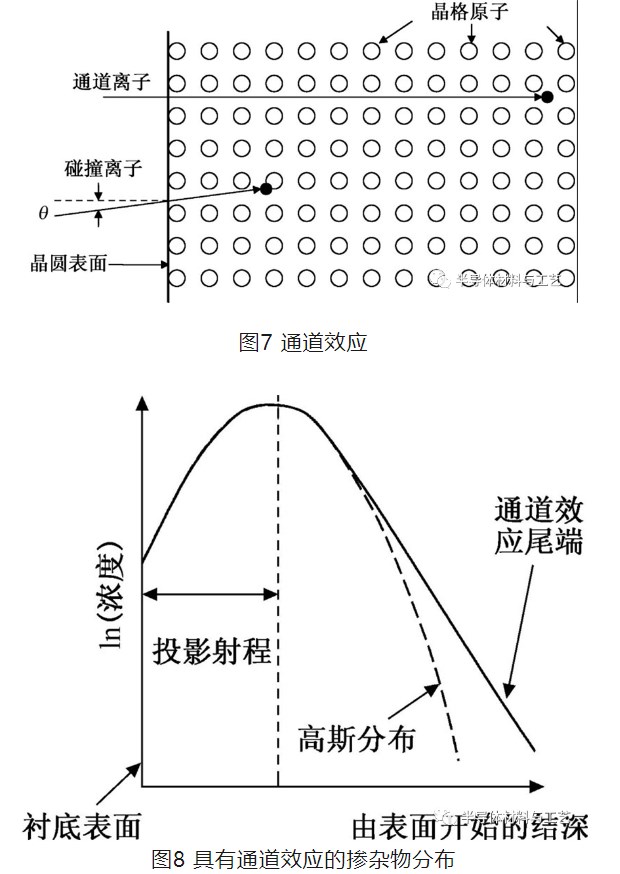
通道效應可以使一個非常低能量的離子穿透到單晶硅的深處。為什么不可以應用這個效應使用不太高的離子能量形成很深的摻雜結?具體原理大家可以思考一下!
4、離子注入的優點
1)精確控制雜質含量:能在很大范圍內控制注入雜質濃度,從1010到1017ions/cm2,誤差在±2%之間。擴散在高濃度控制雜質含量誤差在5%到 10%以內,但濃度越小誤差越大。
2)很好的雜質均勻性:用掃描的方法控制雜質的均勻性。
3)對雜質穿透深度有很好的控制:通過控制注入過程離子能量,控制雜質的穿透深度,增大了設計的靈活性,如埋層,最大雜質濃度在埋層里,最小濃度在硅片表面。
4)產生單一離子束:質量分離技術產生沒有沾污的純離子束,不同的雜質能夠被選出進行注入,高真空保證最少沾污。
5)低溫工藝:注入在中等溫度(小于125℃)下進行,可以使用不同的光刻掩膜,包括光刻膠。
6)注入的離子能穿過薄膜:雜質可以通過薄膜注入,如氧化物或氮化物,這就允許MOS晶體管閾值電壓調整在生長柵氧化層之后進行,增大了注入的靈活性。
7)無固溶度極限:注入雜質含量不受硅片固溶度限制。
5、離子注入的缺點
一是高能雜質離子轟擊硅原子將對晶體結構產生損傷,二是離子注入設備的復雜性。
審核編輯:劉清
-
MOS管
+關注
關注
108文章
2513瀏覽量
69740 -
晶體管
+關注
關注
77文章
9970瀏覽量
140522
原文標題:半導體行業(一百七十四)之離子注入工藝(四)
文章出處:【微信號:FindRF,微信公眾號:FindRF】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
碳化硅離子注入和退火工藝介紹

離子注入技術有什么特點?
SiC的離子注入工藝及其注意事項
離子注入工藝中的重要參數和監控手段






 簡要描述離子注入的原理和優缺點
簡要描述離子注入的原理和優缺點



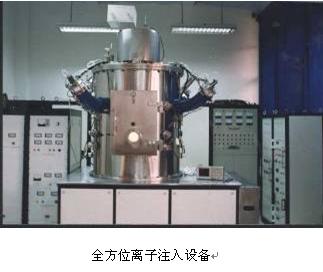
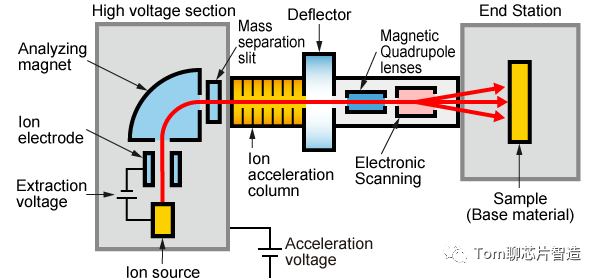
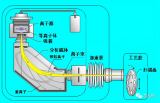
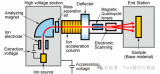











評論