GaN(氮化鎵)器件因其高開關(guān)速度、更高的功率密度和效率等能力而在設(shè)計電源轉(zhuǎn)換器中變得流行,但 GaN 器件的一個缺點是電流崩潰由于當(dāng)器件關(guān)閉和熱電子效應(yīng)時被俘獲的電荷。因此 GaN 器件提供 R DSon(動態(tài)導(dǎo)通狀態(tài)電阻),這使得 GaN 半導(dǎo)體中的傳導(dǎo)損耗不可預(yù)測。捕獲的電荷通過偏置電壓 V off、偏置時間 T off以及開關(guān)狀態(tài)下電壓和電流之間的重疊來測量。當(dāng)器件開啟時,處于關(guān)閉狀態(tài)的俘獲電荷被釋放,因此開啟狀態(tài)時間 T on 等參數(shù)、硬開關(guān)或軟開關(guān)、開關(guān)損耗 和溫度會影響器件動態(tài) R DSon從其靜態(tài) R DSon值發(fā)生變化。研究人員試圖觀察電壓、電流和溫度的變化對動態(tài)R DSon 的影響,可以得出結(jié)論,R DSon比靜態(tài)R DSon提高了50% 。動態(tài) R DSon實際上可以幫助工程師準(zhǔn)確確定電源轉(zhuǎn)換器中的損耗。本文將重點介紹用于測量動態(tài) R DSon的GaN 器件模型價值。所提出的模型將在高頻和穩(wěn)態(tài)下進(jìn)行驗證。將使用軟開關(guān),因為它具有消除熱電子效應(yīng)和較少開關(guān)損耗的優(yōu)點。
GaN-HEMT 動態(tài)RDSon
圖 1 顯示了測量 R DSon 的電路圖。它由三部分組成:器件開關(guān)電路 (DSC)、被測器件 (DUT) 和電壓鉗位電路 (VCC)。圖 2 顯示了測量電路的原型。DUT 和 DSC 組合形成 H 橋,因此可以通過控制四個開關(guān)的信號來設(shè)置 DUT的 t on和 t off。VCC 用于提高分辨率。在關(guān)閉狀態(tài)下,M 1兩端的電位將為 V DC且 V DS(m) = -V Th而在 DUT 的開啟狀態(tài)下,ΔV = 0 所以 V DS(m) = V DSon。所以不是測量 V DS,V應(yīng)測量DS(m)。齊納二極管Z 1和肖特基二極管S 1不允許負(fù)載電流流過V CC。建議的 V CC將使我們能夠計算DUT 的 R DSon。
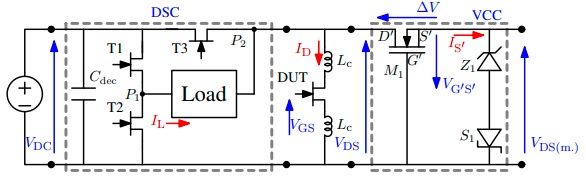
圖 1:測量電路電路圖

圖 2:測量電路原型
測量方法
GaN 半導(dǎo)體器件的動態(tài) R DSon值取決于 T on和 T off。為了獲得由于電荷俘獲和解俘而產(chǎn)生的時間常數(shù),R DSon被表征為不同的 T on和 T off。使用的負(fù)載為 RL,死區(qū)時間為 τ。測量過程分為四個階段,如圖 3 所示。在從 0-T1 的第一階段,DUT 和 T 2 導(dǎo)通,因此 I L為 0。第二階段是 T 1 -T 2,其中 T 2和 T 3處于導(dǎo)通狀態(tài),在這種情況下, I L被充電在反向循環(huán)中。被測設(shè)備off是在這個階段計算的。第三階段是 T 2 -T 3在這個階段 T 2 導(dǎo)通并且 DUT 在 T 2上的 ZVS 處導(dǎo)通并開始反向傳導(dǎo),直到 I L達(dá)到 0。在第四階段 T 3 -T 4 DUT 和 T 1都是ON 和 I L改變方向并開始正向傳導(dǎo)。因此,DUT的 T on由第三個和第四個間隔定義。因此,將R DSON在反向傳導(dǎo)模式可迅速在納米第二從第三級和將R獲得微秒DSON在正向?qū)J较驴梢詮牡谒碾A段獲得微秒到秒的時間。
對于該實驗的GaN晶體管是焊料進(jìn)入子板,以確定它的R DSON在V DC=200V和我d = 1個A.通過驗證?關(guān)閉和T上,R DSON可以得到。由于柵極電壓達(dá)到6V我們的器件打開,我們會盡快[R DSON rapidlyin為50ns。在RDSon值上觀察到捕獲效應(yīng),它在 100us 內(nèi)增加了靜態(tài)RDSon值的 25% 。然后直到 1秒它以緩慢的速度增加,從 1-10秒動態(tài)RDSon迅速增加 70%,30 秒后穩(wěn)定。在去陷阱效應(yīng)的情況下,R DSon的值下降到 10us,然后在 10ms 后穩(wěn)定,然后再次下降,直到 T on達(dá)到 50s。

圖 3:單脈沖控制信號下的四個操作階段
實驗結(jié)果
在瞬態(tài)和穩(wěn)態(tài)期間
首先,H 橋在 RL 負(fù)載下運行,其中 T1 關(guān)閉,T2 開啟,V DC = 200V,IL = 1.3A,f = 100kHz 和 D = 50%。DUT 在反向傳導(dǎo)和軟開關(guān)模式下運行。可以控制電源轉(zhuǎn)換器操作期間的R DSon變化。R B DSon表示在開啟周期開始時測得的RDSon值,而 R E DSon表示在開啟周期結(jié)束時測得的RDSon值 。結(jié)果表明,當(dāng)電源轉(zhuǎn)換器工作時,R DSon值緩慢增加至 3s,然后迅速增加至 30s,R DSon值100 秒后穩(wěn)定。在圖 3 中也觀察到了這種轉(zhuǎn)變。3. 因此,該模型可用于表示功率轉(zhuǎn)換器運行期間GaN 器件的瞬態(tài) R DSon值。
不同開關(guān)頻率下
在這種情況下,將改變電源轉(zhuǎn)換器的開關(guān)頻率以檢查對 R DSon值的影響。為了提高電源轉(zhuǎn)換器的開關(guān)頻率,我們必須減少連接到 GaN 晶體管的損耗,為此我們將使用 LC 負(fù)載而不是使用 RL 負(fù)載。TZCM(梯形電流模式)用于軟開關(guān)并實現(xiàn)添加相移。在 TZCM 中,R DSon是在恒定電流幅度期間測量的 。頻率從 100kHz 增加到 1MHz。當(dāng) DUT 和 T2 導(dǎo)通且處于反向?qū)J綍r,可以測量R DSon的值。R DSon 的這個值將被視為 R B DSon.在正向傳導(dǎo)模式下,DUT 和 T1 將導(dǎo)通,I L由 V DC充電。然后 T1 將切換到關(guān)閉狀態(tài),R DSon的值將在恒定電流幅度下測量,這實際上是 R E DSon。結(jié)果表明,當(dāng)電源的開關(guān)頻率增加時,R B DSon和 R E DSon之間的差異會減小 。實測值與模型相差10%左右。
結(jié)論
在文章中,提出了一個模型來計算功率轉(zhuǎn)換器應(yīng)用中 GaN-HEMT 器件的動態(tài) R DSon值。顯示了一個測量電路,用于獲得不同 ON 和 OFF 狀態(tài)下的 R DSon值。根據(jù)建議的模型,設(shè)計人員可以成功預(yù)測電源轉(zhuǎn)換器中的傳導(dǎo)和開關(guān)損耗。該電路還針對瞬態(tài)響應(yīng)和不同的開關(guān)頻率進(jìn)行了測試。兩個 R DSon的差異小于 10%。已經(jīng)觀察到,在電源轉(zhuǎn)換器操作期間,RDSon的值會在 100 秒后穩(wěn)定下來。
審核編輯:郭婷
-
電源
+關(guān)注
關(guān)注
185文章
18276瀏覽量
255049 -
轉(zhuǎn)換器
+關(guān)注
關(guān)注
27文章
8961瀏覽量
150769 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28613瀏覽量
232790
發(fā)布評論請先 登錄
GaN-HEMT器件的動態(tài)R DSon值測量實驗分析
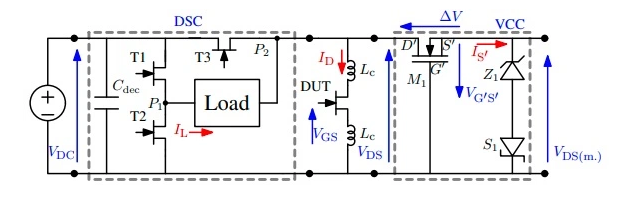
GaN FET重新定義電源電路設(shè)計
實時功率GaN波形監(jiān)視的必要性討論
GaN HEMT在電機(jī)設(shè)計中有以下優(yōu)點
GaN HEMT可靠性測試:為什么業(yè)界無法就一種測試標(biāo)準(zhǔn)達(dá)成共識
SGNE010MK GaN-HEMT
SGK7785-60A GaN-HEMT
SGM6901VU GaN-HEMT模塊
借助高能效GaN轉(zhuǎn)換器,提高充電器和適配器設(shè)計的功率密度
借助高能效GaN轉(zhuǎn)換器,提高充電器和適配器設(shè)計的功率密度
基于GaN HEMT的半橋LLC優(yōu)化設(shè)計和損耗分析
高功率GaN HEMT的可靠性設(shè)計
GaN HEMT工藝全流程
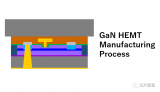





 在高頻電源轉(zhuǎn)換器中演示基于GaN-HEMT的動態(tài)Rds電阻
在高頻電源轉(zhuǎn)換器中演示基于GaN-HEMT的動態(tài)Rds電阻










評論