眾所周知,硅的熱氧化動力學是一個復雜的過程,涉及到氧化劑進入表面,通過剛剛生長的氧化層運輸,最后在大塊硅和SiO之間的界面上發生反應,盡管有許多工作致力于這個問題,但一些關鍵的現象還沒有得到很好的解釋,如預氧化表面處理的影響,這些表面處理的目標是清潔硅表面的污染物,去除天然的氧化物層,并通過鈍化過程改變化學反應行為。
根據所使用的清洗步驟順序,特別是最后一步,表面處理不僅強烈影響生長速率,而且強烈影響整體氧化物和Si/Sio2界面的性質,通過傅里葉變換紅外光譜(FTIR)對薄氧化物層的結構質量進行了比較分析,并與不同的清洗程序所產生的影響有關,這些都是基于標準的RCA方法加上高頻溶液蝕刻法,所得結果表明,紅外技術能夠理解所涉及的現象和完成XPS分析。
結合四種清潔處理,CLI(a+b);CL2(b+a):CI3(d+e);CL4(d+e+c)在不同的步驟之間,晶片在4次降雨中用水沖洗,對兩組晶片進行了實驗,在第一組晶片中,在T = 950°C下,在常規爐中氧化晶片35分鐘(標記為F過程),所有的火焰都被一起氧化了,這是一個非常重要的特征,在第二個過程中,晶片在T=1050°C的快速熱氧化(RTO)爐中被氧化,就在氧化之后,兩組的一些晶片在常規爐中在1000℃退火15分鐘(AF ),或者通過快速熱退火工藝(RTA)在1050℃退火15秒。
因此,為了提高信號/噪聲比,選擇了使用偏振和非偏振的高光譜的反射吸收技術,使用徹底的處理來消除來自硅襯底的背景光譜特征和干擾因素,用這種方法,可以測量厚度小于20的薄膜,此外,由于吸收峰的位置取決于幾何特征(例如入射角或層厚),因此需要仔細模擬紅外光譜,以便將振動頻率與其他作者先前使用透射數據報告的振動頻率進行比較。 二氧化硅紅外光譜的特征經過廣泛的研究,它們在大約450、800和1075厘米處顯示出三個特征光譜峰,由于靈敏度原因,如果入射角偏離法線并且層的厚度低于IR波長,則可以觀察到這種分裂。應力值隨退火過程的演變可以解釋,假設輪胎氧化物松弛應力的粘彈性模型,通過比較計算出的應力弛豫時間,作為溫度的函數,與退火時間,可以解釋AF過程中氧化層的弛豫程度較高。
為了確定氧化過程和/或清洗處理對紅外光譜的影響,比較了相同表面處理的不同氧化過程和退火過程。觀察到(表1 ), RTO工藝使t0-3個峰值位置的波數值高于傳統工藝,此外,退火過程使t0-3峰向更高值移動,在該表中,還指出了根據實驗結果計算的0°透射條件下的吸收峰位置。

觀察到RTO過程使TO3的峰值位置處于比傳統爐1更高的波數值,此外,退火過程產生了TO3峰向更高的值的移動。在這個表中,我們還指出了0°傳輸條件下的吸收峰位置,并計算出了實驗結果。
通過將作為溫度函數的計算應力松弛時間與退火時間進行比較,可以解釋AF過程中氧化層更高程度的松弛,在表中,定義為將應力降低到其初始值的l/e所需的時間,AF工藝的退火時間(1000 ℃)高于其弛豫時間,因此結構變得弛豫,相反,RTA退火時間比該溫度(1050℃)下的弛豫時間短,結果,該層變得不太松弛。因此,為了在分析預氧化處理對應力值的影響時,我們必須考慮所用的熱處理程序,分析了清洗處理對兩組樣品的紅外光譜的影響,如果比較IR光譜(圖1),我們看到在氧化之前進行HF最終步驟的晶片中的t0-3峰值振幅增加。由于氧化時間相同,這一結果與之前報道的較厚的氧化物層的數據一致。

為了解釋結果,我們華林科納進行了XPS分析,與其他清洗過程相比,在高頻最后一步的樣品中,亞信號具有較小的振幅,這些亞羧基層對應于從晶體硅到非晶SiO的轉變,它允許氧化物在沒有界面上存在的固有應力的情況下生長。因此,較小的過渡亞層,最后一步高頻清洗晶片給予更少的應力松弛,該過渡層的厚度可能與清洗過程之后和氧化之前剩余的氧化層有關。
盡管事實上表中報告的FWHH值沒有顯示出顯著的變化,但t0-3個峰顯示出不同的形狀
這取決于清潔過程,對于RTO,觀察到類似的行為,盡管每個成分的重要性并不為人所知,但是這種方法可以增強t0-3吸收帶的變化。
假設t0-3頻率分布與Si-O-Si角度分布相關,可以解釋這種變化,因此,這種分布的微小變化將改變較高或較低頻率的貢獻。然后由于在HF最終步驟后獲得的氧化層顯示出較高的面積比,這可能表明氧化層更加均勻。
總之,報道的結果顯示了HF最終步驟清洗對熱生長氧化物結構的影響。此外,與用H、SO4或RCA最后清洗獲得的層相比,這些層具有更大的壓縮應力,這是由于不同的界面過渡層厚度。此外,退火處理可以改變應力值。
審核編輯:符乾江
-
芯片
+關注
關注
459文章
52151瀏覽量
436018 -
紅外光譜
+關注
關注
0文章
80瀏覽量
12194
發布評論請先 登錄
如何利用高光譜相機實現精確的光譜分析?

長光辰芯發布光譜分析專用線陣CMOS圖像傳感器GLR1402BSI-M
愛德萬ANVANTEST Q8341 光譜分析儀
紫外線光譜分析與應用 紫外線水處理系統的工作原理
安立Anritsu MS9710B 光譜分析儀
Agilent/安捷倫86146B 光譜分析儀
近紅外光譜儀的原理和工作機制
近紅外光譜儀校準方法 近紅外光譜儀與紫外光譜儀區別
SiO2薄膜的刻蝕機理
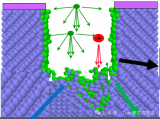
Anristu安立MS9740A光譜分析儀
手持式紅外地物光譜儀在環境監測中的應用






 硅片清洗處理對紅外光譜分析的 Si SiO2 界面
硅片清洗處理對紅外光譜分析的 Si SiO2 界面











評論