引言
為了在半導(dǎo)體工藝中獲得均勻的電氣特性、高可靠性和高倍率,保持硅酮基板清潔度的技術(shù)隨著半導(dǎo)體器件的高密度化,其重要性日益增加。一般來說,半導(dǎo)體工藝中三個定義的目的是從基板表面去除粒子、有機(jī)物(organic residues)、轉(zhuǎn)移金屬和堿金屬。為此,目前再半導(dǎo)體制造過程中使用的方式可以分為干式和濕式工藝,濕式工藝與干式相比,污染物去除率顯著提高,自20世紀(jì)70年代由美國RCA Lab的Kern "開發(fā)以來,基本組成藥品沒有變化,至今廣泛用于半導(dǎo)體工藝。
將N型(100)硅單晶用CZ法和外延法生長的基板熱處理800℃到120℃后,用SCI溶液反復(fù)清洗用NH'F去除氧化膜的基板。清洗的基板使用激光散射法和熱波圖像儀觀察了表面產(chǎn)生的缺陷。報告說,CZ基板上表面的缺陷與熱處理溫度和時間成正比地增加,SCI溶液清洗蝕刻了表面的缺陷,減少了缺陷,KIK基板上的缺陷與熱處理溫度和時間無關(guān)。另外,“Ryuta等”、“銀”報告了SCI清洗后發(fā)現(xiàn)的缺陷是在Si決定內(nèi)從缺陷中衍生出來的pit,而不是particle。觀察到SCI溶液中pit的數(shù)量隨著固定時間的增加而增加。pits基板在16次清洗后仍未形成pits。在上述兩項研究中,前者側(cè)重于氧化過程,后者強(qiáng)調(diào)SCI清洗,進(jìn)行了實驗,但不足以將清洗與氧化的關(guān)聯(lián)與實際工藝聯(lián)系起來。此外,基板上的缺陷測量主要是利用無基板上的方法進(jìn)行的本研究利用KLA公司的晶片搜索設(shè)備,通過觀察連續(xù)的SCI清潔-氧化過程對硅襯底表面的影響,特別是是否形成缺陷來進(jìn)行。

通過搜索,KLA比LPS對缺陷位置的再現(xiàn)能力更好,因此除了將LPS用作比較實驗外,所有基材都使用KLA進(jìn)行了檢查。所有基板在試驗前后分別測量了基板表面的缺陷。KLA的pixel大小為0.63?為了用固定,縮短搜索時間,只搜索了總基板面積的40%左右。LPS只能搜索簡單的缺陷,但KLA不僅可以在搜索后觀察缺陷,還可以在確定一個基板經(jīng)過多道工序后發(fā)現(xiàn)的每個缺陷是新出現(xiàn)的缺陷還是已經(jīng)存在的缺陷的允許范圍內(nèi)決定了。
沒有氧化過程,為了觀察SCI在80℃到的三個正時之間對每個基板表面的影響,上述晶片在0.5wt%的HF溶液中冷卻75秒后,從1 : 2 : 10和1:1: 5( NH4OH : H202 : HQ)比率的SCI清洗了60分鐘。由于SCI內(nèi)的NHQH,SCI溶液不僅會腐蝕硅,還會腐蝕氧化膜。比例為1:1:5的SCI溶液會增加表面的細(xì)度,影響氧化膜的可靠性等,因此SCI溶液內(nèi)的NH、OH
的比例有減少的趨勢嗎?因此,本實驗使用1:2: 10比例的SCI,而不是1:1:5比例,觀察了對硅基板的影響。比例為1:1: 5的SCI溶液用于比較目的。基板上形成圖案后,連續(xù)氧化實驗中使用的基板在氧化前。在5wt% HF下冷卻75秒后,在1:2: 10 SCI溶液中清洗10分鐘后,KLA測定了基板的缺陷。缺陷測量后,400A、200A、400 A的3次pad氧化膜和150A的gate氧化膜在900 C、Q/HC1氣氛下生長。每次氧化膜生長后,氧化膜在HF中冷卻1100秒,過濾氧化膜后,在SCI溶液中清洗10分鐘,然后被KLA每次重新檢查。氧化膜的厚度和SCI蝕刻時間設(shè)置與實際半導(dǎo)體制粗工藝相似。
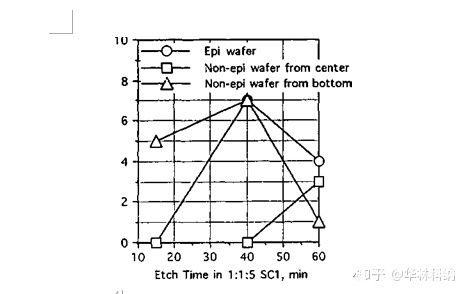
結(jié)果和考察
在以HF為最后清潔液的濕法工藝生成的疏水(hydrophobic)的硅SCI溶液中反復(fù)處理HF時,為了觀察清潔和凈化引起的表面變化,在SCI溶液內(nèi)將無SCZ和外延圖案的CZ和IPIOSILION基板浸泡60分鐘。如Fig. 3所示,在比例為1:1:5的SCI溶液中,15分鐘、40分鐘和60分鐘的清洗后,LPS導(dǎo)管的CZ基板上的缺陷數(shù)與清洗前相比沒有太大差異。在外延中1:2: 10比例的SCI溶液中,也觀察到了同工同酬的結(jié)果。
LPS搜索中缺陷的數(shù)量沒有變化,因此使用KLA再次確認(rèn)在SCI溶液中清洗對硅表面的影響,并使用KLA將有圖案的CZ和外延硅基板在1:2: 10和1 : 1 : 5 SCI溶液中再次清洗60分鐘。在1 : 2 : 10和] : ] : 5比例的SCI溶液中,三個FIG . 4(A)和CZ基板顯示了清洗后產(chǎn)生的缺陷,作為清洗時間的函數(shù)。沒有外延的CZ基板在硅ingot晶體中,由于基板的位置不同,氧氣量也不同,為了了解基板位置的影響,在ingot的中央和底部進(jìn)行了分類,并用于實驗。
連續(xù)氧化-HF-SC1清洗在硅表面產(chǎn)生pit等缺陷,為了觀察酸化過程對表面缺陷形成的影響,CZ基板在N2氣氛下退火110至4小時后,與之前的其他基板一樣,在900℃下經(jīng)歷了連續(xù)氧化-HF-SCI清洗過程。正如Fig. 8所見,這種高溫退火后的連續(xù)氧化過程隨著酸化的不斷增加,缺陷的數(shù)量迅速增加。這被認(rèn)為是110的退火過程在室溫表面形成了defect nuclei,隨后的連續(xù)氧化,即在900℃相對較低的溫度下生長,無法移動到硅的內(nèi)部(bulk)部分,殘留,隨著HF-SCI清洗的重復(fù),其密度增加,在晶圓表面留下了pit等缺陷。這些缺陷將成為導(dǎo)致gate氧化膜低的原因之一。
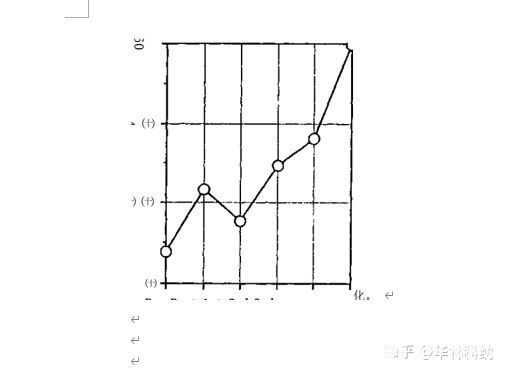
結(jié)論
通過清洗時間和連續(xù)氧化和HF蝕刻考察了SCI清洗對硅片表面的影響,得出的結(jié)論如下:
當(dāng)HF蝕刻硅基板從80℃清洗到1:2: 10和1:1: 5比例的SCI溶液中清洗60分鐘時,LPS或KLA定向的缺陷數(shù)不僅在CZ基板上,而且在IPI基板上,缺陷數(shù)也沒有隨著SCI清洗時間的變化而變
(2)當(dāng)IPI和CZ硅基板重復(fù)連續(xù)的酸化-HF蝕刻-SCI清洗過程時,IPI基板隨著SCI清洗和氧化過程的不斷進(jìn)行,基板表面缺陷的數(shù)量有所減少。但是,隨著CZ基板重復(fù)氧化-HF蝕刻-SCI三個定義過程,缺陷的數(shù)量直線增加。這可以認(rèn)為,外延基板與CZ基板相比,缺陷或雜質(zhì)少得多,在氧化過程中不會在表面生成氧化析出物等缺陷。
(3)通過反復(fù)氧化-HF蝕刻-SCI清洗的共晶生成的CZ基板表面缺陷是裂紋為0.7展示了以下pit一樣的形象。觀察到,這些缺陷隨著工藝的重復(fù)而增加。這不是由LPS或KLA測量的大小缺陷由簡單的SCI清洗產(chǎn)生的,而是由前后的其他工藝(氧化和HF蝕刻燈)產(chǎn)生的。
審核編輯:符乾江
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28890瀏覽量
237595 -
蝕刻
+關(guān)注
關(guān)注
10文章
424瀏覽量
16083
發(fā)布評論請先 登錄
晶圓蝕刻擴(kuò)散工藝流程

晶圓蝕刻后的清洗方法有哪些

晶圓表面清洗靜電力產(chǎn)生原因
芯片清洗機(jī)用在哪個環(huán)節(jié)
半導(dǎo)體清洗SC1工藝
晶圓高溫清洗蝕刻工藝介紹
spm清洗和hf哪個先哪個后
芯片清洗機(jī)工藝介紹
SiC外延片的化學(xué)機(jī)械清洗方法

深入探討 PCB 制造技術(shù):化學(xué)蝕刻
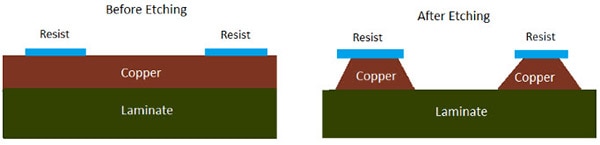
8寸晶圓的清洗工藝有哪些
芯片濕法蝕刻工藝
玻璃電路板表面微蝕刻工藝
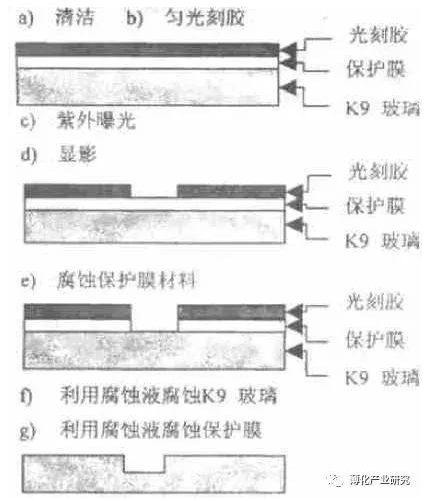





 HF蝕刻堿性化學(xué)清洗工藝對硅表面的影響
HF蝕刻堿性化學(xué)清洗工藝對硅表面的影響












評論