近幾年,先進封裝已成為半導體越來越普遍的主題。在由多個部分組成的系列中,將深入研究實現(xiàn)先進封裝技術(shù),如高精度倒裝芯片、熱壓鍵合(TCB)和各種類型的混合鍵合(HB)。首先讓我們討論一下對先進封裝的需求,摩爾定律正在以迅猛的速度發(fā)展。自臺積電 32nm 失誤以來,直到目前的 5nm 工藝節(jié)點,臺積電的晶體管密度每年增長 2 倍。盡管如此,真實芯片的密度每 3 年增長約 2 倍。這種較慢的速度部分是由于 SRAM 縮放、功率傳輸和熱密度的消亡,但大多數(shù)這些問題都與數(shù)據(jù)的輸入和輸出有關(guān)。

芯片上數(shù)據(jù)的輸入和輸出 (IO) 是計算的命脈。將內(nèi)存置于芯片上有助于通過減少通信開銷來減少 IO 需求,但歸根結(jié)底,這是一種有限的擴展途徑。處理器必須與外部世界進行交易以發(fā)送和接收數(shù)據(jù)。摩爾定律使業(yè)界的晶體管密度大約每 2 年增加 2 倍,但 IO 數(shù)據(jù)的速率每 4 年才增加 2 倍。幾十年來,晶體管密度與 IO 數(shù)據(jù)速率的這種差異出現(xiàn)了巨大差異。共同封裝的光學器件只是解決這個問題的一種方法,它并不是單獨出現(xiàn)的。 從根本上說,芯片需要容納更多的通信或 IO 點才能跟上。不幸的是,這方面的最后一個主要步驟功能增加是在 90 年代轉(zhuǎn)向倒裝芯片封裝。
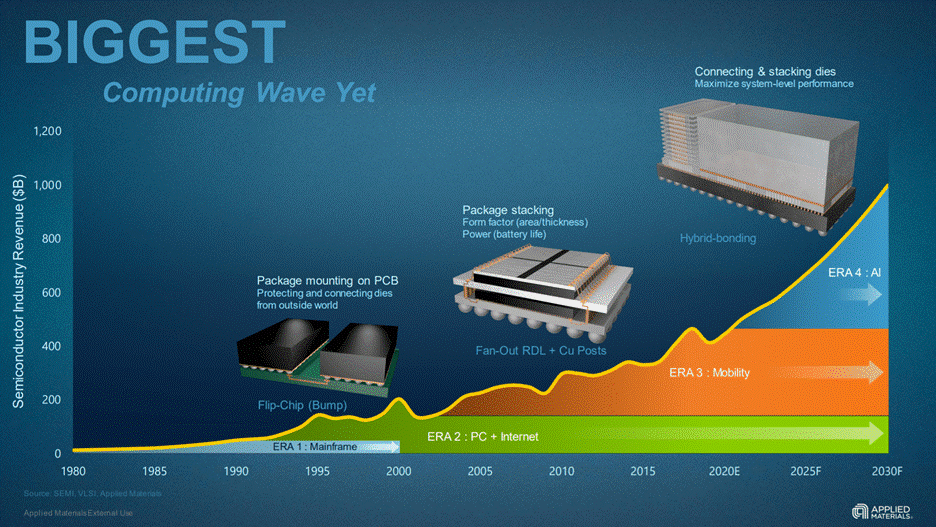
傳統(tǒng)的倒裝芯片封裝的凸點間距在 150 微米到 200 微米之間。這意味著每個 IO 單元在裸片的底側(cè)相距 150 到 200 微米。臺積電 N7將凸點間距降低到 130 微米,英特爾的 10nm 將凸點間距降低到 100 微米,這些進步被稱為細間距倒裝芯片。不要小看這些進步,因為它們極大地促進了更好的處理器,但 2000 年的封裝技術(shù)與 2021 年的封裝技術(shù)基本相同。 2000年的250mm2的芯片與2022年的250mm2芯片在晶體管數(shù)量、性能和成本方面有著難以置信的不同。摩爾定律每 2 年翻一番,表示晶體管數(shù)量增加了 2000 倍以上。顯然,現(xiàn)實并不那么有利,但晶體管仍然增加了幾個數(shù)量級。在硬幣的另一面,封裝沒有享受同樣水平的增長。 在臺積電的 N7 節(jié)點上,AMD 的凸塊間距從約 200 微米變?yōu)?130 微米,IO 僅增加了 2.35 倍。如前所述,英特爾在 10 納米工藝上從200 微米的凸點間距變?yōu)?100 微米,從而實現(xiàn)了更大的縮放。這仍然只會使 IO 增加 4 倍。2.35倍或4倍的增加是相對于晶體管數(shù)量增加的舍入誤差。
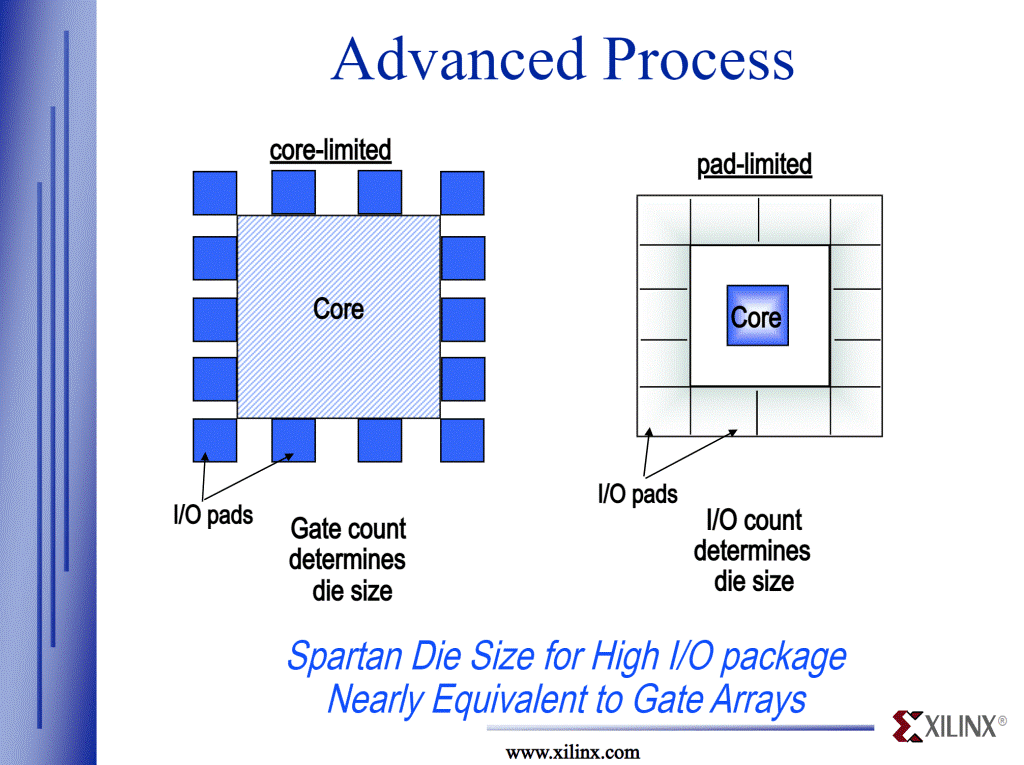
這帶來了pad(硅片的管腳)受限設(shè)計的概念。將舊設(shè)計轉(zhuǎn)移到新工藝節(jié)點時,設(shè)計本身可能會大幅縮小,但 IO 需求會阻止芯片尺寸縮小多少。由于需要 IO,裸片尺寸保持較大且留有空白空間。這些情況稱為pad limited,并且非常頻繁。 這不僅與將使用先進封裝的前沿有關(guān),而且與圍繞汽車芯片和一般半導體短缺的討論有關(guān)。Intel 的首席執(zhí)行官 Pat Gelsinger 認為,這些短缺的公司應(yīng)該轉(zhuǎn)向 Intel 16nm 代工服務(wù)。 Pat Gelsinger表示,我們宣布在英特爾 16 和愛爾蘭工廠的其他節(jié)點上提供歐洲代工服務(wù),我們相信這有機會幫助加速結(jié)束供應(yīng)短缺,我們正在與汽車和其他行業(yè)合作幫助建立這些能力。但我也想說有些人可能會爭辯說,好吧,讓我們在舊節(jié)點上構(gòu)建大部分汽車芯片。舊節(jié)點不需要一些舊晶圓廠嗎?我們是想投資過去還是想投資未來? 一個新的晶圓廠需要 4 到 5 年的時間才能建成并具有生產(chǎn)價值。不是解決今天的危機,投資于未來,不要選擇向后投資。相反,我們應(yīng)該將所有設(shè)計遷移到新的現(xiàn)代節(jié)點,為未來增加供應(yīng)和靈活性做好準備。 Intel的問題在于,當從古老的節(jié)點轉(zhuǎn)移到相對現(xiàn)代的節(jié)點時,這些設(shè)計將受到pad限制。由于每 mm2的成本較高,單位成本經(jīng)濟學在這里不起作用,因為由于pad有限,芯片面積不能很好地縮放。除了這些成本之外,由于必須在較新的節(jié)點上重新設(shè)計舊芯片和整個重新認證過程,因此一次性成本也很高。將舊芯片移到新節(jié)點的解決方案是不可行的。

那么如何增加 IO 計數(shù)呢? 一種途徑是尋找使芯片更大的方法。面積越大,IO的空間就越大。這不是最佳途徑,但設(shè)計人員會經(jīng)常增加芯片上的內(nèi)存,以便在芯片上存儲更多數(shù)據(jù)。這反過來又在一定程度上減少了 IO 需求。AMD 最近的架構(gòu)就是一個很好的例子,因為它們在 CPU 和 GPU 上都有巨大的緩存。 AMD 將其命名為 InfinityCache(無線緩存)。解決方案是通過提供大量的片上 SRAM 來存儲處理器中與計算最相關(guān)的數(shù)據(jù),從而降低內(nèi)存帶寬要求。在 GPU 領(lǐng)域,AMD 明確表示他們能夠通過添加無限緩存將 GDDR6 總線大小從 384 位減少到 256 位。蘋果在這方面也很積極,在他們內(nèi)部設(shè)計的處理器上塞滿了大量的緩存。這些設(shè)計選擇的一個組成部分與功率有關(guān),但很大一部分也是由于pad限制。
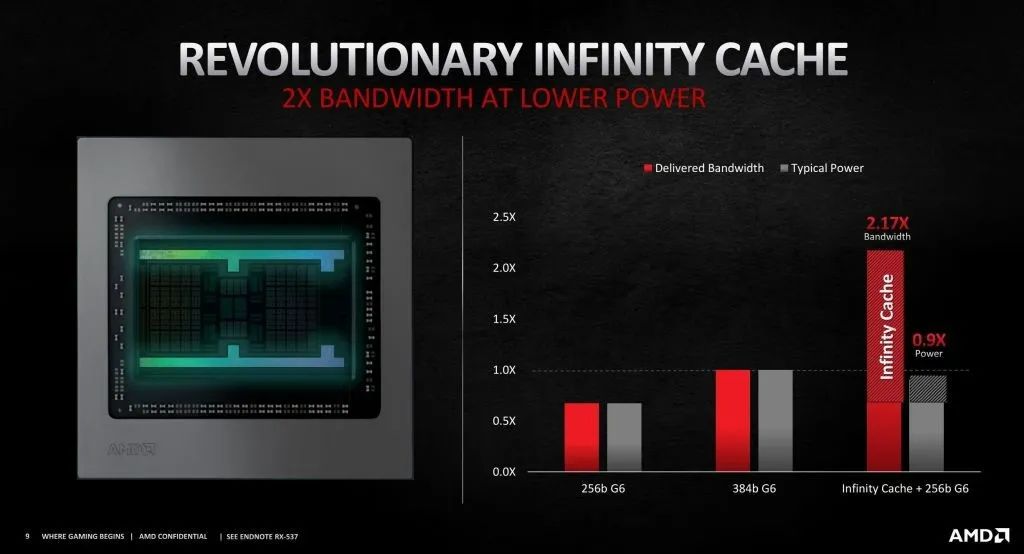
另一種途徑是添加各種專用電路以提高芯片效率。我們在大量的異構(gòu)計算中看到了這一點。回到我們的Apple A15 芯片分析,令人驚訝的是 CPU 或 GPU 的專用區(qū)域如此之少。這是人們談?wù)撟疃嗟膬蓚€方面。Apple 沒有專注于這些營銷方面,而是將大量區(qū)域用于其他功能。雖然沒有標注,但右下角主要是圖像信號處理器。這塊巨大的部分正在做與拍照和視頻相關(guān)的計算。還有另一個未標記的塊與媒體編碼和解碼相關(guān)的計算有關(guān)。在 SoC 周圍,可以找到這些相當小的統(tǒng)一矩形,它們是 SRAM 緩存,可將更多數(shù)據(jù)保存在芯片上,而不必進入內(nèi)存。
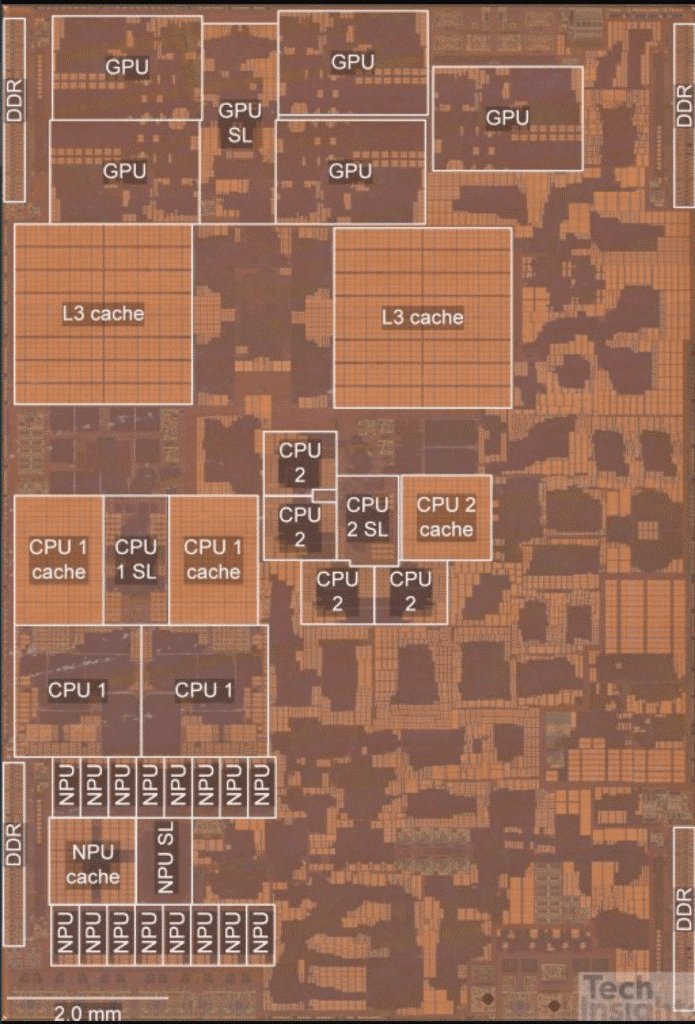
這些工作負載不能在傳統(tǒng)CPU上運行。AI的模型越來越大,F(xiàn)acebook 的深度學習推薦系統(tǒng)模型有超過12萬億個參數(shù)。不斷膨脹的模型尺寸致力于讓你在應(yīng)用上停留更長時間并點擊更多廣告。谷歌開發(fā)了自己的芯片,用于人工智能模型的訓練和推理,稱為 TPU。隨著 VCU(一種新型處理器)的出現(xiàn),他們擴大了在芯片工作的研究,如果專用于同一任務(wù),它能夠取代 1000 萬個 CPU。 亞馬遜有定制的網(wǎng)絡(luò)芯片,也運行他們的管理程序和管理堆棧。他們擁有自己的芯片,專門用于AI 訓練、AI 推理、存儲控制和 CPU。當你查看 Marvell 和 Broadcom ASIC 服務(wù)的重點時,就會發(fā)現(xiàn),硬件設(shè)計和架構(gòu)的分散性只會增加。

就連英特爾,這家認為每個工作負載都應(yīng)該在 CPU 上運行的公司,也認識到唯一的前進道路是異構(gòu)設(shè)計。與針對每項任務(wù)的通用 CPU 硬件不同,該行業(yè)正在采用常見的工作負載并專門為它們構(gòu)建芯片。這使架構(gòu)師能夠獲得更高的每單位硅性能。 除了 CPU 之外,專用集成電路的異構(gòu)集成是至高無上的。不過,更多內(nèi)存和更多異構(gòu)計算并不是萬能的。雖然通過增加內(nèi)存和異構(gòu)計算來增加芯片尺寸對于消除pad限制和提高能源效率非常有用,但這些都是要花錢的。很多錢。 看看英偉達或英特爾的數(shù)據(jù)中心陣容。兩者都接近“標線限制”超過 5 年。即使他們愿意,他們也無法繼續(xù)制造更大的芯片。芯片收縮已經(jīng)大幅放緩,助長了這個問題。更多的芯片面積意味著更多的引腳、更多的集成功能,但這也是成本失控的絕妙方法。并且芯片尺寸已經(jīng)達到極限。

因此,收縮已經(jīng)放緩,芯片尺寸無法增長得更大,設(shè)計也受到pad的限制,這些是唯一的問題嗎? 不是,硅單元經(jīng)濟學也遇到了障礙。半導體行業(yè)及其下游企業(yè)單槍匹馬地推動了整個經(jīng)濟的通縮環(huán)境,抵消了其他地方的通脹行動。沒有它,80 年代以來的美國和歐洲將經(jīng)歷無休止的滯脹。不過,這種變革性的通貨緊縮力量正在遇到障礙。半導體單位經(jīng)濟沒有改善。事實上,將晶體管縮小到更小,它們甚至變得更糟。制造大芯片不僅昂貴,而且比之前的一代更昂貴。

這張來自 AMD 的圖表描繪了一幅非常病態(tài)的畫面。雖然每個節(jié)點的轉(zhuǎn)變并不相同,但很明顯,在 7nm 和 5nm 處,該行業(yè)已經(jīng)達到了拐點。每產(chǎn)出平方毫米的成本增加幅度不是很小,而是很大。盡管節(jié)點轉(zhuǎn)換帶來了類似的密度增益,或者可能由于 SRAM 縮放速度放緩而更糟,但成本的增加并沒有跟上。與每晶體管成本相關(guān)的趨勢逆轉(zhuǎn)令業(yè)界震驚。這種逆轉(zhuǎn)具有巨大的影響,甚至導致無知的銀行家以此為理由,下調(diào)臺積電的評級,稱其估值過高。

摩根士丹利認為,由于摩爾定律正在放緩,晶體管成本縮放已經(jīng)停止,臺積電的定價壓力將減弱。摩根士丹利通過一張可笑的圖表來證明這一點,該圖表顯示 5nm 的晶體管成本低于 7nm,這與業(yè)內(nèi)專家形成鮮明對比。隨著 FinFET 節(jié)點的引入,每個晶體管的成本停滯不前,7nm 完全趨于穩(wěn)定,而 5nm 則比以往任何時候都高。 因此,每個晶體管的成本仍在增加,但對計算的需求比以往任何時候都增加。我們轉(zhuǎn)向異構(gòu)架構(gòu)進行反擊,但現(xiàn)在芯片設(shè)計過程要困難得多。該行業(yè)必須依靠許多擁有不同 IP 的團隊按時交付并將其整合在一起。Synopsys 和 Cadence 等 EDA 供應(yīng)商在協(xié)助方面做得非常出色,但這還不夠。對于沒有超過 1000 萬個單元用例的任何人來說,一個可以購買特定應(yīng)用 IP 或芯片并將其集成到硬件設(shè)計中的開放生態(tài)系統(tǒng)是必要的。即使對于這些公司,小芯片風格的系統(tǒng)架構(gòu)也是答案。

隨著我們繼續(xù)收縮,預期收益率會緩慢下降。這是一個合乎邏輯的結(jié)論,因為每個連續(xù)的節(jié)點都會增加約 35% 的流程步驟。當前沿流程在數(shù)千個流程步驟中進行衡量時,錯誤開始迅速堆積。工業(yè)公司喜歡談?wù)摗癝ix Sigma”,但這對半導體制造來說還不夠。讓我們假設(shè)一個有 2000 個工藝步驟的過程,每個步驟的每 cm2缺陷數(shù)為Six Sigma。那么D0(每 cm2缺陷率的行業(yè)術(shù)語)最終將是0.678。芯片越大,出現(xiàn)缺陷的可能性就越大。 如果這個假設(shè)的過程是構(gòu)建英特爾的高端服務(wù)器 CPU,Ice Lake。這將導致每個晶片有 4 個良好的裸片和 76 個有缺陷的裸片。現(xiàn)在考慮這個分析是在 cm2水平上完成的,并且在前沿工藝節(jié)點上每 cm2有數(shù)十億個晶體管。半導體行業(yè)比Six Sigma好得多。 除了尺寸的完美之外,還有什么解決方案? Chiplets——小芯片!將大籌碼分成許多小籌碼。 AMD 是這方面最受歡迎的例子,但這是整個行業(yè)的趨勢。AMD 可以設(shè)計 3 個芯片,一個CPU 核心小芯片和 2 個 IO 芯片。這 3 種設(shè)計覆蓋了很大一部分市場。同時,英特爾設(shè)計了 2 個 Alder Lake 臺式機芯片和 3 個 Ice Lake 服務(wù)器芯片,以服務(wù)于相同的潛在市場。因此,AMD 可以節(jié)省設(shè)計成本,制造比英特爾更多內(nèi)核的 CPU,并節(jié)省收益成本。 要演示 yield 參數(shù),請參見下表。AMD將 CPU 內(nèi)核拆分為 8 個 CPU 內(nèi)核小芯片。如果良率是 100%,英特爾將能夠以比 AMD 更低的每個 CPU 內(nèi)核的成本制造內(nèi)核。但相反,英特爾必須在每個 CPU 內(nèi)核上花費更多,因為更大的芯片有更多的缺陷。下表有一些明顯的警告,其中最大的假設(shè)是缺陷芯片的收獲率為 0,并且英特爾和臺積電具有相同的 D0。這些假設(shè)都不是真的,這個練習是為了演示目的。
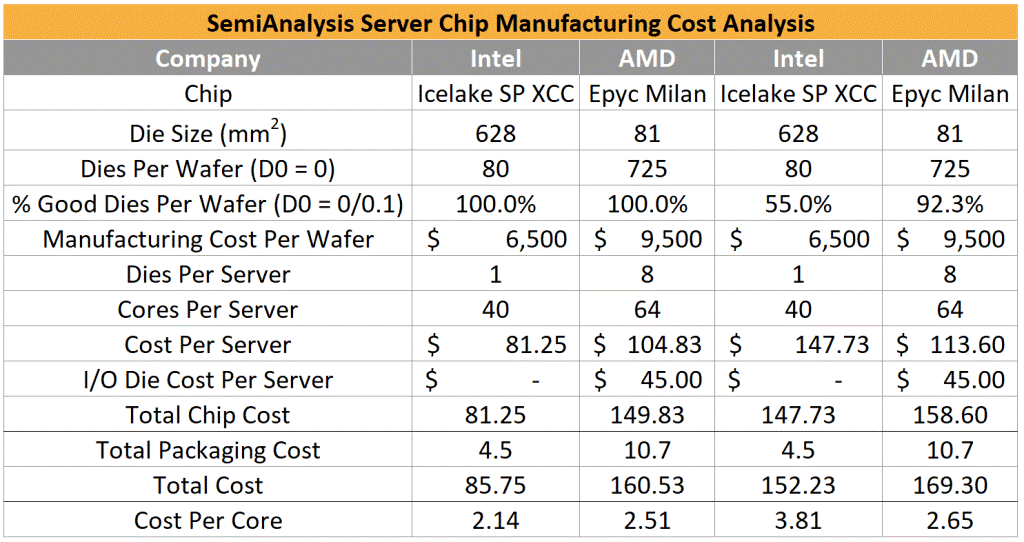
小芯片(Chiplet)很棒,但它不是孤立的解決方案。我們?nèi)匀挥龅皆S多相同的問題。每個晶體管的成本仍在上升,設(shè)計成本飆升,由于需要更多 IO 來與其他芯片接口,小芯片被pad限制。由于 IO 限制,部分芯片無法拆分,因此芯片尺寸仍在達到峰值。 解決辦法是什么? 先進封裝! 這就是我們要注意的地方,一些工具供應(yīng)商將所有倒裝芯片封裝稱為“先進封裝”。SemiAnalysis 和大多數(shù)業(yè)內(nèi)下游人士不會這么說。因此,我們將所有凸點尺寸小于 100 微米的封裝稱為“先進”。

最常見的先進封裝類別稱為扇出。有些人會爭辯說它甚至不是先進的封裝,但那些人大錯特錯。以Apple 為例,他們將讓臺積電采用應(yīng)用處理器芯片,并將其與 90 微米到 60 微米數(shù)量級的更密集凸塊封裝到重組或載體晶圓/面板上。與傳統(tǒng)倒裝芯片封裝相比,凸點密度大約高出 8 倍。 這種重組或載體晶圓/面板然后進一步展開 IO,因此得名扇出。然后將扇出封裝連接到主板。硅芯片的設(shè)計可以減少對pad受限的擔憂,因為扇出處的pad較小。該封裝還可以封裝 DRAM 內(nèi)存、NAND 存儲和 PMIC。集成扇出不僅有利于密度,而且它們還在封裝上保留了大量的芯片間 IO。否則,該 IO 將不得不以更大的IO 間距尺寸通過主板進行接口。 集成扇出對于高性能應(yīng)用程序變得越來越普遍,不僅僅是移動應(yīng)用程序。增長最快的用例是在十多年來設(shè)計一直受到限制的事物的網(wǎng)絡(luò)方面。AMD 將在其服務(wù)器 CPU 和 GPU中非常積極地采用扇出。Tesla Dojo 1是集成扇出封裝的另一個引人注目的例子,但在晶圓級。SemiAnalysis透露,特斯拉將在發(fā)布公告前使用這種包裝類型。

在先進封裝中,有 2.5D 和 3D 封裝。2.5D 涉及封裝在其他硅片上的硅片,但較低的硅片專用于布線,沒有有源晶體管。這通常以55 微米到 50 微米的間距完成,因此凸點密度高出約 16 倍。最常見和最高容量的用例是具有 TSMC CoWoS(基板上晶圓上芯片)的 Nvidia 數(shù)據(jù)中心 GPU。臺積電將有源芯片封裝在只有互連和微凸點的晶圓上。然后使用傳統(tǒng)方法將這疊芯片封裝到基板上。 其他示例基本上包括每個帶有 HBM 的處理器。HBM 是作為一種階梯函數(shù)增加內(nèi)存帶寬的方法而建立的,這種方法高于傳統(tǒng)形式的 DRAM。它通過使用更寬的內(nèi)存總線來實現(xiàn)這一點。這些寬總線會產(chǎn)生與 IO 計數(shù)相關(guān)的問題,但 HBM 是從頭開始設(shè)計的,以便在同一包內(nèi)共存。這顛覆了 IO 問題,同時也允許更緊密的集成。2.5D 的更多示例包括基于Intel EMIB 的產(chǎn)品、Xilinx FPGA、AMD 最新的數(shù)據(jù)中心 GPU 和Amazon Graviton 3。

3D 封裝是將一個有源芯片封裝在另一個有源芯片之上。這最初由英特爾以 55 微米間距的邏輯硅一起發(fā)貨,但批量用例將在 36 微米及以下。臺積電和 AMD 將推出 17 微米間距的 3D堆疊 V-cache。該技術(shù)從凸塊過渡到硅通孔 (TSV),并且具有更大的擴展空間。 其他應(yīng)用方面,例如索尼制造的 CMOS 圖像傳感器,其間距已經(jīng)達到 6.3 微米。為了保持比較,36 微米間距的凸點密度高出 31 倍,17 微米間距實施的銅TSV 的 IO 密度將提高 138 倍,而索尼的6.3微米間距的CMOS圖像傳感器的IO密度比標準翻轉(zhuǎn)芯片高567倍。
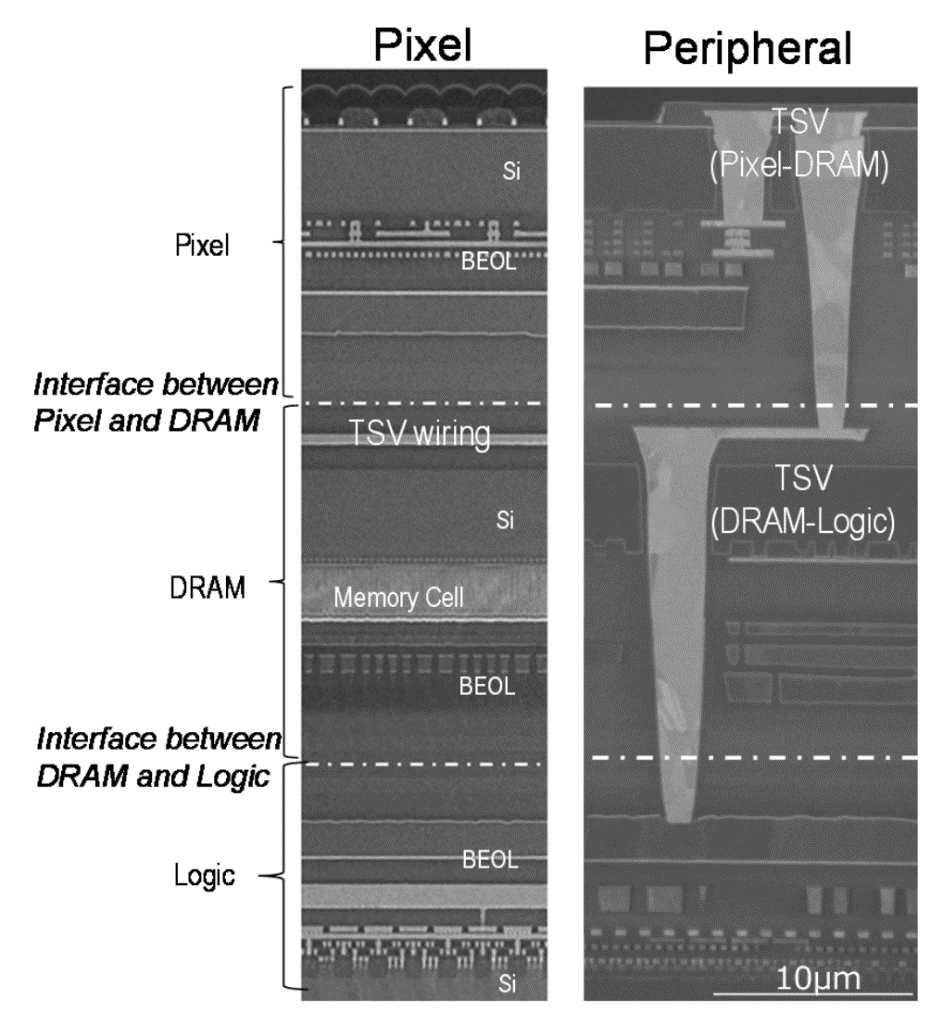
以上只是對主要封裝類型的基本解釋,但我們將深入研究本系列中的不同類型的封裝。對未來的封裝類型、工具以及工具供應(yīng)商有很多不同的賭注。設(shè)備和 IP 方面比人們乍一看想象的要興奮得多,但在我們深入研究之前,需要先解釋基礎(chǔ)知識。對于即將到來的創(chuàng)新海洋,有很多可投資的想法和角度。摩爾定律的放緩正在推動根本性的變化。我們正處于先進封裝推動的半導體設(shè)計復興之中。
審核編輯 :李倩
-
芯片
+關(guān)注
關(guān)注
459文章
52119瀏覽量
435631 -
半導體
+關(guān)注
關(guān)注
335文章
28547瀏覽量
231993 -
晶體管
+關(guān)注
關(guān)注
77文章
9975瀏覽量
140568
原文標題:先進封裝最強科普
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
瑞沃微先進封裝:突破摩爾定律枷鎖,助力半導體新飛躍

芯和半導體將參加重慶半導體制造與先進封測產(chǎn)業(yè)發(fā)展論壇
制局半導體先進封裝模組制造項目開工

全球先進封裝市場現(xiàn)狀與趨勢分析

什么是先進封裝中的Bumping
一文解析全球先進封裝市場現(xiàn)狀與趨勢

先進封裝技術(shù)- 6扇出型晶圓級封裝(FOWLP)

先進封裝技術(shù)推動半導體行業(yè)繼續(xù)前行的關(guān)鍵力量

人工智能半導體及先進封裝技術(shù)發(fā)展趨勢

led封裝和半導體封裝的區(qū)別
功率半導體封裝的趨勢分析
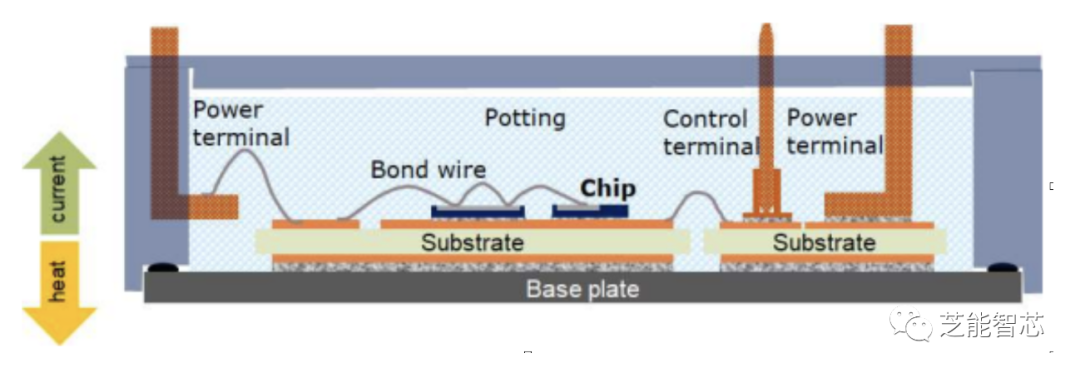
功率半導體雙脈沖測試方案

我們的城市為什么越來越熱?






 先進封裝已成為半導體越來越普遍的主題
先進封裝已成為半導體越來越普遍的主題










評論