摘要
等離子體蝕刻工藝,特別適用于在具有非氧化物成分的特征上選擇性蝕刻氧化物,例如氮化硅,尤其是當(dāng)該特征具有在氧化物蝕刻期間易于刻面的角部時(shí)。主要的含氟氣體,優(yōu)選六氟丁二烯 (C4F6),與顯著更大量的稀釋氣體氙 (Xe) 結(jié)合,可在不發(fā)生蝕刻停止的情況下提高氮化物的選擇性。

發(fā)明領(lǐng)域
本發(fā)明一般涉及硅集成電路的蝕刻。特別地,本發(fā)明涉及在能夠大大降低對(duì)氮化硅15和其他非氧化物材料的蝕刻速率但仍然在氧化物中產(chǎn)生垂直輪廓的工藝中蝕刻氧化硅和相關(guān)材料。
背景技術(shù)
在硅集成電路的制造中,芯片上器件數(shù)量的持續(xù)增加以及隨之而來的最小特征尺寸的減小對(duì)制造過程中使用的許多制造步驟中的許多步驟提出了越來越困難的要求,包括 25 個(gè)不同的沉積層材料到有時(shí)困難的拓?fù)浣Y(jié)構(gòu)上。
氧化物蝕刻提出了一些最困難的挑戰(zhàn)。氧化物是用于 30 二氧化硅,特別是二氧化硅 (SiO 2 ) 的有點(diǎn)通用的術(shù)語,盡管眾所周知,還包括略微非化學(xué)計(jì)量的成分 SiO x 。
各向異性可以通過干式等離子體蝕刻來實(shí)現(xiàn),其中蝕刻氣體,通常是氟基氣體,被電激發(fā)成等離子體。可以調(diào)整等離子體條件以在 60 多種材料中產(chǎn)生高度各向異性的蝕刻。然而,各向異性不應(yīng)通過以純?yōu)R射模式操作等離子體反應(yīng)器來實(shí)現(xiàn),其中等離子體以足夠高的能量向晶片噴射粒子以濺射氧化物。
發(fā)明內(nèi)容
在氟基氧化物蝕刻中使用氙 (Xe) 作為稀釋氣體提供了非常好的氮化物選擇性和寬的工藝窗口,尤其是與六氟丁二烯 (C4F6) 結(jié)合使用時(shí)。對(duì)于氮化物選擇性,氙氣的量應(yīng)該比碳氟化合物的量大得多。氪 (Kr) 承諾類似的效果。
優(yōu)選實(shí)施例的詳細(xì)描述
當(dāng)在氟基氧化物蝕刻中用作稀釋氣體時(shí),氙 (Xe) 表現(xiàn)出與氬 (Ar) 截然不同的行為。在 IPS 反應(yīng)器中進(jìn)行了一系列初步實(shí)驗(yàn),其中質(zhì)譜儀連接到腔室,同時(shí) C4F6 與氦 (He)、Ar 或 Xe 的混合物進(jìn)入腔室并在相當(dāng)現(xiàn)實(shí)的條件下激發(fā)成等離子體激發(fā)功率和壓力。

審核編輯:符乾江
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28499瀏覽量
231582 -
刻蝕
+關(guān)注
關(guān)注
2文章
201瀏覽量
13313
發(fā)布評(píng)論請(qǐng)先 登錄
半導(dǎo)體boe刻蝕技術(shù)介紹
芯片制造中的二氧化硅介紹

VirtualLab Fusion應(yīng)用:氧化硅膜層的可變角橢圓偏振光譜(VASE)分析
深入剖析半導(dǎo)體濕法刻蝕過程中殘留物形成的機(jī)理
什么是MOSFET柵極氧化層?如何測(cè)試SiC碳化硅MOSFET的柵氧可靠性?
半導(dǎo)體濕法刻蝕殘留物的原理
芯片濕法刻蝕方法有哪些
如何提高濕法刻蝕的選擇比
刻蝕工藝的參數(shù)有哪些

SiO2薄膜的刻蝕機(jī)理
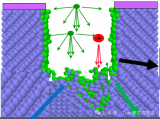
氮化硅薄膜制備方法及用途

刻蝕工藝評(píng)價(jià)的工藝參數(shù)以及如何做好刻蝕工藝






 氧化硅刻蝕速率的提高方法
氧化硅刻蝕速率的提高方法











評(píng)論