引言
SC-l和piranha(H2SO4/H2O2)清潔劑已經(jīng)使用多年來(lái)去除顆粒和有機(jī)污染物。盡管SC-1清潔劑(通常與施加的兆頻超聲波功率一起使用)被認(rèn)為對(duì)顆粒去除非常有效,但去除機(jī)制仍不清楚。對(duì)于去,除重有機(jī)污染物,piranha清洗是一個(gè)有效的過(guò)程;然而,piranha后殘留物頑強(qiáng)地粘附在晶片表面,導(dǎo)致顆粒生長(zhǎng)現(xiàn)象。已經(jīng)進(jìn)行了一系列實(shí)驗(yàn)來(lái)幫助理解這些過(guò)程與硅的相互作用。
實(shí)驗(yàn)
為了評(píng)估piranha清洗后晶片上殘留的硫量,將150毫米n型裸硅和熱氧化晶片在95 °C下通過(guò)5:1或10:1(氫、硫、氫、氧)piranha處理10分鐘。對(duì)沖洗過(guò)程進(jìn)行各種修改后,飛行時(shí)間二次離子質(zhì)譜(TOF- SIMS)和全反射X射線熒光光譜法(TXRF)用于測(cè)量殘留硫。清洗和干燥晶片后,還測(cè)量了作為時(shí)間函數(shù)的光點(diǎn)缺陷。當(dāng)piranha被處理后晶片已經(jīng)顯示出顆粒生長(zhǎng)現(xiàn)象。這些分析技術(shù)的數(shù)據(jù)用于評(píng)估各種沖洗技術(shù)的功效。
結(jié)果和討論
在對(duì)SC-1化學(xué)物質(zhì)的研究中,當(dāng)稀釋時(shí),清潔效率與測(cè)量的開(kāi)路電位或霧度增量之間沒(méi)有明顯的相關(guān)性。使用了SC-1化學(xué)物質(zhì)。圖1顯示了基于去除硅鈉顆粒的鉗去除效率。 這些實(shí)驗(yàn)是在已知影響硅蝕刻的條件下進(jìn)行的(n型和p型Si<100>, 有而疫有照明)。圖2顯示了相同的霧度增量數(shù)。
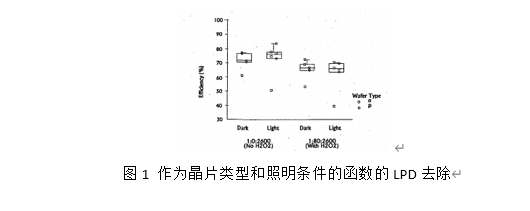
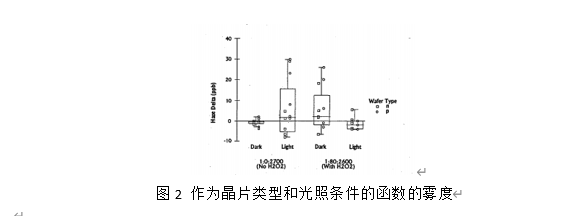
霧度值可能與表面粗糙度有關(guān),這是由基礎(chǔ)介質(zhì)中優(yōu)先的硅{100}蝕刻引起的。可以看出,有助于增加霧度以及蝕刻的條件與 顆粒移動(dòng)效率的增加無(wú)關(guān)(見(jiàn)圖1)。當(dāng)在親水晶片上使用不含H202的足夠稀釋的氨水溶液時(shí),硅的堿性侵蝕和粗糙化最小,但是仍然有效去除顆粒獲得。當(dāng)疏水性裸硅片通過(guò)稀氨水溶液處理時(shí),霧度明顯增加。看來(lái)SC-1預(yù)清洗步驟產(chǎn)生的薄化學(xué)氧化物足以抑制在非常稀的氨水中對(duì)硅表面的堿性蝕刻。
這些數(shù)據(jù)表明硅的蝕刻不是有效清潔的必要條件。為了理解兆聲在粒子去除中的物理機(jī)制,需要清潔浴中聲壓場(chǎng)的預(yù)測(cè)模型。使用射線追蹤方法,計(jì)算的一維壓力場(chǎng)與測(cè)量值進(jìn)行比較,如圖3所示。為了獲得無(wú)反射的莊力測(cè)量值,實(shí)驗(yàn)傳感器以脈沖模式工作,脈沛持續(xù)時(shí)間約為50微秒。該建模方法與測(cè)量值吻合良好,可用于預(yù)測(cè)各種槽幾何形狀中的壓力場(chǎng),并 最終可用于優(yōu)化未來(lái)工具中的清洗槽幾何形狀。
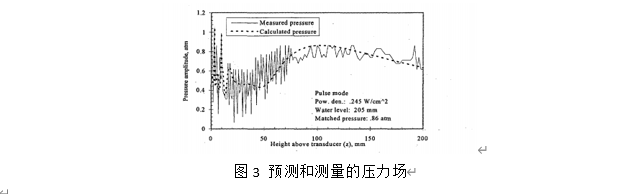
過(guò)氧化硫酸(piranha)沖洗:
經(jīng)過(guò)piranha清洗后,清洗后殘留在晶圓上的硫污染物會(huì)頑強(qiáng)地附著在硅表面。當(dāng)晶片暴露在潔凈室空氣中時(shí),這種殘留的硫會(huì)隨著時(shí)間的推移產(chǎn)生顆粒污染。
圖4所示的piranha清洗過(guò)的晶片的TOF-SIMS負(fù)離子和正離子圖像圖表明,顆粒由SOx”和 NH4組成。已經(jīng)發(fā)現(xiàn),向piranha后沖洗浴中加入少量氫氧化鉉(例如,足以達(dá)到 pH = 10)可有效降低硫的表面濃度,以及減輕piranha引起的顆粒生長(zhǎng)。通過(guò)全反射x射線熒光(TXRF)測(cè)量的硫濃度顯示在圖5中,用于基本漂洗和去離子水中漂洗。
總結(jié)
表面敏感技術(shù)被用來(lái)研究SC-1對(duì)硅片的化學(xué)效應(yīng)。顆粒去除效率不一定取決于表面改性現(xiàn)象,如蝕刻或鈍化。為了研究兆頻超聲波清洗的物理效應(yīng),正在開(kāi)發(fā)計(jì)算和實(shí)驗(yàn)?zāi)P汀_@種模型將允許浴缸制造商根據(jù)第一原則計(jì)算清潔性能。
按照piranha清洗和沖洗順序,硅晶片表面會(huì)殘留硫。當(dāng)晶片儲(chǔ)存在潔凈室環(huán)境中時(shí),這種殘留物會(huì)形成顆粒物質(zhì)。TOF-SIMS被用來(lái)確定這些顆粒是硫酸—鉉。在piranha之后使用堿性漂洗劑(例如,pH = 10)可有效降低殘留硫濃度 ,從而抑制隨時(shí)間變化的顆粒形成。
審核編輯:湯梓紅
-
數(shù)據(jù)
+關(guān)注
關(guān)注
8文章
7237瀏覽量
90937 -
晶片
+關(guān)注
關(guān)注
1文章
406瀏覽量
31904 -
測(cè)量
+關(guān)注
關(guān)注
10文章
5147瀏覽量
112883
發(fā)布評(píng)論請(qǐng)先 登錄
芯片清洗機(jī)用在哪個(gè)環(huán)節(jié)
半導(dǎo)體清洗SC1工藝
Lc-sc和sc-lc一樣嗎
晶圓擴(kuò)散清洗方法
半導(dǎo)體單片清洗機(jī)結(jié)構(gòu)組成介紹
Aigtek高壓放大器在顆粒電霧化布控實(shí)驗(yàn)研究中的應(yīng)用

信捷電氣推出數(shù)粒機(jī)解決方案
上海光機(jī)所在激光燒蝕波紋的調(diào)制機(jī)理研究中取得新進(jìn)展






 SC-1顆粒去除和piranha后漂洗的機(jī)理研究
SC-1顆粒去除和piranha后漂洗的機(jī)理研究











評(píng)論