在現(xiàn)代芯片中,數(shù)十億晶體管通過(guò)金屬互連線連接成復(fù)雜電路。隨著制程進(jìn)入納米級(jí),一個(gè)看似“隱形”的問(wèn)題逐漸浮出水面:金屬線之間的電容耦合。這種耦合不僅會(huì)拖慢信號(hào)傳輸速度,甚至可能引發(fā)數(shù)據(jù)傳輸錯(cuò)誤。而解決這一問(wèn)題的關(guān)鍵,正是低介電常數(shù)(Low-k)材料。
![的頭像]() 發(fā)表于
發(fā)表于 05-15 10:31
?224次閱讀

?芯片必須使用晶振的核心原因是需要精確且穩(wěn)定的時(shí)鐘信號(hào)來(lái)同步內(nèi)部操作,確保數(shù)字電路可靠運(yùn)行。?
![的頭像]() 發(fā)表于
發(fā)表于 04-27 13:49
?268次閱讀
半導(dǎo)體元素是芯片制造的主要材料,芯片運(yùn)算主要是用二進(jìn)制進(jìn)行運(yùn)算。所以在電流來(lái)代表二進(jìn)制的0和1,即0是不通電,1是通電。正好半導(dǎo)體通過(guò)一些微觀的構(gòu)造與參雜可以這種性質(zhì)。
![的頭像]() 發(fā)表于
發(fā)表于 04-15 09:32
?293次閱讀
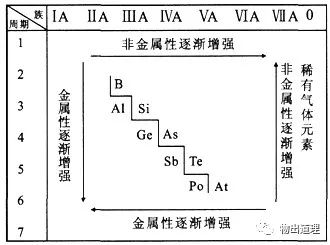
Low-K材料是介電常數(shù)顯著低于傳統(tǒng)二氧化硅(SiO?,k=3.9–4.2)的絕緣材料,主要用于芯片制造中的層間電介質(zhì)(ILD)。其核心目標(biāo)是通過(guò)降低金屬互連線間的寄生電容,解決RC延遲(電阻-電容延遲)和信號(hào)串?dāng)_問(wèn)題,從而提升
![的頭像]() 發(fā)表于
發(fā)表于 03-27 10:12
?1355次閱讀
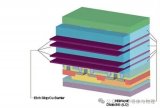
我國(guó)高端新材料技術(shù)和生產(chǎn)偏弱,近年來(lái)產(chǎn)能雖有顯著提高,但未能滿(mǎn)足國(guó)內(nèi)高端產(chǎn)品需求,材料強(qiáng)國(guó)之路任重而道遠(yuǎn)。根據(jù)工信部報(bào)告顯示,我國(guó)新材料產(chǎn)業(yè)還有32%的關(guān)鍵材料處于空白狀態(tài),
![的頭像]() 發(fā)表于
發(fā)表于 12-26 06:19
?1456次閱讀

石墨烯,這種因其多種結(jié)構(gòu)、熱學(xué)和電子特性而受到廣泛贊譽(yù)的二維(2D)材料,已從實(shí)驗(yàn)室走向如今可供購(gòu)買(mǎi)的量產(chǎn)微芯片。這標(biāo)志著電子行業(yè)先進(jìn)材料轉(zhuǎn)型的早期階段。這篇文章將介紹石墨烯是如何走到這一步的,石墨
![的頭像]() 發(fā)表于
發(fā)表于 12-25 10:42
?832次閱讀

,需要更多類(lèi)型的連接。這一綜述,通過(guò)關(guān)注材料的載流子平均自由程和內(nèi)聚能,回顧了開(kāi)發(fā)更好互連的策略。 摘 要 在芯片上集成更多器件的半導(dǎo)體技術(shù),目前達(dá)到了器件單獨(dú)縮放,已經(jīng)不再是提高器件性能的有效方式。問(wèn)題在于連接晶
![的頭像]() 發(fā)表于
發(fā)表于 12-18 13:49
?1176次閱讀

一、IC載板:芯片封裝核心材料(一)IC載板:“承上啟下”的半導(dǎo)體先進(jìn)封裝的關(guān)鍵材料IC封裝基板(ICPackageSubstrate,簡(jiǎn)稱(chēng)IC載板,也稱(chēng)為封裝基板)是連接并傳遞裸芯片
![的頭像]() 發(fā)表于
發(fā)表于 12-11 01:02
?1613次閱讀

一、IC?載板:芯片封裝核心材料 (一)IC?載板:“承上啟下”的半導(dǎo)體先進(jìn)封裝的關(guān)鍵材料 IC 封裝基板(IC Package Substrate,簡(jiǎn)稱(chēng) IC 載板,也稱(chēng)為封裝基?板)是連接并傳遞
![的頭像]() 發(fā)表于
發(fā)表于 12-09 10:41
?2707次閱讀
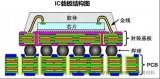
本文簡(jiǎn)單介紹了不同材料間的焊接冶金特性。 不同材料間的焊接冶金特性是超聲波壓焊技術(shù)中需要重點(diǎn)關(guān)注的問(wèn)題。通過(guò)合理選擇材料、優(yōu)化焊接工藝以及綜合考慮應(yīng)用環(huán)境等因素,可以提高焊接點(diǎn)的可靠性
![的頭像]() 發(fā)表于
發(fā)表于 12-06 10:05
?576次閱讀

芯片
芯廣場(chǎng)
發(fā)布于 :2024年11月26日 18:23:15
德索工程師說(shuō)道N型焊接頭作為射頻同軸連接器的一種,其制造過(guò)程中需要使用多種材料以確保其性能的穩(wěn)定性和可靠性。以下是對(duì)N型焊接頭所需材料的詳細(xì)分析:
銅合金:N型焊接頭的核心接觸件通常采用高導(dǎo)電性
![的頭像]() 發(fā)表于
發(fā)表于 11-20 10:52
?499次閱讀

塑封芯片多大才需要點(diǎn)膠加固保護(hù)?塑封芯片是否需要點(diǎn)膠加固保護(hù),并不完全取決于芯片的大小,而是由多種因素共同決定的。以下是一些影響是否
![的頭像]() 發(fā)表于
發(fā)表于 09-27 09:40
?570次閱讀

芯片封裝底部填充材料如何選擇?芯片封裝底部填充材料的選擇是一個(gè)復(fù)雜而關(guān)鍵的過(guò)程,它直接影響到芯片封裝的可靠性和性能。底部填充
![的頭像]() 發(fā)表于
發(fā)表于 08-29 14:58
?901次閱讀

銅區(qū)域是無(wú)法滿(mǎn)足散熱要求的。請(qǐng)問(wèn)有沒(méi)有其他的散熱方式?在OPA544芯片的上表面(標(biāo)記信號(hào)的面)用導(dǎo)熱硅膠粘上散熱片的方式可不可行?OPA544芯片的黑色主體材料導(dǎo)熱性好不好?
發(fā)表于 08-22 06:37

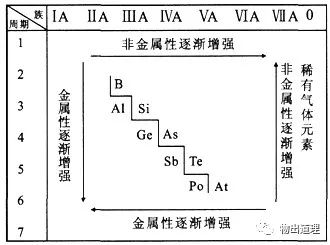
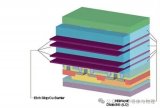




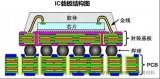









 芯片需要哪些材料
芯片需要哪些材料











評(píng)論