電壓穩(wěn)壓器,特別是集成MOSFET的直流/直流轉(zhuǎn)換器,已從由輸入電壓、輸出電壓和電流限定的簡易、低功耗電壓調(diào)節(jié)器,發(fā)展到現(xiàn)在能夠提供更高功率、監(jiān)控操作環(huán)境且能相應(yīng)地適應(yīng)所處環(huán)境。
以前,需要高于10-15A電流的應(yīng)用通常依賴于具有外部MOSFET的控制器,以提供所需功率完成工作。轉(zhuǎn)換器盡管可讓設(shè)計(jì)的布局更簡單,使用物料清單(BOM)中的組件更少,同時(shí)還能提供具有高可靠性的高密度解決方案,但可提供的功率相對有限。
諸如網(wǎng)絡(luò)路由器、交換機(jī)、企業(yè)服務(wù)器和嵌入式工業(yè)系統(tǒng)等應(yīng)用的耗電量越來越高,需要30A、40A、60A或更高電流以用于它們的負(fù)載點(diǎn)(POL)設(shè)計(jì)。當(dāng)適應(yīng)控制器和外部MOSFET時(shí),這些應(yīng)用極大地限制了主板空間。
MOSFET和封裝技術(shù)的進(jìn)步使得TI能夠成功應(yīng)對這些挑戰(zhàn)。諸如TI 2.x NexFET?功率MOSFET的新一代MOSFET,在給定的硅面積中具有更低電阻率(RDS(on)),以實(shí)現(xiàn)更高的電流容量。我們的PowerStack?封裝技術(shù)將集成電路(IC)和MOSFET相互堆疊(見圖1),以提供能夠供應(yīng)每相35A-40A的轉(zhuǎn)換器。為達(dá)到新高度,TI目前提供的轉(zhuǎn)換器,比如TPS546C23 SWIFTTM轉(zhuǎn)換器,可實(shí)現(xiàn)電流堆疊(見圖2),提供高達(dá)70A的POL。
下載參考設(shè)計(jì)“采用具有PMBus 接口的堆疊 TPS546C23 DC/DC 轉(zhuǎn)換器的12Vin、1.2Vout、60A大功率密度頂部電感器負(fù)載點(diǎn)(POL)”。
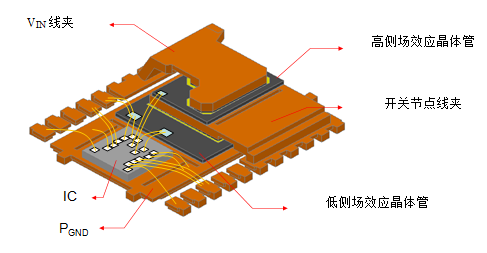
圖1:PowerStack封裝實(shí)現(xiàn)高密度
處理高密度功率環(huán)境需要優(yōu)化系統(tǒng)功率和動(dòng)態(tài)電源管理(APM)。例如,1VOUT30A POL中10%的電壓上下波動(dòng)范圍會(huì)影響封裝熱量,達(dá)到0.5W!避免過多熱量留在安全操作區(qū)域(SOA),且不影響系統(tǒng)的可靠性至關(guān)重要。為了實(shí)時(shí)正確管理電源(見圖3),監(jiān)測遙測參數(shù)(如電流,電壓和溫度)至關(guān)重要。TI 具有PMBus的新型TPS546C23轉(zhuǎn)換器支持遙測技術(shù)。

圖3:Fusion GUI通過PMBus管理電源
電壓穩(wěn)壓器從簡易低功率供電,發(fā)展到如今具有集成MOSFET的DC/DC轉(zhuǎn)換器,可以傳輸更高功率,并對環(huán)境進(jìn)行監(jiān)控和適應(yīng)。現(xiàn)在,您可輕松地監(jiān)控、管理并堆疊TI的TPS546C23 PowerStack轉(zhuǎn)換器,提供高達(dá)70A的高密度、高性能POL。獲取更多信息并訂購評估面板。
審核編輯:何安淇
-
電流
+關(guān)注
關(guān)注
40文章
7134瀏覽量
134929 -
電源管理
+關(guān)注
關(guān)注
117文章
6431瀏覽量
146089
發(fā)布評論請先 登錄
淺談辰達(dá)MOSFET在USB PD快充電源中的應(yīng)用挑戰(zhàn)與應(yīng)對

動(dòng)力電池測試中的直流負(fù)載挑戰(zhàn)與應(yīng)對策略
MOSFET開關(guān)損耗計(jì)算
Nexperia推出高效耐用的1200 V SiC MOSFET,采用創(chuàng)新X.PAK封裝技術(shù)

全面剖析倒裝芯片封裝技術(shù)的內(nèi)在機(jī)制、特性優(yōu)勢、面臨的挑戰(zhàn)及未來走向
Marvell展示2納米芯片3D堆疊技術(shù),應(yīng)對設(shè)計(jì)復(fù)雜性挑戰(zhàn)!

一文帶你讀懂MOSFET開關(guān)損耗計(jì)算!!(免積分)
Nexperia推出CCPAK1212封裝MOSFET,性能再升級
2024 TI高壓研討會(huì)精彩回顧
海外HTTP安全挑戰(zhàn)與應(yīng)對策略
SiC MOSFET模塊封裝技術(shù)及驅(qū)動(dòng)設(shè)計(jì)
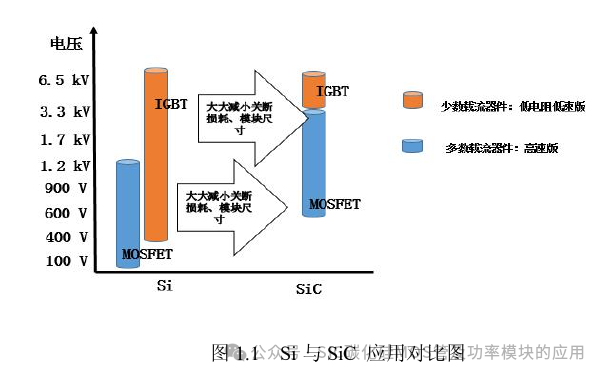
成功并聯(lián)功率MOSFET的技巧

億鑄科技談大算力芯片面臨的技術(shù)挑戰(zhàn)和解決策略
3D封裝熱設(shè)計(jì):挑戰(zhàn)與機(jī)遇并存

使用SiC技術(shù)應(yīng)對能源基礎(chǔ)設(shè)施的挑戰(zhàn)






 MOSFET和封裝技術(shù)的進(jìn)步使得TI能夠成功應(yīng)對這些挑戰(zhàn)
MOSFET和封裝技術(shù)的進(jìn)步使得TI能夠成功應(yīng)對這些挑戰(zhàn)











評論