Q1
QFP的封裝,MCU的RTC功能,外部32.768K晶振不起振,把MCU重新焊接一下就好了,晶振電路沒有動(dòng)。可以排除晶振外部電路的焊接問題和芯片boot strapping問題。這個(gè)可能是什么原因?需要做什么分析?嘗試改過MCU內(nèi)部晶振電路驅(qū)動(dòng)能力,還有晶振的負(fù)載電容,和反饋電阻,但都沒有效果。懷疑溫度導(dǎo)致MCU的這兩個(gè)晶振管腳電氣特性發(fā)生變化,變好了。客戶端懷疑芯片封裝問題,高溫改變了管腳封裝的內(nèi)部晶圓阻抗特性等。
A
可能的原因:
1、確認(rèn)晶振選型是否合適,例如看匹配電容參數(shù)。
2、確認(rèn)不同溫度條件下晶振是否能起振,如果室溫就不能起振、低溫條件下也要驗(yàn)證一下。天干物燥、重新焊接等等環(huán)境變化,都會導(dǎo)致該管腳輕微的量級變化,從而導(dǎo)致芯片出現(xiàn)完全不同的狀態(tài)。
3、Boot Strapping配置問題。舉個(gè)例子,STM32 MCU 的Boot0管腳如果不接GND,而是懸空,那么就會導(dǎo)致有時(shí)候能啟動(dòng),有時(shí)候不能啟動(dòng)。對于芯片的啟動(dòng)配置管腳,如果懸空,芯片內(nèi)部也沒有上下拉,那么這個(gè)管腳就會出于未知狀態(tài)。當(dāng)這個(gè)管腳積累的電荷比較少,就會以低電平方式啟動(dòng)芯片,當(dāng)電荷積累的較多,就會以高電平配置方式啟動(dòng)芯片。
4、焊接問題,可以用3D Xray看看是否有焊接問題。
分析:要做FA分析,看看Bonding線和 First Pad, Second Pad是否有連接問題。測一下起振電流的大小,一般起振電流都不大,如果焊接或者封裝不良導(dǎo)致寄生的電路會影響起振。
Q2
植球產(chǎn)品做完P(guān)CT168試驗(yàn)后測試Fail,SEM看到有PI crack。錫球UBM看著很奇怪,打了EDS成分里有錫,PI 表面沾污里也有。PCT試驗(yàn)會導(dǎo)致這種情況嗎?
A
PCT實(shí)驗(yàn)條件中121℃不會導(dǎo)致PI/ubm成分中含錫,但是植球后需要reflow,可能導(dǎo)致EDS分析含錫。
Q3
有個(gè)FC產(chǎn)品要做solder bump,bump pitch 150;封裝廠建議我們bump diameter最大90,我們想bump diameter盡可能高,方便EMC填充,但是兩家bumping廠給出的最大bump height 差異太大,不知道那個(gè)正確?
A
工廠都應(yīng)該給出schematic,標(biāo)示具體各個(gè)部位的尺寸。或者選Filler size比較小的CPD填充,比改Bumping會更省力點(diǎn)。
Q4
是否碰到過BHAST后Vmin漂移的情況,同晶圓還是封裝工藝相關(guān)性強(qiáng)些?Vmin是電源有拉偏,呈增加的趨勢。有些像HTOL之后的。
A
建議看看該電源壓力測試前后漏電情況有沒有變化,并嘗試相應(yīng)FA分析。
Q5
封裝用的是fanout封裝,但是我們發(fā)現(xiàn)經(jīng)過溫度循環(huán)后部分芯片測試失效,有IQ失效也有短路,結(jié)果發(fā)現(xiàn)裸die背面有不同程度裂紋,有橫向也有豎向,方向都不一致,并且有個(gè)缺口大一點(diǎn),一個(gè)點(diǎn),幫忙分析下什么原因造成的?
A
建議在TC前后進(jìn)行40x鏡檢,確保疑似裂紋不是測試時(shí)導(dǎo)入。
Q6
QFN的產(chǎn)品,做完預(yù)處理+BHAST后再激光開蓋,做拉力和推力,這個(gè)數(shù)據(jù)情況和試驗(yàn)前做會有差異嗎?現(xiàn)在的情況是發(fā)現(xiàn)有2個(gè)球脫落了,如果對其他沒掉的球做拉力和推力,怎么去判斷這個(gè)結(jié)果?
A
通常,拉力和推力都較之前的Qual數(shù)據(jù)低了,但是也有可能是開蓋過程中有損傷了。樣品出現(xiàn)拉力球脫或者推力很小,那就是不正常的。可以后續(xù)分析下球脫怎么失效的,和同顆芯片未失效的做下對比。
Q7
這種圖片,是SMT之后取下來的圖片。板廠說電鍍有問題,封裝廠說板廠SMT有問題
大家覺得可能的問題是什么?很困惑。這些都是一顆樣品上的不同管腳的圖片。
A
可以檢查下有沒有高溫翹曲,或者看看出現(xiàn)non-wetting的位置有沒有共性。
Q8
整機(jī)的環(huán)境測試。芯片規(guī)格書工作溫度-40到125℃,那點(diǎn)溫計(jì)點(diǎn)殼溫應(yīng)該保證殼溫在多少度合適呢?
A
這個(gè)芯片工作的環(huán)境溫度就是125度,只要環(huán)境溫度不超過125度都是合規(guī)的。
Q9
copper pillar,側(cè)爬錫嚴(yán)重,造成void,擔(dān)心有橋接;各位有改善側(cè)爬方法嗎?(不加Ni)。Solder Mask厚度為15~20um。
A
既然不想它往上爬,SR window科實(shí)嘗試開大一些,還有,Warpage可能對此也有影響,在Reflow工藝上面想想辦法。或者,做下這個(gè)仿真一下就知道了,設(shè)計(jì)不同,影響因素相對多了點(diǎn)。
Q10
芯片內(nèi)部水汽入侵的話,芯片表面形貌會體現(xiàn)出來嗎?有沒有典型圖能學(xué)習(xí)一下?
A
芯片有水汽入侵的判斷方法:過三遍回流焊,有水汽,SAT會有紅區(qū),TSCAN,芯片下面有紅區(qū),甚至過三遍回流焊,后去做推拉力實(shí)驗(yàn)。或者開蓋,看看表面是否有侵蝕痕跡,下圖是decap后的圖片。
Q11
封裝中的打廢治具是必須的嗎?以前都沒有聽說過這個(gè)東西。封裝過程中標(biāo)記reject的,比如內(nèi)部打線不良的,塑封后就看不到了,需要標(biāo)記出來,切割后就打廢掉不進(jìn)入包裝。
A
根據(jù)工廠的現(xiàn)狀,每家要求不一樣。比如系統(tǒng)比較好的有mapping+Jig saw就可以直接踢出不良。系統(tǒng)不完善的,就只能手工記錄, Tape saw就更不易操作了。
Q12
合封的費(fèi)用比普通封裝的費(fèi)用大概會貴多少?比如都是wire bond BGA256,一個(gè)是單顆die,一個(gè)是兩顆die(兩顆die之間只有不到10個(gè)引腳互聯(lián)),合封的價(jià)格大概會貴多大比例?
A
這個(gè)不好說,UPH什么的都要考慮進(jìn)去。UPH=unit per hour,每小時(shí)產(chǎn)量。
Q13
封裝可能會影響MCU系統(tǒng)時(shí)鐘的頻率嗎?我們有款產(chǎn)品在兩家封裝廠封裝出來的產(chǎn)品有一家封裝片測出來的系統(tǒng)時(shí)鐘跟CP校準(zhǔn)后的相比偏差很大,另外一家沒有問題,有沒有遇到過類似問題?
A
RC震蕩電路的R/C值會引起頻率變化。不知道你是那種頻率發(fā)生器。可以找設(shè)計(jì)來解釋。
編輯:jq
-
mcu
+關(guān)注
關(guān)注
146文章
17841瀏覽量
360513 -
封裝
+關(guān)注
關(guān)注
128文章
8509瀏覽量
144802 -
RC
+關(guān)注
關(guān)注
0文章
236瀏覽量
49530
原文標(biāo)題:季豐電子IC運(yùn)營工程技術(shù)知乎 – 21W35
文章出處:【微信號:zzz9970814,微信公眾號:上海季豐電子】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
季豐計(jì)量榮獲CNAS認(rèn)可資質(zhì)

季豐電子推出低高溫手動(dòng)探針臺設(shè)備
季豐電子與林眾電子、瞻芯電子達(dá)成戰(zhàn)略合作伙伴關(guān)系
季豐電子新型電池材料評估能力概覽
季豐電子全新推出MonitorMaster三代

上海季豐榮獲ISO14001和ISO45001雙體系認(rèn)證證書
成都季豐獲批CNAS實(shí)驗(yàn)室認(rèn)可證書
季豐電子MonitorMaster系統(tǒng)在BHAST實(shí)驗(yàn)中的應(yīng)用

衢州季豐獲得CMA擴(kuò)項(xiàng)資質(zhì)認(rèn)定證書
2024季豐電子技術(shù)交流研討會深圳站圓滿結(jié)束
衢州季豐獲得CNAS擴(kuò)項(xiàng)認(rèn)證
杭州季豐成功獲得CNAS認(rèn)可證書
季豐電子與數(shù)字電源設(shè)計(jì)公司華源智信攜手建立聯(lián)合實(shí)驗(yàn)室

季豐電子與孤波科技攜手合作為車規(guī)量產(chǎn)提供大數(shù)據(jù)支持
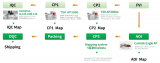
季豐電子成功通過IECQ換證審核






 季豐電子IC運(yùn)營工程技術(shù)問答
季豐電子IC運(yùn)營工程技術(shù)問答










評論